摘要: 采用磁控溅射法制备了不同厚度的Sn
15 Sb
85 薄膜, 使用电阻-温度-时间测试系统研究了Sn
15 Sb
85 薄膜在热致作用下从非晶态到晶态的相变动力学过程. 应用近红外分光光度计获得了非晶Sn
15 Sb
85 薄膜的反射率光谱, 拟合计算得到薄膜的光学带隙. 通过原子力显微镜观察了Sn
15 Sb
85 薄膜晶化后的表面形貌, 研究了膜厚对薄膜粗糙度的影响. 通过X射线衍射仪(XRD)分析了晶态Sn
15 Sb
85 薄膜的相结构及晶粒尺寸变化. 采用互补金属氧化物半导体(CMOS)工艺制备了基于不同厚度Sn
15 Sb
85 薄膜的T型相变存储器单元, 并通过半导体器件测试系统分析了其阈值转换能力及功耗. 研究结果表明, 随着薄膜厚度的减小, Sn
15 Sb
85 相变材料的非晶态和晶态电阻、相变温度、十年非晶态数据保持力、结晶激活能、光学带隙均显著提升. 基于20 nm厚度Sn
15 Sb
85 薄膜相变存储单元在纳秒级电脉冲作用下能够实现可逆SET/RESET操作, 且厚度较小的薄膜具有较高的SET电压和较低的RESET电压, 体现了超薄Sn
15 Sb
85 薄膜的高热稳定性和低操作功耗特征, 有利于实现相变存储器的高密度集成.
关键词: Sn15 Sb85 薄膜 /
厚度效应 /
热稳定性 /
功耗 English Abstract Thickness effect of Sn15 Sb85 phase change film Huang Yu-Feng 1 ,Wu Wei-Hua 1,2 ,Xu Sheng-Qing 1 ,Zhu Xiao-Qin 1 ,Song San-Nian 3 ,Song Zhi-Tang 3 1.School of Mathematics and Physics, Jiangsu University of Technology, Changzhou 213001, China Fund Project: Project supported by the Natural Science Foundation of the Jiangsu Higher Education Institutions of China (Grant No. 19KJB510025), China Postdoctoral Science Foundation (Grant No. 2020M671566) and Natural Science Foundation of China (Grant No. 12074152)Received Date: 24 May 2021Accepted Date: 01 July 2021Available Online: 15 August 2021Published Online: 20 November 2021Abstract: Sn15 Sb85 thin films with different thickness are prepared by magnetron sputtering. The evolution of Sn15 Sb85 thin film from the amorphous state to the crystalline state is studied by an in-situ resistance temperature measurement system. The crystallization temperature, electrical resistance, crystallization activation energy, and data retention capacity of Sn15 Sb85 thin film increase significantly with film thickness decreasing. The near infrared spectrophotometer is used to record the diffuse reflectance spectra of amorphous Sn15 Sb85 film. The results show that the band gap energy increases with film thickness decreasing. The surface morphology of Sn15 Sb85 film after being crystalized is observed by atomic force microscope, which shows that the thinner film has lower roughness. The analysis of X-ray diffraction indicates that the grain size becomes smaller and the crystallization may be inhibited by reducing the film thickness. T-type phase change memory cells based on Sn15 Sb85 thin films with different thickness are fabricated by the CMOS technology. The electrical performances of phase change memory show that the thinner Sn15 Sb85 film has a larger threshold switching voltage and smaller RESET operation voltage, which means the better thermal stability and lower power consumption. The outcomes of this work provide the guidance for designing the high-density phase change memory by reducing the size of Sn15 Sb85 thin film.Keywords: Sn15 Sb85 thin film /thickness effect /thermal stability /power consumption 全文HTML --> --> --> 1.引 言 近年来, 随着量子计算(QC)[1 ] 、集成电路(IC)[2 ] 、人工智能(AI)[3 ] 的迅猛发展, 对数据超快存取和海量存储提出了巨大的挑战, 使得现有的非易失性固态存储器NAND[4 ] 和易失性主存储器DRAM[5 ] 设备无法兼顾当前大数据的快速高密度存储需求. 在众多的新兴半导体存储器中, 相变存储器(Phase change memory, PCM)具有编程速度快、操作功耗低、可循环次数高、与传统的互补金属氧化物半导体(CMOS)工艺兼容等特点, 现已被公认为下一代最有发展前景的非易失性存储器[6 ] . PCM的工作原理是利用相变材料在非晶态和晶态之间的可逆相变实现信息存储的[7 ] . 处于高阻非晶态的相变材料在一个弱而宽的电脉冲作用下晶化转变为低阻晶态(即SET过程), 而低阻晶态相变材料在一个窄而强的电脉冲作用下会非晶化转变成高阻非晶态(即RESET过程), 数据的读出过程(READ)是通过施加强度微弱且作用时间极短的电脉冲来测量相变材料的电阻值, 从而保证相变材料温度远低于结晶温度, 避免了引起相变材料的相变[8 ,9 ] .2 Sb2 Te5 (GeTe和Sb2 Te3 组成的伪二元合金, 简称GST)是当前研究最为成熟的相变材料, 由于它具有纳秒级的开关速度, 存在多级相变可以实现多级存储等优点, 被广泛运用在消费类电子器件中[10 ] . 但是, GST仍存在诸多有待改善的缺点, 如: 非晶态热稳定性偏低(十年数据保持温度仅有85 ℃); Te元素的极易挥发性, 使材料容易产生相分离和污染半导体工艺; 结晶后的电阻率偏低等[11 ,12 ] . 为了克服上述不足之处, 研究人员纷纷提出了许多新型无Te富Sb的相变材料, 如SnSb[13 ] 、GaSb[14 ] 、GeSb[15 ] 、ZnSb[16 ] 和TiSb[17 ] 等相变材料. Rao等[18 ] 发现了SnSb薄膜具有一些共振特性显示了其相变能力, 尽管SnSb材料具有较高的电离度(0.1)和较低的杂化度(1.78), 但是它的热稳定性和激活能均高于传统的GST相变材料, 并且SnSb材料生长主导的结晶机制确保了快速结晶速度, SnSb被认为是一种潜在的相变材料. Wu等[19 ] 研究发现GeSb薄膜的相变性能与薄膜厚度之间存在着强烈的依赖关系, 薄膜厚度越小, 材料的非晶态热稳定性和晶态电阻得到提高, 但是相变速度受到了抑制. 相变存储介质厚度的减小有利于实现PCM器件的高密度存储. 为此, 本文以Sn15 Sb85 薄膜为研究对象, 重点研究薄膜材料的厚度效应, 期望通过减小薄膜厚度改善材料的非晶热稳定性和操作功耗, 为获得高存储密度相变材料提供科学支持.15 Sb85 薄膜, 详细研究了薄膜厚度对Sn15 Sb85 相变材料的相变温度、十年非晶态保持力、非晶态热稳定性、可靠性等相变特性的影响, 并制备了基于超薄Sn15 Sb85 薄膜的相变存储原型器件, 分析了其阈值转换等电学性能.2.实验方法 所有薄膜样品均是通过磁控溅射法沉积在Si/SiO2 衬底上. 在制样之前将Si/SiO2 衬底放在装有无水乙醇的烧杯中超声波清洗20 min, 去除衬底表面杂质和污染物. 实验中采用的Sn15 Sb85 靶材纯度大于99.999%, 本底真空度小于6×10–4 Pa, 溅射在功率为30 W、氩气压力0.4 Pa、流量为30 SCCM的条件下进行的. 为了保证薄膜溅射的均匀性, 样品盘以20 r/min的速率匀速旋转.R -T -t )测试系统研究了不同厚度的Sn15 Sb85 薄膜的电阻与温度的关系, 并采用Arrhenius方法估算了非晶态薄膜的十年非晶态保持力和结晶激活能. 通过近红外分光光度计测试了非晶薄膜的反射率, 并通过Kubelka-Munk函数推算出能带间隙. 通过原子力显微镜(atomic force microscope, AFM)观察了薄膜晶化后的表面形貌, 分析了膜厚对薄膜表面性能的影响. 采用X射线衍射仪(X-ray diffraction, XRD)分析了薄膜的晶体结构及晶粒尺寸变化. 采用CMOS工艺制备了基于厚度为20 nm和40 nm的Sn15 Sb85 薄膜T型PCM原型器件, 器件直径为190 nm. 使用任意波形发生器(Tektronix AWG5012B)和半导体参数分析仪(Keithley 2602A)搭建的半导体测试系统分析了PCM器件单元的电流-电压(I-V )和电阻-电压(R-V )特性.3.实验结果与分析 图1 显示了不同厚度的Sn15 Sb85 薄膜(10, 20, 40, 80 nm和160 nm)在20 ℃/min的升温速率下的电阻与退火温度之间的关系. 刚开始, 所有的薄膜都处于一个较高的电阻, 这表明薄膜处于非晶态. 随着退火温度的升高, 薄膜的电阻缓慢下降, 这是由于半导体材料的温度特性所致. 当退火温度到达一个特殊值的时候, 薄膜的电阻都急剧下降, 这表明薄膜进入到了相变过程, 此时的温度被定义为结晶温度T c . 随着退火温度的继续升高, 薄膜的电阻值基本保持稳定, 这表明薄膜已完成非晶到晶态的转变. 如图1 所示, 随着Sn15 Sb85 薄膜厚度的减小, 薄膜晶化温度由160 nm的198 ℃上升到10 nm的246 ℃, 并且当厚度在80 nm以下晶化温度变化的更加明显, 这表明Sn15 Sb85 薄膜的结晶性能在80 nm以下对厚度更加敏感. 通常来讲, 越高的结晶温度表明相变材料的非晶热稳定性越好. 此外, 随着薄膜厚度的减小, 薄膜的晶态电阻R c 及非晶态电阻R a 都增加了两个数量级以上, 根据焦耳热公式Q = I 2 Rt , 较高的电阻有助于减小PCM器件的操作电流, 从而降低PCM器件的功耗. 因此, Sn15 Sb85 薄膜的厚度减小可以提高相变材料的非晶态热稳定性且降低PCM器件功耗, 这对于实现PCM的高密度集成是有利的.图 1 不同厚度Sn15 Sb85 薄膜在20 ℃/min的升温速率下的R-T 曲线Figure1. R-T curves of Sn15 Sb85 films with different thicknesses at the heating rate of 20 ℃/min15 Sb85 薄膜的非晶态热稳定性的影响, 采用等温结晶法评估了薄膜的结晶激活能E a 和十年非晶态保持力T 10 . 在T c 温度之前, 选取固定间隔为5 ℃的3—4个温度进行等温结晶实验, 随着退火时间的增加, 薄膜的电阻逐渐减小. 在本工作中, 失效时间定义为薄膜电阻下降到初始值一半的退火时间. 然后根据Arrhenius关系拟合出失效时间与1/k B T 的关系曲线图, Arrhenius关系如下[20 ,21 ] :t , τ 0 , E a , k B , T 分别表示失效时间、依赖于材料性质的前置指数、晶化激活能、玻尔兹曼常数和绝对温度. 如图2 所示, 随着膜厚的减小, 薄膜的晶化激活能从160 nm的2.88 eV提高到10 nm的3.87 eV, 较高的晶化激活能意味着相变材料从非晶态到晶态所需要的能量越多, 也就说明薄膜在更薄时具有更好的非晶态热稳定性. 此外, 厚度为10, 20, 40, 80 nm和160 nm的Sn15 Sb85 薄膜的十年数据保持温度T 10 分别为184, 167, 152, 139 ℃和130 ℃, 随着薄膜厚度的减小, 其数据保持温度单调增加, 这可能是由于薄膜在结晶过程中晶粒生长受到厚度限制引起的. 一般来说, 较高的T 10 意味着相变材料非晶态的可靠性越高, 可以在高温下存储数据. 这与上述的R-T 分析结果相符合.图 2 不同厚度的Sn15 Sb85 薄膜的失效时间与温度倒数的关系Figure2. The relationship between the failure time and reciprocal temperature of Sn15 Sb85 film with different thickness.15 Sb85 薄膜在波长为400—2500 nm范围内的反射率光谱, 反射率和吸光度的转换通过Kubelka-Munk函数获得[22 ] :F (R )是Kubelka-Munk, R 是反射率, K 是吸收系数, S 是散射系数. 因为考虑到散射系数S 与波长无关, 可以假设F (R )与吸收系数K 成正比, Tauc plot法认为K 与能带间隙E g 有关, 公式为: $ Kh\nu =A{(h\nu -{E}_{\mathrm{g}})}^{n} $ [23 ] . 对于漫反射测量, 相同的方程可以写为$ F\left(R\right)h\nu =A{(h\nu -{E}_{\mathrm{g}})}^{n} $ . 因此, 在Kubelka-Munk函数曲线图中, 能带间隙值E g 定义为曲线线性部分的拟合线延长与能量轴的截距. 如图3 所示, 随着薄膜厚度的减小, 薄膜的能带间隙值从80 nm的1.035 eV增加到10 nm的1.762 eV. 能带间隙的大小意味着电子从价带跃迁到导带的难易程度, 能带间隙越大表明较低的电导率和较高的电导激活能, 使得电子从价带跃迁到导带需要的能量更多[24 ] . 结果表明, 更薄的Sn15 Sb85 薄膜具有更大的能带间隙, 也就意味着更高的非晶电阻. 这与上述R -T 曲线结果是一致的.图 3 不同厚度的非晶Sn15 Sb85 薄膜Kubelka-Munk函数曲线Figure3. Kubelka-Munk function curves of Sn15 Sb85 films with different thicknesses.图4 显示了不同厚度的Sn15 Sb85 薄膜在260 ℃下退火10 min(保证每个厚度的薄膜都处于晶态)的表面形貌图. 随着膜厚的减小, 薄膜的表面变得更加均匀. 一般来说, 薄膜均方根(root-mean-square, RMS)的大小能直接反映出薄膜表面的粗糙度情况, RMS值越小表明相变材料的表面越光滑. 10, 20, 40 n m和80 nm 的Sn15 Sb85 薄膜RMS分别为0.23, 0.26, 0.32 nm和0.38 nm, 这意味着越薄的Sn15 Sb85 薄膜, 具有更加光滑的表面, 这有利于增加电极与相变材料间的有效接触, 从而提高相变材料器件的可靠性.图 4 不同厚度的Sn15 Sb85 薄膜在260 ℃下退火10 min的AFM图Figure4. AFM images of Sn15 Sb85 films with different thicknesses annealed at 260 ℃ for 10 min, respectively.15 Sb85 薄膜的相结构. 图5 显示了不同厚度的Sn15 Sb85 薄膜在260 ℃下退火10 min的XRD图谱, 可以看出在160 nm的Sn15 Sb85 薄膜中出现了(012)和(110)的衍射峰, 通过对比标准PDF卡片, 确认为菱方结构的Sb相, 表明晶态SnSb薄膜仅仅析出Sb相, Sn或SnSb化合物以非晶态形式存在. 随着薄膜厚度的减小, (012)衍射峰的强度变弱, (110)衍射峰在厚度为80 nm的Sn15 Sb85 薄膜中强度变弱且在厚度为10, 20 nm和40 nm的Sn15 Sb85 薄膜中均未出现, 这可能是由于Sb相的择优生长引起的. 此外, 在厚度从160 nm降低到80 nm的薄膜中, (012)衍射峰发生了向左的小幅度偏移, 这可能缘于厚度减小引起宏观残余拉应力的变小引起了晶格各向异性收缩, 从而导致衍射峰向低角度的方向偏移. 这意味着厚度的减小可能会抑制Sb晶粒的生长. Sn15 Sb85 薄膜的晶粒尺寸可利用Scherrer计算出薄膜晶粒的大小[25 ] : D hkl = 0.943λ /(β cosθ ). 其中λ 是X射线的波长, β 是半峰全宽(full width at half maxima, FWHM), θ 是衍射角. 选取160 nm和20 nm的Sn15 Sb85 薄膜(012)对应的衍射峰计算, 他们对应的半峰全宽分别为0.516°和0.664°, X射线波长为0.154 nm, 计算得到平均晶粒尺寸分别为16.1 nm和12.5 nm, 这表明薄膜厚度减小使得晶粒细化, 细小的晶粒会产生更多的晶界, 引起载流子的散射, 从而提高了薄膜的晶态电阻[26 ] . 这与图1 中更薄的薄膜具有更高的晶态电阻相吻合.图 5 不同厚度的Sn15 Sb85 薄膜在260℃下退火10 min的XRD衍射图谱Figure5. XRD patterns of Sn15 Sb85 films with different thicknesses annealed at 260 ℃ for 10 min.15 Sb85 薄膜T型结构PCM器件. 图6(a) 显示了20 nm的PCM器件(PCM20)和40 nm的PCM器件(PCM40)在电流扫描模式下的I -V 特征曲线. 随着扫描电流增加, 两个PCM器件的电压都逐渐升高(此过程中器件单元处于非晶态). 当PCM20和PCM40的电压分别增加到3.84 V和3.26 V时, 电压都急剧减小, 即典型的负电阻特性, 表明器件单元中的存储介质从非晶态转变到晶态. I-V 曲线表明, PCM40的阈值电压(V th )低于PCM20, 根据焦耳热定律计算可知PCM20结晶需要更多的能量, 表明更薄的Sn15 Sb85 薄膜的非晶热稳定性越好, 这一结果与前文的R-T 分析结果是吻合的. 图6(b) 显示了PCM20与PCM40在脉冲宽度为500 ns下的R-V 特性, 随着脉冲电压的增加, 两个PCM器件均实现了高阻-低阻-高阻的转变. PCM20的SET电压高于PCM40, 进一步说明了越薄的PCM单元需要更多的能量完成结晶过程. 相反的是, PCM20的RESET电压(5.02 V)低于PCM40的RESET电压(5.40 V), 根据焦耳定律可知PCM20具有更低的RESET功耗. 这可能是由于较薄的Sn15 Sb85 薄膜具有更低的热导率, 这将意味着薄膜在RESET过程中热能损耗更小. 也可能是由于PCM20的存储单元相对较薄, 在熔化时所需要的能量也就越小, 从而降低了PCM器件的RESET功耗.图 6 (a) PCM20和PCM40器件的I -V 特性; (b) PCM20和PCM40器件的R -V 特性Figure6. (a) I -V characteristics of PCM20 and PCM40; (a) R -V characteristics of PCM20 and PCM40.4.总 结 本文系统地研究了厚度对Sn15 Sb85 薄膜相变性能、光学性质、相结构、晶粒尺寸和电开关特性等的影响. 结果表明, 随着薄膜的厚度从160 nm减小到10 nm, 相变材料的晶态和非晶态电阻提升了约两个数量级、相变温度从198 ℃提高到246 ℃、十年数据保持温度从130 ℃提升到184 ℃、光学带隙能从1.035 eV增大到1.762 eV, 这些结果表明了越薄的Sn15 Sb85 薄膜具有更好的非晶态热稳定性. AFM观察结果证实越薄的Sn15 Sb85 薄膜在晶化后表面越平滑, 有利于提高PCM器件工作可靠性. XRD分析表明随着Sn15 Sb85 薄膜厚度的减小, 薄膜的结晶受到抑制, 平均晶粒尺寸减小. PCM器件性能证实了更薄的Sn15 Sb85 薄膜具有更高的阈值电压和更低的复位电压, 表明更薄的Sn15 Sb85 薄膜具有更高的非晶态热稳定性和更低的功耗. 总之, 通过缩小相变材料薄膜的厚度可以获得优异的相变性能, 有助于实现器件高存储密度和低功耗存储, 为未来的体积小、密度大PCM器件的研制提供了科学指引. 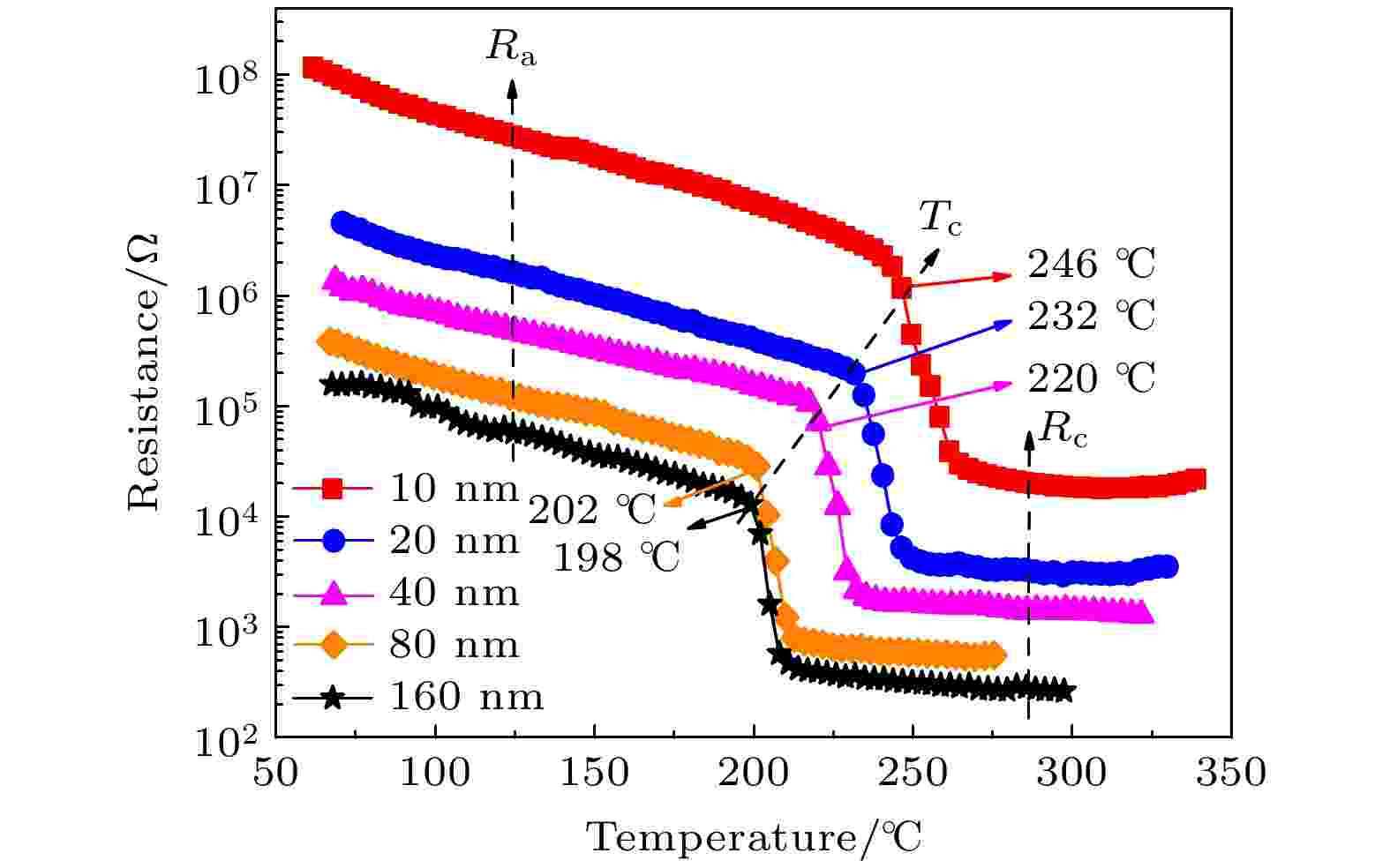 图 1 不同厚度Sn15Sb85薄膜在20 ℃/min的升温速率下的R-T曲线
图 1 不同厚度Sn15Sb85薄膜在20 ℃/min的升温速率下的R-T曲线 图 2 不同厚度的Sn15Sb85薄膜的失效时间与温度倒数的关系
图 2 不同厚度的Sn15Sb85薄膜的失效时间与温度倒数的关系

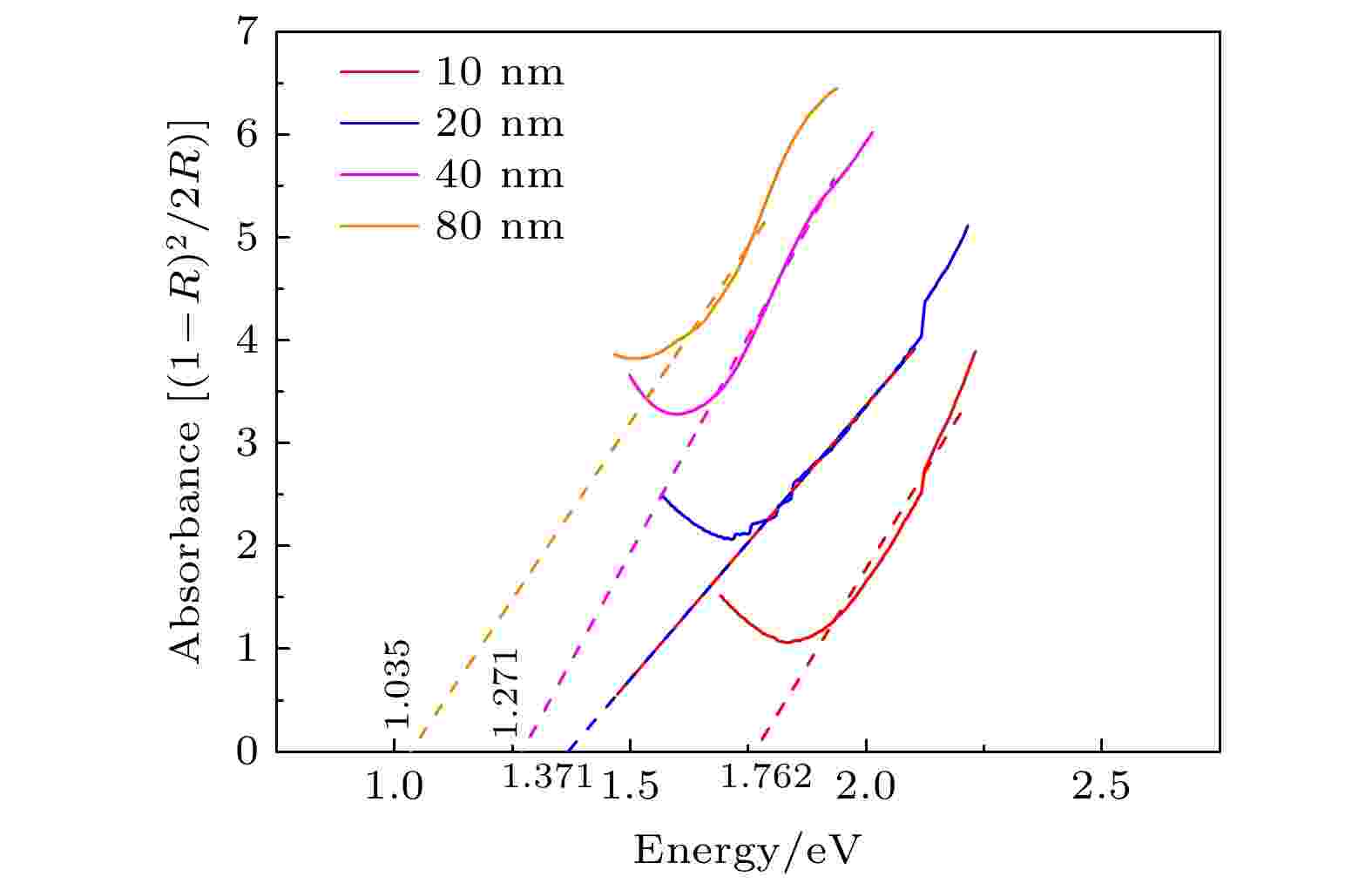 图 3 不同厚度的非晶Sn15Sb85薄膜Kubelka-Munk函数曲线
图 3 不同厚度的非晶Sn15Sb85薄膜Kubelka-Munk函数曲线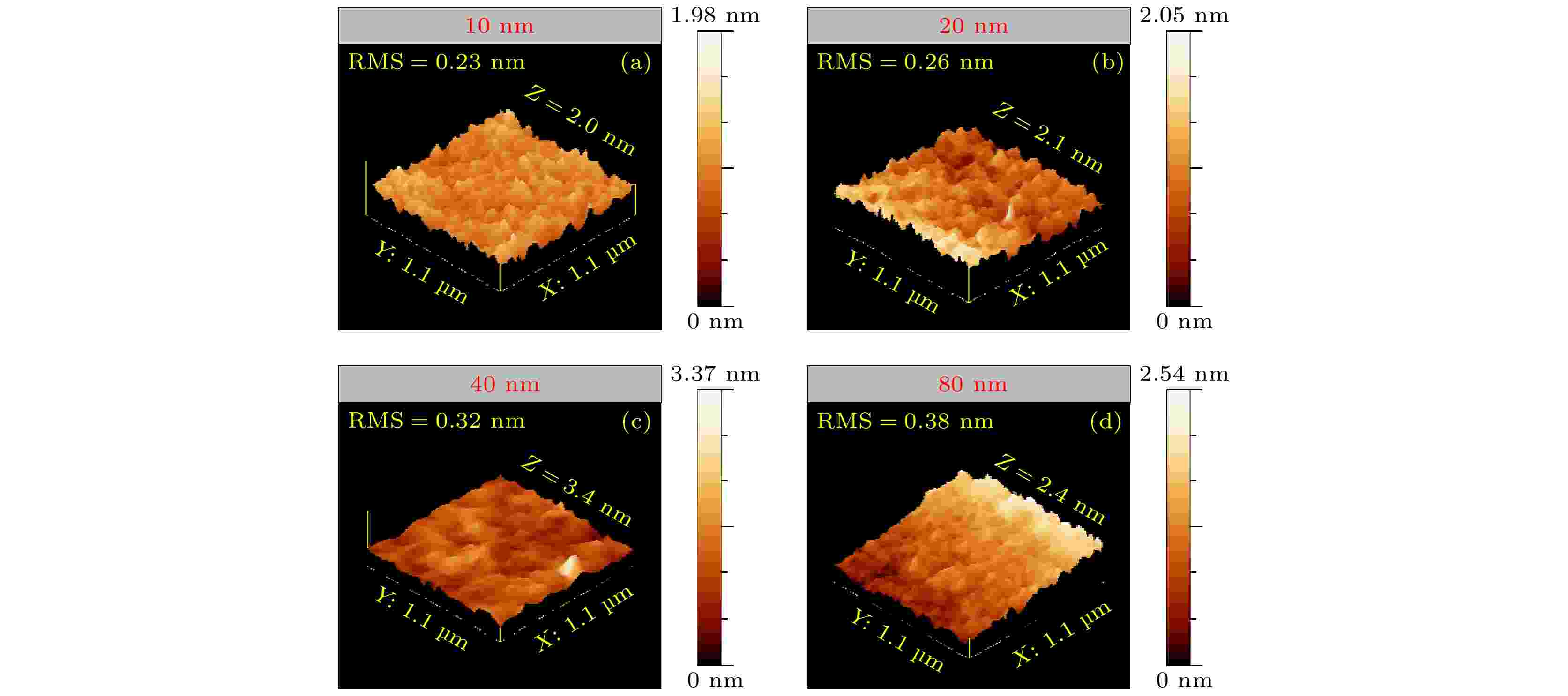 图 4 不同厚度的Sn15Sb85薄膜在260 ℃下退火10 min的AFM图
图 4 不同厚度的Sn15Sb85薄膜在260 ℃下退火10 min的AFM图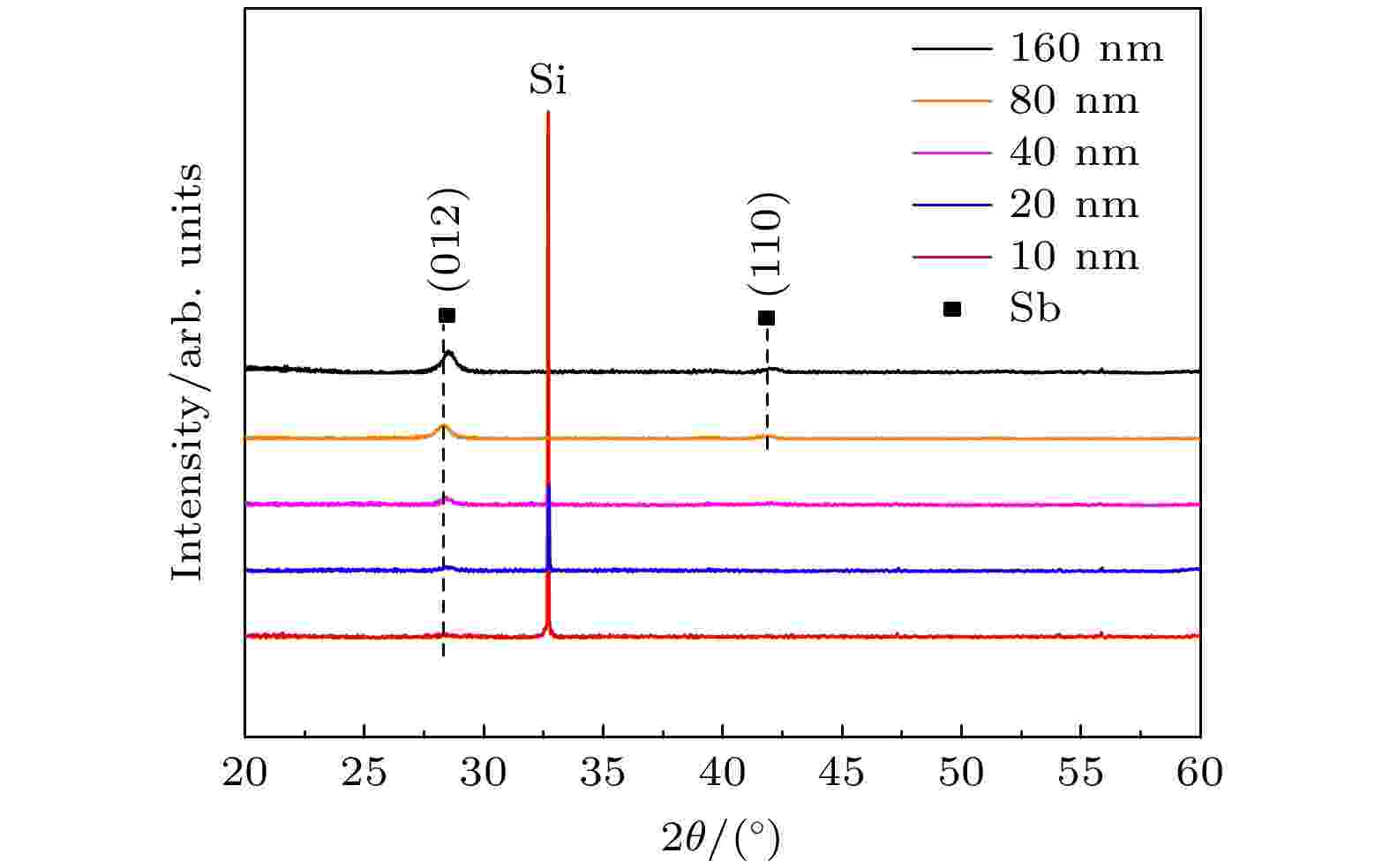 图 5 不同厚度的Sn15Sb85薄膜在260℃下退火10 min的XRD衍射图谱
图 5 不同厚度的Sn15Sb85薄膜在260℃下退火10 min的XRD衍射图谱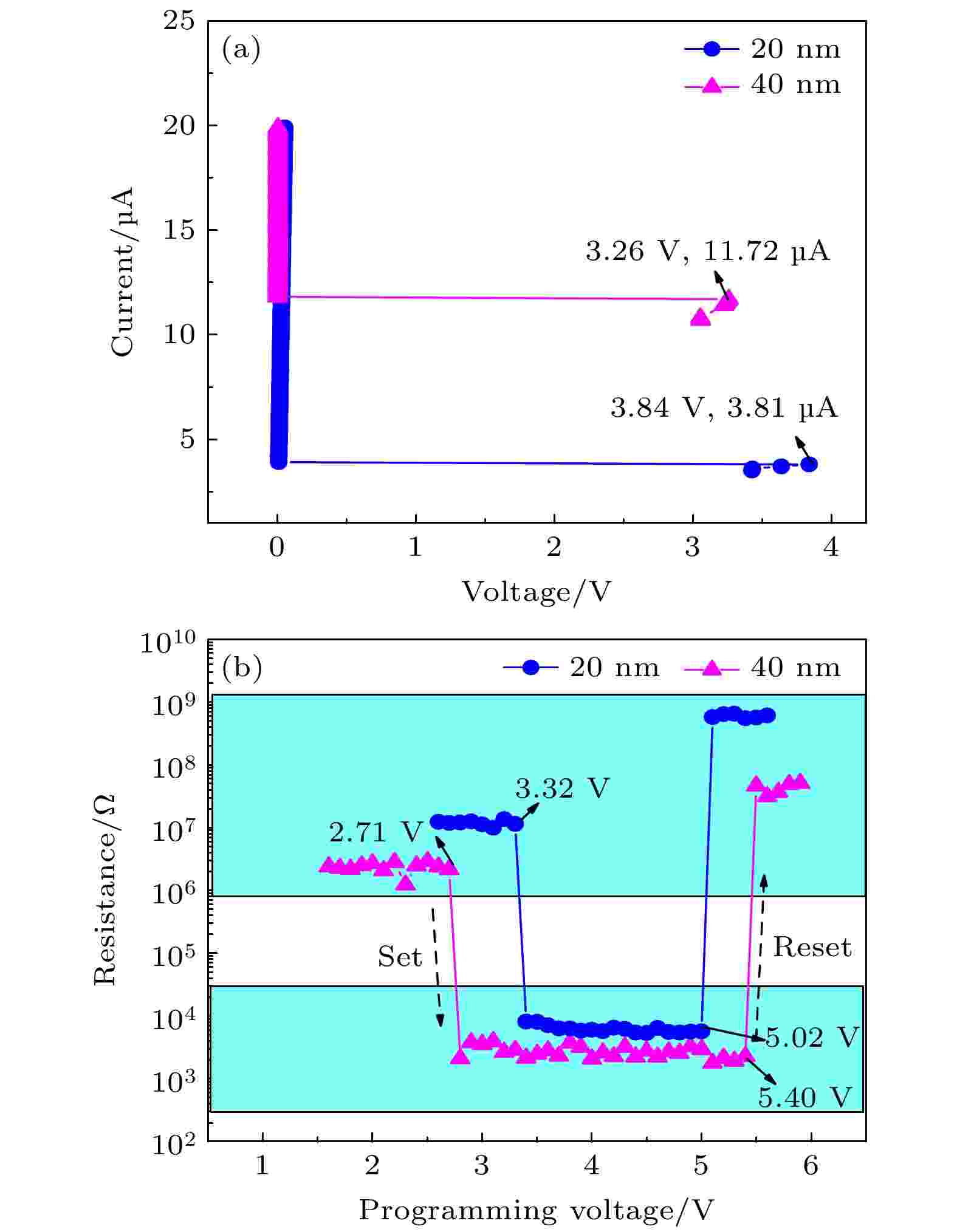 图 6 (a) PCM20和PCM40器件的I-V特性; (b) PCM20和PCM40器件的R-V特性
图 6 (a) PCM20和PCM40器件的I-V特性; (b) PCM20和PCM40器件的R-V特性