全文HTML
--> --> -->目前, 对于HfO2基阻变存储器的研究, 国内外已经有大量的报道[14-17]. 研究表明, 掺入杂质可以有效改善HfO2的特性, 实验证实掺杂的金属原子对氧空位缺陷形成的难易程度和缺陷之间的相互作用都有一定的影响, 导致氧空位(VO)具有形成团簇的倾向, 并且这些团簇容易在杂质周围形成[18,19]. 通过向基于ZrO2的RRAM中加入N来研究对氧空位的影响, 不仅降低了器件的形成电压和工作电压, 而且器件的电阻开关性能和多级存储能力也显著提高[20]. 文献[21]在研究利用原子层沉积制备无定形薄膜时发现, 通过掺杂Si, Al等元素, 可以提高无定形HfO2的热稳定性. 文献[22]研究表明, 无论以原子层沉积(ALD) HfO2中采用离子注入Al, 还是采用在制备HfO2过程中加入Al2O3来引入杂质Al, 都能够使数据的保持特性和形成电压得到改善. 对掺杂Al, La, Ga等三价元素的HfO2体系研究时, 发现氧空位才是材料产生导电现象的主要原因[23,24]. 掺杂降低了氧空位缺陷的形成能, 杂质Al, La, Ga和Gd等元素可以更好地控制导电细丝的形成[25,26]. 在含氧空位和不含氧空位的HfO2体系中掺杂Au都能够显著提高电导率, 氧空位和Au都在电阻开关中起到重要作用[27]. 不仅仅是掺杂剂的类型对改善RRAM性能有影响, 掺杂剂的浓度也是不可忽略的因素[28]. 在数据的高密度存储以及编程/擦写 (P/E)操作方面, 氧空位机制的阻变薄膜总能优于金属细丝机制, 因而在未来的高密度存储上氧空位机制阻变薄膜具有更好的发展前景[29]. 此外, 缺陷引入造成晶格结构改变也会影响材料特性. 高Al组分AlGaN材料随掺杂浓度不同而引起的晶格结构变化, 有利于出光效率的改善[30]. 高介电常数 (k)材料 HfO2中的VO缺陷引起的晶格结构变化对电荷俘获起主导作用, 相比VO缺陷本身, 更有利于提高电荷俘获型存储器(CTM)的存储特性[31].
以上研究证实了掺杂可以改善器件的性能. 考虑到对于不同的阻变材料其阻变机理也是不同的, 如研究Ni/HfO2/Pt阻变存储器时, 发现该存储单元在低阻态时阻变层内部的导电通道是由Ni导电细丝和VO共同形成的, 该模型对复杂的阻变特性做出了合理的解释[32]. 文献[10]制备Ni/HfOx/TiN存储单元时, 对高低阻态的阻变机理做出分析, 氧含量的增加有利于减少单元功耗, 循环耐受性增强并且转变电压的均匀一致性得到改善, 低阻态时器件的导电机理为欧姆传导, 高阻态时器件的导电机理为肖特基传导. 考虑到前期研究中并未涉及掺杂引起的HfO2晶格结构变化对阻变特性的影响. 因此, 本文通过向VO缺陷HfO2阻变材料中掺入不同组分的Al杂质, 运用Material Studio建模, 并基于第一原理计算的软件包VASP[33], 首先判断杂质Al在HfO2材料中存在的方式以及与VO的相对位置, 然后分别计算了最适掺杂方式下的变组分Al对含VO缺陷的HfO2体系的分波电荷态密度及最大等势面和临界等势面值以及形成能, 并且分析了掺杂引起的晶格结构变化对HfO2中VO导电细丝形成的影响.
| 晶格参数 | ɑ/nm | b/nm | c/nm | β/(°) |
| 计算值[38] | 0.5137 | 0.51950 | 0.53090 | 99.7760 |
| 实验值[39] | 0.5119 | 0.51690 | 0.52970 | 99.1800 |
| 本文扩展超胞 | 1.0236 | 1.03714 | 1.05682 | 99.3523 |
| 本文原胞(= 超胞晶格参数/20) | 0.5118 | 0.51857 | 0.52841 | 99.3523 |
表1m-HfO2晶格参数
Table1.
 图 1 HfO2缺陷超胞模型 (a) Sub-Al掺杂到含有VO的HfO2; (b)—(f) Int-Al掺杂含有VO的HfO2, 掺杂Int-Al的个数分别为1—5
图 1 HfO2缺陷超胞模型 (a) Sub-Al掺杂到含有VO的HfO2; (b)—(f) Int-Al掺杂含有VO的HfO2, 掺杂Int-Al的个数分别为1—5Figure1. HfO2 defect supercell model: (a) Sub-Al doping into HfO2 containing VO; (b)?(f) Int-Al doping into HfO2 containing VO, the number of Int-Al is 1 to 5.
计算过程中采用了基于密度泛函理论(DFT)的平面波赝势法(PWP)和广义梯度近似(GGA)函数[40-42]. 通过优化测试得到布里渊区K点网格和平面波基截断能分别为


为了描述掺杂体系实验制备的难易程度, 对掺杂体系的总能变化进行了计算. 计算中掺入杂质导致体系的总能变化越小, 该体系在实验中就越容易制备. 此外, 缺陷形成的难易程度直接决定着导电细丝形成的难易程度. 为了描述含VO缺陷的HfO2中掺杂Al时形成的难易程度, 定义杂质Al的形成能为








计算得到的形成能越小, 相应的掺杂体系收敛越快、越稳定; 形成能越髙, 收敛越慢、稳定性越差. 因而, 形成能与RRAM的操作速度也有一定的联系.
3.1.杂质Al在HfO2中存在的方式
杂质Al在HfO2晶体中可能以间隙和替位的方式存在, 如图2中的插图所示, 不同存在方式的Al引起HfO2晶格结构的变化不同, 因而对材料阻变特性的影响不同. 为此, 本文通过理论计算, 对HfO2中杂质Al的存在方式进行了分析和研究. 如图2所示, 当Al分别以Int-Al和Sub-Al的方式掺杂到HfO2中时, 通过VASP计算得到的形成能分别为4.88 eV和7.53 eV, 与文献[12]的结果大致相同. 可见Int-Al掺杂到HfO2中形成的缺陷体系更为稳定. 在HfO2超胞中含有VO缺陷的前提下, 分别以Int-Al和Sub-Al的方式掺杂, 计算得到的形成能分别为3.37 eV和4.23 eV, 进一步验证了Int-Al掺杂到HfO2中形成的缺陷体系更稳定. 图 2 杂质Al的形成能 (插图中显示了杂质Al的存在方式, 虚线圆表示失去一个O原子后形成的VO)
图 2 杂质Al的形成能 (插图中显示了杂质Al的存在方式, 虚线圆表示失去一个O原子后形成的VO)Figure2. Formation energy of impurity Al, The illustration shows the existence of impurity Al. The dotted circle indicates the formation after losing an O atom.
考虑到Int-Al原子和VO同时存在时, 两种缺陷的相对位置对相互之间的作用以及HfO2阻变特性的影响, 因此对Int-Al与VO之间不同间距的缺陷HfO2超胞体系的形成能和分波电荷态密度进行了计算, 结果如图3所示. 可见VO在Int-Al原子周围时的形成能为5.38 eV, 相对间距较远时的形成能则为6.57 eV, 这与VO容易在杂质周围形成的观点一致[23]. 图3插图显示的近距离分波电荷态密度主要聚集在VO周围, 而距离较远时的分波电荷态密度分布则相对较离散.
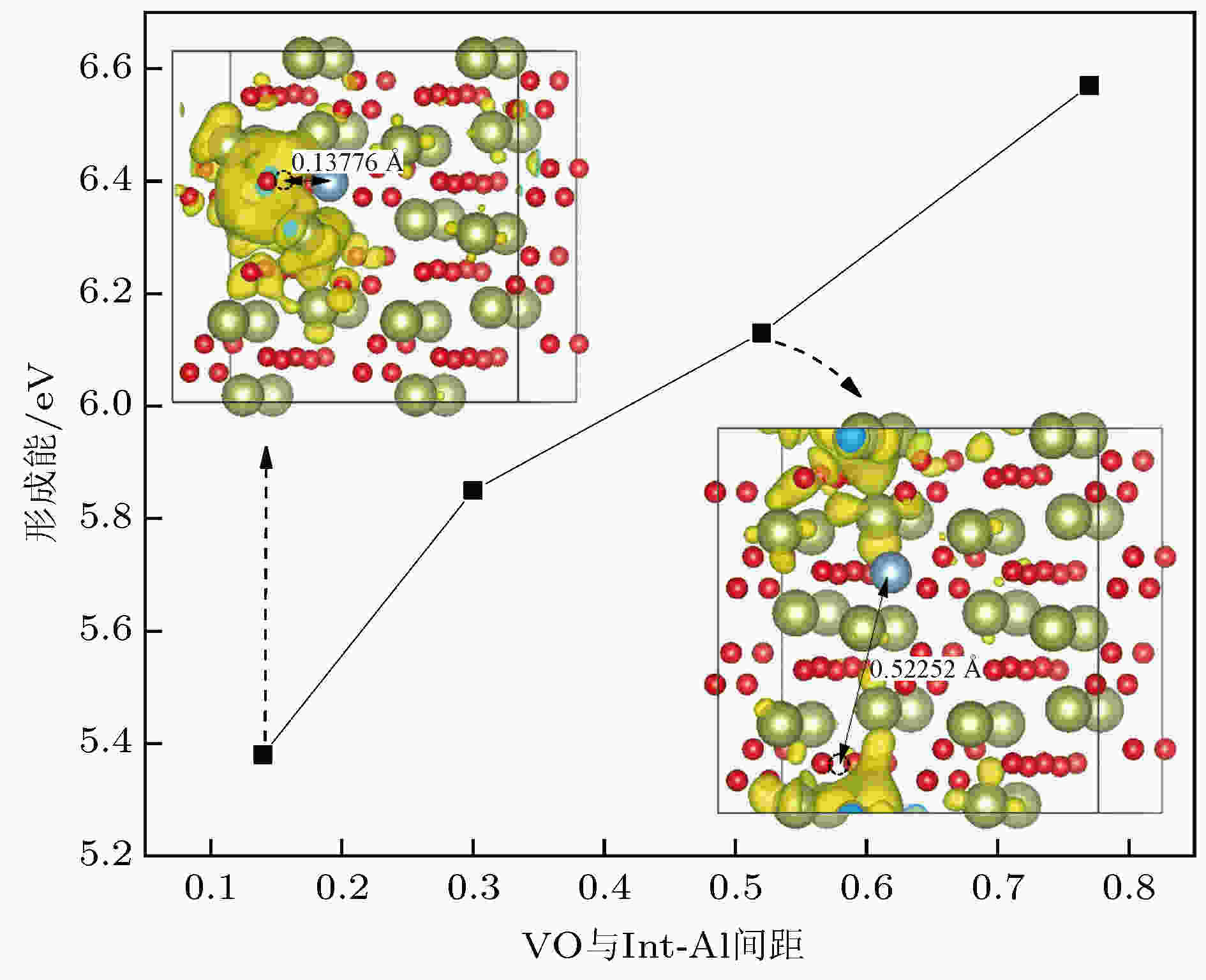 图 3 VO缺陷HfO2体系中Int-Al形成能 (插图显示了Int-Al与VO不同间距的分波电荷态密度)
图 3 VO缺陷HfO2体系中Int-Al形成能 (插图显示了Int-Al与VO不同间距的分波电荷态密度)Figure3. Int-Al formation energy in VO deficient HfO2 system, the illustration shows the partial wave charge density of Int-Al and VO at different pitches.
2
3.2.变组分Int-Al对VO导电细丝形成的影响
Int-Al浓度变化一方面会引起晶格结构的改变, 另一方面会引起与VO之间相互作用的改变, 造成对HfO2中导电细丝的形成及阻变特性的影响. 为了明确Al浓度变化的具体影响及在浓度多大时VO导电细丝形成最佳, 计算了变组分Int-Al和VO共同存在时的超胞体系.图4显示的是变组分Int-Al掺杂含有VO缺陷的HfO2超胞的分波电荷态密度, 图中黄色表示的是电荷态密度高的区域. 在Int-Al掺杂浓度分别为3.06%, 4.04%和5%时, 缺陷超胞中均出现相对较完美的电荷通道, 而低浓度的缺陷超胞中没有形成电荷通道, 说明这三种掺杂浓度的缺陷超胞最有可能形成导电细丝.
 图 4 不同浓度Int-Al体系的分波电荷态密度图 (a) 1.04%; (b) 2.06%; (c) 3.06%; (d) 4.04%; (e) 5%
图 4 不同浓度Int-Al体系的分波电荷态密度图 (a) 1.04%; (b) 2.06%; (c) 3.06%; (d) 4.04%; (e) 5%Figure4. The partial wave charge density of Int-Al systems with different concentrations: (a) 1.04%; (b) 2.06%; (c) 3.06%; (d) 4.04%; (e) 5%.
分波电荷态密度不仅表明了电荷分布的情况, 而且根据电荷密度最大等势面值可以获得电荷聚集相对较高的区域. 此外, 运用形成电荷通道的临界状态对应的临界等势面值作为衡量电荷聚集的难易程度, 若所设定的等势面值高于临界值, 则电荷聚集的部分团簇会淡化, 使得导电细丝不能完整地出现. 本文中的缺陷体系临界等势面值越高, 电荷聚集程度越高, 导电通道也就越容易形成. 如图5所示, 当Int-Al浓度为4.04%时, 分波电荷态密度的最大等势面和临界等势面值都相对最高, 说明此时的HfO2缺陷体系的电荷通道形成效果相对最好. 图5插图中的形成能计算结果显示, 当Int-Al浓度增加时, 缺陷的形成能逐渐增加; 当掺杂浓度大于4.04%时, 形成能明显增加, 说明缺陷体系的材料制备更加困难.
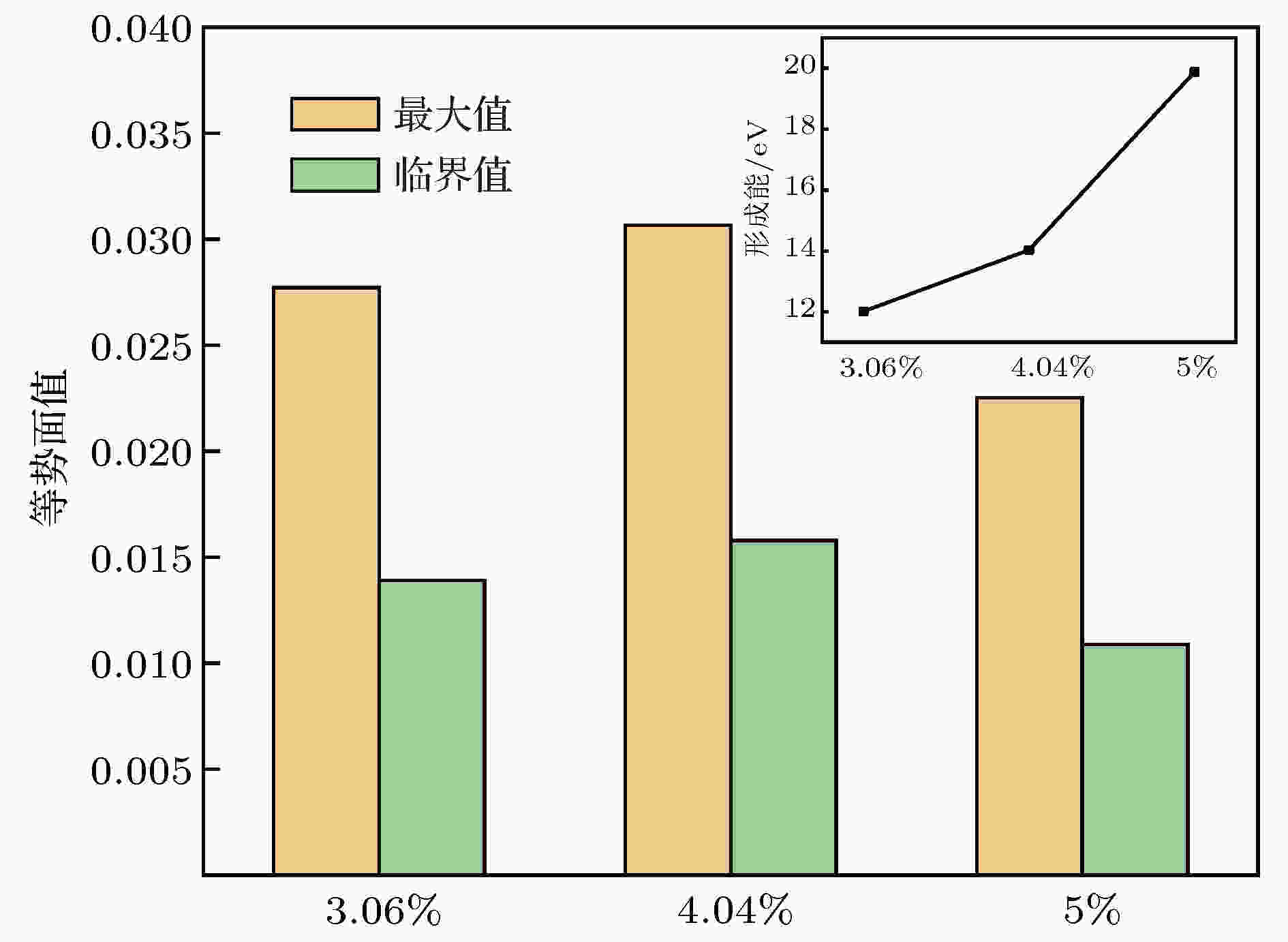 图 5 变组分Int-Al掺杂VO缺陷HfO2体系的分波电荷密度等势面值, 插图为Int-Al与VO共掺时的形成能
图 5 变组分Int-Al掺杂VO缺陷HfO2体系的分波电荷密度等势面值, 插图为Int-Al与VO共掺时的形成能Figure5. The partial wave charge density equipotential surface value of variable component Int-Al doped VO defect HfO2 system. The illustration shows the formation energy of Int-Al and VO co-doping.
通过上述对分波电荷态密度、最大等势面值以及形成能的分析, 发现当Int-Al浓度为4.04%时, 掺杂体系相对较容易形成; 分波电荷态密度的最大等势面值相对较高, 电荷团簇更加集中; 分波电荷态密度临界等势面值也相对较高, 易于形成较为完整的电荷通道. 因此, 当掺杂Int-Al浓度为4.04%时, 对VO导电细丝的形成最有利.
2
3.3.晶格结构变化对VO导电细丝的影响
杂质的引入及VO缺陷破坏了原本完整的晶体结构, 导致杂质周围原子的位置发生了偏移, 晶体内部原子价电子轨道及能级发生改变, 影响到HfO2缺陷体系内部电荷的分布. 为了观察材料的微观变化, 计算了Int-Al浓度为4.04%时的HfO2缺陷体系晶格结构变化前后的分波电荷态密度, 同时还计算了VO缺陷的形成能.为了研究晶格结构变化对VO导电细丝形成的影响, 通过固定HfO2缺陷体系晶格结构中原子的位置作为参照, 与经过晶格结构优化后的HfO2缺陷体系相对比, 使用VASP软件包进行计算. 对比图6与图4(d)中晶格变化前后的分波电荷态密度, 明显可以发现晶格变化之后HfO2缺陷超胞中电荷分布发生大幅度改变, 电荷聚集形成完美的电荷通道, 有利于导电细丝的形成, 改善了HfO2缺陷超胞的阻变特性. 对HfO2缺陷超胞晶格结构变化前后的VO缺陷形成能的计算结果分别为71.4944 eV和15.0292 eV, 表明晶格结构变化明显加快了缺陷体系趋于稳定的收敛速度, 提高了缺陷体系的稳定性.
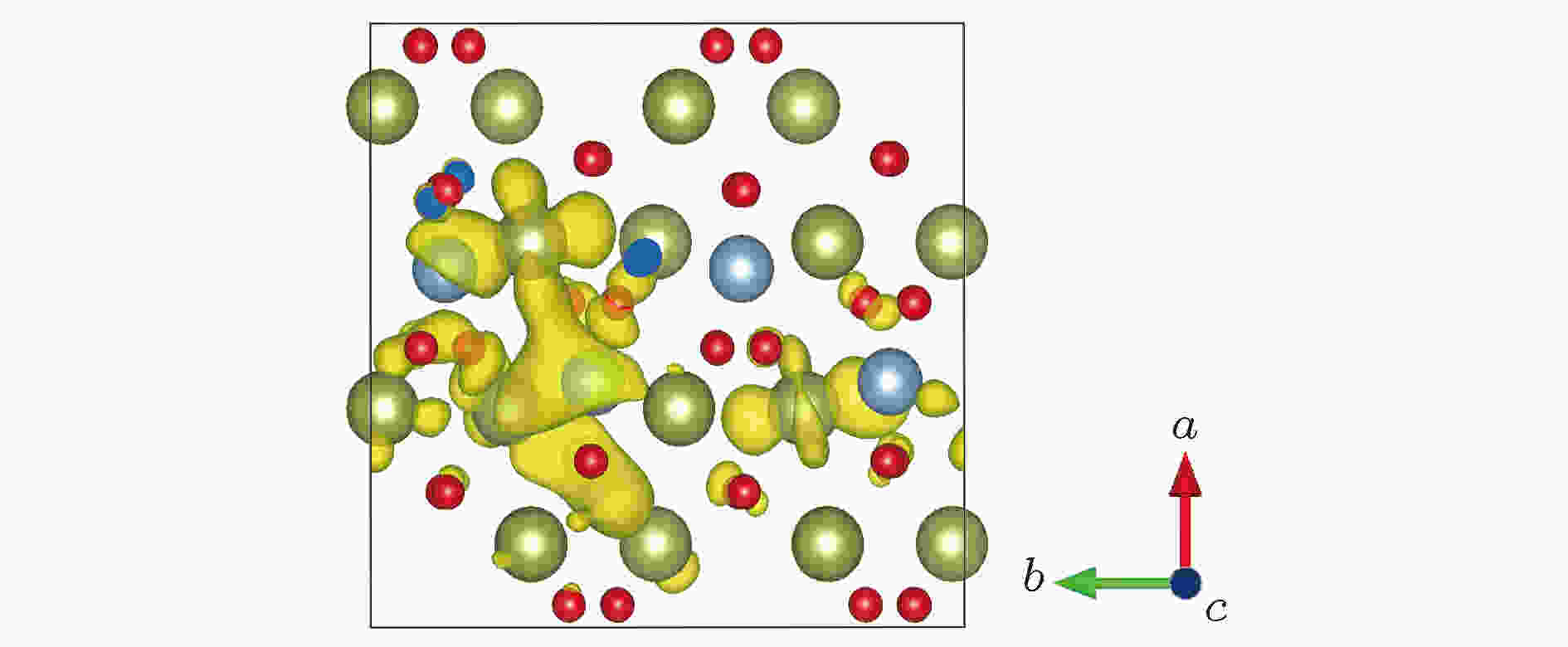 图 6 HfO2缺陷超胞晶格结构不变的分波电荷态密度
图 6 HfO2缺陷超胞晶格结构不变的分波电荷态密度Figure6. The partial wave charge density of in HfO2 defect supercell lattice with invariant lattice structure.
