全文HTML
--> --> -->应用于空间环境的存储器件需要面对极端恶劣的辐射环境, 各种高能带电粒子(如电子、质子和重离子)与射线会对器件的功能、性能和可靠性产生显著影响[8]. 通常主要关注电离总剂量效应和单粒子效应等. 电离总剂量效应会引起器件阈值电压漂移、漏电增加、噪声增加和电子迁移率降低等退化, 甚至造成器件失效[9,10]. 国内外****已对浮栅型闪存的辐射效应开展了大量研究工作, 包括存储单元、或非门(NOR)和与非门(NAND)电路等[11-15]. Snyder等[16]指出, 引起浮栅型闪存中辐射诱发阈值电压漂移的机制主要包括: 1)周围氧化层中产生的电荷注入至浮栅; 2)隧穿氧化层中的电荷俘获; 3)浮栅中载流子的光电效应. Northrop Grumman和Cypress等公司在高可靠SONOS闪存研制方面开展了系统性的工作[17-19].

本文首先介绍SONOS闪存单元的测试结构和总剂量辐照实验及流程, 重点研究60Co-γ射线源和10 keV X射线源对闪存单元I- V特性曲线、存储窗口和静态电流的影响, 然后基于TCAD和Geant 4工具, 仿真分析和讨论SONOS闪存器件退化机理, 并模拟和深入分析两种射线的剂量增强效应.
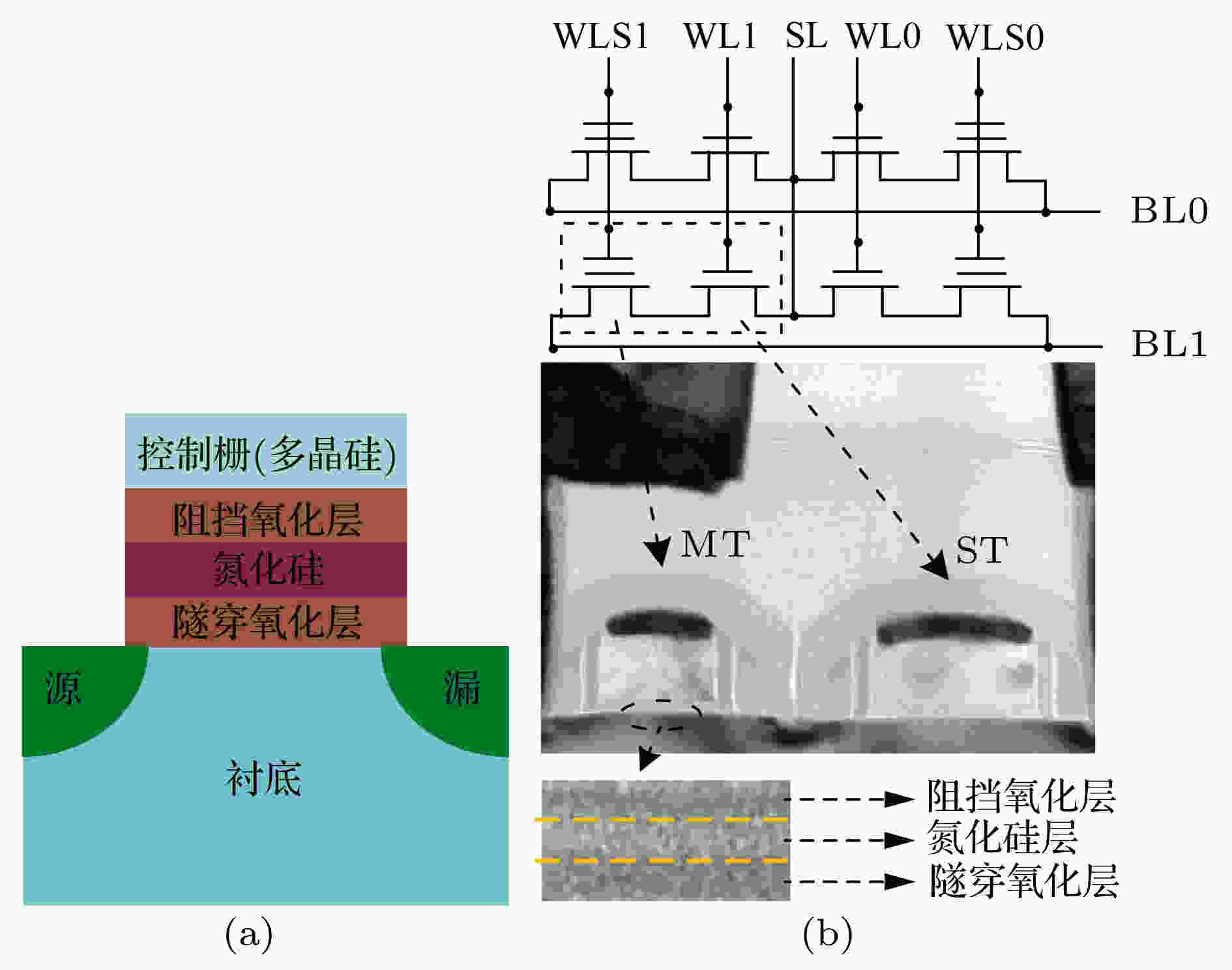 图 1 (a) SONOS结构示意图; (b) 2 × 2位的闪存单元微阵列及其TEM横截面
图 1 (a) SONOS结构示意图; (b) 2 × 2位的闪存单元微阵列及其TEM横截面Figure1. (a) Diagram of SONOS structure; (b) 2 × 2 bit flash cells mini-array and the TEM cross-section.
室温下, 基于Agilent B1500A半导体器件分析仪对测试结构进行电性测量. 辐照前, 利用Fowler-Nordheim隧穿机制预先对闪存单元进行编程(PGM)或擦除(ERS)操作, 具体条件如表1所列. 读操作(READ)时, ST开启(对应栅压为2.5 V), MT漏极偏置为0.6 V. 从?3 V至3 V扫描MT的栅压, 当其漏电流达到1 μA时, 对应的MT栅极电压定义为阈值电压






| 操作 | VWLS/Vg/V | VWL/V | VBL/Vd/V | VSL/V | 脉冲宽度/ms |
| PGM | 9.5 | 0 | 0 | 0 | 1.5 |
| ERS | ?9.5 | 0 | 0 | 0 | 2.5 |
| READ | ?3—3 | 2.5 | 0.6 | 0 | — |
表1SONOS闪存单元的操作条件
Table1.Operation conditions of the SONOS single flash cell.
基于60Co-γ射线源的总剂量辐照实验在北京师范大学进行, 辐照剂量率为100 rad(Si)/s, 辐照过程中未施加电学偏置, 辐照后离线移位测试电学特性; 基于10 keV X射线源的总剂量辐照实验在中国科学院新疆理化技术研究所进行, 辐照剂量率为100 rad(Si)/s, 辐照后在线原位测试电学特性.
3.1.60Co-γ射线辐射源
图2给出了60Co-γ射线源辐照下SONOS闪存单元Id- Vg曲线的变化规律. 辐照后, 编程态SONOS闪存单元的Id- Vg曲线负向漂移, 而擦除态对应的曲线则正向漂移. 为直观比较闪存单元的抗辐照能力, 图3(a)给出了总剂量辐照引起的编程态和擦除态的Vth漂移. Vth在60Co-γ射线下的变化较为平缓, 辐照总剂量达到300 krad(Si)时, 编程态Vth较初始减小69.2%, 而擦除态Vth增大10.0%, 存储窗口减小27.9%. 辐照总剂量在100 krad(Si)以下时存储窗口的变化显著, 而在100—300 krad(Si)区间的变化较平缓. 除Vth漂移外, 总剂量辐照也导致闪存单元的Istand-by发生变化, 如图3(b)所示. 60Co-γ 射线下的Istand-by变化平缓, 辐照总剂量达到300 krad(Si)时, 编程态和擦除态Istand-by 变化均小于一个数量级.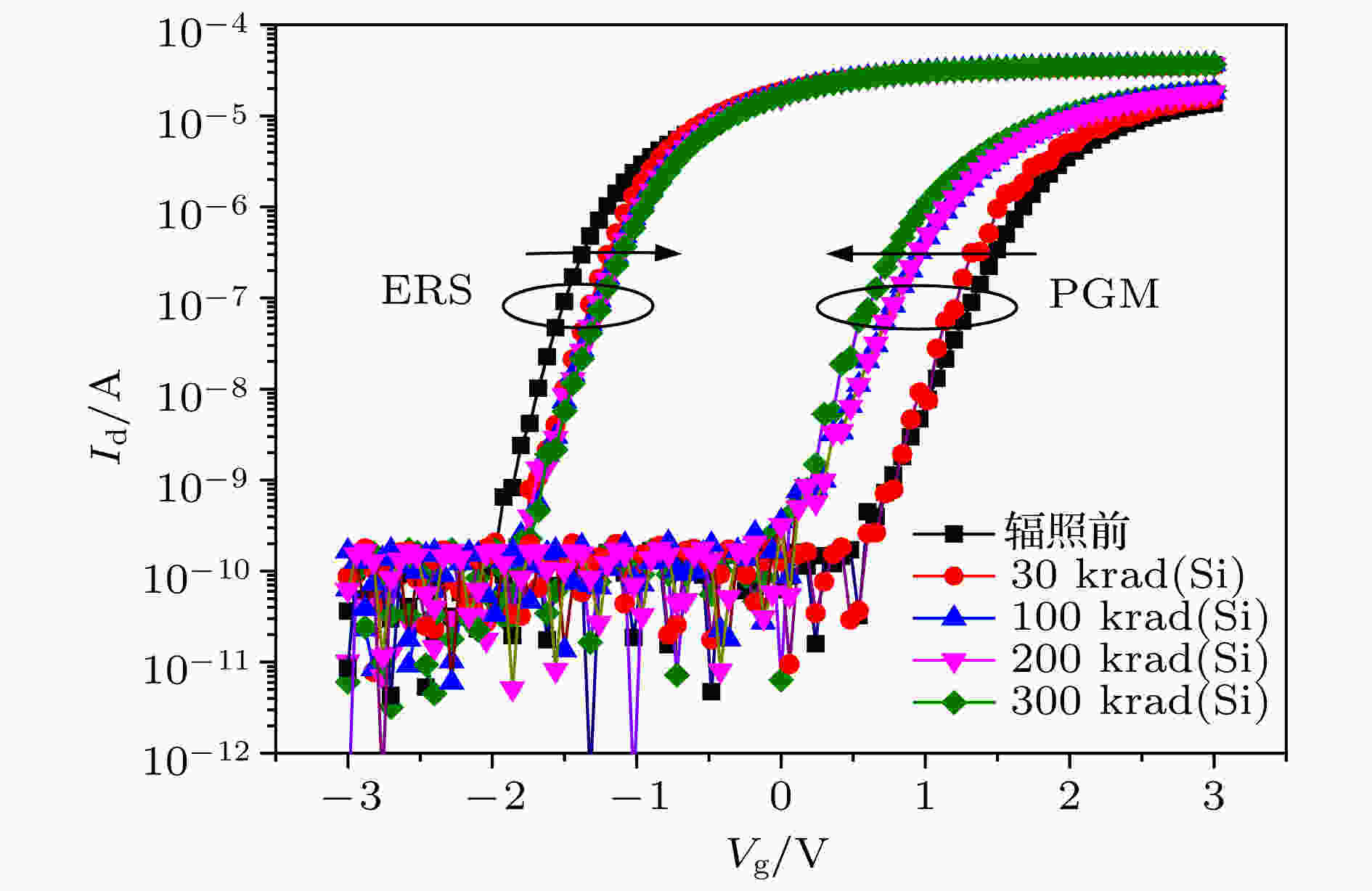 图 2 60Co-γ射线总剂量辐照后, 编程态和擦除态的SONOS闪存单元的I-V特性变化规律
图 2 60Co-γ射线总剂量辐照后, 编程态和擦除态的SONOS闪存单元的I-V特性变化规律Figure2. I-V characteristics of the programmed and erased single SONOS flash cell after total ionizing dose irradiation by 60Co-γ rays.
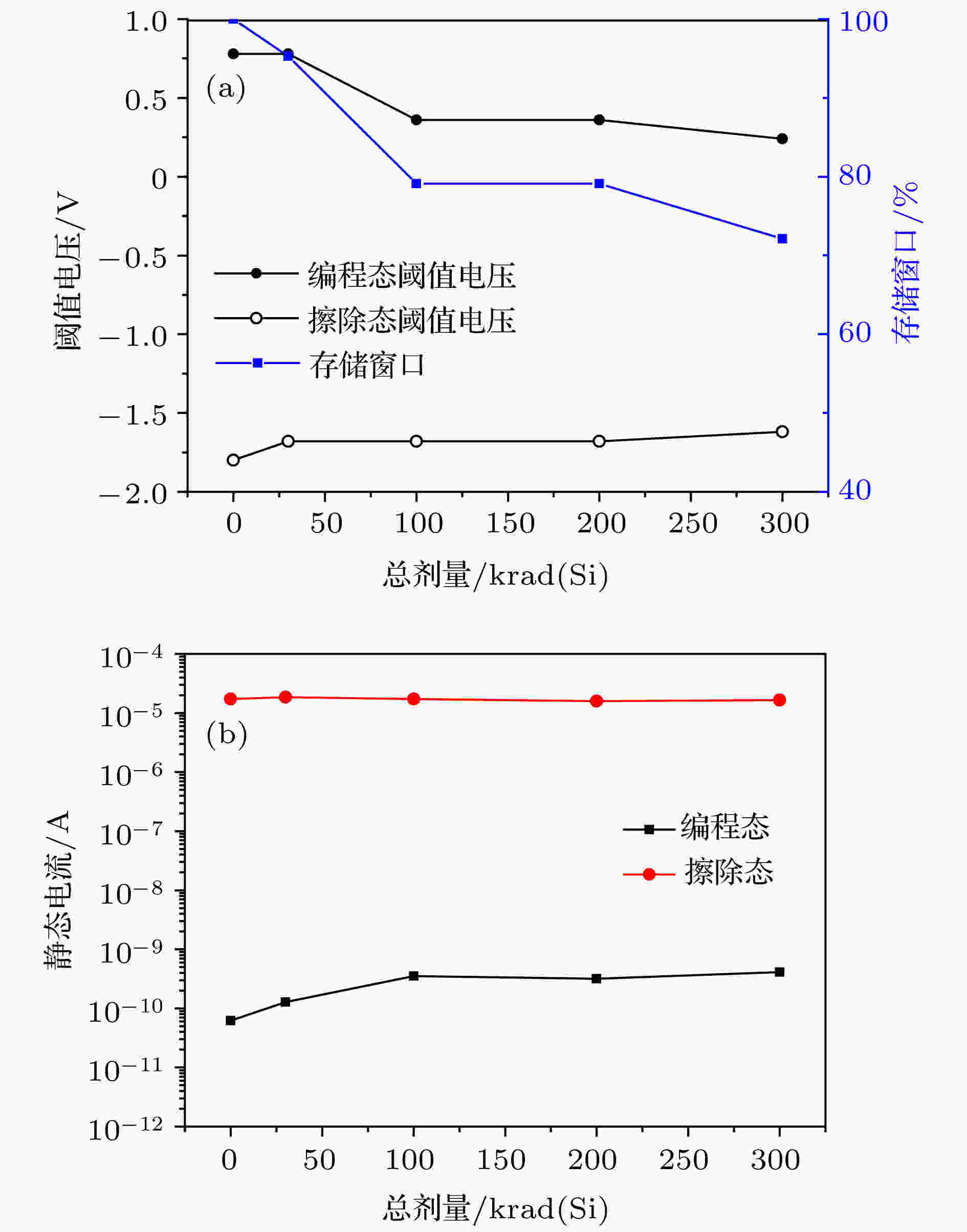 图 3 编程态和擦除态闪存单元的(a)阈值电压和归一化的存储窗口, 以及(b)静态电流随60Co-γ射线总剂量辐照的变化规律
图 3 编程态和擦除态闪存单元的(a)阈值电压和归一化的存储窗口, 以及(b)静态电流随60Co-γ射线总剂量辐照的变化规律Figure3. (a) Threshold voltage and normalized memory window, and (b) stand-by current of the programmed and erased single flash cell after total ionizing dose irradiation by 60Co-γ rays.
2
3.2.10 keV X射线辐射源
图4给出了10 keV X射线源辐照下SONOS闪存单元Id- Vg曲线的变化规律. 编程态闪存单元的Id- Vg曲线在辐照后显著负向漂移, 而擦除态负向漂移幅度较小. 对比两种射线辐照, 擦除态的Id- Vg曲线漂移方向不同. 随10 keV X射线辐照总剂量增至150 krad(Si), Vth变化显著, 编程态Vth减小248.4%, 擦除态Vth减小11.1%, 存储窗口减小60.7%, 如图5(a)所示. 擦除态Istand-by基本无变化, 而编程态Istand-by上升了5个数量级, 如图5(b)所示.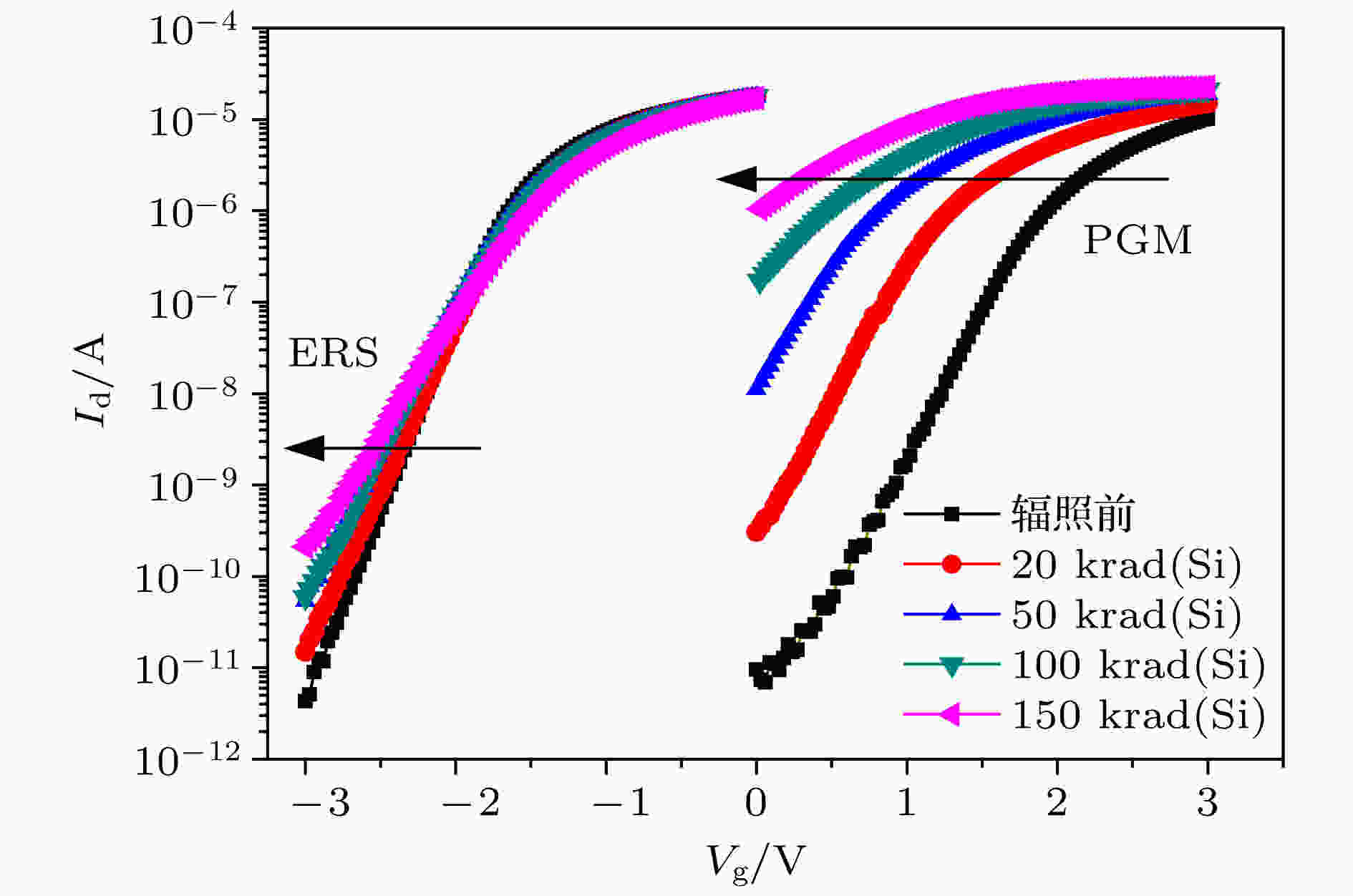 图 4 辐射源为10 keV X射线下编程态和擦除态闪存单元的I-V特性变化规律
图 4 辐射源为10 keV X射线下编程态和擦除态闪存单元的I-V特性变化规律Figure4. I-V characteristics of the programmed and erased single flash cell after total ionizing dose irradiation by 10 keV X-rays.
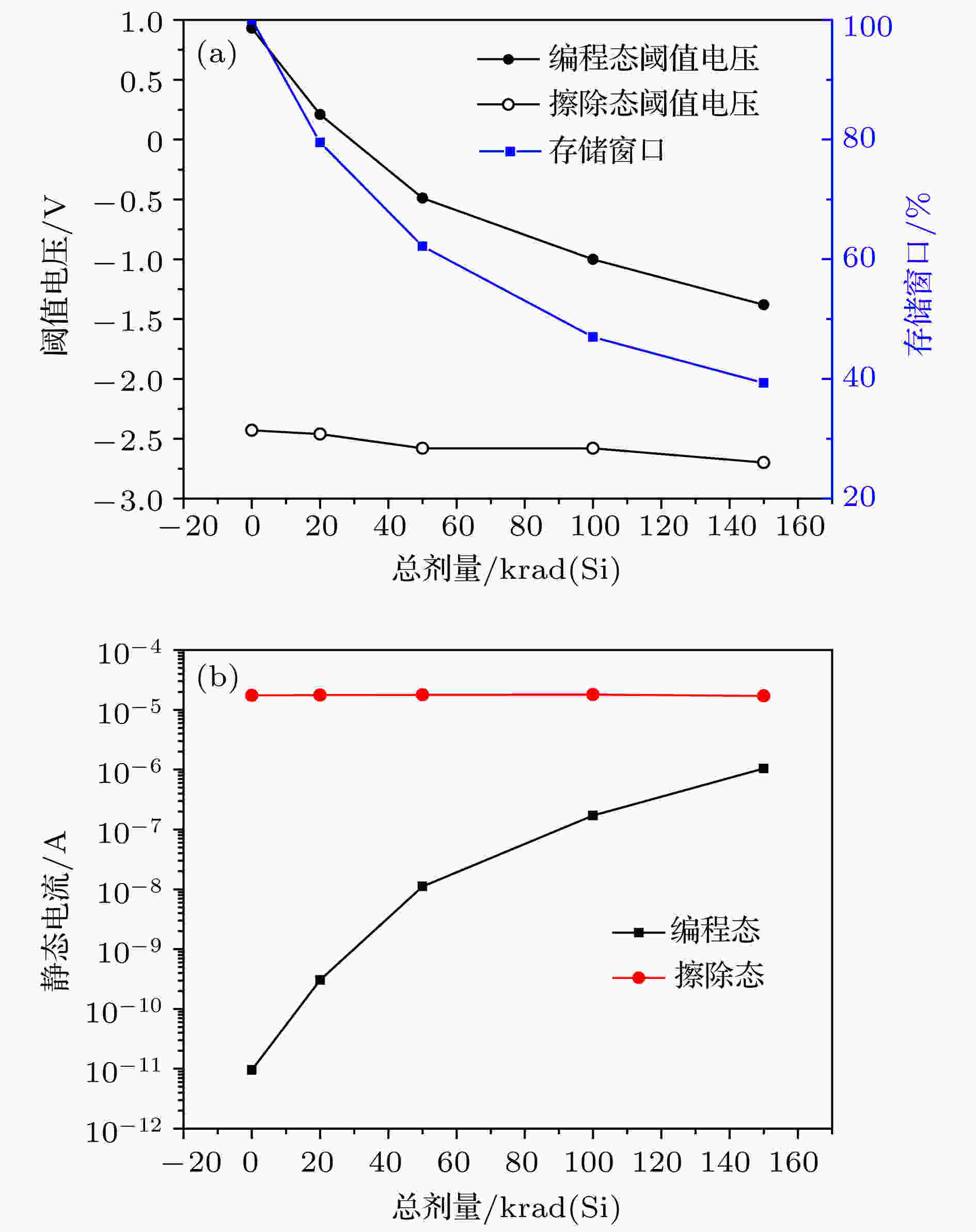 图 5 编程态和擦除态闪存单元的(a)阈值电压和归一化的存储窗口, 以及(b)静态电流随10 keV X射线总剂量辐照的变化规律
图 5 编程态和擦除态闪存单元的(a)阈值电压和归一化的存储窗口, 以及(b)静态电流随10 keV X射线总剂量辐照的变化规律Figure5. (a) Threshold voltage and normalized memory window, and (b) stand-by current of the programmed and erased single flash cell after total ionizing dose irradiation by 10 keV X-rays.
在测试过程中, MOS结构的ST均处于强开启状态, 总剂量辐照对ST的影响在单元级特性研究中不明显, 因此本文着重讨论总剂量辐照对SONOS结构MT的影响. 为研究55 nm SONOS闪存单元电离总剂量效应的物理机理(以编程态为例), 利用 Sentaurus TCAD工具构建了MT的SONOS器件结构, 并获得编程态SONOS结构能带图, 分别如图6和图7所示. 辐照诱发编程态SONOS器件I-V特性退化的机制主要为图7所示的5个子物理过程:
1) 栅极材料吸收辐照能量, 氮化硅层中产生电子-空穴对. 小尺寸SONOS器件的隧穿氧化层和阻挡氧化层很薄(< 5 nm), 其内的辐照诱发电子-空穴对数量很少, 可忽略不计[23];
2) 氮化硅层中存储的大量电子导致其电势较栅极和衬底低, 产生内建电场E1, E2, 将1)产生的电子-空穴对中的电子扫出氮化硅层, 部分越过隧穿氧化层和阻挡氧化层, 进入栅极或衬底;
3) 由1)产生的电子-空穴对中的空穴缓慢移动到Si3N4/SiO2界面, 被俘获形成陷阱电荷和界面态;
4) 部分电子或空穴重新被氮化硅层中的陷阱俘获, 形成电子或空穴的积累;
5) 存储在氮化硅层中的电子吸收辐照能量, 被激发到导带.
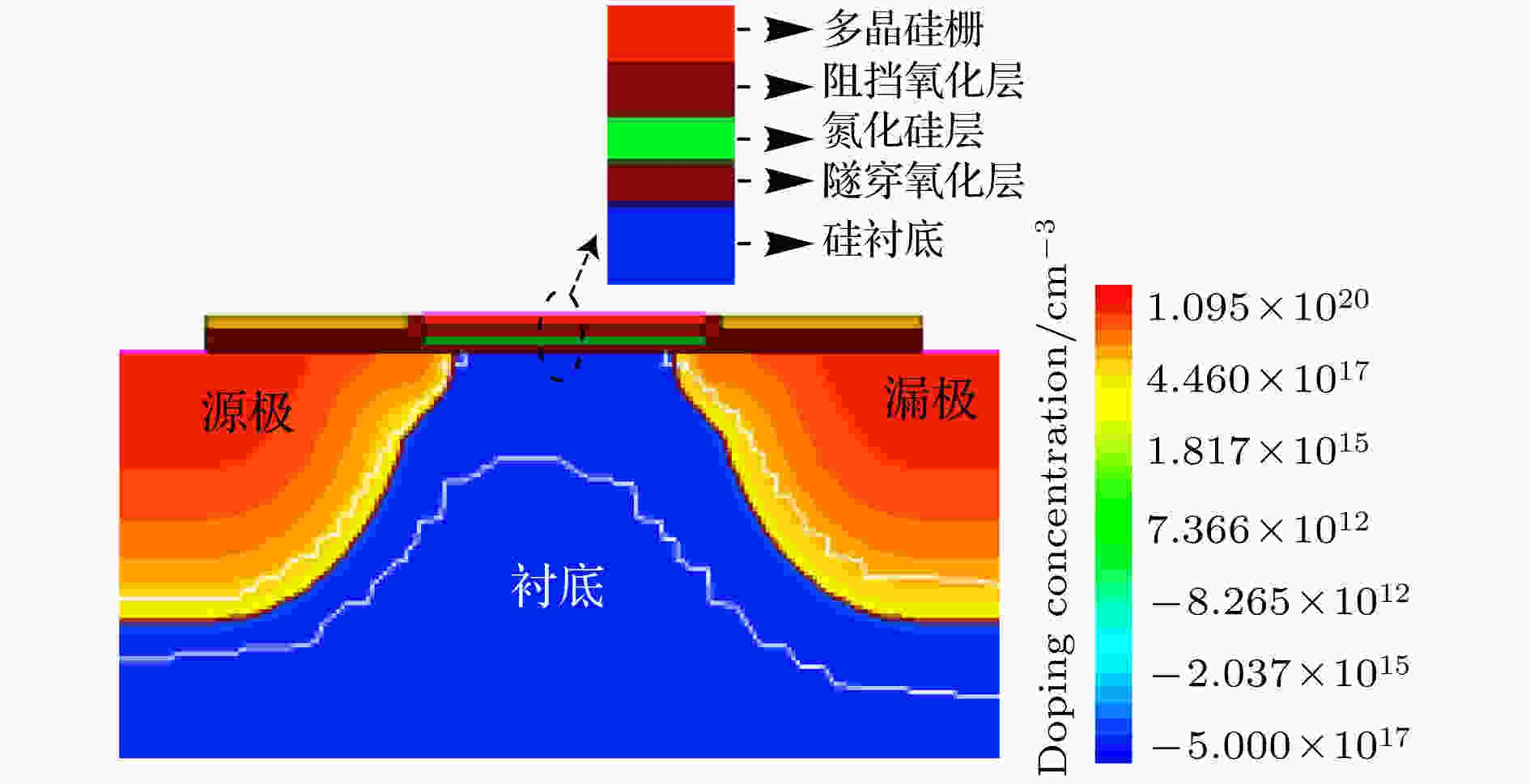 图 6 在Sentaurus TCAD中构建MT的SONOS结构, 其主要物理参数来自于图1中的TEM截面信息
图 6 在Sentaurus TCAD中构建MT的SONOS结构, 其主要物理参数来自于图1中的TEM截面信息Figure6. Diagram of MT’s SONOS structure constructed in Sentaurus TCAD tool, with main physical parameters derived from the cross-section TEM information in Fig. 1.
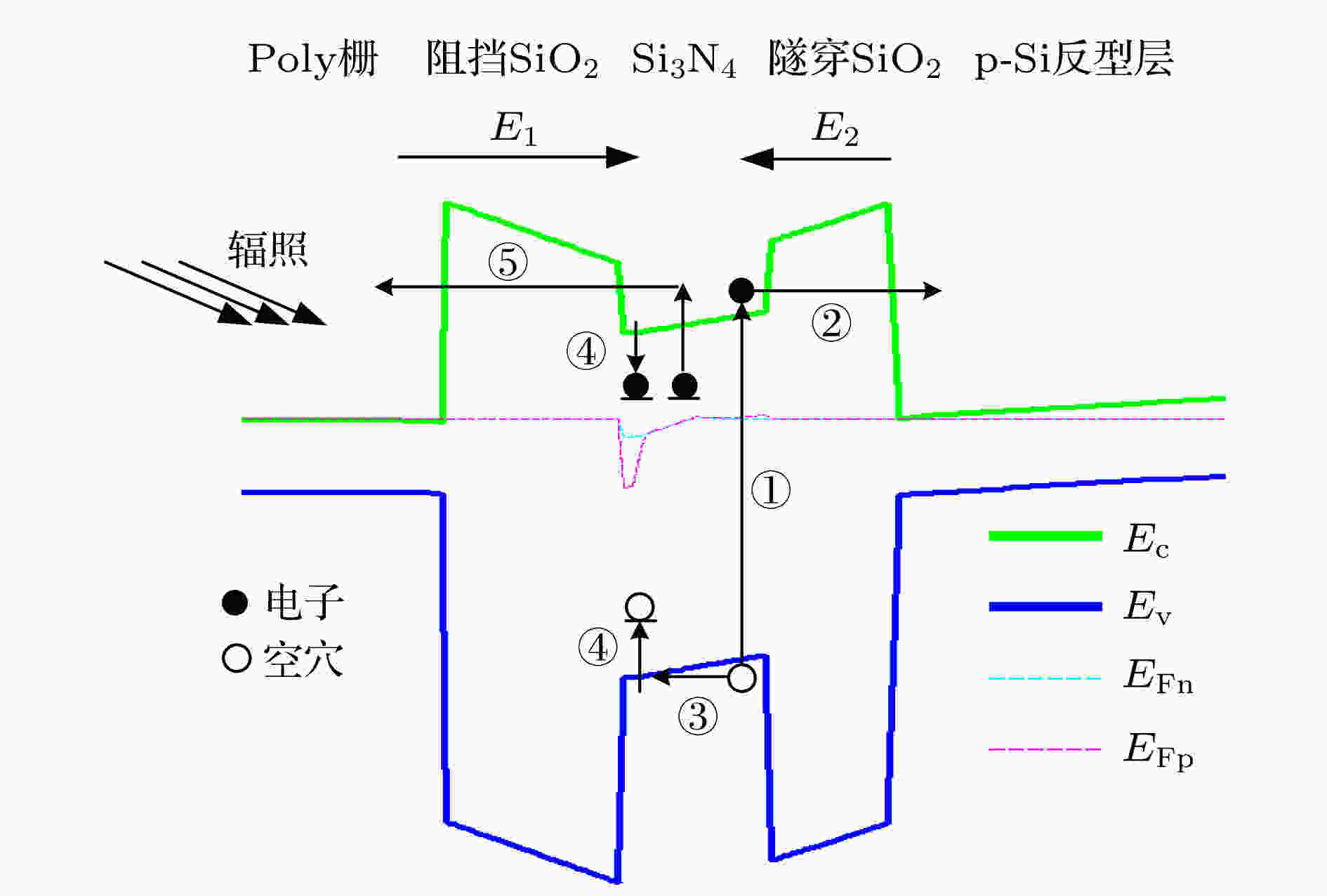 图 7 基于图6获得编程态SONOS器件能带图, 并标示出其电离总剂量效应的子物理过程
图 7 基于图6获得编程态SONOS器件能带图, 并标示出其电离总剂量效应的子物理过程Figure7. Energy band diagram of programmed SONOS device based on Fig. 6, which illustrates sub-physical processes of total ionizing dose effect.
上述编程态器件退化机制中, 导致SONOS闪存单元的阈值电压降低、I- V特性曲线负向漂移的主要原因包括: 氮化硅层中存储电子的损失、辐照诱发的电荷积累和界面态. 擦除态器件退化机制与编程态类似, 不同之处在于存储电荷为空穴, 内建电场方向与图7中E1, E2相反, 退化表现为阈值电压升高、I- V特性曲线正向漂移. 值得注意的是, 图4中10 keV X射线总剂量辐照后的编程态I- V特性变化比擦除态明显, 且擦除态的I-Vg曲线负向漂移. 在超薄氧化层情况下, 辐照导致的隧穿氧化层和阻挡氧化层中陷阱电荷及界面态的产生也是使器件退化的重要因素[24]. 编程态和擦除态器件中穿过氧化层的电场方向和强度不同, 根据文献[25], 10 nm厚度氧化层的n型多晶硅栅电容器中负向氧化层电场比正向产生更多的界面态, 由此可推测编程态SONOS器件中产生了更多的界面态, 进而显著增加了器件的亚阈值斜率(图8中得以验证), 表现为退化更严重. 根据前面的理论模型, Vth漂移的主因是氮化硅层中存储电荷的损失和辐照诱发的电荷积累[26]. 编程态器件中存储电子的损失与辐照诱发的空穴积累相叠加, 擦除态下存储空穴的损失与后者则是相抵消, 因此两种状态下的器件Vth漂移程度不同; 当擦除态器件中辐照诱发的空穴积累甚至大于存储空穴的损失时, 发生图4中I-Vg曲线的负向漂移[6].
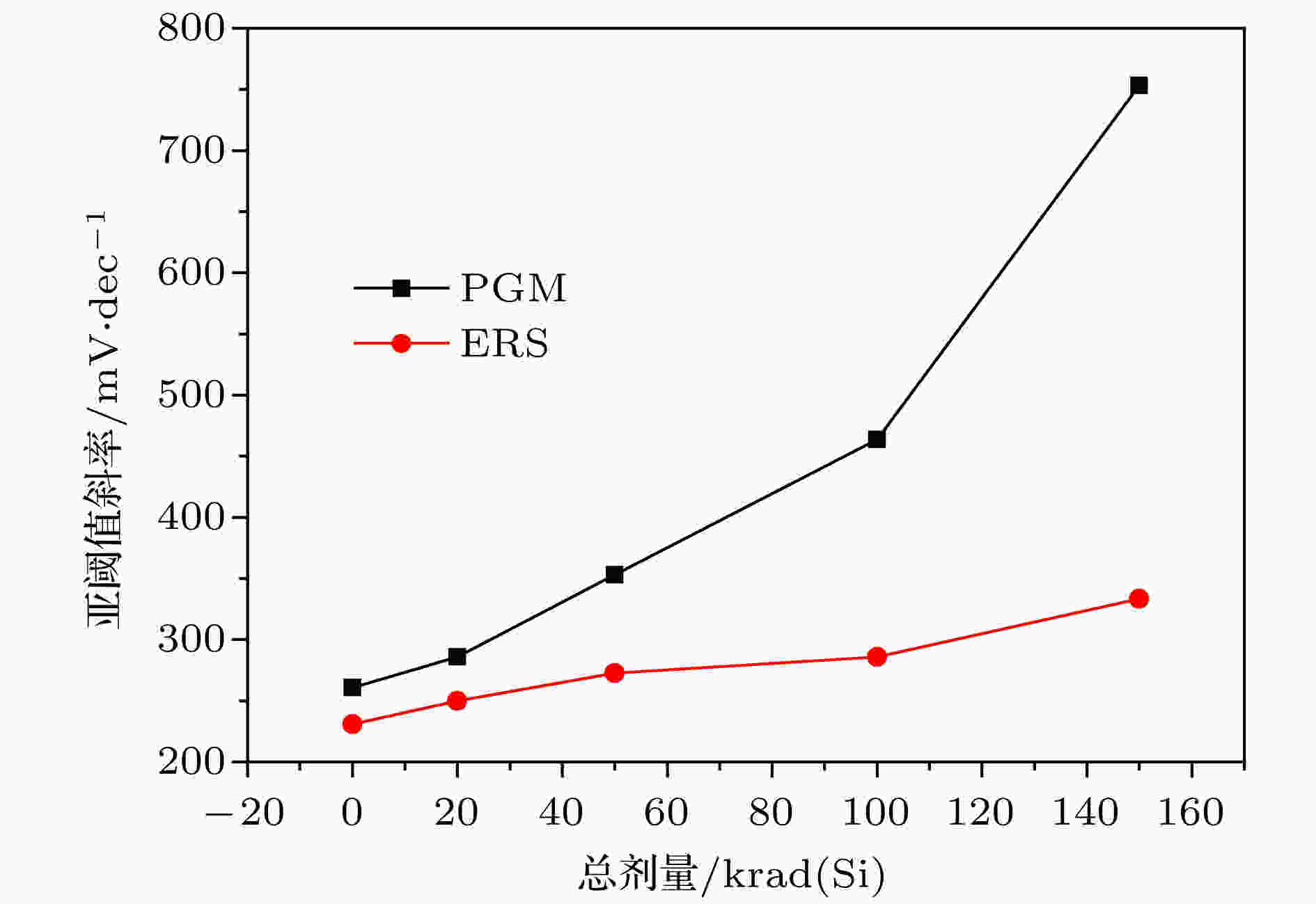 图 8 辐射源为10 keV X射线下编程态和擦除态闪存单元的亚阈值斜率变化规律
图 8 辐射源为10 keV X射线下编程态和擦除态闪存单元的亚阈值斜率变化规律Figure8. Sub-threshold slopes of the programmed and erased single flash cell after total ionizing dose irradiation by 10 keV X-rays.
闪存单元的另一个重要辐照退化现象是静态电流Istand-by的增加. 造成此退化的原因主要包括: 1)闪存单元的I-V特性曲线漂移导致Istand-by不可避免地产生变化, 且从图4可以看到X射线下编程态I-V特性曲线漂移远超擦除态(其机理已在上文分析), 因此在Istand-by上也反映为退化比擦除态严重得多; 2)辐照诱发了寄生电流的产生. 本器件采用浅沟道隔离工艺实现闪存单元间和阱间隔离, 此时闪存单元中的MT可等效成一个主晶体管和两个寄生晶体管并联[27-29], 如图9所示. 寄生晶体管的有效栅氧厚度相对较大, 辐照前阈值电压较大, 泄漏电流较小; 辐照后氧化层中产生正的陷阱电荷, 导致阈值电压负向漂移. 而阈值电压变量(




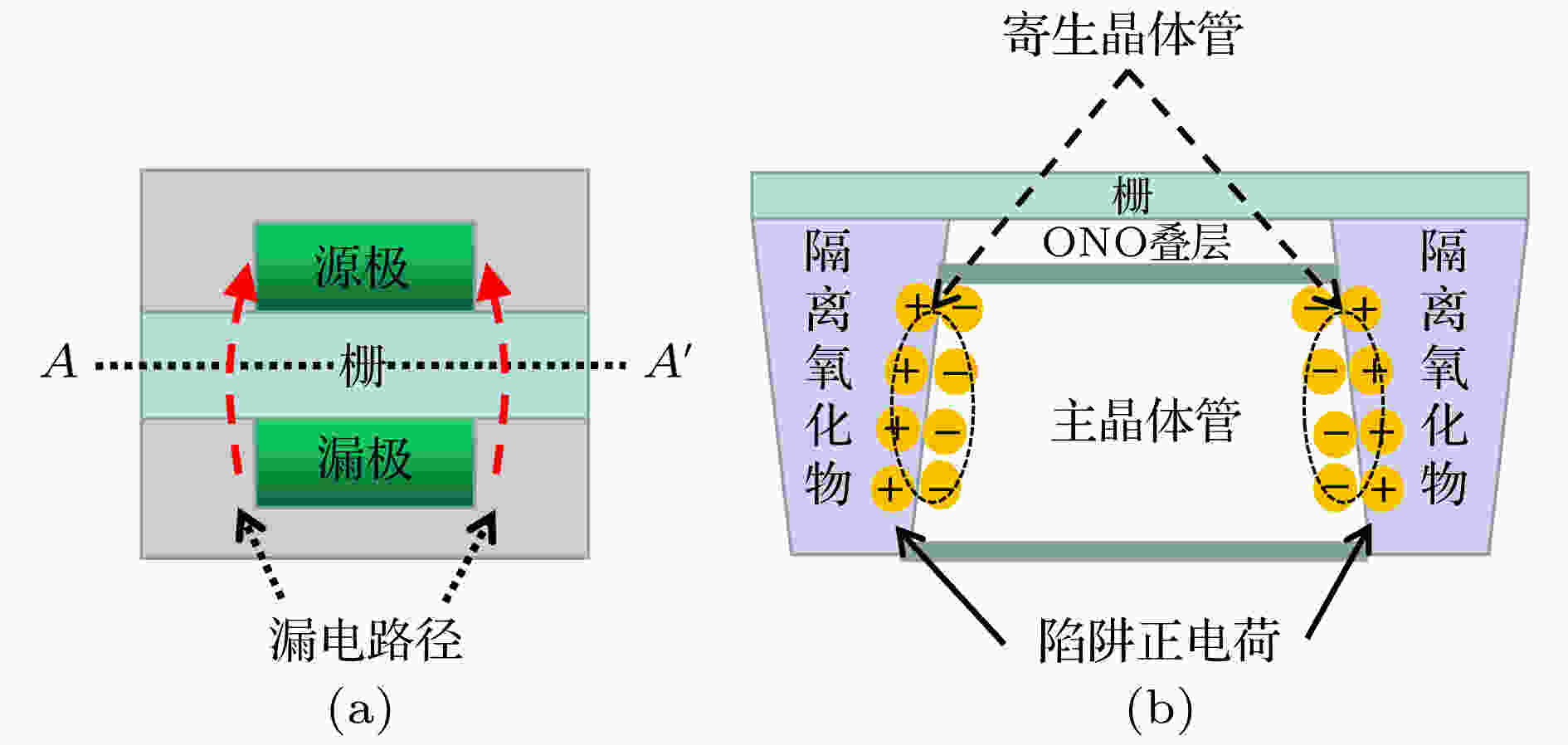 图 9 (a)闪存单元中MT的布局简图和沟道边缘的漏电路径; (b)沿虚线A—A', MT可等效成一个主晶体管与两个寄生晶体管的并联, MT靠近隔离氧化物处反型层的形成导致寄生电流产生
图 9 (a)闪存单元中MT的布局简图和沟道边缘的漏电路径; (b)沿虚线A—A', MT可等效成一个主晶体管与两个寄生晶体管的并联, MT靠近隔离氧化物处反型层的形成导致寄生电流产生Figure9. (a) MT top view with the leakage paths at the channel edges; (b) cross-section of MT along line A–A' indicates that MT can be considered as a main transistor in parallel with two parasitic transistors. The formation of the inverse layer along the isolated oxide leads to the generation of parasitic currents.
两种射线辐照剂量率均为100 rad(Si)/s, 但对比图3和图5, 10 keV X射线总剂量辐照导致的阈值电压和静态电流退化均远超60Co-γ 射线. 光子入射到材料中与靶材料发生相互作用的物理机理主要包括康普顿效应和光电效应. 高能光子辐照(60Co-γ 射线)中康普顿效应为主导, 光子与靶材料原子的外层电子(自由电子)发生弹性碰撞, 反应截面与靶材料原子序数Z的依赖关系较浅; 而低能光子辐照(10 keV X射线)中则以光电效应为主导, 光子与内层电子作用, 反应截面与Z呈很强的正相关关系(Z的5次方)[31-34]. 本器件在多晶硅栅上方使用了实现金属接触的高Z材料(如W, Cu等), X射线在高Z材料中产生大量二次电子, 部分次级电子进入交界面(如Si/SiO2, SiO2/Si3N4界面)的灵敏区中, 因此在灵敏区产生剂量增强效应.
为研究本器件中X射线的剂量增强效应与高Z材料种类、厚度的关系, 利用Geant 4工具建立MT的器件模型(如图10)[35-37], 然后分别调整两种高Z材料的厚度参数对其进行模拟: 1) Cu厚度为100 nm, 其下方W厚度从70 nm增至300 nm; 2) W厚度为100 nm, 其上方Cu厚度从70 nm增至300 nm. 设置SiN及上下两层氧化物为灵敏体积(SV), 辐照模拟过程中检测SV中的电子-空穴对数目, 设置Cu及W两层高Z材料厚度、入射射线后, 分别更改Cu或W高Z层为Si 材料, 模拟得到辐照下SV中电子数目为N1; 将高Z层中的Si材料换回为高Z材料, 重复模拟得到SV中电子数目N2. 剂量增强因子为N2/N1, 代表了高Z材料存在情况下的剂量增强效应强度. 从图11可看到, W材料的存在使得X射线的剂量增强效应明显, 其剂量增强因子远大于γ射线, 但与W层厚度无明显关系; Cu材料的影响很小, 其一是因为射线在W层中产生的电子-空穴对密度远高于Cu, 相当于阻隔了Cu对灵敏区的影响, 其二则是因为Cu层离器件灵敏区距离较远.
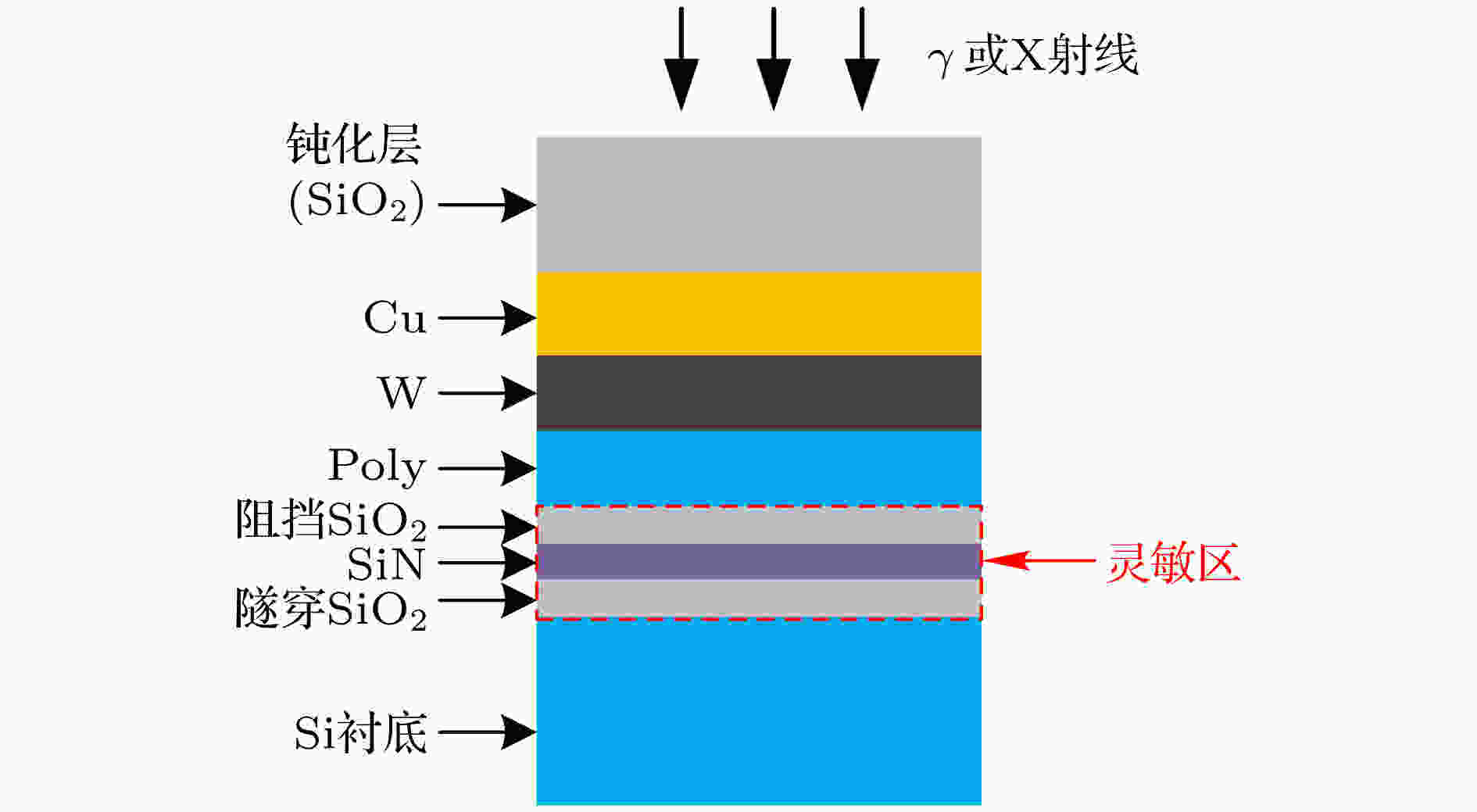 图 10 Geant 4中建立的MT器件模型
图 10 Geant 4中建立的MT器件模型Figure10. MT device model established by Geant 4 tool.
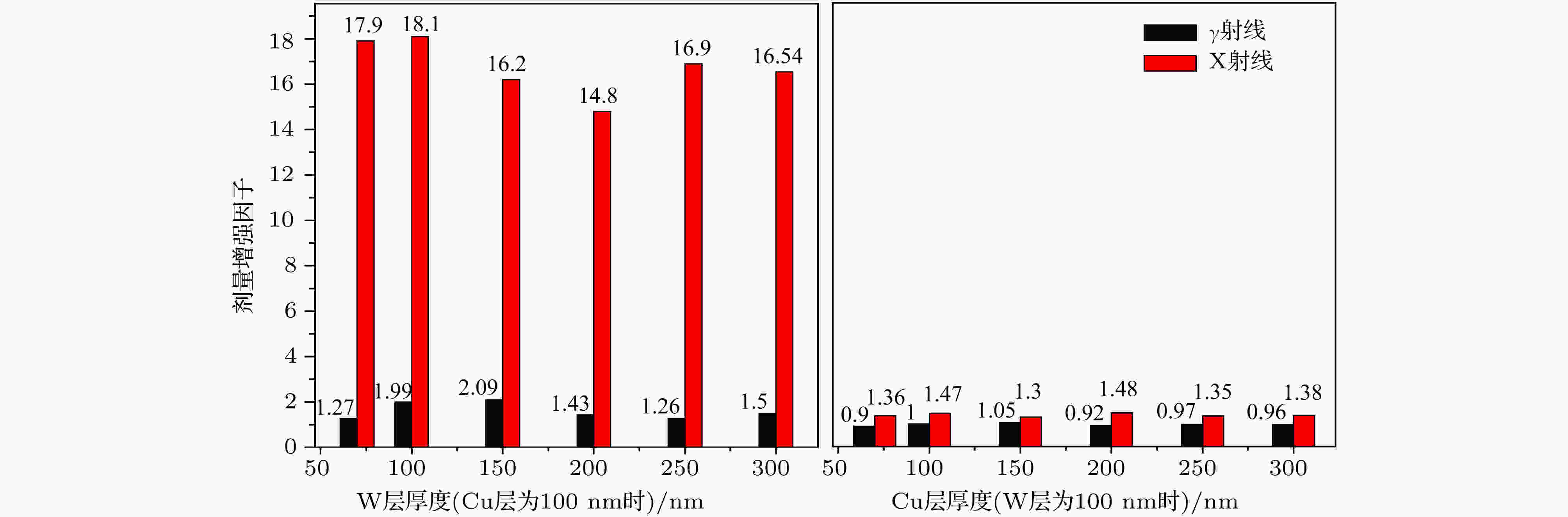 图 11 Geant 4工具模拟高Z材料与X射线剂量增强效应的关系
图 11 Geant 4工具模拟高Z材料与X射线剂量增强效应的关系Figure11. Dose enhancement effect of X-rays on high-Z materials, simulated by Geant 4 tool.
