全文HTML
--> --> -->团簇离子最广泛的应用是表面平坦化处理, 平坦化效应形成的主要原因有: 1)横向溅射效应[14], 团簇垂直轰击靶材表面时, 从靶材中溅射出的物质几乎是平行靶材表面飞溅出去; 2)具有高质荷比, 每个原子携带的能量仅为单体能量的千分之一, 平均能量低, 团簇尺寸大, 原子数量多; 3)具有高溅射率[15]. 团簇离子的高溅射率和横向溅射效应可以有效地进行平坦化处理, 这是单离子束做不到的[16].
团簇的平坦化效果主要取决于样品材质、团簇尺寸、能量和离子剂量[17]. 高能团簇溅射率高[18], 加快平坦化进程, 但是高能团簇轰击会对靶材表面形成离子损伤. Merkle等[19]、Gspann[20]发现了这种现象(高能团簇轰击会对靶材表面形成离子损伤), 将它解释为弧坑. Takeuchi等[21]用高能Ars团簇离子轰击高取向软石墨, 在其表面上也观察到了陨石坑形状的痕迹. 扫描电子扫描显微镜观测表明, Ar团簇离子轰击呈环形弹坑状, 其直径与离子能量立方根成正比. 他发现团簇离子的动能是等向沉积在表面的. Matsuo等[22]用变温扫描隧道显微镜研究了Si (111)7 × 7表面的陨石坑形成, 并与分子动力学(molecular dynamics, MD)模拟的实验和理论计算进行了比较, 讨论了损伤形成与团簇大小的关联. Allen等[23]对不同能量状态、团簇尺寸和衬底材料的团簇离子形成陨石坑进行了实验研究, 再次证实, 对于团簇离子的垂直轰击, 在MD模拟中通常观察到陨石坑是半球形的.
离子损伤形成过程如下[24]: 载能团簇以一定速度轰击到靶材表面, 其能量会传递给与之接触的靶材原子, 这些原子获得能量后向前推进或溅射至靶材外, 同时, 气体团簇失去能量后蒸发汽化, 被分子泵排出腔室外, 在靶材表面遗留一个孔洞, 称之为半球形离子损伤, 底部低于靶材平均表面, 四周高于靶材平均表面. 这种不平整结构会破坏已经形成的平坦表面, 增加靶材表面的粗糙度. 离子损伤(弧坑)随团簇能量增大而变宽变深[25], 这意味着低能团簇可以减轻离子损伤, 而且在一定程度上可以修复靶材表面遗留的离子损伤, 促进形成更平坦的靶材表面.
表面粗糙度随离子剂量变化的速度遵循先迅速降低, 最后保持动态平稳的过程[26]: 团簇轰击靶材初期, 样品表面高凸起部分迅速被击出, 粗糙度降低得很快; 而中期对宽矮凸起的去除稍显困难, 粗糙度缓慢降低; 对于末期, 团簇溅射的同时会遗留离子损伤, 破坏靶材表面结构, 在平坦化和粗糙化的双重效应下, 粗糙度保持动态平稳.
本文研究的多级能量模式修形法是对之前两步能量平坦化研究的延续[27], 在本文中, 以带有创伤的n-Si (100)单晶片为样品, Ar气体团簇为轰击离子, 采用了两种离子剂量比不一的多级能量模式对其进行平坦化处理, 通过原子力显微镜(atomic force microscope, AFM)测试表征, 对比两种模式在划痕去除、离子损伤修复中的差异.
本文中选用惰性气体Ar为实验气体, 源气体压强为9 bar (1 bar = 0.1 MPa), 喷嘴腔室和靶材室的真空度分别为2.0 Pa和4.3 × 10–3 Pa. 同时选用n-Si (100)单晶片作为靶材材料, 并用金刚石研磨膏(粒径0.5 μm)打磨, 在其表面形成带有划痕的机械损伤, 然后用无水乙醇和去离子水进行超声清洗, 除去表面油污、灰尘等杂质, 并将Si片切成5 mm × 5 mm × 0.5 mm的形状, 放置在铜质样品台上, 最后置于靶材室, 用气体团簇离子束对其进行垂直辐照.
本文研究了单一团簇能量对带有机械损伤的Si片的影响, 包括单一15 keV高能、单一8 keV低能、单一5 keV低能团簇离子辐照靶材, 以上实验研究中的离子剂量均为6 × 1016 cm–2, 并分析了不同单一能量团簇辐照靶材产生的影响. 在研究单一能量团簇辐照靶材表面影响的基础上, 另外对比研究了两种多级能量模式对靶材表面平坦化处理的差异, 模式一: 低剂量(其离子剂量为2 × 1016 cm–2)高能团簇和高剂量(其离子剂量为4 × 1016 cm–2)低能团簇组合, 采取多级能量团簇辐照15 keV + 8 keV + 5 keV的修形处理; 模式二: 高剂量(其离子剂量为3 × 1016 cm-2)高能团簇和低剂量(其离子剂量分别为2 × 1016 cm–2、1 × 1016 cm–2)低能团簇组合, 采取多级能量团簇辐照15 keV + 8 keV + 5 keV的修形处理. 这两者的不同主要在于不同能量的团簇辐照靶材时所用的离子剂量不同, 而离子剂量的多少, 直接影响到靶材表面的平坦化效果.
采用AFM作为表征手段, 分析团簇辐照前后Si片表面形貌的变化情况. AFM测试选取的扫描面积为10 μm × 10 μm, 0.5 μm × 0.5 μm. 表1和表2分别列出了单一能量团簇轰击靶材和两种多级能量模式轰击靶材的平坦化参数(加速电压、离子剂量、抛光时间), 平坦化结果(均方根表面粗糙度Rq).
| 团簇能量 /keV | 离子剂量 /(ions·cm-2) | 抛光时间 /min | 均方根粗 糙度/nm |
| 0 | 0 | 0 | 1.69 |
| 15 | 6 × 1016 | 10 | 1.64 |
| 8 | 6 × 1016 | 20 | 1.07 |
| 5 | 6 × 1016 | 25 | 1.10 |
表1Si片样品的平坦化参数(团簇能量、离子剂量、抛光时间)和平坦化结果(均方根表面粗糙度Rq)
Table1.The smoothing parameters (cluster energy, ion dose, smoothing time) and root mean square roughness Rq.
| 团簇能量/keV | 离子剂量/(ions·cm–2) | 抛光时间/min | 均方根粗糙度/nm |
| 0 | 0 | 0 | 1.69 |
| 15 + 8 + 5 | 2 × 1016 + 2 × 1016 + 2 × 1016 | 3 + 6 + 8 | 0.62 |
| 15 + 8 + 5 | 3 × 1016 + 2 × 1016+1 × 1016 | 5 + 6 + 4 | 1.02 |
表2Si片样品的平坦化参数(团簇能量、离子剂量、抛光时间)和平坦化结果(均方根表面粗糙度Rq)
Table2.The smoothing parameters (cluster energy, ion dose, smoothing time) and root mean square roughness Rq.
3.1.单一能量团簇辐照对Si片的影响
为了验证创伤去除、离子损伤程度与团簇能量的关系, 先用单一能量带有机械损伤(划痕)的Si片. 图1为经不同能量的Ar团簇垂直辐照后, Si片的AFM表面形貌图. 图1(a)为团簇轰击前的初始表面形貌, 可以看到表面有很多划痕, 划痕最大深度有9—10 nm, 其表面均方根粗糙度Rq为1.69 nm, 如表1所示. 经过15 keV高能团簇轰击之后, Si片的AFM表面形貌图如图1(b)所示, 划痕明显很浅, 都在1 nm以下, 但表面颗粒粗大, 其表面均方根粗糙度Rq为1.64 nm, 粗糙度稍有降低, 这是因为在高能量团簇溅射率高, 可以迅速除去划痕, 同时在Si片表面遗留下离子损伤(弧坑), 破坏靶材表面结构, 所以最终粗糙度变化不明显. 经过8 keV低能团簇轰击后, Si片的AFM表面形貌图如图1(c)所示, 可以看到颗粒变得细腻, 其表面均方根粗糙度Rq为1.07 nm, 这是因为在低能量轰击靶材后, 样品表面遗留的离子损伤更轻, 从而样品表面显得更平坦些, 但划痕去除效果较差, 最大划痕深度在2 nm左右. 最后用更低能量5 keV团簇轰击靶材, Si片的AFM表面形貌图如图1(d)所示, 同样可以看到Si片表面变得细腻, 但深划痕清晰可见, 且划痕深度变化不大, 最大划痕深度有6 nm, 其表面均方根粗糙度Rq为1.10 nm, 这是因为当能量很低时, 并不能很快除去靶材开始带有的机械损伤, 即不能有效去除靶材高突起的形状物质, 虽然离子损伤很轻, 但是划痕在靶材表面粗糙度上贡献更大, 从而靶材平坦化效果也不能达到最佳. 图 1 Si片经不同单一能量的Ar团簇垂直辐照前后的AFM表面形貌图 (a) 0 keV (initial); (b) 15 keV; (c) 8 keV; (d) 5 keV
图 1 Si片经不同单一能量的Ar团簇垂直辐照前后的AFM表面形貌图 (a) 0 keV (initial); (b) 15 keV; (c) 8 keV; (d) 5 keVFigure1. AFM images of Si surface before and after Ar cluster bombardment at different single energies: (a) 0 keV (initial surface); (b) 15 keV; (c) 8 keV; (d) 5 keV.
对比图1(b)、图1(c)和图1(d), 可以得出, 当用15 keV高压加速团簇离子时, 划痕去除效率最高, 最终表面划痕很浅, 但粗糙度下降不明显, 这是因为高能团簇轰击靶材后会遗留下离子损伤, 破坏靶材已形成的平坦表面结构; 当用8 kV和5 kV低压加速团簇离子时, 样品表面变得细腻, 遗留的离子损伤最轻, 但是不能有效去除靶材表面深划痕. 即高能团簇溅射率高, 而低能团簇造成的离子损伤小.
2
3.2.两种多级能量模式对Si片创伤的修复
同样以带有机械损伤的Si片为研究对象, 对比研究了在不同离子剂量比下, 气体团簇离子束多级能量模式在机械损伤修复中的作用. 图2为经两种不同模式的Ar团簇离子垂直辐照后, Si片的AFM表面形貌图. 图2(a)为团簇轰击前的初始表面, Si片是由金刚石研磨膏打磨而成, 表面有很多划痕, 最大划痕深度达9—10 nm, 其均方根粗糙度Rq为1.69 nm, 如表2所示. 图2(b)为经15 keV + 8 keV + 5 keV (3个能量对应的离子剂量均为2 × 1016 cm–2)多级能量模式一辐照后的表面形貌, 图2(c)为经15 keV + 8 keV + 5 keV (3个能量对应的离子剂量分别为3 × 1016, 2 × 1016, 1 × 1016 cm–2)多级能量模式二辐照后的表面形貌, 样品表面划痕几乎不复存在, 其表面均方根粗糙度Rq分别降低至0.62 nm、1.02 nm, 如表2所示. 对比图2(b)和图2(c)可以看出, 模式一修复的靶材表面颗粒非常细密光腻, 表面光洁几乎无污染, 平坦化效果最佳; 模式二修复靶材表面颗粒相对模式一粗大, 没有图2(b)中细腻光滑. 这是因为在多级能量模式二中, 前期采用了3 × 1016 cm–2高剂量的15 kV高能团簇轰击靶材表面, 这样高能团簇轰击后会遗留更多的离子损伤, 后期的2 × 1016 cm–2低剂量的8 kV低能团簇、1 × 1016 cm–2低剂量的5 kV低能团簇只能除去部分离子损伤, 修复力度不够. 与之不同的是在多级能量模式一中, 先采用了2 × 1016 cm–2低剂量高能团簇去轰击靶材表面, 这样高能量团簇可以先快速去除样品表面高突起的形状物体, 且在低剂量模式下, 不至于遗留下太多离子损伤, 利于后期修复. 并且在多级能量模式一后期, 采用了4 × 1016 cm–2高剂量低能团簇去轰击靶材表面, 这样不仅可以减轻离子损失, 还可以延长低能团簇修复离子损伤的时间, 从而得到最佳化的平坦化效果.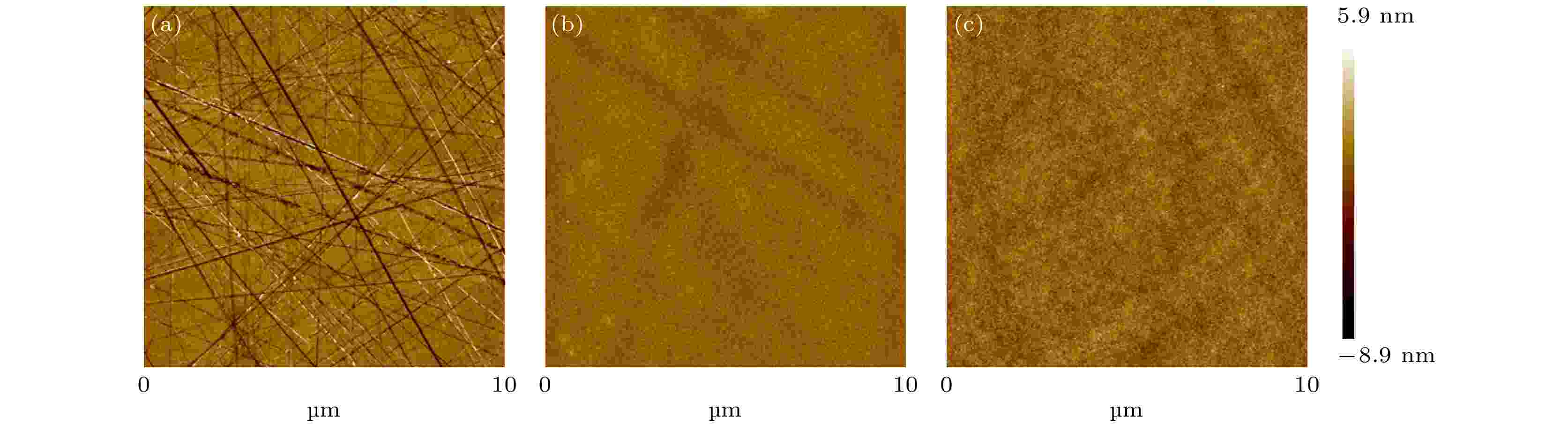 图 2 Si片经两种不同模式的Ar团簇垂直辐照后的AFM表面形貌图 (a) 0 keV (初始); (b) 15 keV + 8 keV + 5 keV多级能量(其离子剂量均为2 × 1016 cm–2); (c) 15 keV + 8 keV + 5 keV多级能量(其离子剂量分别为3 × 1016, 2 × 1016, 1 × 1016 cm–2)
图 2 Si片经两种不同模式的Ar团簇垂直辐照后的AFM表面形貌图 (a) 0 keV (初始); (b) 15 keV + 8 keV + 5 keV多级能量(其离子剂量均为2 × 1016 cm–2); (c) 15 keV + 8 keV + 5 keV多级能量(其离子剂量分别为3 × 1016, 2 × 1016, 1 × 1016 cm–2)Figure2. AFM images of mechanically polished Si surface irradiated by two different modes of Ar cluster bombardment: (a) Initial surface; (b) 15 keV + 8 keV + 5 keV, consequently (all ion doses are 2 × 1016 cm–2); (c) 15 keV + 8 keV + 5 keV, consequently (ion doses respectively are 3 × 1016, 2 × 1016, 1 × 1016 cm–2)
对图2的AFM照片进行分析, 其PSD频谱曲线如图3所示. 从图3可以看出: 每条曲线与横坐标围成一个梯形区域, 而这个区域的面积大小反应出均方根粗糙度的大小, 梯形区域面积越大, 则均方根粗糙度也越大; 原始表面形成的区域面积最大, 将两种多级能量模式进行对比, 多级能量模式一形成的区域面积比多级能量模式二形成的区域面积小. 再次表明, 多级能量模式一的平坦化效果优于多级能量模式二的平坦化效果.
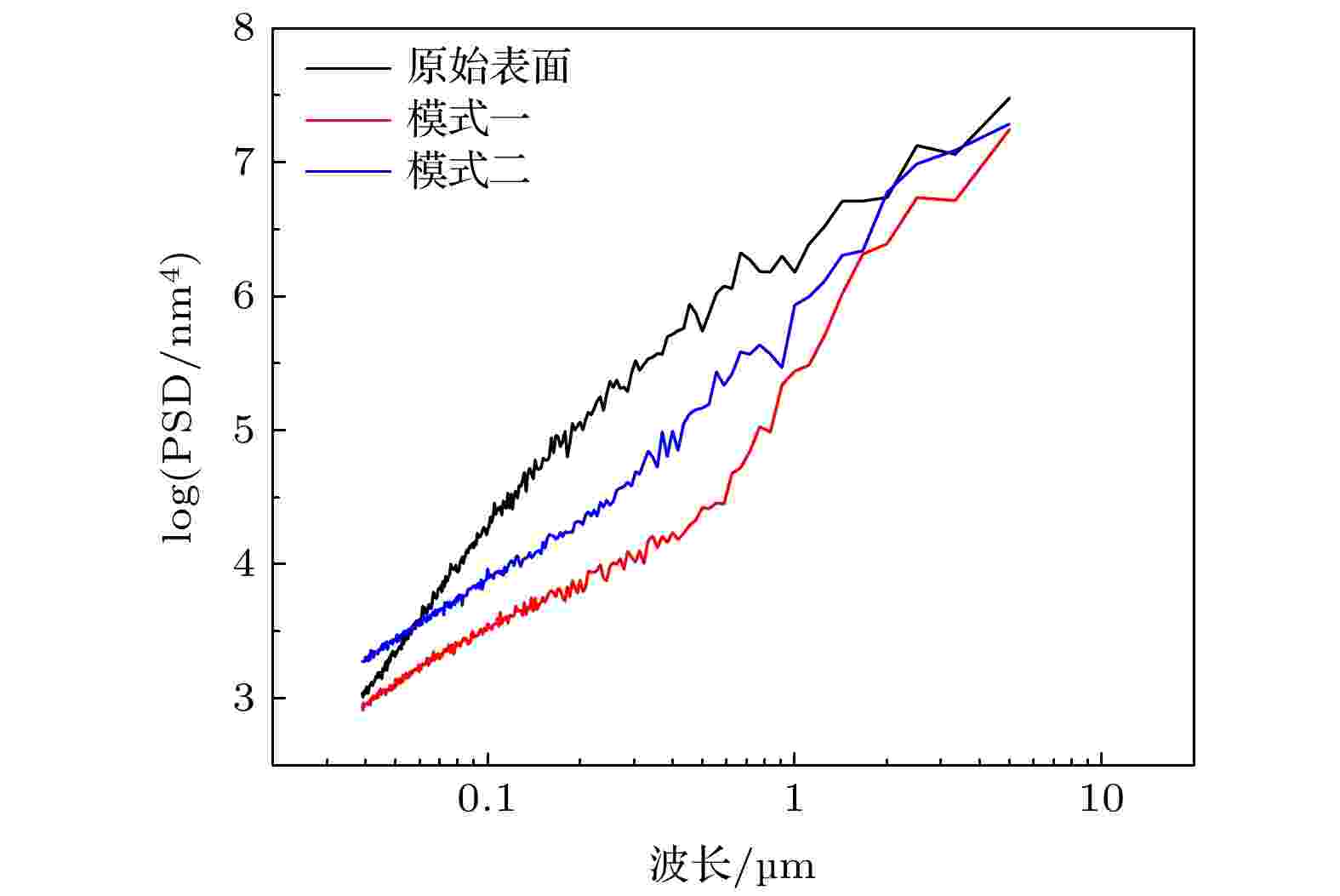 图 3 两种不同模式下, Ar团簇垂直辐照Si片后的PSD曲线
图 3 两种不同模式下, Ar团簇垂直辐照Si片后的PSD曲线Figure3. PSD curves of Ar clusters after vertical irradiation of Si wafer under two different modes
为了更好地观察靶材微观形貌、离子损伤(孔洞)大小, 将AFM扫描面积减小到0.5 μm × 0.5 μm. 图4为经不同能量的Ar团簇垂直辐照后, Si片的AFM表面形貌图. 图4(a)为经过15 keV高能团簇轰击之后的Si片的AFM表面形貌图, 可以看出颗粒略粗大, 图4(e)是其孔洞的截面轮廓图, 孔洞直径约25 nm、深10 nm. 图4(b)为经过5 keV低能团簇轰击之后的Si片的AFM表面形貌图, 可以看出表面颗粒较细密, 图4(f)是其孔洞的截面轮廓图, 孔洞直径约20 nm、深5 nm. 图4(c)为多级能量模式一15 keV + 8 keV + 5 keV(3个能量对应的离子剂量均为2 × 1016 cm–2)辐照后Si片的AFM表面形貌图, 可以看出颗粒很小, 图4(g)是其孔洞的截面轮廓图, 孔洞相对平坦, 直径约25 nm、深3 nm. 图4(d)为多级能量模式二15 keV + 8 keV + 5 keV(3个能量对应的离子剂量分别为3 × 1016, 2 × 1016, 1 × 1016 cm–2)辐照后Si片的AFM表面形貌图, 可以看出颗粒较小, 图4(h)是其孔洞的截面轮廓图, 孔洞较模式一辐照的更大, 孔洞直径约15 nm、深5 nm. 从弧坑(孔洞)的截面轮廓图中得出, 图4(e)、图4(f)和图4(h)具体表现为中间低于Si片平均表面、边缘高于Si片平均表面的不平整结构, 高低变化差较大; 而图4(g)可以看出孔洞高低变化差很小, 整个截面几乎为一平面. 再次证明, 多级能量修形模式一的平坦化效果要比单一高能团簇、单一低能团簇, 以及多级能量模式二轰击靶材的平坦化效果要好.
 图 4 Si片经不同能量的Ar团簇垂直辐照后的AFM表面形貌图 (a) 15 keV; (b) 5 keV; (c) 15 keV + 8 keV + 5 keV (离子剂量均为 2 × 1016 cm–2); (d) 15 keV + 8 keV + 5 keV (离子剂量分别为 3 × 1016, 2 × 1016、1 × 1016 cm–2); (e) 图(a)中孔洞的截面轮廓图; (f) 图(b)中孔洞的截面轮廓图; (g) 图(c)中孔洞的截面轮廓图; (h) 图(d)中孔洞的截面轮廓图
图 4 Si片经不同能量的Ar团簇垂直辐照后的AFM表面形貌图 (a) 15 keV; (b) 5 keV; (c) 15 keV + 8 keV + 5 keV (离子剂量均为 2 × 1016 cm–2); (d) 15 keV + 8 keV + 5 keV (离子剂量分别为 3 × 1016, 2 × 1016、1 × 1016 cm–2); (e) 图(a)中孔洞的截面轮廓图; (f) 图(b)中孔洞的截面轮廓图; (g) 图(c)中孔洞的截面轮廓图; (h) 图(d)中孔洞的截面轮廓图Figure4. AFM images of mechanically polished Si surface after Ar cluster bombardment with different energy: (a) 15 keV; (b) 5 keV; (c) 15 keV + 8 keV + 5 keV, consequently (all ion doses are 2 × 1016 cm–2); (d) 15 keV + 8 keV + 5 keV, consequently (ion doses respectively are 3 × 1016, 2 × 1016, 1 × 1016 cm–2); (e) cross section of a crater from (a); (f) cross section of a crater from (b); (g) cross section of a crater from (c); (h) cross section of a crater from (d).
