全文HTML
--> --> -->在诸多多孔材料保护方法中, 孔填充技术是最为直接有效的手段. Frot等[7,8]首次提出了这种孔填充技术(P4技术: post porosity plasma protection). 在等离子体刻蚀工艺进行前, 预先对小孔内部填充聚合物材料, 在等离子体刻蚀工艺过程中, 这些填充材料可以有效抑制活性自由基的扩散, 以保护多孔材料内部免受损伤. 刻蚀完成之后, 再通过高温加热(约400 ℃)等手段将填充材料移除, 留下完整的刻蚀结构. 这种工艺技术最大的缺点是需要额外增加孔填充和填充物移除工序, 增加工艺复杂度和时间成本.
低温刻蚀技术的概念最早是在20世纪80年代, 由日本研究团队提出的[9-11]. 在等离子体刻蚀过程中, 通过在常用刻蚀气体(如SF6)中添加钝化气体(如C4F8), 且将基片台的温度降低到–100 ℃至130 ℃之间, 在刻蚀槽的侧壁形成钝化层, 起到保护侧壁免受等离子体侵蚀的作用, 而在刻蚀槽底部形成的钝化层则会在离子定向轰击的作用下被移除(即离子辅助刻蚀), 进而实现各向异性的高纵宽比刻蚀工艺. 有时还会在工艺气体中额外添加O2以辅助钝化层的形成. 来自比利时微电子研究中心(interuniversity microelectronics center, IMEC)的Zhang等[12,13]最早尝试将这种技术应用到多孔材料的刻蚀工艺中. 他们指出刻蚀过程中形成的副产物(如SiOxFy和CxHyOH等)在极低温度下, 会在材料表面凝结, 进而在刻蚀过程中保护材料免受等离子体活性自由基的损伤. 刻蚀完成之后, 只需加热基片台温度, 这些凝结的副产物即可挥发殆尽. 与P4工艺技术相比, 这种技术流程很简单, 经济效益也高, 但是往往需要将基片台温度降至–100 ℃以下, 这对于机台设备是个挑战, 并且需要较长时间才能实现如此多的温降, 很难推广应用.
近年, IMEC又提出一种新的低温刻蚀工艺技术, 它是一种P4工艺和传统低温刻蚀技术的折中[14-18]. 在等离子体刻蚀开始之前, 预先将腔室内部充入前驱气体(如C4F8, C6F6), 使气体填充多孔材料内部, 再降低基片台的温度, 前驱气体会在材料内部凝结成液态, 并在刻蚀过程中持续保护材料. 刻蚀结束后, 恢复基片台温度至室温, 凝结物就会蒸发殆尽. 通过选择合适的前驱气体, 这种工艺可以实现–50 ℃的多孔材料无损伤刻蚀.
本文将针对多孔材料的无损伤等离子体刻蚀工艺, 介绍两种低温刻蚀技术, 以及不同气体组分下的低温刻蚀过程, 阐述多孔材料的刻蚀损伤机制、保护机制、实验诊断方法和研究进展等, 并对比分析各自的优缺点.
 图 1 (a)等离子体损伤示意图; (b)无等离子体损伤和(c)等离子体损伤后的low-k多孔材料化学结构[6]
图 1 (a)等离子体损伤示意图; (b)无等离子体损伤和(c)等离子体损伤后的low-k多孔材料化学结构[6]Figure1. (a) Schematic of plasma induced damage; chemical structure of low-k porous materials (b) before plasma damage and (c) same structure after plasma damage[6].
| 优点 | 缺点 | |
| 傅里叶变换红外光谱 | 通过吸收峰变化, 可表征材料化学结构变化 | 对操作环境较敏感, 要避免材料二次污染的影响 |
| 光谱椭偏仪测量 | 通过反射率变化, 可间接推测介电常数等变化 | 需要额外数据处理 |
| dHF酸浸泡法 | 操作简单, 易观测损伤 | 使用化学试剂, 腐蚀损伤材料 |
表1等离子体材料损伤检测手段[6]
Table1.Characterization methods of plasma induced damage[6].
傅里叶变换红外光谱(Fourier transformed infrared spectroscopy, FTIR)是一种用来表征多孔低介电常数材料的常用技术. 多孔低介电常数材料的主要吸收峰为950—1250 cm–1的Si—O—Si基团和1273 cm–1的Si—CH3基团. 而多孔材料经过等离子体中的自由基化学改性受到损伤后, Si—CH3基团将部分损失, 相应的Si—CH3基团的1273 cm–1吸收峰将降低. 同时吸收光谱将出现额外的930, 960以及3000—3700 cm–1的吸收峰, 这些峰分别对应Si—F, Si—OH和—OH基团, 根据对应吸收峰在处理前后的大小变化, 可以判断多孔材料的损伤程度.
光谱椭偏仪测量是利用线偏振光与样品相互作用, 反射后转变为椭圆偏振光的性质, 通过使用合适的数据处理模型, 得到材料的光学常数. 对于多孔SiO2透明材料, 可使用柯西模型和Cauchy公式, 处理反射的椭圆偏振光数据, 得到薄膜的厚度、折射率和介电常数.
dHF酸浸泡法是一种简单且容易重复实现的等离子体损伤检测方法. 当低介电常数的多孔材料暴露在等离子体中时, 等离子体中的活性自由基将与多孔材料发生化学改性, 原本疏水的Si—CH3会变成亲水的Si—OH, 同时化学反应也可能导致孔隙的坍塌, 使得多孔材料表面变得致密而亲水. 由于dHF溶解亲水表面的速率比溶解疏水表面的速率高几个数量级, 因此将这种材料浸入1/300 (质量分数比)稀dHF水溶液中30—60 s, 之后测量薄膜进行等离子体处理前后的厚度变化, 就可以观察到材料的损伤程度. 半导体行业上首选这种检测损伤方法.
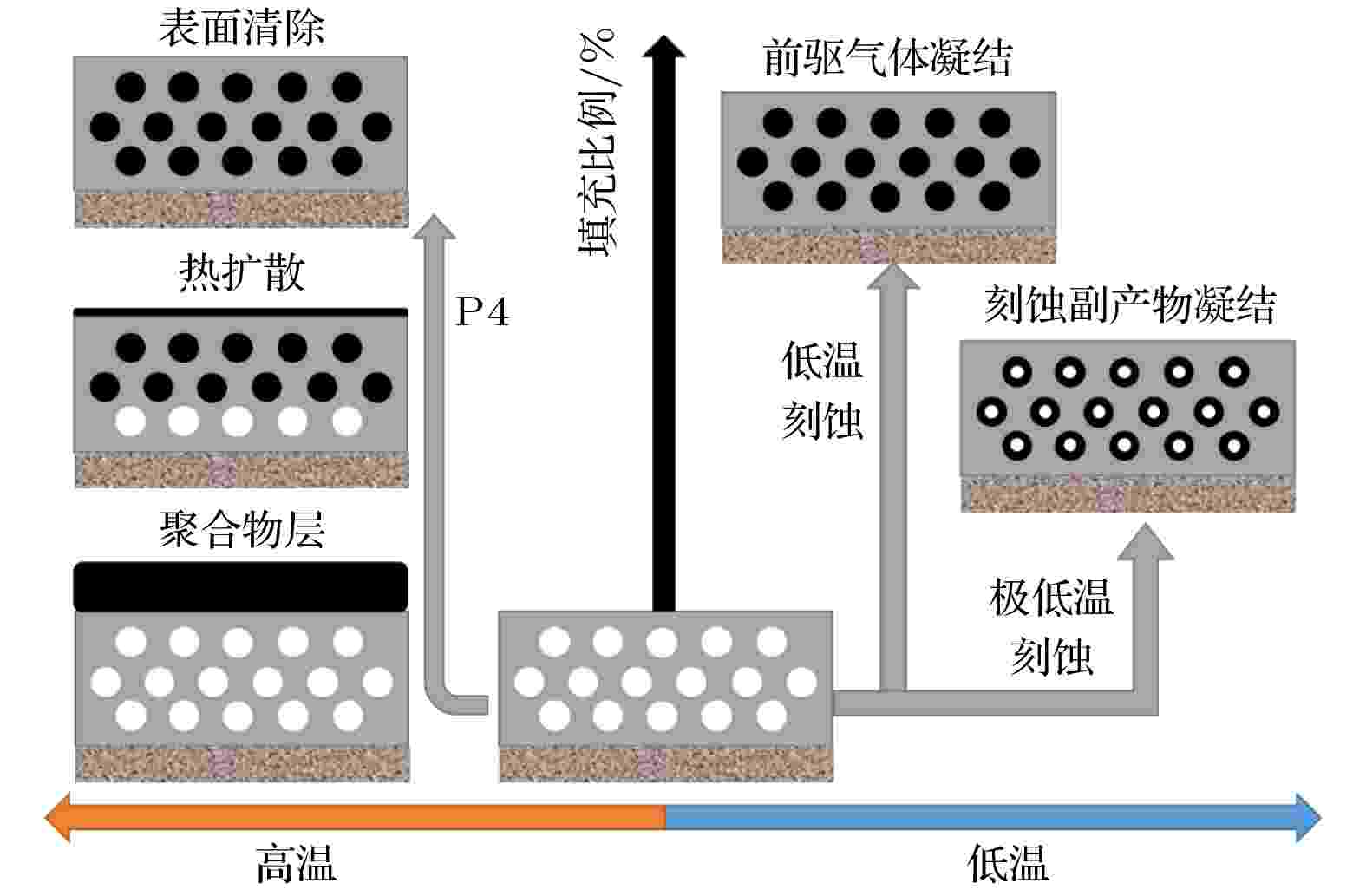 图 2 多孔材料无损伤刻蚀技术: P4, 极低温刻蚀, 低温刻蚀(利用刻蚀前驱气体凝结作用)[14]
图 2 多孔材料无损伤刻蚀技术: P4, 极低温刻蚀, 低温刻蚀(利用刻蚀前驱气体凝结作用)[14]Figure2. Damage free etching of porous low-k material: Post porosity plasma protection (P4), cryogenic etch and low temperature etch using precursor condensation[14].
2
3.1.极低温刻蚀(刻蚀副产物凝结)
来自IMEC的Zhang等[13]首次将低温刻蚀技术应用到多孔材料的刻蚀. 他们首先研究了纯SF6等离子体在不同基片温度下, 对多孔材料的刻蚀情况. 如图3所示, 通过对比OSG-2.0材料在刻蚀前后和不同基片温度下刻蚀结构的FTIR谱线, 可以看到在–120 ℃时, Si—CH3元素对应的峰值最接近原始(即刻蚀前的黑色曲线)的峰值, 随着温度的升高, Si—CH3峰值急剧下降, 代表甲基(CH3)的损失增多, 等离子体损伤增大. 并且在有偏压时(图3(b)), 由于离子轰击作用增强, 接近常温时的材料损伤更为剧烈. 但无论有无偏压, 在极低温度(–120 ℃)下, 多孔材料都可以实现近乎无损伤的刻蚀效果.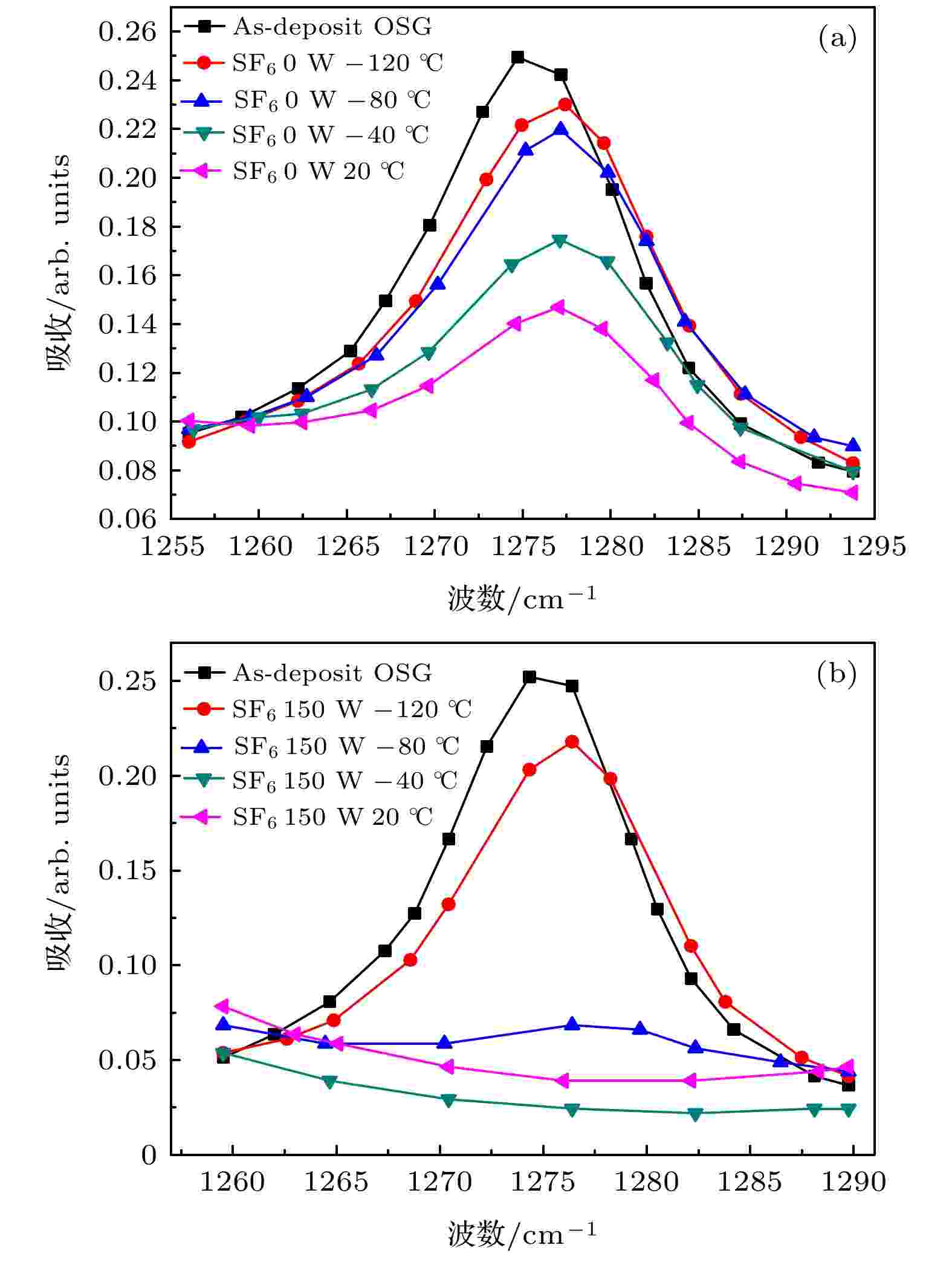 图 3 OSG-2.0材料刻蚀前后的FTIR谱线 (a)无偏压刻蚀; (b)有偏压刻蚀[13]
图 3 OSG-2.0材料刻蚀前后的FTIR谱线 (a)无偏压刻蚀; (b)有偏压刻蚀[13]Figure3. FTIR spectra of OSG-2.0 material (before and after plasma etching): (a) Without bias; (b) with bias[13].
图4所示是OSG-2.0材料在不同基片温度下的刻蚀速率[13], 当有150 W偏压时, 由于离子轰击基片的作用增强, 其刻蚀速率远大于偏压为0 W的情况. 随着温度的降低, 刻蚀速率逐渐下降. 在–120 ℃时, 有偏压时的刻蚀速率是无偏压时的8倍, 由于偏压只会增强纵向刻蚀速率(离子垂直向下轰击), 这有助于实现各向异性的材料刻蚀(即纵向刻蚀速率远大于横向刻蚀速率).
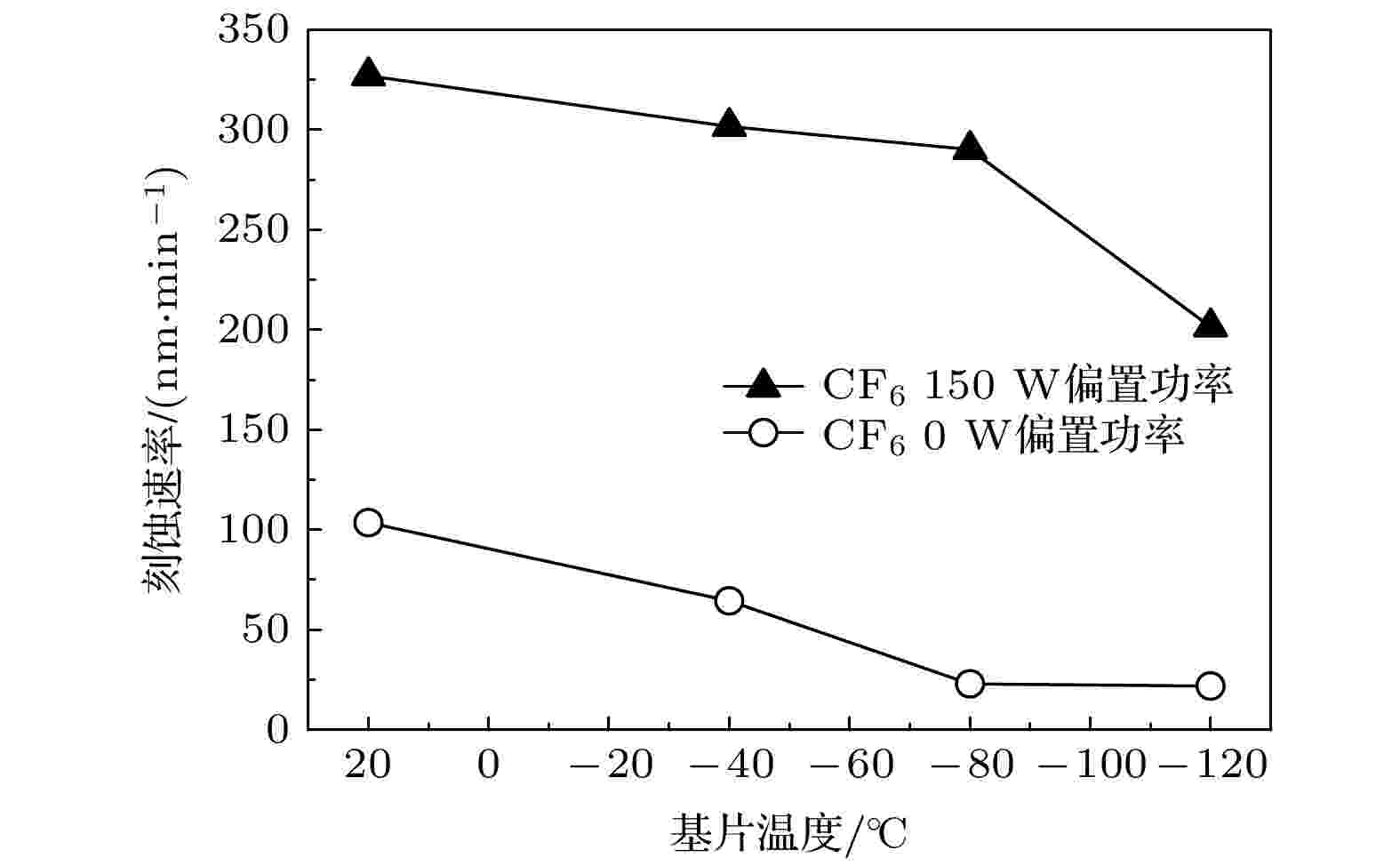 图 4 OSG-2.0材料在不同基片温度下的刻蚀率[13]
图 4 OSG-2.0材料在不同基片温度下的刻蚀率[13]Figure4. Etching rate of OSG-2.0 material at different chuck temperature[13].
图5对比了纯SF6气体放电和SiF4/O2/SF6混合气体放电对多孔材料的刻蚀效果[13]. 可以看出, 有偏压时材料介电常数(k值)普遍偏大, 即由于离子的轰击作用增强, 材料损伤较大. 随着基片温度的降低, 材料k值逐渐减小, 暗示材料损伤在减小, 在–120 ℃时材料损伤达到最小. 此外, 混合气体放电刻蚀中, 材料的k值要更小一些, 甚至在–80 ℃时, 材料的k值也非常小. 这说明混合气体放电中更容易在较低温度下生成容易钝化的聚合物(SiOxFy)以保护材料免受损伤.
 图 5 等离子体刻蚀后OSG-2.0材料的介电常数k值 (a)纯SF6等离子体刻蚀; (b) SiF4/O2/SF6等离子体[13]
图 5 等离子体刻蚀后OSG-2.0材料的介电常数k值 (a)纯SF6等离子体刻蚀; (b) SiF4/O2/SF6等离子体[13]Figure5. k value of OSG-2.0 material (before and after plasma etching): (a) Pure SF6 plasma etching; (b) SiF4/O2/SF6 plasma etching[13].
Rezvanov等[19]进一步研究了CF3Br和CF4等离子体对多孔材料的极低温刻蚀过程. 图6所示是多孔材料在CF3Br等离子体中的刻蚀率和材料折射率与基片温度的关系. 刻蚀速率并不是随着基片温度而单调变化, 在–60 ℃时刻蚀速率最小, 并且在–90 ℃附近达到饱和. 在低温下形成的沉积物质很容易通过加热移除, 例如在–70 ℃以下温度经等离子体刻蚀后的材料, 在加热处理后, 折射率非常接近刻蚀前的材料折射率(pristine RI虚线), 说明沉积物质不仅起到了保护材料的作用, 在加热处理后皆被移除掉. 然而, –70 ℃以上温度时, 经等离子体刻蚀后的材料, 在加热处理后折射率仍然很高, 表征着材料损伤的发生. 因此, –70 ℃以下温度的等离子体刻蚀对多孔材料造成的损伤非常小.
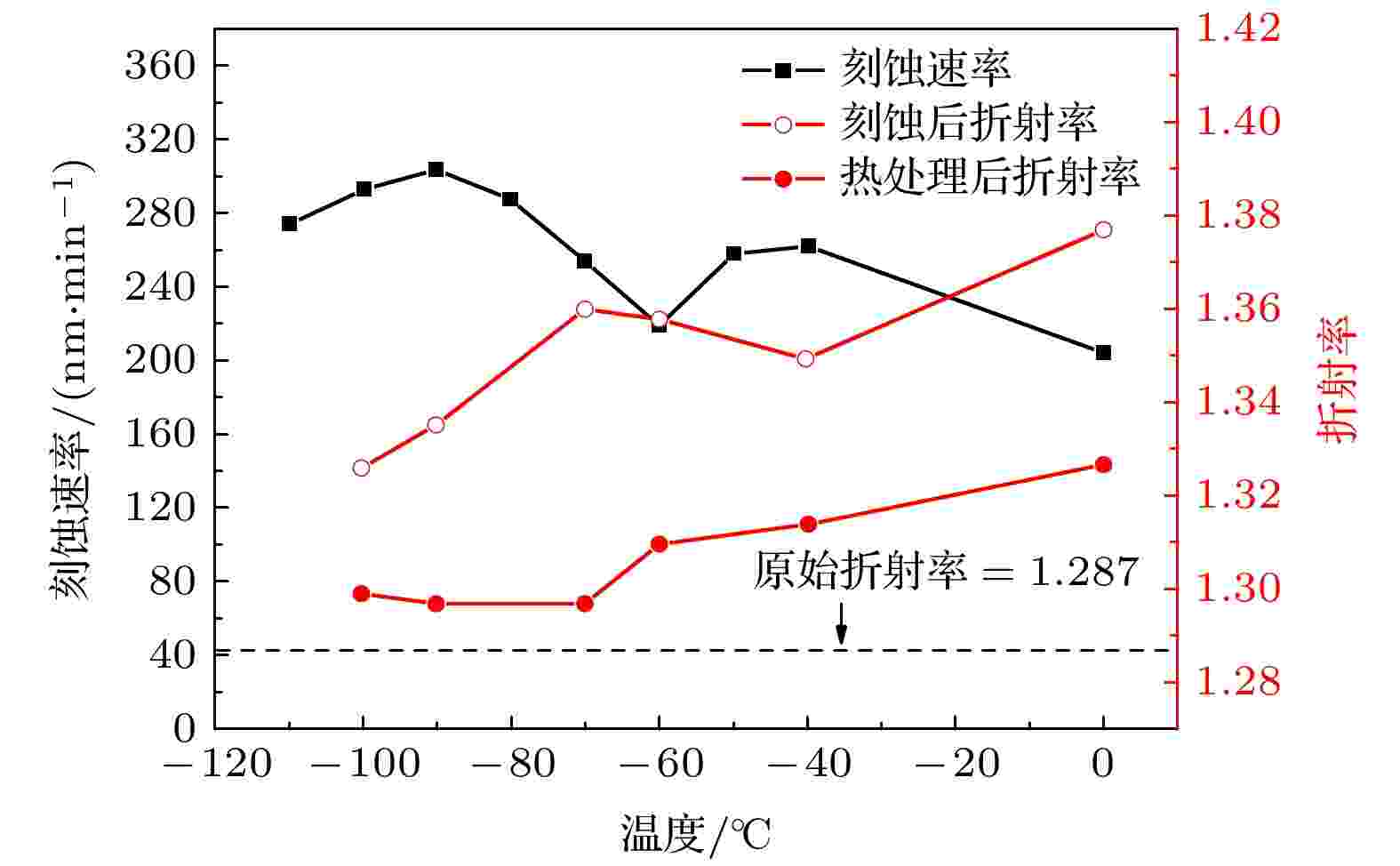 图 6 不同基片温度下, 多孔材料在CF3Br等离子体中的刻蚀率和材料折射率[19]
图 6 不同基片温度下, 多孔材料在CF3Br等离子体中的刻蚀率和材料折射率[19]Figure6. Etching rate and refractive rate of porous material after CF3Br plasma etching at various chuck temperature[19].
如图7所示, 他们进一步测量了不同温度下多孔材料刻蚀前后的FTIR谱线. 相比于刻蚀前(pristine, 图7(a)), 谱线上多出许多小峰(对应—CF3, —CHxBry和—SIFx元素), 这些小峰对应着易沉积的刻蚀产物, 使低k材料变得更加亲水(对应水吸收峰). 在经过30 min的300 ℃加热处理后, 这些谱线峰值消失, 但是材料仍保持一定的亲水性(对应图7(b)中的水吸收峰). 他们推测刻蚀产物中可能仍含有一定浓度的Si—CHxBry元素, 该元素增加了材料的亲水性.
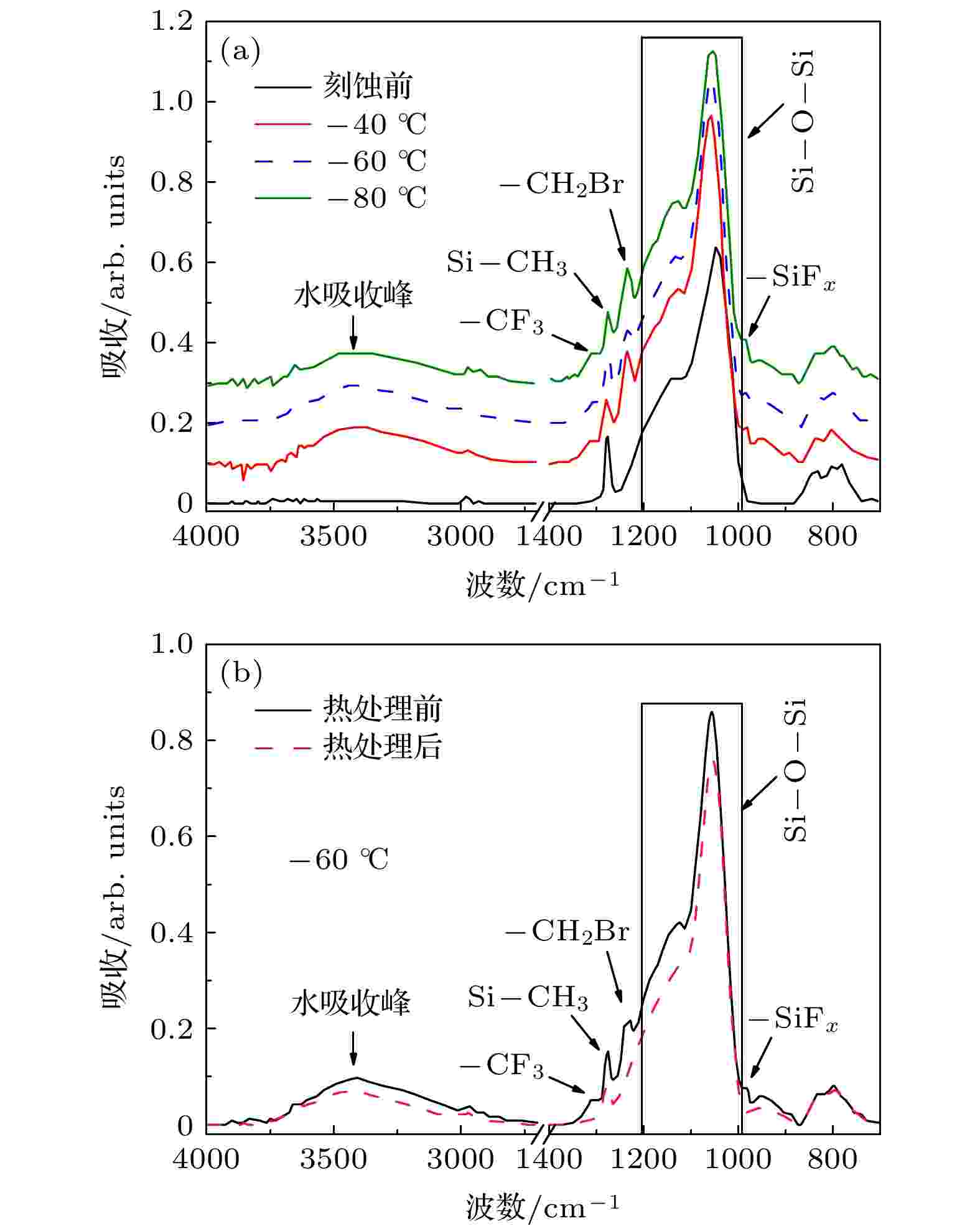 图 7 在不同温度下, CF3Br等离子体刻蚀多孔材料的FTIR谱线 (a)加热处理前; (b)加热处理后[19]
图 7 在不同温度下, CF3Br等离子体刻蚀多孔材料的FTIR谱线 (a)加热处理前; (b)加热处理后[19]Figure7. FTIR spectra of porous material after CF3Br plasma etching: (a) Before annealing; (b)after annealing[19].
相比于CF3Br等离子体, CF4等离子体含有更高浓度的F (易于刻蚀), 并且不会与多孔材料(SiO2基体)反应生成难以挥发掉的化合物. 因此, Rezvanov等[19]进一步研究了不同基片温度下, 多孔材料在CF4等离子体中的刻蚀率和材料折射率. 如图8所示, 材料的刻蚀速率随着温度的下降而急剧减小. 在–70 ℃以上温度时, 材料的折射率几乎不变, 但是在–90 ℃时, 折射率突然增大, 表征着大量沉积物(CFx类聚合物)的生成, 并导致了刻蚀速率的急剧减小. 在将材料加热处理后, –90 ℃刻蚀温度时的材料折射率几乎恢复至与材料刻蚀之前相同的折射率值, 表征材料几乎无损伤发生. 此外, 对比图6中的结果, 即便是在–60 ℃的刻蚀温度, CF4等离子体刻蚀处理后的材料折射率仍小于CF3Br等离子体刻蚀情况. 因此, 对于多孔材料的刻蚀, CF4等离子体的性能要高于CF3Br等离子体, 其在–60 ℃附近温度就可以实现多孔材料低损伤刻蚀, 并保持较高的刻蚀率(120 nm/min).
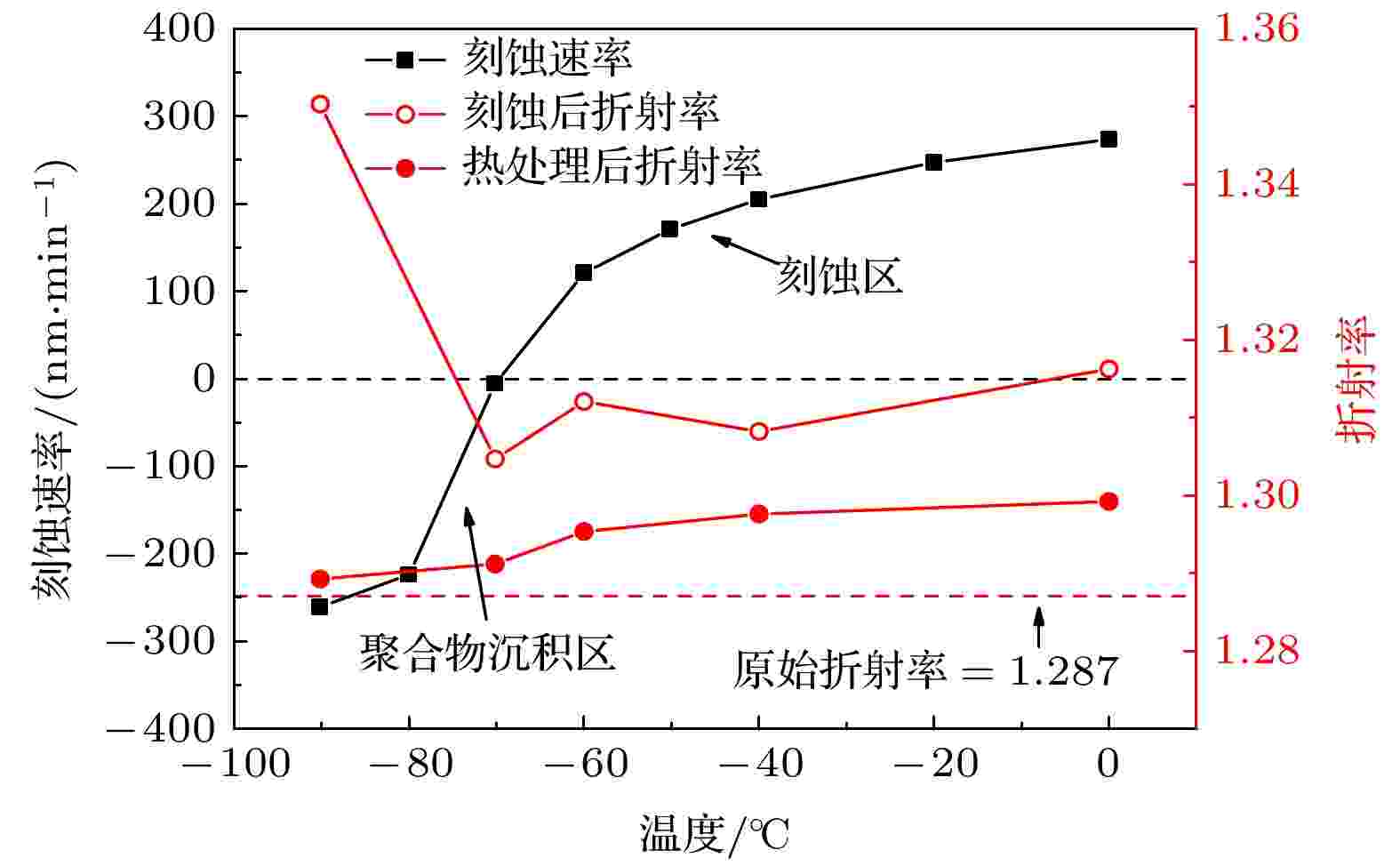 图 8 不同基片温度下, 多孔材料在CF4等离子体中的刻蚀率和材料折射率[19]
图 8 不同基片温度下, 多孔材料在CF4等离子体中的刻蚀率和材料折射率[19]Figure8. Etching rate and refractive rate of porous material after CF4 plasma etching at various chuck temperature[19].
2
3.2.低温刻蚀(刻蚀前驱气体凝结)
前面介绍的极低温刻蚀工艺, 皆是利用刻蚀生成的副产物在较低温下的凝结作用, 来抑制等离子体中自由基的扩散, 进而保护多孔材料免受损伤. 然而这种工艺对于工艺混合气体的比例、基片温控极为严苛. 为进一步优化低温刻蚀工艺, 来自IMEC的Zhang等[14]又提出了利用刻蚀前驱气体在低温下的凝结-液化作用来实现多孔材料的保护. 他们首先检测了不同气体(SF6和C4F8)在无等离子体放电情况下, 于材料内部的凝结作用. 如图9所示, 在腔室内充入SF6后, 随着基片温度的降低, 材料的折射率只是略微升高, 这表征SF6在低温时只是部分凝结在材料的内部表面. 而在腔室内充入C4F8后, 当温度降低到–110 ℃以下, 材料的折射率迅速升高并到达饱和, 这表征此时C4F8气体可以充分在材料内部表面发生凝结, 甚至填满材料内部孔隙. 由此, 他们指出可以在刻蚀进行之前, 将基片台温度降低, 并充入易于凝结的前驱气体, 使其液化并附着在材料内壁. 刻蚀过程中, 通过保持较低的基片台温度, 凝结的液化气体会一直保护材料. 当刻蚀工艺完成之后, 恢复基片台温度至室温, 凝结的液化气体会自然挥发, 进而留下完好无损的刻蚀结构.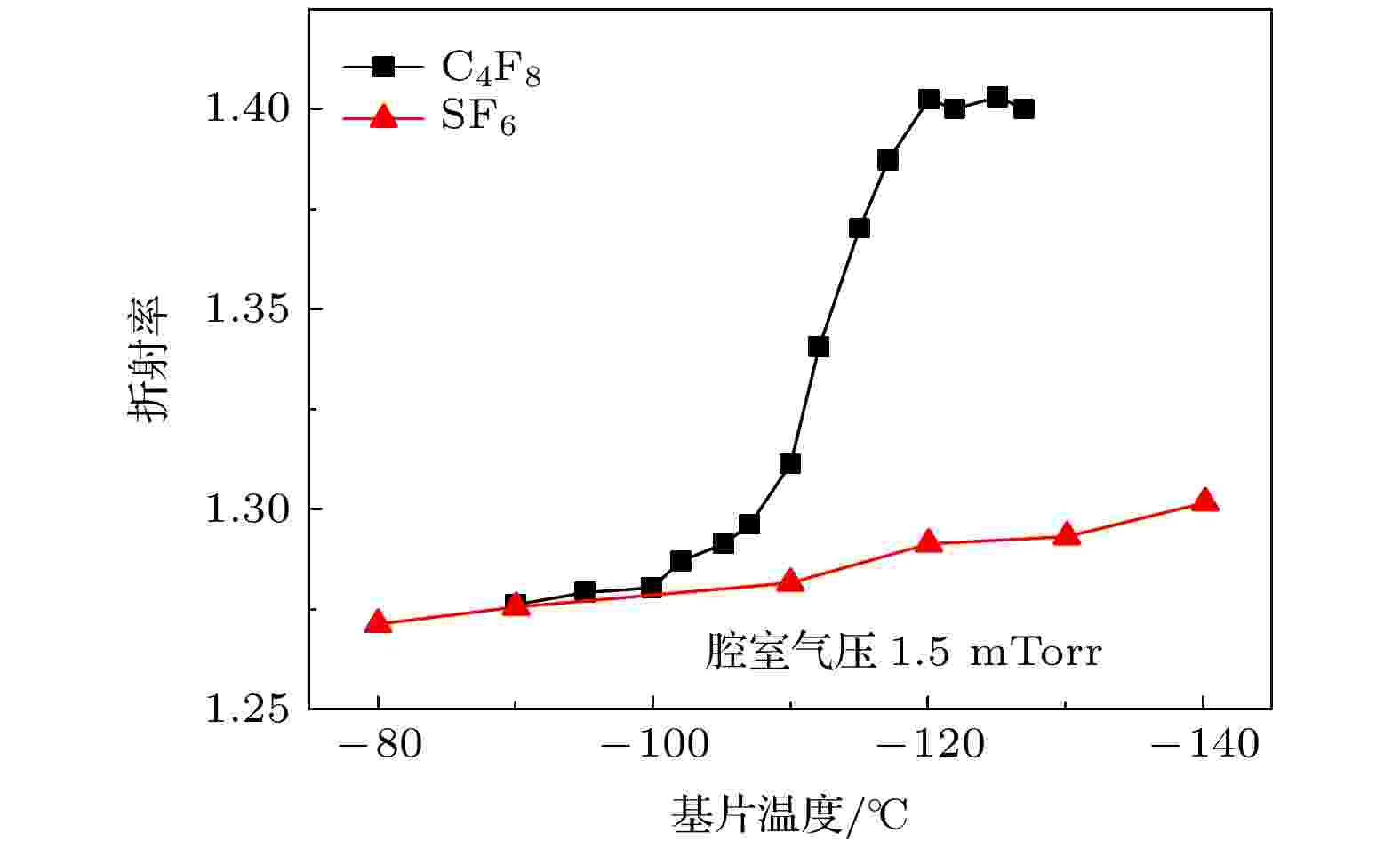 图 9 多孔材料内部分别充入SF6和C4H8气体后, 在不同温度下的折射率(反应气体的凝结比例, 1 Torr = 1.33322×102 Pa)[14]
图 9 多孔材料内部分别充入SF6和C4H8气体后, 在不同温度下的折射率(反应气体的凝结比例, 1 Torr = 1.33322×102 Pa)[14]Figure9. Change of refractive index as a function of temperature, showing the condensation of pure SF6 or C4H8 into a porous low-k SBA-2.2[14].
为验证这一技术的可行性, 他们检验了利用C4F8/SF6混合气体进行低温刻蚀的结果. 如图10所示, 随着基片温度的下降, 材料的折射率迅速升高(图10(a)), 表征大量前驱气体凝结在材料内部, 填充材料内部孔隙. 由于这些凝结物可以有效阻止等离子体内部活性自由基的扩散, 起到保护材料的作用. 如图10(b)所示, 当温度降低到–110 ℃以下时, 刻蚀过后材料的介电常数很小(接近原始k值), 由此实现了多孔材料的无损刻蚀. 但是在垂直的刻蚀方向上, 这些凝结物仍需要由等离子体移除, 因此等离子体的刻蚀速率有所减小.
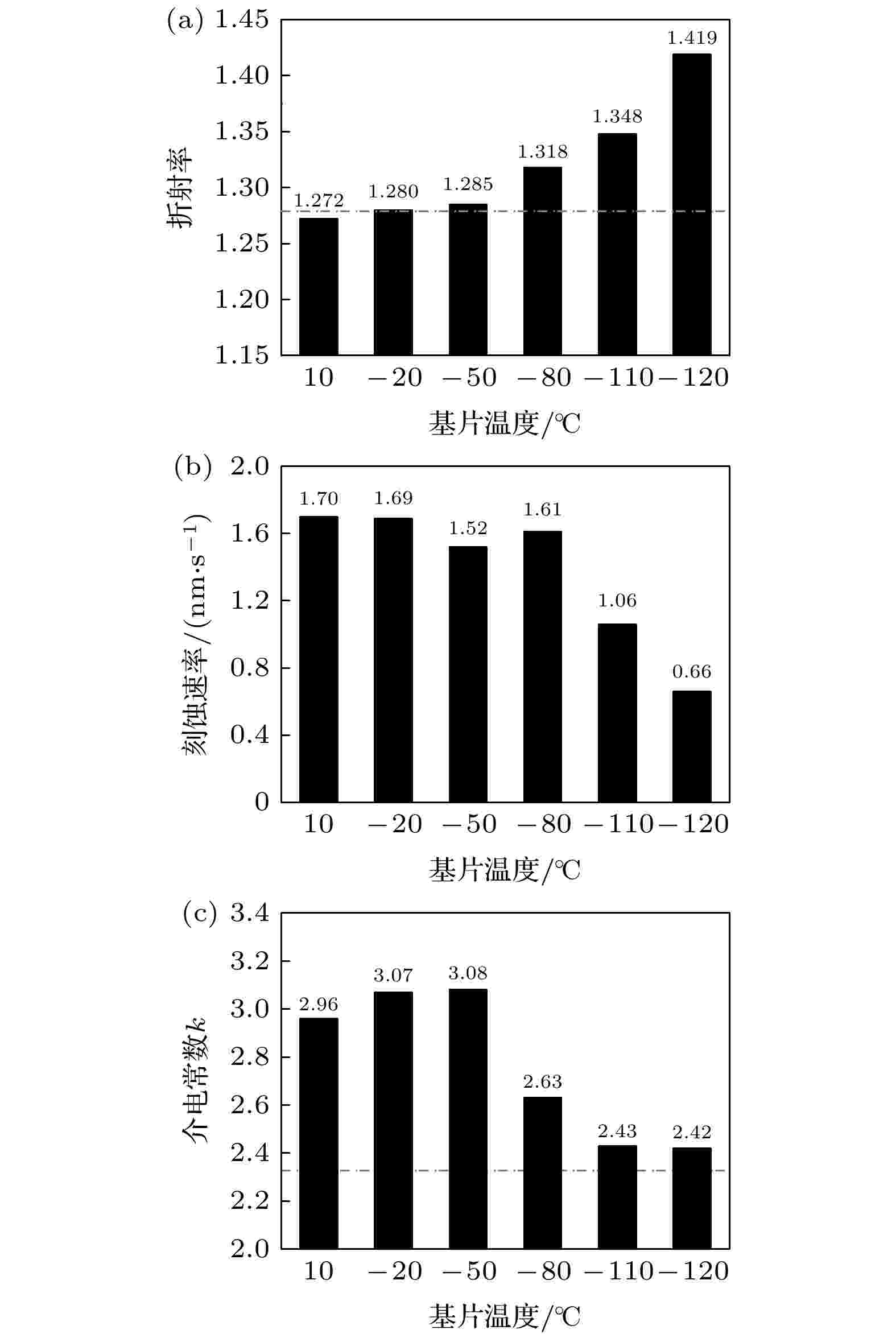 图 10 C4F8/SF6等离子体刻蚀多孔材料 (a)折射率; (b)刻蚀率; (c)介电常数k[14]
图 10 C4F8/SF6等离子体刻蚀多孔材料 (a)折射率; (b)刻蚀率; (c)介电常数k[14]Figure10. Plasma etch results with mixture of C4F8/SF6 at different chuck temperature: (a) Refractive index; (b) etching rate; (c) k value[14].
尽管C4F8/SF6混合气体可以实现预期的低温刻蚀效果, 但是其对基片的温度要求仍极为苛刻, 实现–110 ℃的低温不仅对刻蚀机台是个挑战, 且需要较长液氮处理时间, 这会降低工艺生产效率. 为此, IMEC进一步研制了一种新的工艺气体HBPO(high boiling point organic), 以实现在较高温度下的液化效果[16]. 图11对比了几种气体在低温下在多孔材料内部的凝结效果(对应材料折射率), 可以看出, HBPO气体在–50 ℃左右即可近似实现C4F8气体在–120 ℃附近温度的效果.
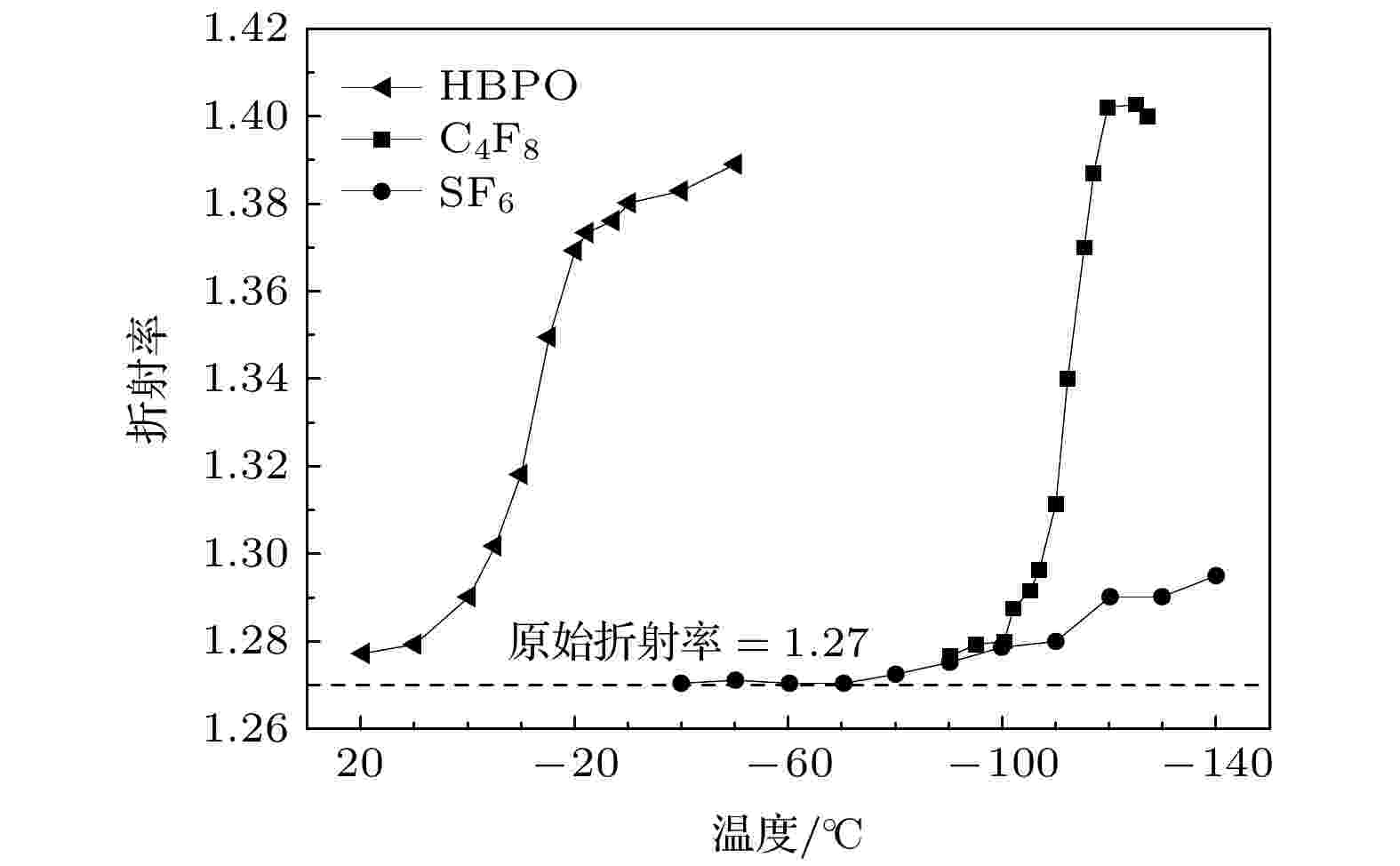 图 11 多孔材料内部分别充入HBPO, SF6和C4F8气体后, 在不同温度下的折射率(反应气体的凝结比例)[16]
图 11 多孔材料内部分别充入HBPO, SF6和C4F8气体后, 在不同温度下的折射率(反应气体的凝结比例)[16]Figure11. Refractive index of porous material at various chuck temperature in HBPO, SF6 and C4F8 gas[16].
他们进一步检验了不同基片温度下, 等离子体刻蚀多孔材料后的介电常数[16]. 如图12所示, 室温时材料k值最高, 表征相当程度的材料损伤. 随着基片温度的降低, 材料的k值一直在减小, 即低温凝结逐渐起到保护材料的作用. 当基片温度在–50 ℃时, 材料的介电常数十分接近刻蚀之前的k值, 意味着实现了近乎无损的多孔材料刻蚀效果. 由此可见, 放电气体的选取对于推广低温刻蚀工艺技术是十分重要的.
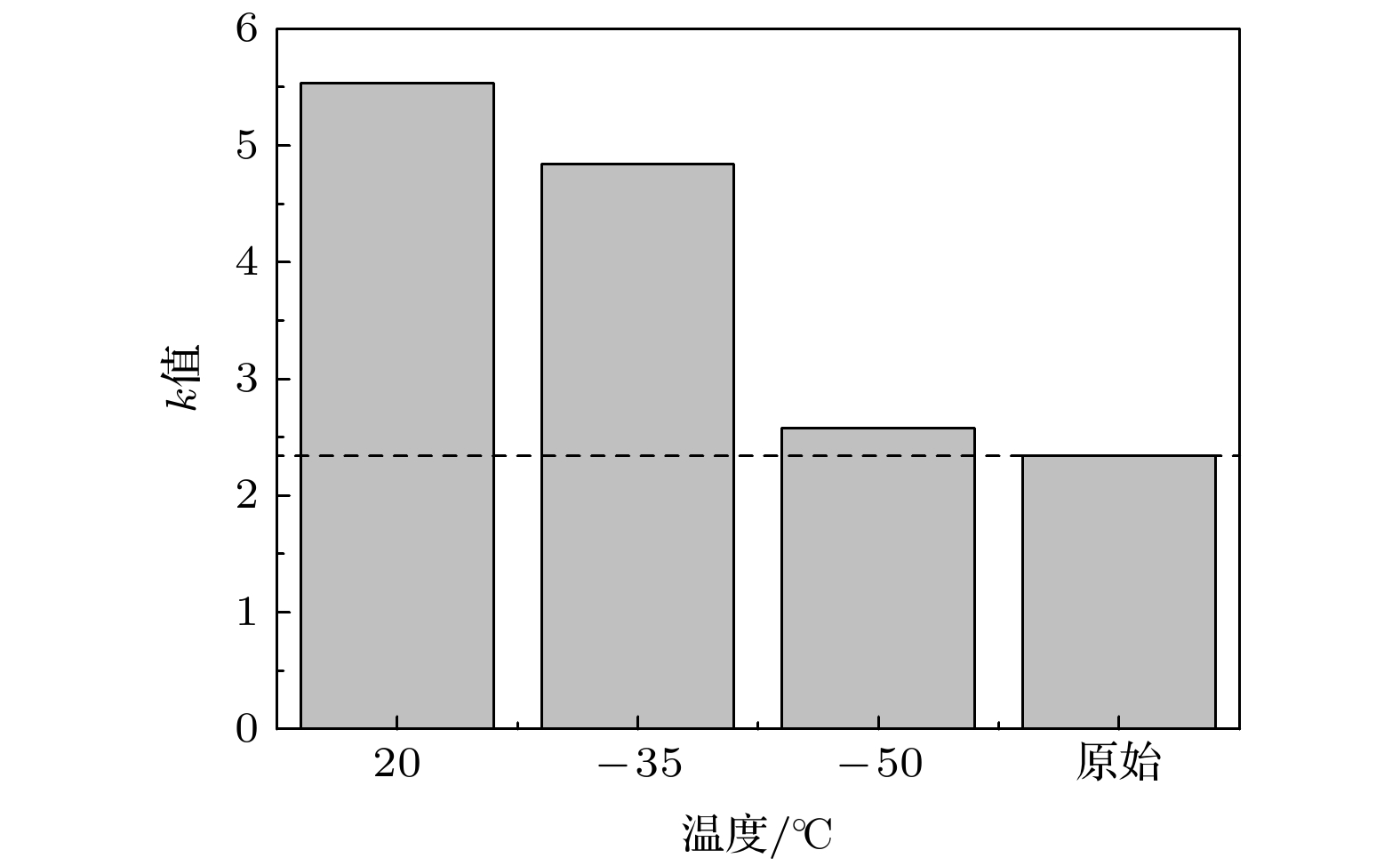 图 12 不同温度下, HBPO等离子体刻蚀多孔材料后的介电常数[16]
图 12 不同温度下, HBPO等离子体刻蚀多孔材料后的介电常数[16]Figure12. k value of porous material after HBPO plasma etching at various chuck temperature[16].
为丰富工艺气体的选择可能性, IMEC进一步尝试对比了多种工艺气体(合成气体)的低温刻蚀效果[18]. 图13列出了多种工艺气体在不同温度下, 刻蚀多孔材料的刻蚀速率和介电常数k值. 通过对比可以发现, HBPO, Mikado和Sumida三种气体分别在–50, –55和–60 ℃时进行的等离子体刻蚀, 可实现较为接近材料原始k值(2.31)的效果, 表征近乎无损刻蚀的实现.
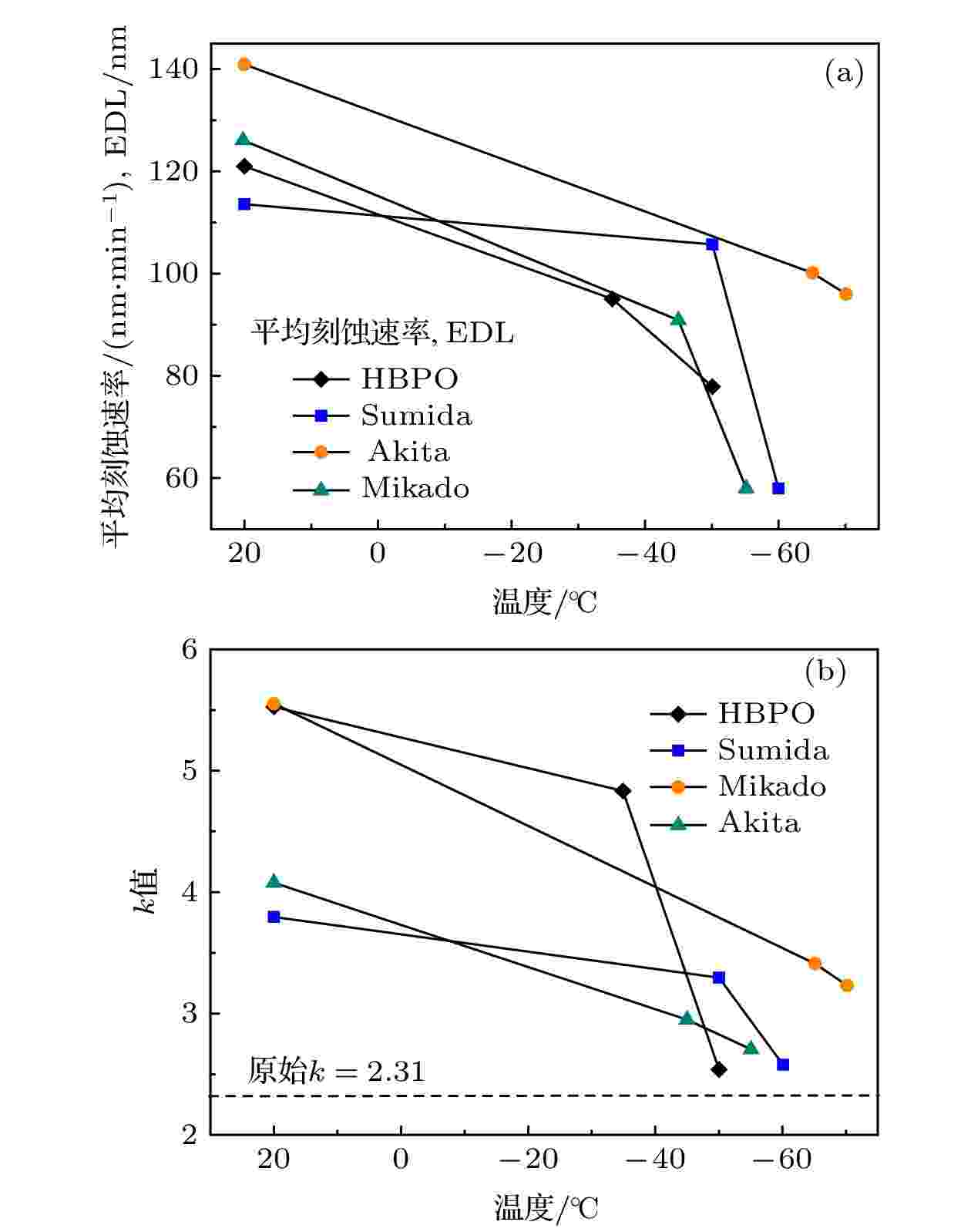 图 13 多种工艺气体在不同温度下, 对多孔材料刻蚀过程中的刻蚀率和介电常数k值[18]
图 13 多种工艺气体在不同温度下, 对多孔材料刻蚀过程中的刻蚀率和介电常数k值[18]Figure13. Etching rate and k value of porous material for different gas discharge as a function of chuck temperature[18].
前面的研究内容皆为实验结果, 且缺少低温基片对等离子体状态影响的研究. 因此, 本课题组利用Kushner等[20,21]开发的HPEM混合模型(流体耦合蒙特卡罗模型)[22,23], 模拟研究了低温基片对等离子体(SF6/C4F8)放电特征和材料刻蚀效果的影响[24]. 模型首先求解流体模型(求解粒子连续性方程, 能量和动量守恒方程), 计算等离子体腔室内的放电过程, 得到等离子体密度、温度等宏观参数, 再耦合离子蒙特卡罗模型(模拟一定量带电粒子运动和碰撞过程), 输出带电粒子和活性自由基到达基片表面的通量和能量分布. 进一步将这些物理量作为输入量, 导入表面刻蚀模型, 通过耦合大量的自由基与材料表面之间的化学反应(包含刻蚀挥发和沉积过程), 实现等离子体刻蚀过程的模拟(包含刻蚀剖面和刻蚀速率的演化过程).
图14所示是不同温度下, 模拟的刻蚀剖面[24]. 图中红色代表材料损伤, 黄色代表凝结液化的C4F8, 灰色代表多孔材料, 黑色是衬底(即空白). 在–50 ℃时, 由于C4F8还没有凝结, 材料损伤很大. 在–95— –104 ℃之间温度时, 材料内部开始凝结很大一部分C4F8 (黄色物质增多), 其对材料起到了一定的保护作用, 但是由于材料表面并没有完全被液化的C4F8覆盖, 因此少量等离子体自由基仍可以向材料内部扩散, 造成损伤. 但是当温度降低到–110 ℃以下, 材料内部几乎被凝结的C4F8填充, 材料损伤降到最低. 由于凝结的C4F8也需要由等离子体移除, 这会降低刻蚀速率.
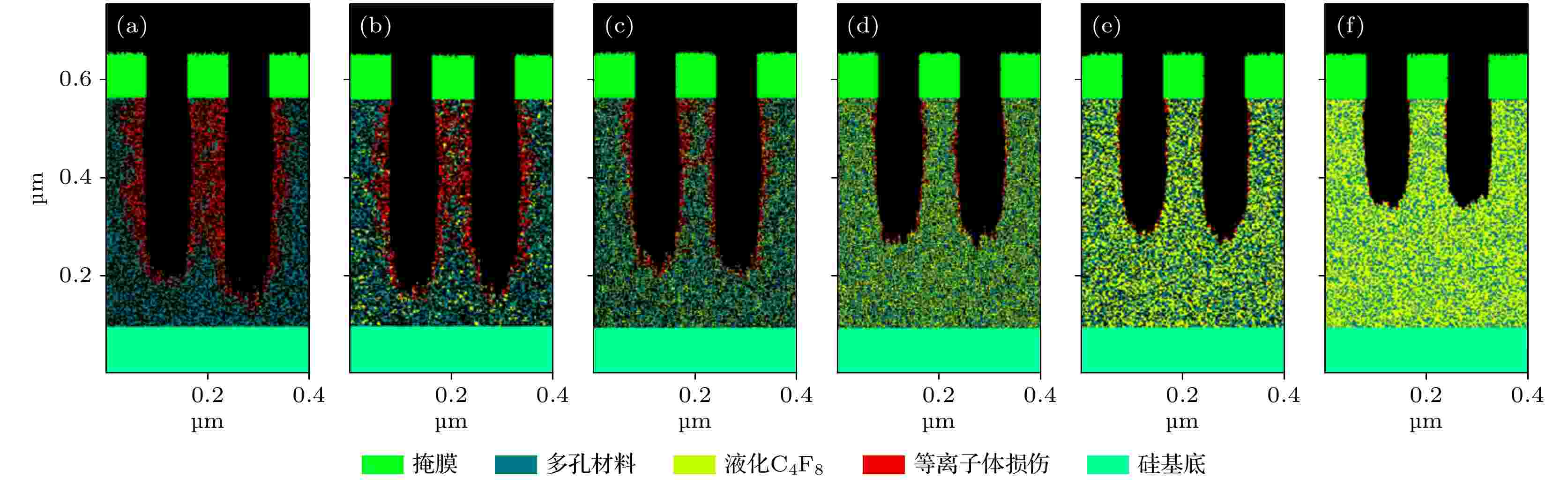 图 14 计算得到的不同温度下的刻蚀轮廓 (a) –50 ℃; (b) –95 ℃; (c) –104 ℃; (d) –110 ℃; (e) –115 ℃; (f) –120 ℃[24]
图 14 计算得到的不同温度下的刻蚀轮廓 (a) –50 ℃; (b) –95 ℃; (c) –104 ℃; (d) –110 ℃; (e) –115 ℃; (f) –120 ℃[24]Figure14. Etching profiles at various chuck temperature: (a) –50 ℃; (b) –95 ℃; (c) –104 ℃; (d) –110 ℃; (e) –115 ℃; (f) –120 ℃[24].
图15进一步给出了不同基片温度下刻蚀轮廓的演化过程[24]. 在–50℃温度下, 由于C4F8没有凝结, t1时刻就产生一定程度的刻蚀损伤, 随着刻蚀的纵向进行, 刻蚀损伤也在横向发展, 直到t3时刻中间结构几乎被损伤殆尽. 在–104 ℃温度下, 部分C4F8凝结在材料内部, 形成一定的保护作用, 因此在t1时刻, 几乎没有材料损伤发生, 刻蚀在离子辅助轰击的作用下, 仍可以向下进行. 然而, 随着时间的推进, 由于材料并没有完全被凝结的C4F8保护起来, 仍有部分自由基可以缓慢向材料内部扩散, 造成一定的损伤. 在–120 ℃温度下, C4F8几乎完全凝结在材料内部, 自由基的横向扩散被完全阻隔, 因此3个时刻的刻蚀损伤几乎为零. 以上的模拟过程, 可以清晰地观测到自由基的扩散和等离子体损伤的过程以及低温保护机制.
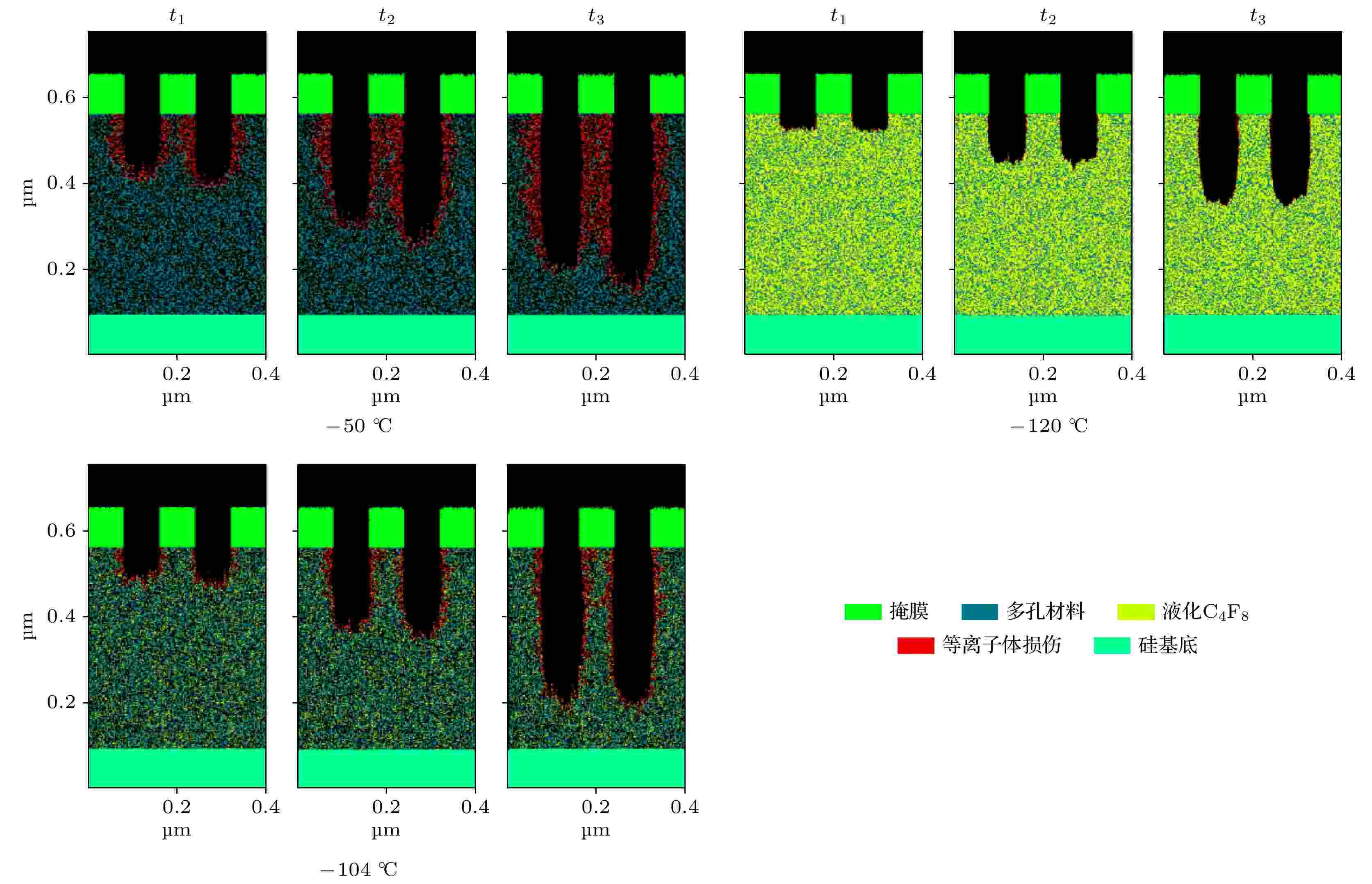 图 15 不同基片温度(–50, –104, –120 ℃)下3个时刻(t1, t2, t3)的刻蚀轮廓[24]
图 15 不同基片温度(–50, –104, –120 ℃)下3个时刻(t1, t2, t3)的刻蚀轮廓[24]Figure15. Evolution of etching profiles at various chuck temperature (–50, –104, –120 ℃)[24].
为确认模型的准确性, 图16给出了相应放电参数下的等离子体刻蚀实验结果[24]. 如图16(a)和图16(b)所示, 在–50 ℃温度下刻蚀材料后, 由于材料内部受到大量等离子体损伤, 导致刻蚀结构近乎完全被dHF酸腐蚀. 而在–110 ℃温度下, 由于低温导致C4F8大量凝结成液态并附着在材料表面, 保护材料免受损伤, 在被浸到dHF酸溶液后, 刻蚀结构仍保持完整. 这与图14中的模拟结果一致.
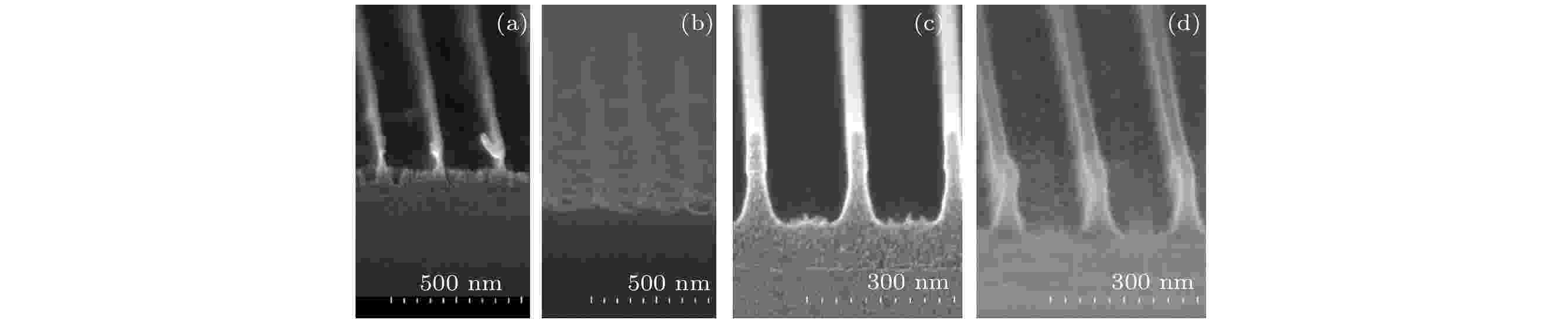 图 16 SF6/C4F8等离子体刻蚀多孔材料的截面结构 (a) –50 ℃刻蚀后结构; (b) –50 ℃刻蚀后浸到dHF酸溶液30 s; (c) –110 ℃刻蚀后结构; (d) –110 ℃刻蚀后浸到dHF酸溶液30 s[24]
图 16 SF6/C4F8等离子体刻蚀多孔材料的截面结构 (a) –50 ℃刻蚀后结构; (b) –50 ℃刻蚀后浸到dHF酸溶液30 s; (c) –110 ℃刻蚀后结构; (d) –110 ℃刻蚀后浸到dHF酸溶液30 s[24]Figure16. Cross-sectional images of narrow spacing trench profiles: (a) –50 ℃, after plasma etching; (b) –50 ℃, after plasma etching and 0.5% dHF dip 30 s; (c) –110 ℃, after plasma etching; (d) –110 ℃, after plasma etching and 0.5% dHF dip 30 s [24].
进一步模拟了不同基片温度对等离子体状态的影响. 图17所示是不同基片温度对应的感性耦合放电中的等离子体空间分布和轰击到基片上的离子能量分布[24]. 感性耦合放电会在线圈附近诱发很强的环向交变电场, 这一电场平行于腔室侧壁, 可以长时间加速电子而不损失到侧壁, 因此线圈附近的功率耦合效率最高, 等离子体密度也是最高的. 等离子体由线圈附近逐渐向下方的腔室扩散, 并到达底部的基片(如图17(a)、图17(b)、图17(d)、图17(e)). 此外, 如图17(c)和图17(f)所示, 基片电极上的射频功率源会在电极上诱导出自偏直流电压和直流鞘层, 加速离子到很高的能量轰击基片, 这些离子入射角度很小, 可以实现定向的离子轰击辅助刻蚀效果.
 图 17 低温刻蚀–50 ℃时, (a) F密度分布, (b) C2F4自由基分布, (c)离子能量分布; 低温刻蚀–120 ℃时, (d) F密度分布, (e) C2F4自由基分布, (f)离子能量分布[24]
图 17 低温刻蚀–50 ℃时, (a) F密度分布, (b) C2F4自由基分布, (c)离子能量分布; 低温刻蚀–120 ℃时, (d) F密度分布, (e) C2F4自由基分布, (f)离子能量分布[24]Figure17. Calculated (a) and (d) F atom density (in cm–3), (b) and (e) C2F4 molecule density (in cm–3), and (c) and (f) normalized ion energy and angular distributions, at –50 ℃ (a)–(c) and –120 ℃ (d)–(f)[24]
通过对比两个基片温度情况, 可以清晰看到当温度由–50 ℃降到–120 ℃后, 基片附近的F密度和C2F4密度均有升高(图17(a)、图17(b)、图17(d)、图17(e)), 这是由于根据理想气体方程(

此外, 基片温度对等离子体放电过程也会产生一定影响, 这种影响会最终反过来调制刻蚀效果. 当基片温度降低, 基片附近的中性气体浓度会升高, 诱导更高的碰撞概率, 调制轰击到基片表面的粒子通量和能量, 进而影响刻蚀效果. 实际工艺优化中, 不能忽略基片刻蚀温度与等离子体状态之间的相互影响.
