全文HTML
--> --> -->1/f低频噪声(flicker noise)指的是半导体器件功率谱密度随频率增大而减小的随机涨落现象, 其对半导体材料与器件中潜在的缺陷很敏感. 自从1925年1/f噪声被首次观察到后, 1/f噪声测量就一直作为电子器件以及线路低频噪声的主要研究手段. 利用低频噪声测量, 可以对界面处陷阱的能量以及空间分布进行分析[7-10], 对半导体器件在各种外加条件下的退化过程进行表征. 近几年的相关研究结果显示, 半导体器件中1/f噪声的幅值与器件的可靠性有密切关系. 因此, 通过分析半导体器件中的1/f噪声可以对半导体器件的可靠性进行预测和评估. 1/f噪声测量作为一种非破坏性的半导体器件可靠性表征手段, 已经被大量用于BJT, MOS, GaN以及半导体激光器等器件的无损评价和筛选中[11-13].
目前, 国内外的研究人员针对AlGaN/GaN HEMT器件在辐照环境下电学参数退化进行了大量理论与试验研究. 2019年Zheng等[14]对GaN HEMT器件开展了60Co γ射线辐照试验, 指出栅偏置会对器件的退化产生影响; 2016年Smith等[15]开展了AlGaN/GaN HEMT器件的60Co γ射线总剂量辐照试验, 指出器件在关态下表现出高的稳定性; 2017年Bhuiyan等[16]针对以氧化物为栅介质的MOS-HEMT器件开展了总剂量响应研究, 指出氧化物能提高器件的抗辐照性能. 虽然之前研究者的工作包括了器件制备工艺、结构尺寸以及辐照期间的偏置设置等对AlGaN/GaN HEMT器件辐照性能的影响, 但关于辐照前后低频噪声特性变化却鲜有报道. 因此开展AlGaN/GaN HEMT器件60Co γ射线总剂量辐照与低频噪声相关性的研究很有必要. 工作的开展为AlGaN/GaN HEMT器件抗辐照加固、无损伤评价和筛选提供方法补充.
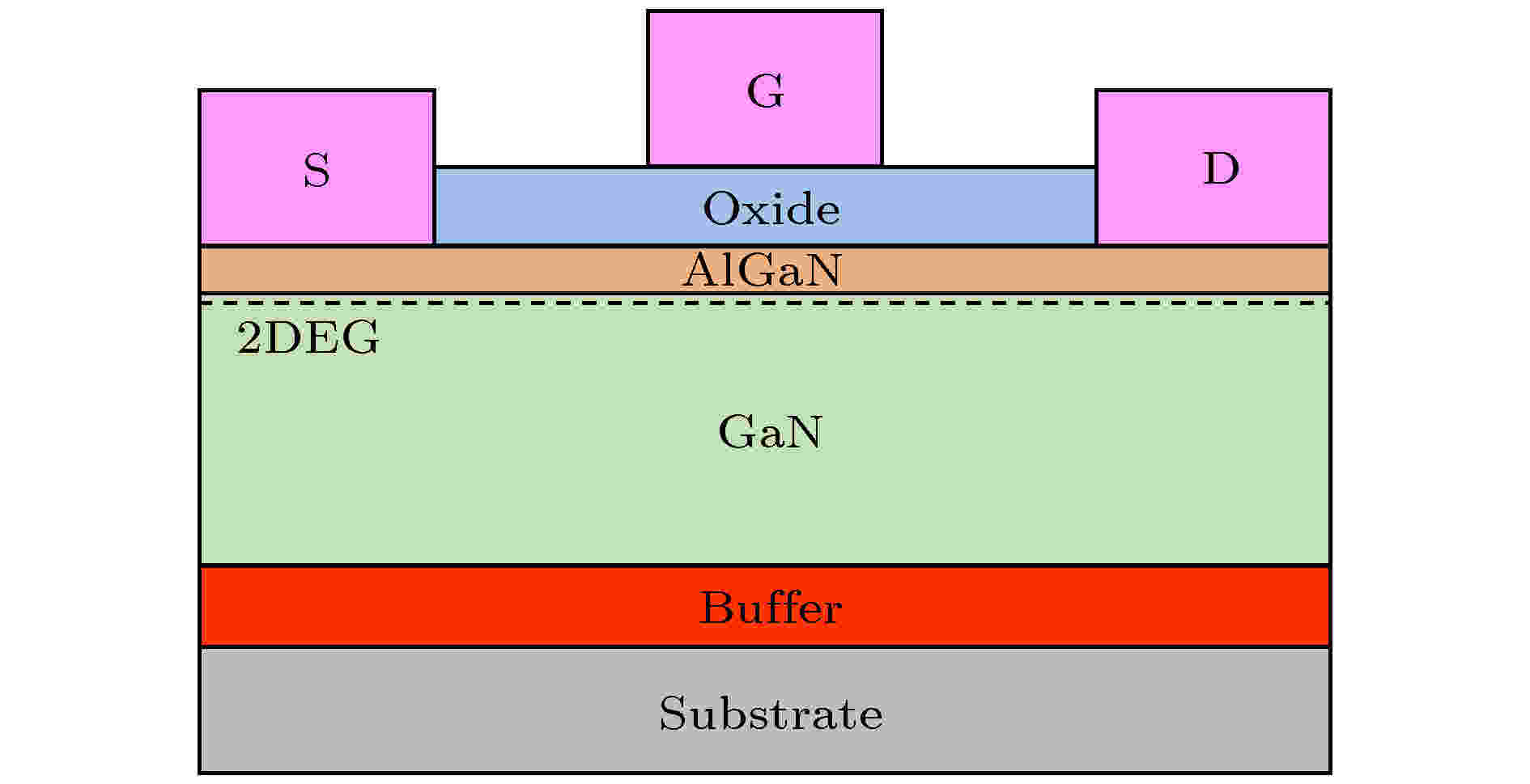 图 1 AlGaN/GaN HEMT器件的剖面图
图 1 AlGaN/GaN HEMT器件的剖面图Figure1. AlGaN/GaN HEMT devices’ cross-section.
AlGaN/GaN HEMT器件的总剂量实验是在中国科学院新疆理化技术研究所的60Co γ射线辐照实验源上进行的, 选择的剂量率为297.29 rad(Si)/s, 实验中对器件设置了三种偏置, 如表1所列.
| VGS/V | VDS/V | |
| 关态(OFF) | –3.0 | 0.5 |
| 半开态(SEMI-ON) | –1.9 | 0.5 |
| 零偏(zero-bias) | 0 | 0 |
表1AlGaN/GaN HEMT器件辐照实验偏置设置
Table1.The biases set of AlGaN/GaN HEMT device irradiation experiment.
本文实验所选取的剂量点分别为80 krad(Si), 200 krad(Si), 300 krad(Si), 500 krad(Si)和1 Mrad(Si). 器件辐照后的电学特性测试均在实验结束后1 h内完成, 直流电参数测试在半导体参数分析仪Agilent B1500, BC 3193和Keithley 4200上进行.
实验采用低频噪声测试系统对AlGaN/ GaN HEMT器件辐照前后的低频噪声特性进行了测量.
每单位频率所携带的功率被称为功率谱密度(power spectral density, PSD), 通常情况下可由信号的频率密度乘以一个适当的系数后得到. 通过对噪声功率谱的测量, 可以对噪声信号的能量随频率的分布情况进行描述, 如低频噪声的功率谱密度随频率的增大而减小.
AlGaN/GaN HEMT器件低频噪声测量系统如图2所示. 该系统使用半导体参数测试仪Agilent B1500的SMU单元监控AlGaN/GaN HEMT器件的电学参数变化, 使用SR785频谱分析仪测量AlGaN/GaN HEMT器件沟道电流的噪声功率谱密度, 用Proplus 9812B噪声测量系统的滤波与低频噪声放大单元[17].
 图 2 AlGaN/GaN HEMT器件的低频噪声测量系统[17]
图 2 AlGaN/GaN HEMT器件的低频噪声测量系统[17]Figure2. AlGaN/GaN HEMT devices’ low frequency noise measurement system.
3.1.AlGaN/GaN HEMT器件电离辐照敏感参数
对所有偏置下器件辐照前后的直流参数进行分析对比, 发现器件的直流参数均有明显的退化. 辐照前后零偏条件下功率AlGaN/GaN HEMT器件的输出特性曲线和转移特性曲线如图3所示.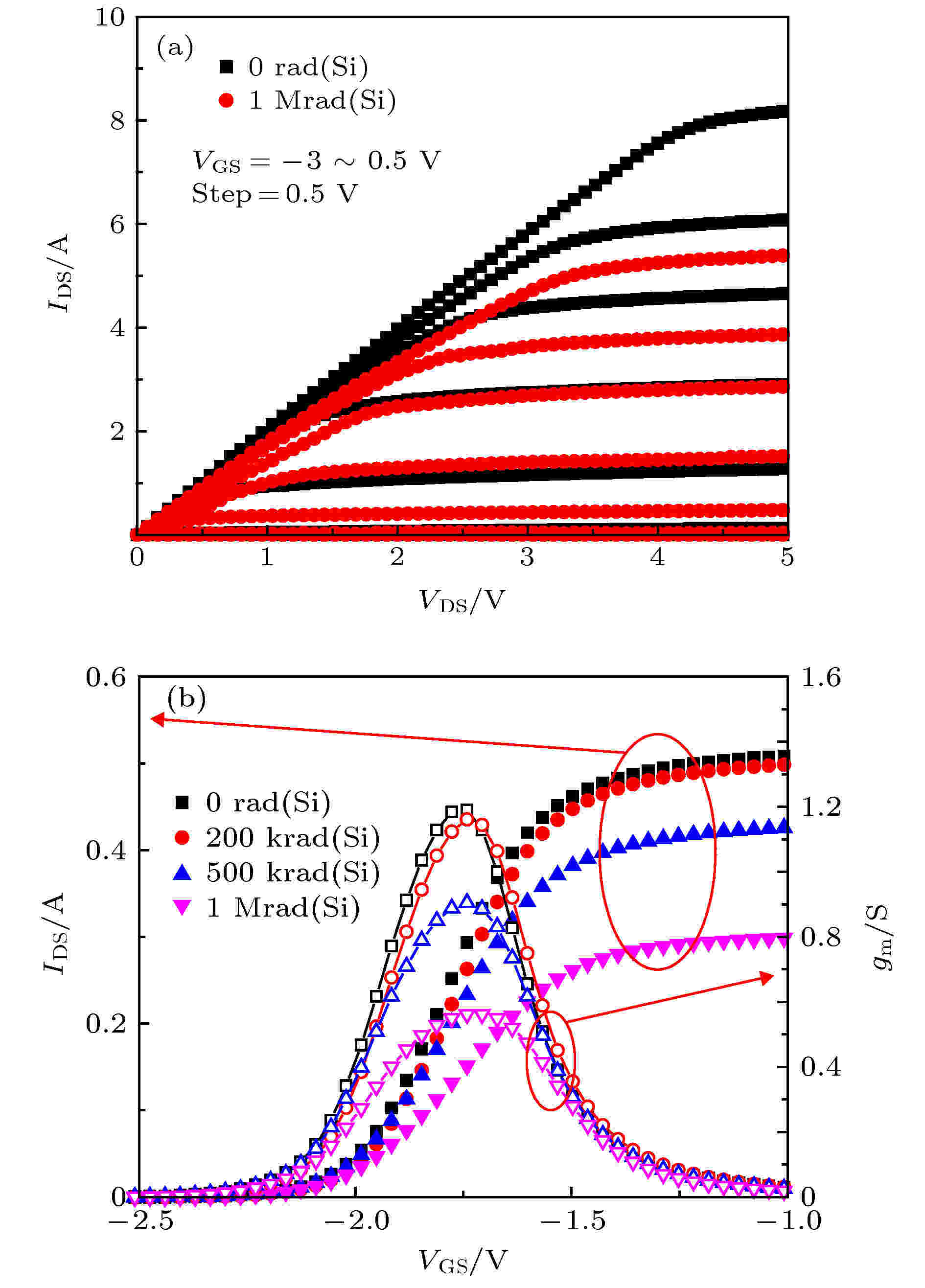 图 3 零偏下AlGaN/GaN HEMT器件辐照前后输出特性曲线(a)与转移特性曲线(b)
图 3 零偏下AlGaN/GaN HEMT器件辐照前后输出特性曲线(a)与转移特性曲线(b)Figure3. The output characteristic curve (a) and transfer characteristic curve (b) of the AlGaN/GaN HEMT device before and after irradiation under the zero-bias.
从输出特性曲线提取的栅压VGS = 0 V时所有偏置下AlGaN/GaN HEMT器件辐照前后的饱和漏电流


| 关态(OFF) | 半开(SEMI-ON) | 零偏(zero-bias) | |
| ΔIDSsat/% | –26.00 | –31.42 | –36.28 |
| Δgmmax/% | –22.86 | –34.58 | –52.94 |
表2不同偏置下AlGaN/GaN HEMT器件辐照前后饱和漏电流与最高跨导的变化
Table2.Variation of saturation drain current and maximum transconductance before and after irradiation in AlGaN/GaNHEMT devices with different biases.
由表2可知, 在零偏下, 辐照后AlGaN/GaN HEMT器件饱和漏电流


从转移特性曲线还提取出了不同偏置下AlGaN/GaN HEMT器件的阈值电压随60Co γ射线辐照剂量的变化情况, 结果表明关态和半开态下AlGaN/GaN HEMT器件的阈值电压在60Co γ射线辐照前后几乎没有变化, 零偏条件下出现了1.5%的正漂, 说明辐照对阈值电压的影响很小. 二维电子气(2-dimensional electron gas, 2 DEG)中的总电荷




AlGaN/GaN HEMT器件的氧化物介质层在γ射线辐照下产生电子-空穴对, 大部分电子很快被扫出栅源和栅漏间隔区对应的氧化物区域, 只有少部分电子和空穴发生复合, 所以大部分空穴留在氧化物内, 在内建电场的作用下缓慢向氧化物与AlGaN界面移动. 同时, γ射线辐照也在器件的栅源和栅漏间隔区产生表面态负电荷, 这些表面态负电荷会对栅源和栅漏间隔区下方对应的2DEG产生一定的耗尽作用, 导致漏和源串联电阻明显增加. 在关态和半开态下, 由于栅电极上加的负压形成的电场远大于器件的内建电场, 所以空穴会向栅电极移动, 不会对栅电极下方对应的界面态产生明显影响, 因而栅电极下面对应沟道的2DEG面密度没有受到γ射线辐照的影响, 阈值电压基本没有发生改变, 如图4(a)所示. 在零偏条件下, 由于栅电极上电压为零, 栅电极下方对应的氧化物在γ射线辐照下产生的电子在内建电场的作用下向栅电极移动并留在栅电极上, 使栅电极表面表现为微弱的负压状态, 阻碍空穴向氧化物-AlGaN界面移动, 但还是有部分空穴移动到氧化物-AlGaN界面, 通过电荷感应对栅电极下方对应沟道的2DEG产生一定的耗尽作用, 如图4(b)所示. 因此零偏条件下, AlGaN/GaN HEMT器件的阈值电压出现了较小的正漂.
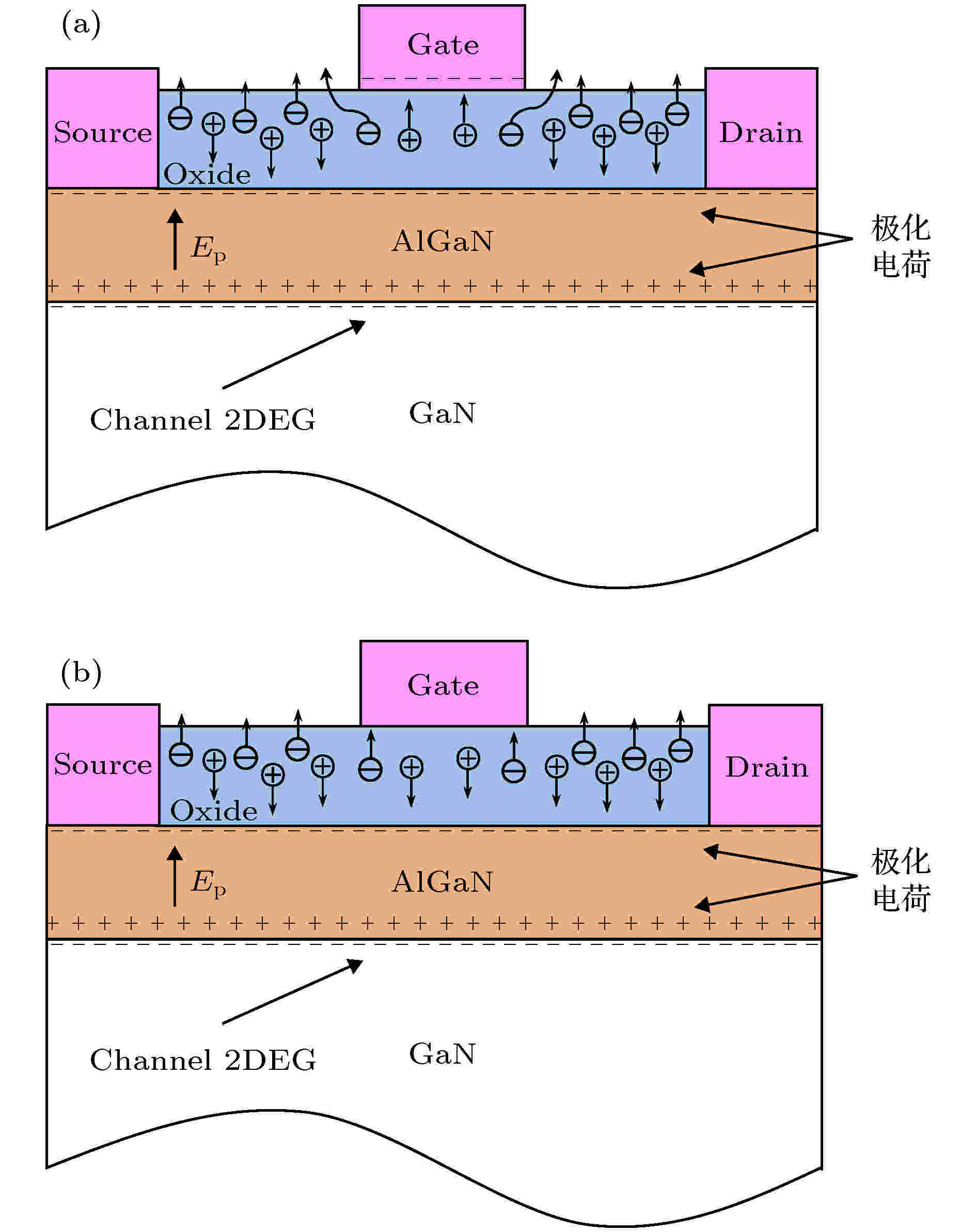 图 4 AlGaN/GaN HEMT器件辐照时的电荷分布图 (a)关态和半开态; (b)零偏
图 4 AlGaN/GaN HEMT器件辐照时的电荷分布图 (a)关态和半开态; (b)零偏Figure4. Charge distribution patterns of AlGaN/GaN HEMT devices: (a) The off and semi-on states; (b) zero-bias.
当栅压处于比较低的水平时, 栅电极下方对应的沟道电阻是构成源漏导通电阻的主要部分, 栅源和栅漏间隔区下方对应的沟道电阻在整个源漏导通电阻中所占的比例比较小, 故在此条件下γ射线辐照对漏极饱和电流影响较小; 而当栅压处于比较高的水平时, 栅下方对应的沟道电阻比较小, 栅源和栅漏间隔区下方对应的沟道电阻在整个源漏导通电阻中所占的比例比较大, 故在此条件下γ射线辐照对漏极饱和电流影响较大. 这就很好地解释了为什么随着栅压的增加, AlGaN/GaN HEMT器件的漏极饱和电流在γ射线辐照下越来越严重[19].
2
3.2.电离辐照对AlGaN/GaN HEMT器件低频噪声特性的影响
在不同偏置条件下, 辐照前后AlGaN/GaN HEMT器件的低频噪声特性(沟道电流

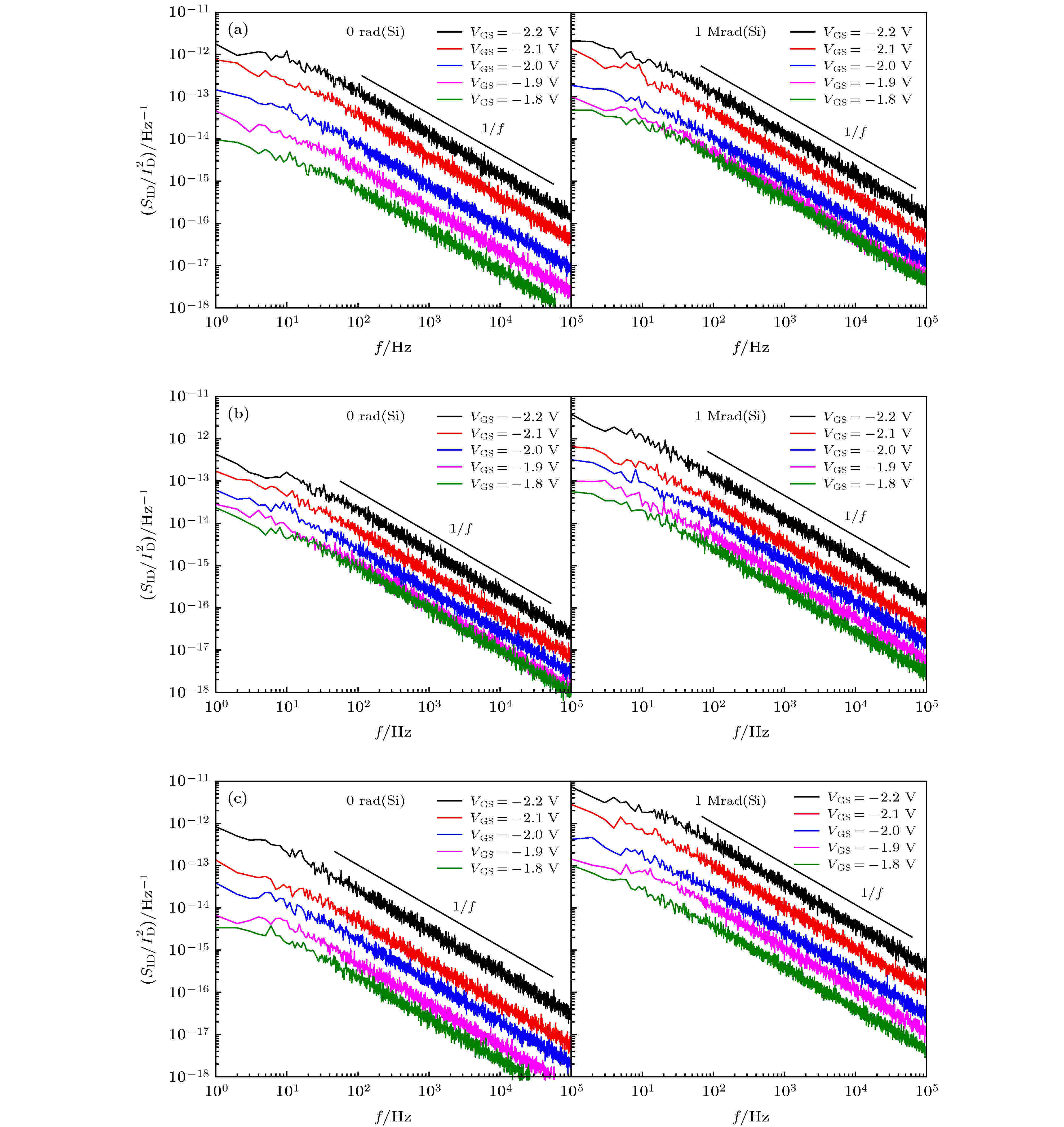 图 5 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度 (a)关态; (b)半开态; (c)零偏
图 5 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度 (a)关态; (b)半开态; (c)零偏Figure5. Normalized channel current noise power spectral density in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias.
由图5可知, AlGaN/GaN HEMT器件辐照前后的沟道电流噪声功率谱密度随频率的变化遵循1/f的变化规律, 满足经典的低频噪声理论. 由文献[20]可知辐照诱生氧化物陷阱是导致AlGaN/GaN HEMT器件性能退化的主要原因. 基于McWhorter模型, AlGaN/GaN HEMT器件的1/f噪声主要是由势垒层内陷阱和缺陷态对载流子的俘获与释放过程产生的载流子随机涨落所引起的. AlGaN/GaN HEMT器件的沟道电流归一化噪声功率谱密度




比较辐照前后AlGaN/GaN HEMT器件的噪声功率密度谱, 不难看出辐照后器件的噪声功率密度谱均出现了增加, 其中关态下噪声功率谱密度增加得最小, 零偏下噪声功率谱密度增加幅度最大. 这是由辐照产生的界面态、表面陷阱和氧化层陷阱电荷共同作用导致的. 辐照后上述的电荷密度增加, 势垒层内的电荷在隧穿机理下的交互行为加剧, 这就会使(2)式中

为了更加深入描述辐照总剂量对氧化层陷阱电荷、界面陷阱等电荷的影响, 需要利用平带电压噪声功率谱密度

基于McWhorter模型, AlGaN/GaN HEMT器件的沟道电流归一化噪声功率密度谱密度与平带电压噪声功率谱密度之间的关系可以表示为[23-27]

当频率在25 Hz时, AlGaN/GaN HEMT器件沟道电流归一化噪声功率谱密度随沟道电压和沟道电流的变化如图6、图7所示. 结合(4)式, 可从图7中提取出不同偏置条件下AlGaN/GaN HEMT器件辐照前后平带电压噪声功率谱密度

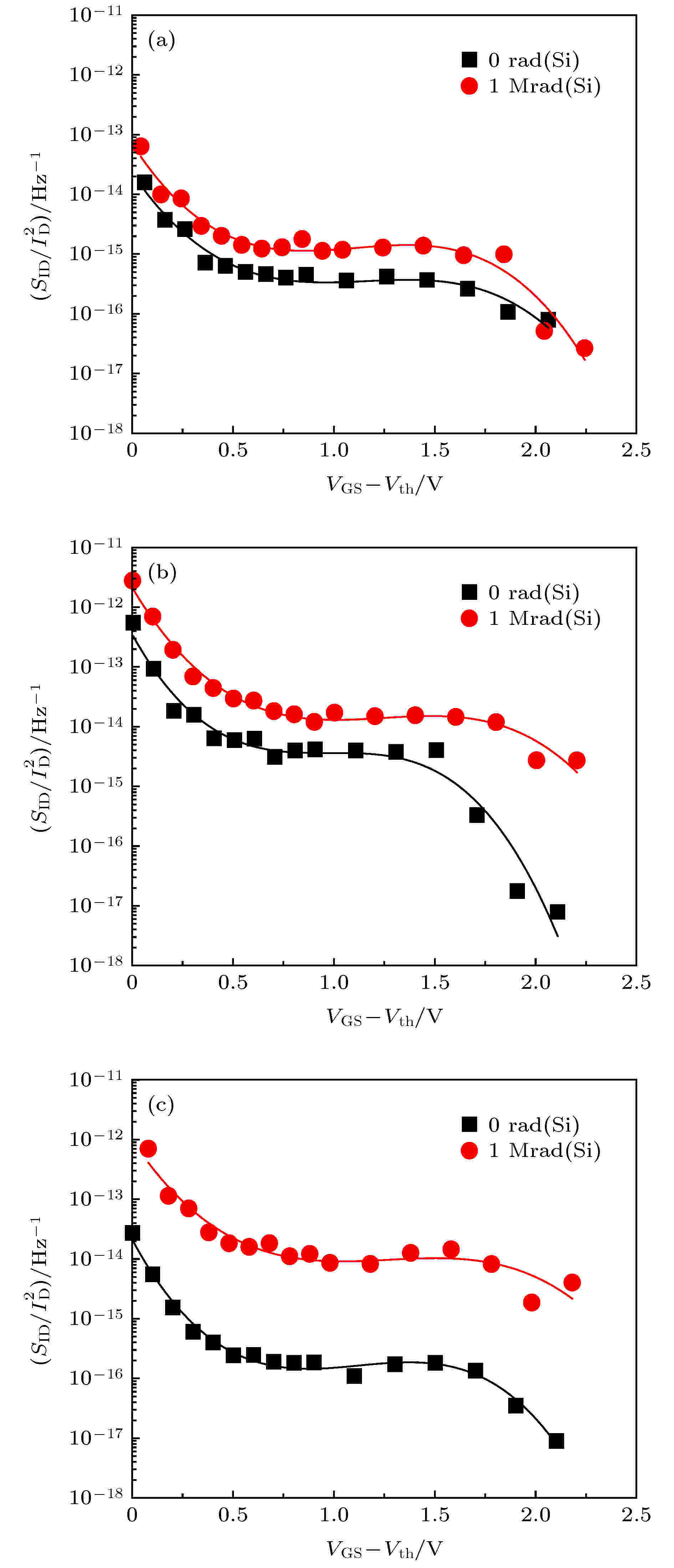 图 6 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度随过驱动电压的变化(点: 测量值; 实线: 拟合值) (a)关态; (b)半开态; (c)零偏
图 6 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度随过驱动电压的变化(点: 测量值; 实线: 拟合值) (a)关态; (b)半开态; (c)零偏Figure6. Normalized channel current noise power spectral density versus overdrive voltage in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias (dot: measured value; continuous line: fitted value).
| 关态 (OFF) | 半开态 (SEMI-ON) | 零偏 (zero-bias) | |
| 0 rad(Si) | 3.20 × 10–14 | 2.65 × 10–14 | 3.18 × 10–14 |
| 1 Mrad(Si) | 4.21 × 10–14 | 3.85 × 10–14 | 5.16 × 10–14 |
表3不同偏置下AlGaN/GaN HEMT器件辐照前后平带电压噪声功率谱密度(单位: V2·Hz–1)
Table3.Flat-band voltage noise power spectral density in the AlGaN/GaN HEMT devices before and after irradiation under different biases (in V2·Hz–1).
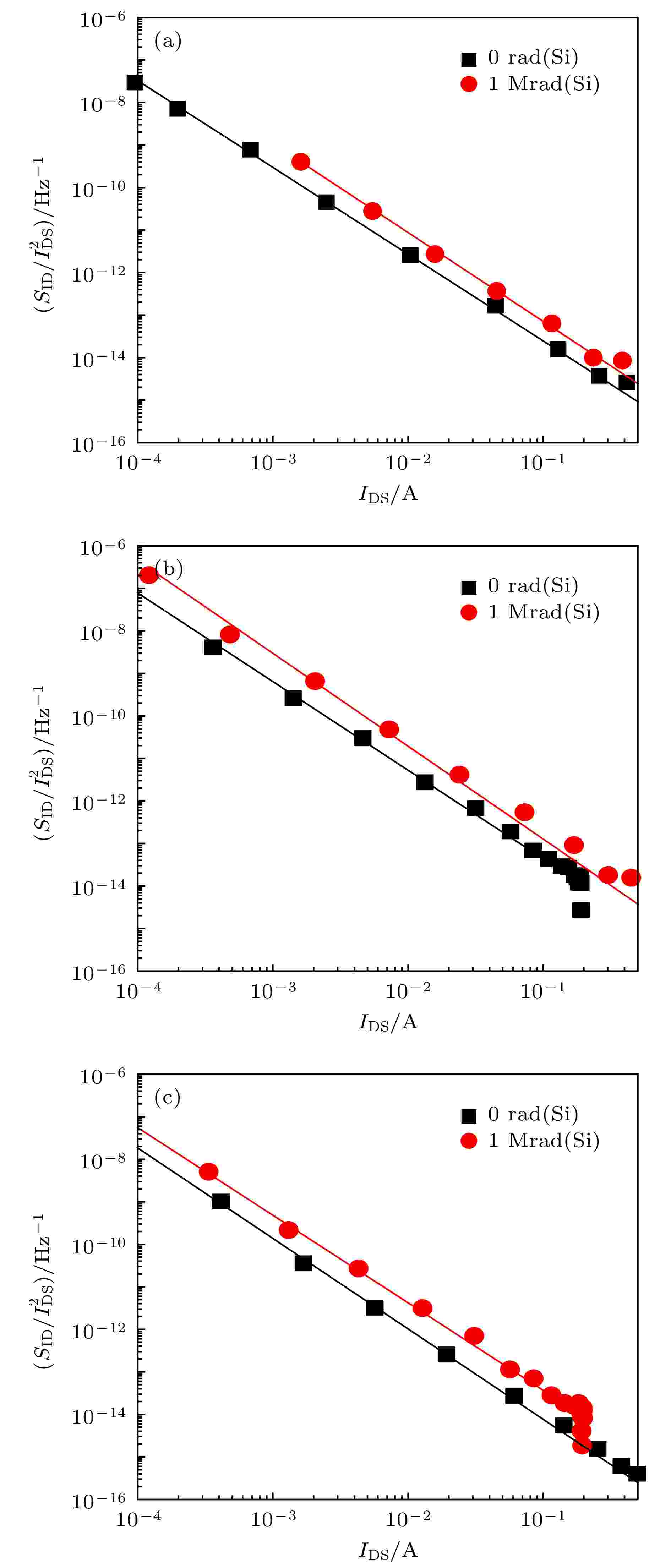 图 7 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度随沟道电流的变化(f = 25 Hz, 点: 测量值; 实线: 拟合值) (a)关态; (b); 半开态; (c)零偏
图 7 AlGaN/GaN HEMT器件辐照前后沟道电流归一化噪声功率谱密度随沟道电流的变化(f = 25 Hz, 点: 测量值; 实线: 拟合值) (a)关态; (b); 半开态; (c)零偏Figure7. Normalized channel current noise power spectral density versus channel current in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias (f = 25 Hz, dot: measured value; continuous line: fitted value).
缺陷密度


| 关态 (OFF) | 半开态 (SEMI-ON) | 零偏 (zero-bias) | |
| 0 rad(Si) | 4.106 × 1017 | 3.400 × 1017 | 4.080 × 1017 |
| 1 Mrad(Si) | 5.402 × 1017 | 4.940 × 1017 | 6.621 × 1017 |
| ΔNt/% | 31.56 | 45.29 | 62.28 |
表4不同偏置下AlGaN/GaN HEMT器件辐照前后缺陷密度(单位: cm–3·eV–1)
Table4.The defect density in the AlGaN/GaN HEMT devices before and after irradiation under different biases (in cm–3·eV–1).
从表4中不难看出, 关态下器件辐照后缺陷密度增加幅度最小, 为31.46%, 零偏下增加幅度最大, 为62.31%. 就本文实验使用的器件而言, 辐照主要是在氧化物层产生缺陷, 上述结果说明60Co γ射线辐照会导致AlGaN/GaN HEMT器件氧化物层中缺陷密度增加, 并且在零偏条件下增加幅度最大, 这一结果与上文中的直流特性分析十分符合.
基于电荷隧穿机理, AlGaN/GaN HEMT器件中低频噪声的主要来源是氧化物层内陷阱对载流子的俘获与释放过程. 由于电荷在氧化物层内的隧穿距离受时间常数


利用(5)式和(6)式, 结合图5, 可以获得AlGaN/GaN HEMT器件辐照前后势垒层内部陷阱电荷的空间分布情况, 如图8所示. 从图8中可知, 辐照后AlGaN/GaN HEMT器件氧化物层内的陷阱电荷密度均明显增加了, 且零偏下增加幅度最大, 这与辐照诱生氧化物层固定电荷等理论很好符合. 使用1/f低频噪声的电学表征手段, 可以对辐照前后AlGaN/GaN HEMT器件氧化物层中缺陷电荷的变化进行定量描述, 为器件抗辐照加固的评价与考核, 以及无损筛选提供一种新的表征方法.
 图 8 AlGaN/GaN HEMT器件辐照前后势垒层内陷阱电荷密度的空间分布 (a)关态; (b)半开态; (c)零偏
图 8 AlGaN/GaN HEMT器件辐照前后势垒层内陷阱电荷密度的空间分布 (a)关态; (b)半开态; (c)零偏Figure8. Extracted spatial distribution of trapped charges in the AlGaN/GaN HEMT devices’ barrier layer: (a) OFF state; (b) SEMI-ON state; (c) zero-bias.
