全文HTML
--> --> -->虽然锗和硅基锗光电探测器经过几十年的发展, 已经取得了很大的进展[10]. 然而由于锗材料高的表面态密度和较窄的禁带宽度, 锗光电探测器往往有着较高的暗电流, 探测率等性能受到一定影响[11]. 报道较多的P-本征-N(P-intrinsic-N, PIN)型和金属-半导体-金属 (metal-semiconductor-metal, MSM)型锗光电探测器暗电流密度一般在10—102 mA/cm2范围内[12-17]. 锗雪崩型光电探测器虽然由于其具有内部增益而具有高的响应度, 但制作工艺复杂, 且需要在高偏压下工作[18]. 因此, 寻求简单又有效的方法减小锗探测器暗电流、提高其探测率仍具重要的意义. 金属-绝缘体-半导体结构之前已经被证实可以提升探测器性能, 其使用较厚(60 nm)的MgO作为介质插层, 增益表现为绝缘层中碰撞离化导致的载流子倍增[19,20]. 而近期, 笔者课题组提出采用极薄(1—3 nm)金属氧化物介质层调制ITO与锗接触势垒高度的方法, 研制出具有较低暗电流和高响应度的锗肖特基结光电探测器[21]. 本文工作是前期工作的延续和拓展, 使用两种不同掺杂浓度的锗, 以及硅基外延锗材料制作肖特基结光电探测器, 分别比较了2 nm厚Al2O3和MoO3介质层作为插入层对锗肖特基光电探测器性能的影响, 并讨论了其作用机理.
采用原子力显微镜测试样品的表面形貌和粗糙度. 图1分别给出了i-Ge衬底及在其上沉积了2 nm厚的Al2O3, MoO3的原子力显微镜图以及肖特基光电探测器结构示意图. 介质层厚度选取2 nm是考虑其对势垒高度调制作用和引入串联电阻等因素后优化的结果[19]. 图1(a)—(c)分别为本征锗及其上沉积2 nm厚MoO3和Al2O3原子力显微镜图, 表面粗糙度分别为0.27, 0.25和0.28 nm, 表明制备的氧化层表面平整光滑. 图1(d)为ITO/ Al2O3(或MoO3)/Ge肖特基光电探测器结构示意图. 采用透明导电电极ITO是为了避免使用金属电极对入射光的反射和吸收损失, 提高器件的响应度. ITO作为一种透明导电薄膜, 拥有很高的可见光和近红外光透光率, 且其透光率与生长条件和厚度有关[22], 本实验室利用磁控溅射生长的110 nm的ITO薄膜在1310 nm及1550 nm波段透光率达到80%以上[23]. 为了对比超薄介质层对器件的影响, 还制备了未生长介质插层的ITO/Ge光电探测器.
 图 1 10 μm × 10 μm原子力显微镜图 (a) 本征锗表面; (b) MoO3(2 nm)/i-Ge; (c) Al2O3(2 nm)/i-Ge; (d) ITO/介质层/Ge光电探测器结构示意图
图 1 10 μm × 10 μm原子力显微镜图 (a) 本征锗表面; (b) MoO3(2 nm)/i-Ge; (c) Al2O3(2 nm)/i-Ge; (d) ITO/介质层/Ge光电探测器结构示意图Figure1. AFM images with a scanned area of 10 μm × 10 μm: (a) Bare i-Ge; (b) MoO3 (2 nm)/i-Ge; (c) Al2O3(2 nm)/i-Ge; (d) schematic illustration of the ITO/dielectric-layer/Ge photodetector.
采用Keithley 2635B作为源表测试了探测器的伏安(I-V)特性. 光电测试则是采用了波长分别为1310 nm和1550 nm的两种功率可调激光器作为光源. 光源经光纤耦合引入显微镜, 再聚焦到器件的电极表面. 同时, 使用261标准探测器对所用到的激光光源都进行了功率校准. 在单点成像方面, 利用水平方向的xy轴平移平台, 以一个器件直径(金相显微镜下测量器件直径约为350 μm)为步长做机械移动, 进行了共计25个像素点的光电测试.
 图 2 探测器在不同激光功率(1310 nm)照射下的I-V曲线与暗电流曲线对比 (a) ITO/Al2O3/n-Ge; (b) ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epi
图 2 探测器在不同激光功率(1310 nm)照射下的I-V曲线与暗电流曲线对比 (a) ITO/Al2O3/n-Ge; (b) ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epiFigure2. Photocurrent and darkcurrent of the detectors measured under illumination by a 1310 nm laser at different powers: (a) ITO/Al2O3/n-Ge; (b) ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epi.
使用波长1310 nm的可变功率激光器对探测器进行了光电流测试, 在不同激光功率照射下, 各类探测器的光电流均随着光功率的增强而增大. 对比每一组不同类型锗光电探测器光电流的大小, 可以看到, 虽然插入Al2O3介质层后暗电流有显著降低, 但是其光电流没有任何的减小, 反而有显著的增大. 而插入MoO3介质层的探测器光电流与没有插层的器件相比较没有明显的变化. 这再次证明插入超薄介质层并未以增大器件串联电阻为代价而降低暗电流.
图3给出所有器件在波长1310 nm激光垂直光照下的响应度随入射光功率的变化关系. 可以看出, 所有光电探测器的响应度随着外加偏压的增大均有不同程度的增大, 其中i-Ge组肖特基光电探测器及ITO/Al2O3/n-Ge肖特基光电探测器的在高光功率下响应度随偏压的增大呈现出明显的线性增大的趋势, 其他类型的光电探测器在继续增大偏压后, 器件的光响应度增速则减缓或稍有降低. 但是不同结构和不同类型锗材料制备的光电探测器响应度随入射光功率的变化规律并不完全一致. 从图3明显看到, 具有2 nm厚Al2O3插层的所有类型Ge光电探测器响应度最大. 而同一种Ge材料响应度最大的分别为: ITO/Al2O3/i-Ge探测器在–4 V偏压, 功率3.82 mW的激光照射下, 光响应度高达4.11 A/W; ITO/Al2O3/n-Ge探测器在–4 V偏压, 功率10.2 mW的激光照射下, 光响应度达到了2.21 A/W; ITO/Al2O3/Ge-epi探测器则能够在–3 V偏压, 功率10.2 mW的激光照射下, 光响应度达到了0.38 A/W. 相较而言, i-Ge组光电探测器响应度在不同偏压下均与入射光功率相关性并不明显. ITO/Al2O3/i-Ge探测器的响应度在低功率下几乎不变, 并在功率达到6.6 mW后略有下降, 说明此组光电探测器性能更加稳定. 而引入MoO3插层的三种光电探测器, 其光电响应度略低于没有插层的ITO/Ge光电探测器. 同时, 还使用1550 nm激光器对加入了Al2O3插层的器件进行了相同的光电测试, ITO/Al2O3/i-Ge探测器在–4 V偏压, 光响应度为0.46 A/W; ITO/Al2O3/n-Ge探测器的光响应度为0.26 A/W; 而ITO/Al2O3/Ge-epi探测器在1550 nm波长处的光响应则比较微弱.
 图 3 探测器在偏压为–1, –2, –3, –4 V、不同激光功率(1310 nm)照射下的响应度变化曲线 (a) ITO/Al2O3/n-Ge; (b) ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epi
图 3 探测器在偏压为–1, –2, –3, –4 V、不同激光功率(1310 nm)照射下的响应度变化曲线 (a) ITO/Al2O3/n-Ge; (b) ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epiFigure3. Responsivities of the photodetectors measured at –1, –2, –3 and –4 V reverse bias under illumination by a 1310 nm laser at various powers: (a) ITO/Al2O3/n-Ge; (b)ITO/MoO3/n-Ge; (c) ITO/n-Ge; (d) ITO/Al2O3/i-Ge; (e) ITO/MoO3/i-Ge; (f) ITO/i-Ge; (g) ITO/Al2O3/Ge-epi; (h) ITO/MoO3/Ge-epi; (i) ITO/Ge-epi.
将制备得到的ITO/Al2O3/i-Ge肖特基光电探测器与文献报道的Ge光电探测器性能进行了对比, 如表1所示.
| 年份 | 暗电流大小(密度) | 响应度 | 结构类型 | 文献 |
| 2006 | 40 mA/cm2@1 V | 0.28 A/W@1550 nm | NI PIN | [17] |
| 2010 | 90 μA@1 V | 0.14 A/W@1550 nm | WG MSM | [24] |
| 2010 | 0.2 mA@–0.5 V | 0.7 A/W@1550 nm | WG PIN | [25] |
| 2011 | 40 mA/cm2@1 V | 0.8 A/W@1500 nm | WG Photodiode | [26] |
| 2013 | 412 μA@5 V | 1.76 A/W@1550 nm | WG MSM | [27] |
| 2015 | 3 nA@–1 V | 1.0 A/W@1567 nm | WG PIN | [28] |
| 2017 | 75 mA/cm2@1 V | 0.58 A/W@1550 nm | WG PIN | [29] |
| 2021 | 5.91 mA/cm2@–4 V | 0.46 A/W@1550 nm 4.11 A/W@1310 nm | NI MS | 本文 |
表1超薄介质插层调制的ITO/Ge肖特基光电探测器与文献报道的器件性能对比
Table1.A comparison of the performance of our works with those from other groups.
为了定量理解Al2O3和MoO3插层对势垒高度的调制作用, 对所有的器件进行变温伏安特性测试, 以提取其有效接触势垒高度. 图4给出典型的ITO/Al2O3/i-Ge探测器在293—373 K(间隔为20 K)下的无光照变温I-V特性曲线及所有9种光电探测器根据变温I-V特性画出的

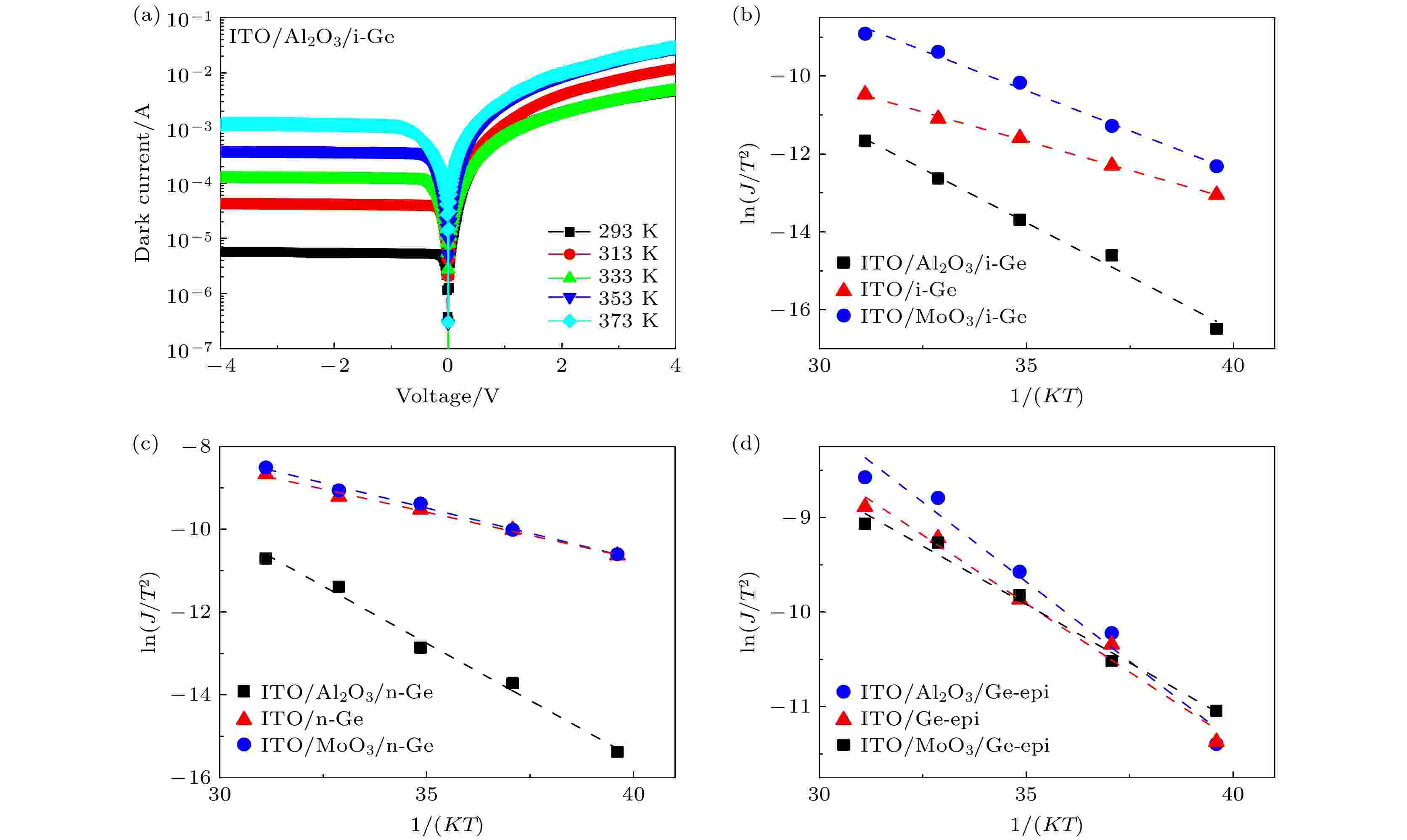 图 4 (a) ITO/Al2O3/i-Ge变温I-V曲线; (b) i-Ge组器件ln(J/T 2)与1/(kT)拟合结果; (c) n-Ge组器件ln(J/T 2)与1/(kT)拟合结果; (d) Ge-epi组器件ln(J/T 2)与1/(kT)拟合结果
图 4 (a) ITO/Al2O3/i-Ge变温I-V曲线; (b) i-Ge组器件ln(J/T 2)与1/(kT)拟合结果; (c) n-Ge组器件ln(J/T 2)与1/(kT)拟合结果; (d) Ge-epi组器件ln(J/T 2)与1/(kT)拟合结果Figure4. (a) Temperature dependent I-V characteristics of ITO/Al2O3/i-Ge detector; (b) ln(J/T 2) versus 1/(kT) for i-Ge detectors; (c) ln(J/T 2) versus 1/(kT) for n-Ge detectors; (d) ln(J/T 2) versus 1/(kT) for Ge-epi detectors.
| 结构类型 | i-Ge | n-Ge | Ge-epi |
| ITO | 0.34 eV | 0.24 eV | 0.29 eV |
| 2 nm Al2O3 + ITO | 0.55 eV | 0.56 eV | 0.30 eV |
| 2 nm MoO3 + ITO | 0.39 eV | 0.22 eV | 0.25 eV |
表2不同结构的有效肖特基势垒高度
Table2.Effective Schottky barrier heights of different structures.
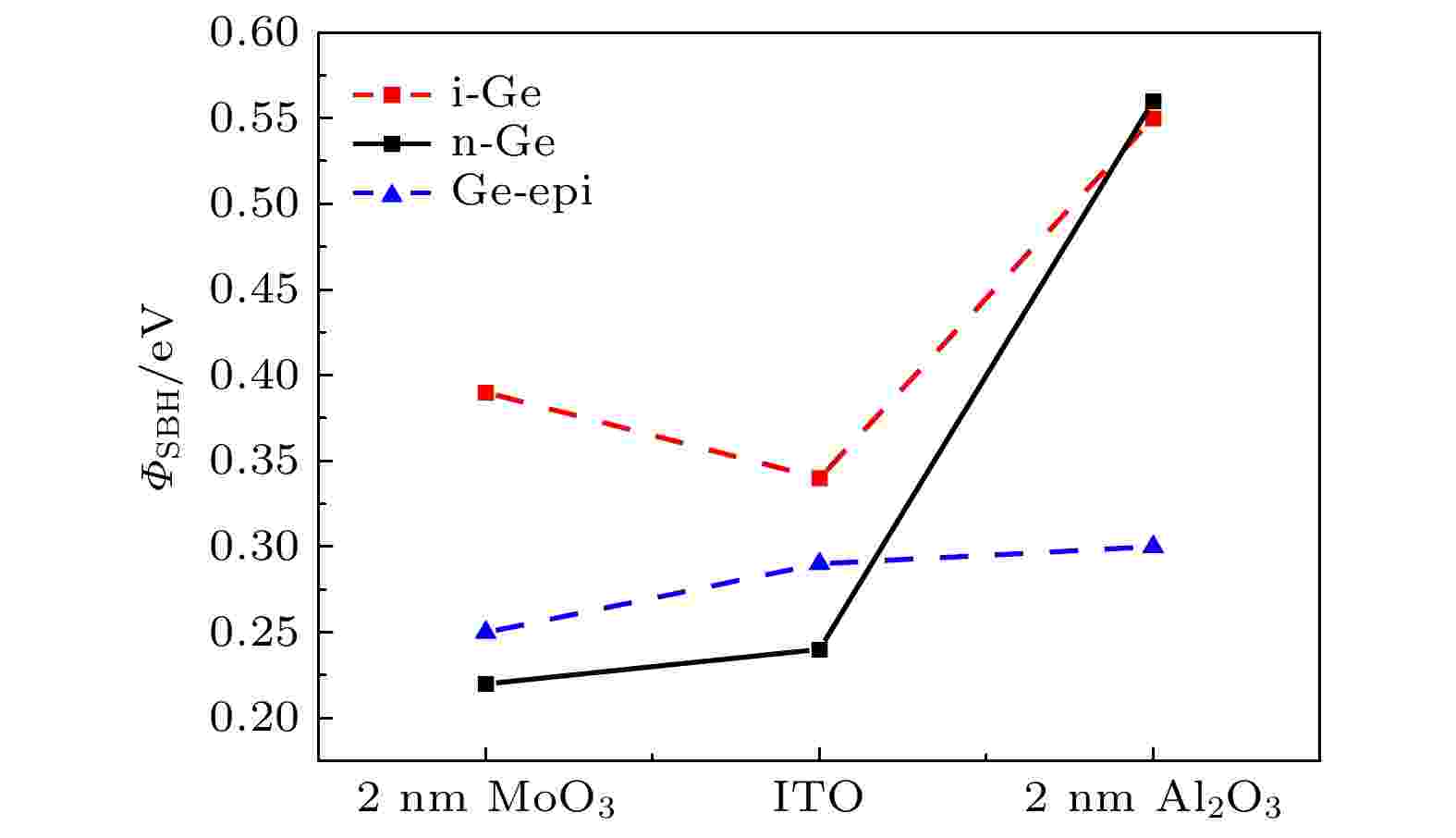 图 5 有效肖特基势垒高度与器件类型关系图
图 5 有效肖特基势垒高度与器件类型关系图Figure5. Diagram of effective Schottky barrier heights with device types.
而由于半导体Ge表面存在大量表面态, 导致强烈的费米钉扎效应[11], ITO作为一种高掺的氧化物电极, 能够起到解除半导体表面的费米钉扎效应的作用[31], 与Ge之间仅有很小的接触势垒, 且对不同类型的Ge略有差别, 其有效接触势垒在0.24—0.34 eV之间. 但当ITO与Ge之间插入2 nm厚的Al2O3之后, 伏安特性中反向暗电流显著下降, 整流比提高. 相比较而言, 插入MoO3介质层对ITO/Ge接触势垒高度的影响不大.
为了更好地理解不同结构光电探测器暗电流和光电特性, 图6展示了ITO/Al2O3/Ge, ITO/MoO3/Ge和ITO/Ge能带和载流子输运示意图. 在反向偏压下, 内建电场增大, 光生载流子主要发生在空间电荷层, 但由于ITO的电子填充水平较高, 光生空穴可以顺利输运到ITO表面, 因此不存在载流子被限制的情况[7], 而在ITO和Ge之间加入了Al2O3插层后, 由于Al2O3电子亲和能很小, 约为1.0 eV[32], 而带隙很大, 达到10.7 eV[33], 使得光生空穴遂穿的几率减小, 被限制在界面以及介质层中缺陷能级上, 产生光电流增益, 因此在ITO/Al2O3/Ge类光电探测器中得到高的响应度. 对ITO/MoO3/Ge类光电探测器, 插入MoO3介质层, 其接触势垒高度变化很小, 在误差范围内可以忽略不计. MoO3薄膜的电子亲和能较大, 约为5.22 eV, 而其带隙约为3.19 eV[34]. 由于MoO3的电子亲和能远大于Ge的电子亲和能, MoO3插层对ITO/Ge接触电子势垒高度影响不大. 另一方面, MoO3可以作为空穴传输层用于太阳电池中[35], 对光生空穴没有明显的的限制作用. 对比Al2O3和MoO3两种介质插层对ITO/Ge光电探测器性能的调制, 进一步明确了Al2O3介质插层对ITO/Ge势垒高度的调制以及限制空穴的作用是降低探测器暗电流和提高光电响应度的主要原因.
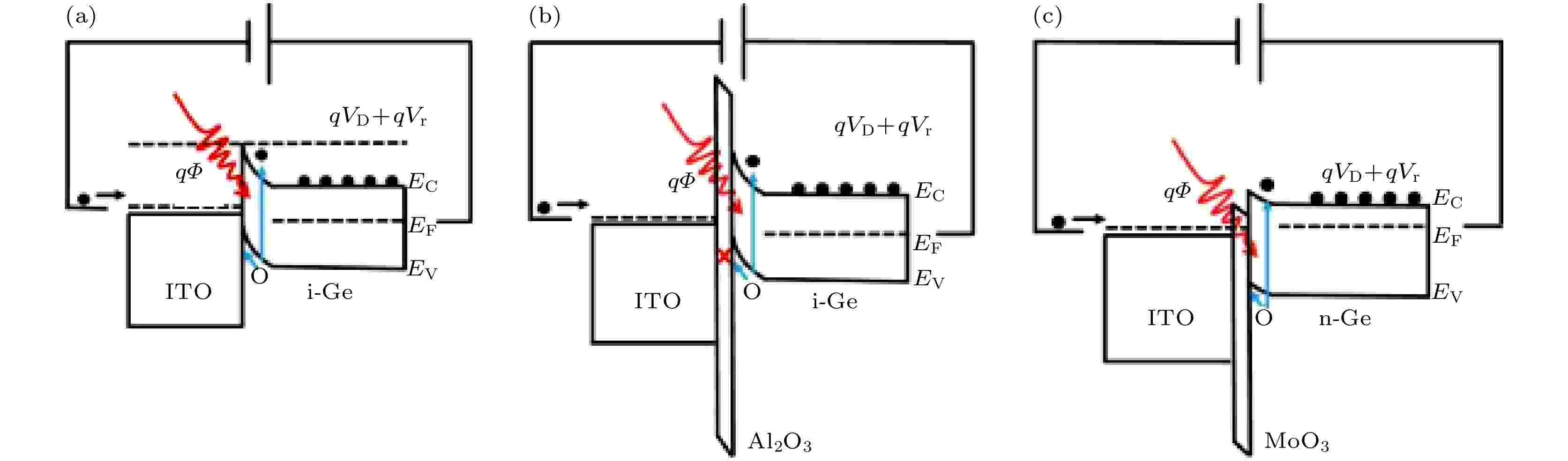 图 6 光照下探测器的能带结构图以及载流子输运示意图 (a) ITO/i-Ge; (b) ITO/Al2O3/i-Ge; (c) ITO/MoO3/n-Ge
图 6 光照下探测器的能带结构图以及载流子输运示意图 (a) ITO/i-Ge; (b) ITO/Al2O3/i-Ge; (c) ITO/MoO3/n-GeFigure6. Energy band and carrier transport diagram of detectors under light illumination: (a) ITO/i-Ge; (b) ITO/Al2O3/i-Ge; (c) ITO/MoO3/n-Ge.
室温工作短波红外焦平面成像在微光夜视或雾霾气象条件下无人驾驶等领域具有重要的应用前景. 使用二维位移平台对制备的响应度最高的肖特基光电探测器(ITO/Al2O3/i-Ge)进行了单点成像实验. 分别在X方向和Y方向都移动了5个器件直径的距离, 即整个测试图像面积为1750 μm × 1750 μm. 使用波长1310 nm和1550 nm的激光器, 激光光斑的大小约为100 μm. 通过测试不同位置时光电探测器的光电流(电压), 与对应位置坐标利用MATLAB灰度图进行成像, 即得到激光光斑所在位置的图像, 如图7所示. 考虑到不同波长(1310 nm, 1550 nm)激光光斑是独立耦合所得, 在更换光纤后光斑位置会出现一定程度的偏差, 虽然如此, 图中可以看到最亮光斑的移动不会超过350 μm. 因此可认为所制备的探测器及其成像系统仍然具有很高的保真特性, 证明了制备的红外光电探测器可以应用于红外光电成像系统中.
 图 7 ITO/Al2O3/i-Ge二维成像图 (a) 1310 nm波长; (b) 1550 nm波长
图 7 ITO/Al2O3/i-Ge二维成像图 (a) 1310 nm波长; (b) 1550 nm波长Figure7. Two dimensional image obtained from the ITO/Al2O3/i-Ge detector: (a) 1310 nm laser; (b) 1550 nm laser.
