摘要: 本文研究了镨掺杂铟镓氧化物 (PrIGO)薄膜晶体管 (thin film transistor, TFT) 的低频噪声特性. 根据低频噪声测试分析结果得知: IGO-TFT和PrIGO-TFT器件沟道电流的功率谱密度与频率的关系均满足1/
fγ (
γ ≈ 0.8) 的关系, 符合载流子数涨落模型. 通过研究不同沟道长度对器件低频噪声的影响, 明确了器件的噪声主要来源于沟道区而非源/漏接触区. 基于载流子数涨落模型, 提取界面处的缺陷态, 发现Pr元素掺杂会在IGO体系中诱导出缺陷态. 而该缺陷态可以作为电离氧空位和电子的复合中心, 进而改善氧化物TFT器件中由氧空位所导致的光照负偏压 (negative bias illumination stability, NBIS) 稳定性问题.
关键词: 铟镓氧化物 /
薄膜晶体管 /
低频噪声 English Abstract Analysis of low frequency noise characteristics of praseodymium doped indium gallium oxide thin film transistor Zhu Yu-Bo 1,3 ,Xu Hua 2 ,Li Min 2 ,Xu Miao 2,3 ,Peng Jun-Biao 3 1.School of Electronic and Information Engineering, South China University of Technology, Guangzhou 510640, China Fund Project: Project supported by the Key-Area Research and Development Program of Guangdong Province, China (Grant Nos. 2019B010924004, 2019B010934001, 2019B010925001), the Guangdong Provincial International Science & Technology Cooperation Program, China (Grant No. 2018A050506022), and Ji Hua Laboratory Scientific Research Project, China (Grant No. X190221TF191)Received Date: 25 February 2021Accepted Date: 19 March 2021Available Online: 07 June 2021Published Online: 20 August 2021Abstract: Metal oxide thin film transistors (MOTFTs) have been extensively investigated in the display industry because of their attractive characteristics, including high performances, low processing temperatures, and simple fabrication. However, under the actual working condition, the characteristics of TFTs are easily affected by the light irradiation caused the negative gate bias stress (NBIS). Therefore, the NBIS stability of MOTFT is a crucial issue that must be solved before their commercialization into an optoelectronic device. In this article, praseodymium-doped indium gallium oxide (PrIGO) is employed as the channel layer of thin film transistor (TFT). The TFTs with Pr doping exhibit a remarkable enhancement in NBIS stability. The structure and chemical composition of PrIGO film are analyzed by X-ray diffraction (XRD) and X-ray photoelectron spectroscopy (XPS), respectively. Besides, to further explore the mechanism for the improvement of NBIS stability, the low-frequency noise characteristics of IGO-TFT device and PrIGO-TFT device are studied. According to the low frequency noise characterization and analysis results, the correspondence between the normalized drain current noise power spectral density($ S_{\rm ID}/I_{\rm DS}^2 $ ) and frequency shows 1/fγ (γ ≈ 0.8) low frequency noise behavior for IGO-TFT device and PrIGO-TFT device. In addition, by studying the influences of different channel lengths on the low frequency noise of the IGO-TFT and PrIGO-TFT devices, it can be concluded that the low frequency noise of the device comes mainly from the channel region rather than from the source/drain contact region. In the linear region of the IGO-TFT device and PrIGO-TFT device, according to the linear fitting of the $ S_{\rm ID}/I_{\rm DS}^2 $ versus the overdrive voltage (V GS – V th ), it is proved that the low frequency noise of the IGO-TFT device and the PrIGO-TFT device are mainly affected by the carrier number fluctuation model. Finally, based on the carrier number fluctuation model, the defect state density at the interface between active layer and gate insulating layer is extracted to be 7.76 × 1017 cm–3 ·eV–1 and 9.55 × 1017 cm–3 ·eV–1 for IGO-TFT and PrIGO-TFT devices, respectively. We speculate that the Pr element can induce defect states in the IGO system, and the trap states induced by Pr ions facilitate the capture of free electrons by positively charged oxygen vacancies, which lead the photo-induced carrier in conduction band to be suppressed.Keywords: indium gallium oxide /thin film transistor /low-frequency noise 全文HTML --> --> --> 1.引 言 金属氧化物薄膜晶体管 (metal oxide thin film transistor, MOTFT) 因其具有较高的迁移率、均匀性较好、开关电流比大以及透光性佳等优点[1 -3 ] , 在显示领域具有广泛的应用潜力, 其制备和电学性能研究已成为国内外研究热点.[4 ] , 这在实际的产品应用中具有较强的吸引力. 但是, 三元的铟镓氧化物相对较易结晶[5 ] , 其在大面积均匀性方面有一定的影响. 另外, 根据薄膜晶体管 (thin film transistor, TFT)的实际工作状态, TFT会长时间的工作在负偏压状态, 而且会受到周围环境光或自身像素点发光照射的影响, 因此, 研究负偏压和光照共同作用下的薄膜晶体管的稳定性具有重要的现实意义. 目前, 光照下的负偏压稳定性 (negative bias illumination stability, NBIS) 较差是当前氧化物薄膜晶体管在实际应用中必须面对的挑战[6 -8 ] . 通常需要增加遮光层以降低光照对器件的恶化, 但这必然会导致制造成本和设计复杂程度的增加. 我们前期的研究表明, 通过在氧化铟锌 (indium zinc oxide, IZO)体系材料中掺入一定量的氧化镨, 可以在基体材料的浅能级处诱导出受主缺陷态, 该缺陷态可以作为电离的氧空位与离化电子的复合中心, 能有效地改善薄膜晶体管与光照相关的稳定性[9 ] . 因此, 本文将基于IGO体系, 通过引入镨离子制备氧化物半导体材料镨铟镓氧(PrIGO), 以改善器件光稳定性. 通过对半导体器件的噪声特性分析, 研究稀土元素掺杂前后的薄膜晶体管低频噪声的物理机制. 噪声特性分析作为模拟电路应用中关键参数, 可评估后续电路和系统可以检测和处理的信号电平的下限, 而且噪声是决定系统分辨力和信噪比的主要因素[10 ] . 器件噪声的大小直接影响整个电子系统的性能与可靠性, 而且能直接地反映器件内部, 特别是界面中缺陷状态和数量[11 ,12 ] . 因此, 我们尝试引入噪声分析, 进一步研究稀土氧化物在半导体器件中的影响.2.IGO-TFT和PrIGO-TFT器件制备与性能 22.1.IGO-TFT和PrIGO-TFT器件制备 2.1.IGO-TFT和PrIGO-TFT器件制备 如图1(a) 所示, 所用器件均采用刻蚀阻挡层 (etch stop layer, ESL) 结构. 首先, 采用直流磁控溅射的方式在玻璃衬底上溅射一层200 nm厚的栅极金属钼 (Mo) 层, 利用湿法刻蚀对栅极薄膜进行图形化. 然后, 通过等离子体增强型化学沉积 (plasma enhanced chemical vapor deposition, PECVD) 技术制备双层堆叠的栅绝缘层, 下层为250 nm厚的氮化硅薄膜, 上层为50 nm厚的二氧化硅薄膜, 利用干法刻蚀进行图形化. 随后, 通过物理气相沉积 (physical vapor deposition, PVD) 分别制作一层30 nm厚的IGO (In/Ga = 2 mol/1 mol) 薄膜或PrIGO (Pr/In/Ga = 0.2 mol/2 mol/1 mol) 薄膜作为薄膜晶体管器件的有源层; 溅射气压为5 mTorr, 溅射气氛为氧气和氩气的混合气体, 氧气所占比例为20%, 溅射功率为300 W, 利用草酸进行刻蚀图形化. 再次通过PECVD制作一层300 nm厚的二氧化硅薄膜作为刻蚀阻挡层, 利用干法刻蚀进行薄膜图形化. 随后, 采用直流磁控溅射方式制备一层200 nm厚的钼金属作为源漏电极, 以湿法刻蚀方式进行图形化. 最后, 所有器件在350 ℃空气氛围中退火30 min. 采用半导体参数分析仪Agilent B1500 A和Platform-da FS-Pro分别对器件的电流-电压特性和噪声特性进行表征测试.图 1 IGO-TFT和PrIGO-TFT (a) 结构示意图; (b) 转移特性曲线; IGO-TFT (c) 和PrIGO-TFT (d) NBIS稳定性Figure1. (a) Cross section views and (b) transfer characteristics of IGO-TFT and PrIGO-TFT; NBIS stability of (c) IGO-TFT and (d) PrIGO-TFT.2.2.IGO-TFT和PrIGO-TFT器件性能 -->2.2.IGO-TFT和PrIGO-TFT器件性能 如图1(b) 所示为IGO-TFT和PrIGO-TFT的转特性曲线, 器件W /L 均为20 μm/10 μm. 器件工作在线性区 (V DS ≤ V GS – V th ) 时, 通常V DS 的值比较小, 漏源电流 (I DS ) 表达式为V DS 为源漏电压; V GS 为栅电压; W /L 为器件的宽长比; $ \mu _{\rm{FE}} $ 为场效应迁移率; C ox 为栅绝缘层的单位面积电容; V th 为阈值电压. 取V DS = 0.1 V, 通过拟合I DS -V GS 曲线, 可以计算得到器件的场效应迁移率, 拟合曲线的反向延长线与横坐标的截距为阈值电压. 亚阈值摆幅 (SS) 由下式定义V th 为0.3 V, 载流子的$ \mu _{\rm{FE}} $ 为19.9 cm2 ·V–1 ·s–1 , SS 为0.19 V/decade, 电流开关比 (I on /I off ) 约为109 , PrIGO-TFT器件V th 为0.9 V, 器件的 $ \mu_{\rm{FE}} $ 为15.1 cm2 ·V–1 ·s–1 , SS 为0.19 V/decade, I on /I off 约为109 . 图1(c) 和图1(d) 分别为IGO-TFT和PrIGO-TFT在光照条件下的负偏压稳定性 (测试条件: V GS = –30 V, V DS = 0 V, 光强 = 10000 nits). 由图1(c) 和图1(d) 可知, IGO-TFT在偏压测试7200 s后, 开启电压V on (器件源漏电流I DS 为10 nA时所对应的栅极电压) 漂移量为–8.4 V, 而PrIGO-TFT在偏压测试7200 s后, 开启电压V on 漂移量仅为–1.8 V. 很显然, 稀土镨元素的掺入可以有效的提高器件的NBIS稳定性.3.实验结果与分析 23.1.薄膜结晶特性研究 3.1.薄膜结晶特性研究 图2(a) 为IGO薄膜和稀土镨元素掺杂的PrIGO薄膜的X射线衍射 (X-ray diffraction, XRD) 谱图. 如图2(a) 可知, IGO薄膜的衍射谱中有一明显的结晶峰位 (31.33°), 根据衍射谱图可知其对应氧化铟 (In2 O3 ) 的 (222) 晶面[13 ] . 当一定量的氧化镨掺杂到IGO基体材料后, 可以明显地看出In2 O3 (222) 晶面处的结晶峰消失. 其原因可能是由于Pr离子 (~101 pm) 的半径大于In离子 (~81 pm) 和Ga离子 (~62 pm), Pr离子的掺入, 会使IGO基体产生晶格畸变, 从而使IGO基体向非晶状态转变. 因此, 氧化镨的掺入可以促进IGO薄膜的非晶化, 从而保证了薄膜大面积的均匀性; 并且在载流子的传输过程中, 有效地降低薄膜晶界散射的影响.图 2 IGO和PrIGO薄膜 (a) X射线衍射谱图; (b) 紫外-可见透射光谱图 (插图为 (αhv )2 随hv 变化曲线); (c) X射线光电子能谱图 (插图为局部放大图)Figure2. (a) X-ray diffraction spectra, (b) UV-visible transmission spectra (the inset shows the curve of (αhv )2 varying with hv ) and (c) X-ray photoelectron spectroscopy (the inset is a partial enlarged view) of IGO and PrIGO thin film.图2(b) 为IGO薄膜和稀土镨元素掺入的PrIGO薄膜的紫外-可见透射光谱图. 由图2(b) 可知, IGO薄膜和PrIGO薄膜在可见光波段内的平均透过率均大于80%. 在紫外光波段, Pr掺入的PrIGO薄膜透过率曲线相对IGO薄膜发生了轻微的红移现象. 通过Tauc 公式进行计算薄膜光学带隙的大小, 具体公式为α 表示吸收系数; hv 表示光子能量; E g 表示光学带隙; C 表示比例常数. 如图2(b) 插图所示, 以hv 为横坐标, (αhv )2 为纵坐标, 作出 (αhv )2 随hv 变化曲线的切线, 该切线与横坐标的交点即为薄膜的光学带隙. 通过该方法获得了IGO和PrIGO薄膜的光学带隙分别为3.54 eV和3.47 eV. 可知, Pr元素的掺入会导致薄膜光学带隙的减小, 所以器件NBIS稳定性的提高并不是由于光学带隙的展宽所引起的.图2(c) 为IGO薄膜和PrIGO薄膜的X射线光电子能谱 (X-ray photoelectron spectroscopy, XPS) 表征的全谱图, 图2(c) 的插图为IGO和PrIGO薄膜总谱图能量在920—960 eV之间的局部放大图, 从局部放大图中可以明显地看出, IGO薄膜没有出现明显的峰位镨, 而PrIGO薄膜在933.5和953.5 eV处出现了两个主峰位, 分别对应Pr 3d5/2 和Pr 3d3/2 . 此外, 根据XPS测试分析, 各元素的百分比含量如表1 所列. 由表1 可以看出, PrIGO和IGO薄膜各元素的百分比含量与实际靶材中的百分比含量基本相似, 说明稀土元素Pr在IGO中能实现良好的掺入.Element/at.% Pr In Ga O PrIGO 2.86 28.76 15.10 51.89 IGO — 30.93 15.51 51.85
表1 IGO和PrIGO薄膜中各元素的百分比含量Table1. Percentage contents of each element in IGO and PrIGO films.3.2.IGO-TFT和PrIGO-TFT的低频噪声特性与影响机制 -->3.2.IGO-TFT和PrIGO-TFT的低频噪声特性与影响机制 在获得了较好的器件稳定性后, 有必要对器件的改善机制做进一步的研究. 大量研究表明, 器件的低频噪声特性是表征器件缺陷机制的有效手段.f 噪声) 以及产生复合噪声 (G-R噪声)[14 ] . 不同噪声的产生机制各不相同, 由于在低频情况下, 1/f 噪声和G-R噪声较为显著, 故统称为低频噪声. 由于1/f 噪声是由器件界面缺陷及氧化层陷阱电荷所引起的, 因此, 通过对IGO-TFT和PrIGO-TFT器件低频噪声特性的研究, 能反映出器件内在的质量与可靠性.V DS = 0.1 V, 过驱动电压V GS – V th = 10.1 V条件下, IGO-TFT和PrIGO-TFT归一化的噪声功率谱密度 ($S_{\rm ID}/I_{\rm DS}^2$ ) 随频率的变化如图3 所示. 由图3 可以看出, 在10 Hz < f < 1 kHz时, 通过1/fγ 拟合, 得出γ ≈ 0.8; 当f > 1 kHz时, IGO-TFT和PrIGO-TFT的$ S_{\rm ID}/I_{\rm DS}^2 $ 值随着频率的改变几乎没有变化, 对于更高的频率而言, 1/f 噪声通常湮没在背景噪声和或热噪声中而不可测. 本文主要研究1/f 噪声, 下文低频噪声测试频率范围均为10 Hz至1 kHz. 另外, γ 因子还反映了界面附近缺陷态的纵向分布. 当γ > 1时, 说明有源层内的缺陷密度小于栅氧化层内的缺陷密度; 当γ < 1时, 说明有源层内的缺陷密度大于栅氧化层内的缺陷密度[15 ] . 因此, 由γ ≈ 0.8可以得出, 在IGO-TFT和PrIGO-TFT的有源层与栅绝缘层的界面处, 有源层IGO和PrIGO一侧的缺陷态密度大于二氧化硅一侧的缺陷态密度.图 3 IGO-TFT和PrIGO-TFT归一化噪声功率谱密度随频率的变化Figure3. Normalized noise power spectral densities (S ID /I 2 DS ) versus frequency in the IGO-TFT and PrIGO-TFT.3.3.IGO-TFT和PrIGO-TFT的低频噪声特性的来源 -->3.3.IGO-TFT和PrIGO-TFT的低频噪声特性的来源 在明确了低频噪声满足1/fγ , 而且噪声主要来源于有源层一侧的影响后; 对于ESL结构的器件而言, 栅极与源漏电极之间的交叠区域是比较大的, 因此需要进一步研究器件低频噪声的空间位置的来源, 明确源/漏结接触是否对器件的低频噪声产生影响.[16 ] S ch 表示沟道产生的噪声功率谱密度; S cont 表示接触电阻引起的噪声功率谱密度; R ch 表示沟道电阻; R cont 表示接触电阻 (R ch $\gg $ R cont ); 如果沟道噪声是主要的, 即S ch $\gg $ S cont , (4 )式可表达为S ch $\ll $ S cont , (4 )式可表达为5 )式和(6 )式可知, 通过归一化的噪声功率谱密度与沟道长度的变化关系可以确定源/漏接触区是否对器件低频噪声产生影响. 固定V GS –V th = 10.1 V, 在V DS = 1.1 V的情况下分别对宽长比为10 μm /10 μm, 10 μm /20 μm, 10 μm /40 μm三种器件进行低频噪声测量, 器件归一化的噪声功率谱密度随频率的变化如图4(a) 和图4(b) 所示.图 4 不同沟道长度的IGO-TFT (a) 和PrIGO-TFT (b) S ID /I 2 DS 随频率的变化Figure4. S ID /I 2 DS versus frequency in the (a) IGO-TFT and (b) PrIGO-TFT with different channel length.图4(a) 和图4(b) , 在f = 10 Hz时, 提取不同沟道长度器件对应的$S_{\rm ID}/I_{\rm DS}^2$ 值, 如图5(a) 所示, IGO-TFT和PrIGO-TFT的$ S_{\rm ID}/I_{\rm DS}^2 $ 值随的沟道长度的增加而线性减小, 对应的斜率分别为–1.08和–0.97, 均约等于–1. 因此, 基于该实验结果, 可以很明确地得出IGO-TFT和PrIGO-TFT器件的低频噪声主要来源于器件沟道区的闪烁噪声, 并且可以忽略源/漏接触区对器件低频噪声的影响.图 5 IGO-TFT和PrIGO-TFT (a) S ID /I 2 DS 随沟道长度的变化; (b) S ID /I DS 2 随过驱动电压V GS –V th 的变化Figure5. S ID /I 2 DS versus (a) channel length and (b) overdrive voltage (V GS –V th ) in the IGO-TFT and PrIGO-TFT.[17 ] . 当器件工作在线性区时, 对于载流子数波动模型, 归一化的漏极电流噪声功率谱密度可以近似表示为[18 ] k * 取决于有源层与绝缘层界面附近缺陷俘获和释放载流子的效应; C ox 为单位面积的栅绝缘层电容; f 为频率. 对于迁移率波动模型, 归一化的漏极电流噪声功率谱密度可以近似表示为[19 ] α H 为Hooge因子, 可用于评价不同器件和材料的品质. 另外一种模型是两种的混合模型, 载流子数波动及其诱导迁移率波动模型. 由(7 )式和(8 )式, 可以得出通过$ S_{\rm ID}/I_{\rm DS}^2 $ 与过驱动电压 (V GS – V th ) 之间的关系来判断IGO-TFT和PrIGO-TFT器件低频噪声的所适用的模型.V DS = 0.1 V条件下, 变换不同的V GS – V th , 对器件$ S_{\rm ID}/I_{\rm DS}^2 $ 进行测量. 当频率f = 10 Hz时, 提取$ S_{\rm ID}/I_{\rm DS}^2 $ 随V GS – V th 的变化关系如图5(b) 所示. 由图5(b) 可知, IGO-TFT器件的$ S_{\rm ID}/I_{\rm DS}^2 $ 随V GS –V th 的变化斜率约为–1.8, 而PrIGO-TFT器件的$ S_{\rm ID}/I_{\rm DS}^2 $ 随V GS –V th 的变化斜率约为–2. 由(7 )式和(8 )式可知, 当斜率关系为–1时, 器件的低频噪声机理主要来源于迁移率涨落模型; 当斜率关系为–2时, 器件的低频噪声机理主要来源于载流子数涨落模型. 对于IGO-TFT而言, 在低频噪声的影响机理中还包含了一小部分的迁移率涨落机理, 掺杂Pr元素后, 器件的低频噪声影响机理完全转化为了载流子数涨落机理. 从IGO和PrIGO薄膜的XRD结果可知 (如图2(a) 所示), Pr的掺入能抑制IGO薄膜的结晶, 导致晶格对载流子的散射减弱, 而迁移率的波动会受到晶格散射的影响[20 ] , 因此, 相对于IGO-TFT来说, 当掺入Pr元素后, 迁移率涨落的影响机理会削弱. 虽然Pr掺杂前后, 斜率有了轻微的变化, 但IGO-TFT和PrIGO-TFT器件的低频噪声特性主要还是受载流子数涨落机理的影响.3.4.IGO-TFT和PrIGO-TFT的缺陷态提取 -->3.4.IGO-TFT和PrIGO-TFT的缺陷态提取 进一步地, 在确定器件的低频噪声特性主要受载流子涨落机理决定后, 下面对器件的缺陷态密度进行提取.[21 ] g m 表示器件的跨导; S vfb 表示平带电压功率谱密度, 通常由器件的有源层与栅绝缘层界面处电荷波动所引起, 可用来描述界面态及氧化层边界陷阱对界面处电荷的影响, 另外, S vfb 可以表达为N t 表示缺陷态密度; KT 表示热电势; λ 表示隧道衰减系数, 在SiO2 中约为0.1 nm; C ox 表示栅绝缘层电容, 约为16.5 nF/cm2 . 由(10 )式可得出N t 表达为9 )式、(10 )式和(11 )式可知, 要想提取器件界面附近处的缺陷态密度N t , 必须首先提取器件的平带电压功率谱密度S vfb , 根据文献[22 ]的提取方法, IGO-TFT和PrIGO-TFT器件的实际测量和拟合的S ID /I DS 2 值随I DS 的变化关系如图6(a) 和图6(b) 所示, 提取的S vfb 分别为1.3 × 10–9 V2 ·Hz–1 和1.6 × 10–9 V2 ·Hz–1 . 基于(11 )式可知, 对于IGO-TFT和PrIGO-TFT, 界面处的缺陷态密度N t 分别为7.76 × 1017 cm–3 ·eV–1 和9.55 × 1017 cm–3 ·eV–1 . 由N t 的结果可以得出, 当Pr元素掺杂到IGO薄膜后, PrIGO-TFT器件的有源层与栅绝缘层界面附近处的缺陷态密度有一定的增加. 其原因可能是由于稀土元素Pr具有丰富的电子能级结构, Pr元素在氧化物形式中有Pr3+ 和Pr4+ 离子存在, Pr4+ 离子未被占用的4f 轨道对电子具有较强的俘获作用[23 ] . 因此, PrIGO-TFT所提取的缺陷态密度N t 会比IGO-TFT的高.图 6 IGO-TFT (a) 和PrIGO-TFT (b) S ID /I 2 DS 随沟道电流的变化Figure6. S ID /I 2 DS versus drain current in the (a) IGO-TFT and (b) PrIGO-TFT.图2(a) 所示) 相关, 晶界散射效应会导致器件的SS增加; 而掺杂Pr的薄膜呈非晶态, 晶界散射较弱, 但是其引入了一定量的“受主缺陷”, 势垒散射增加; 因此导致了二者SS相当.4.结 论 本文通过稀土元素Pr掺杂IGO, 制备出高稳定性的薄膜晶体管. 由实验结果分析可知: IGO-TFT和PrIGO-TFT器件的低频噪声随频率的变化均满足1/fγ (γ ≈ 0.8) 变化关系; 通过研究不同沟道长度对IGO-TFT和PrIGO-TFT器件低频噪声的影响, 明确了器件的噪声主要来源于沟道区, 源/漏接触区对器件低频噪声的影响可以被忽略. 在器件的线性区, 通过沟道电流归一化噪声功率谱密度与过驱动电压函数关系的线性拟合, 确定IGO-TFT和PrIGO-TFT器件的低频噪声主要受载流子数涨落机理的影响. 根据载流子数涨落机理的模型, 提取IGO-TFT和PrIGO-TFT界面处的缺陷态密度分别为7.76 × 1017 cm–3 ·eV–1 和9.55 × 1017 cm–3 ·eV–1 . Pr元素可以在IGO体系中诱导出缺陷态, 该缺陷态可以作为电离的氧空位与离化电子复合中心, 促进器件NBIS稳定性提高. 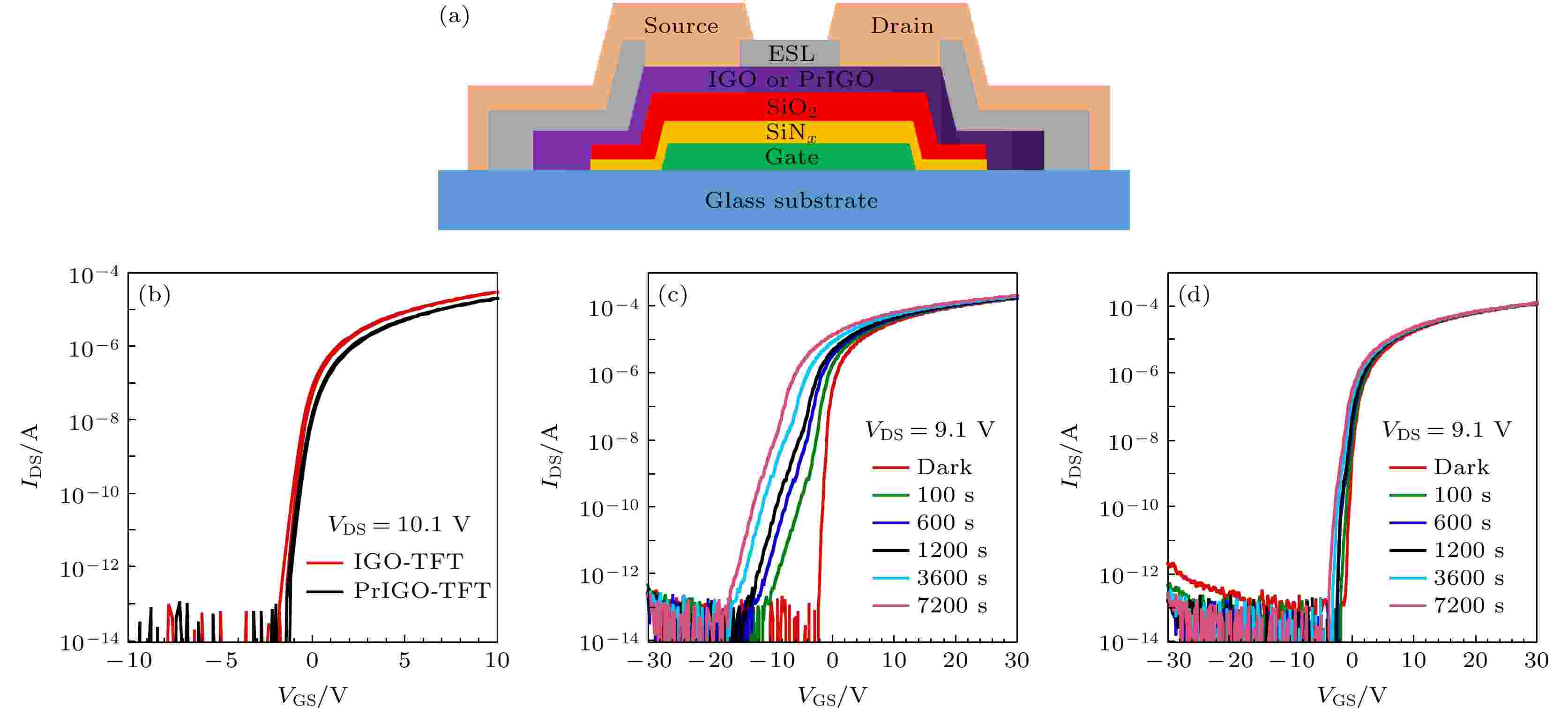 图 1 IGO-TFT和PrIGO-TFT (a) 结构示意图; (b) 转移特性曲线; IGO-TFT (c) 和PrIGO-TFT (d) NBIS稳定性
图 1 IGO-TFT和PrIGO-TFT (a) 结构示意图; (b) 转移特性曲线; IGO-TFT (c) 和PrIGO-TFT (d) NBIS稳定性


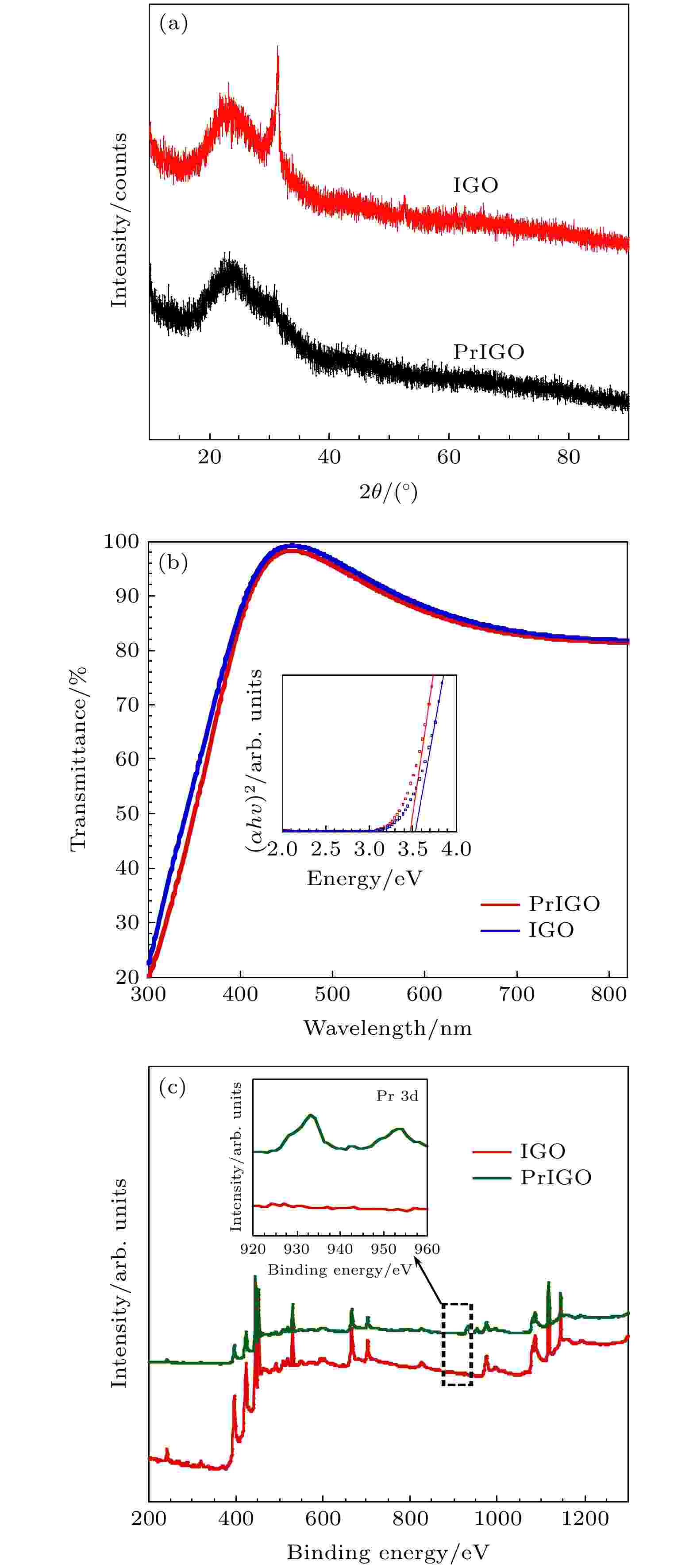 图 2 IGO和PrIGO薄膜 (a) X射线衍射谱图; (b) 紫外-可见透射光谱图 (插图为 (αhv)2随hv变化曲线); (c) X射线光电子能谱图 (插图为局部放大图)
图 2 IGO和PrIGO薄膜 (a) X射线衍射谱图; (b) 紫外-可见透射光谱图 (插图为 (αhv)2随hv变化曲线); (c) X射线光电子能谱图 (插图为局部放大图)

 图 3 IGO-TFT和PrIGO-TFT归一化噪声功率谱密度随频率的变化
图 3 IGO-TFT和PrIGO-TFT归一化噪声功率谱密度随频率的变化




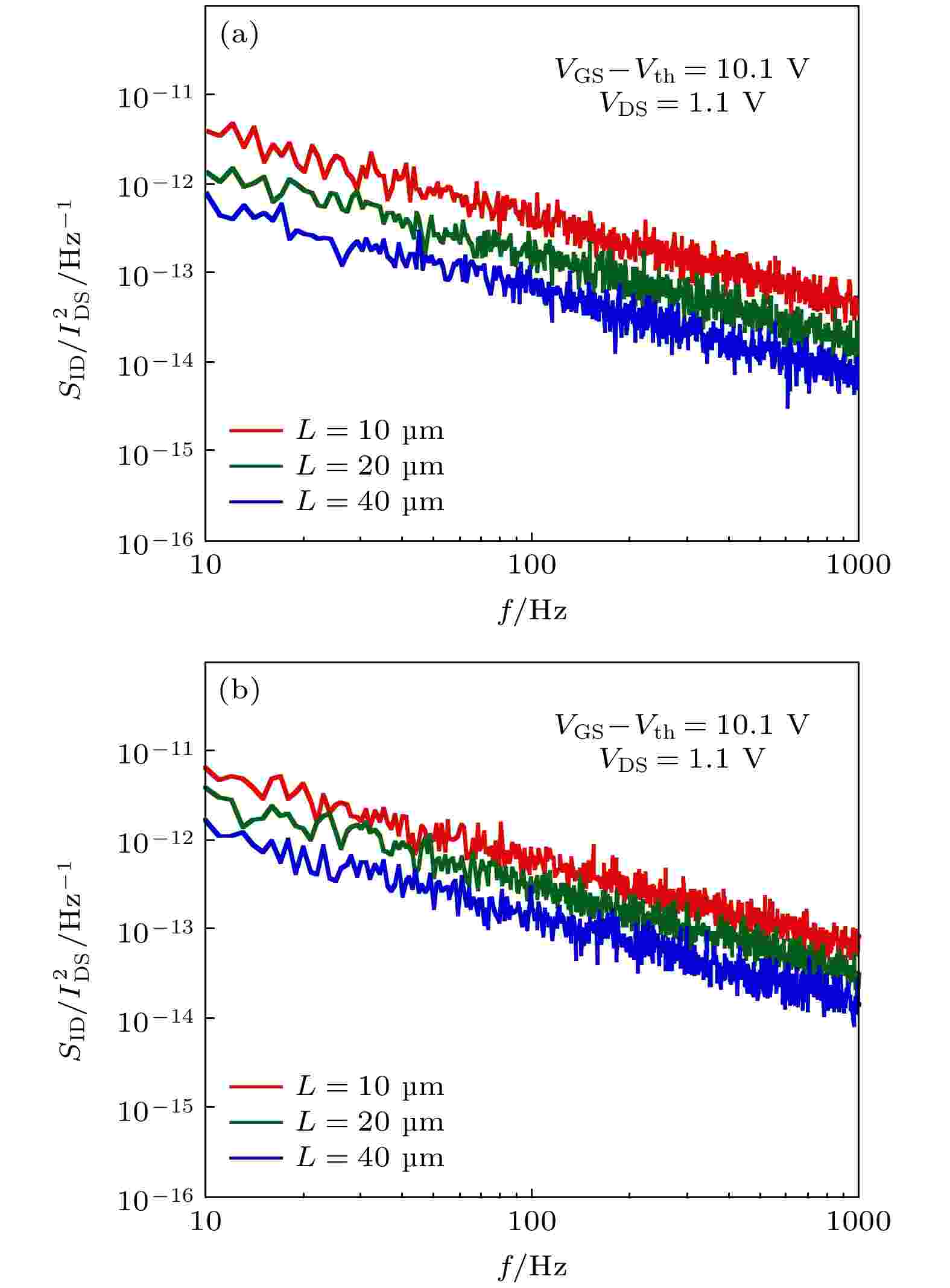 图 4 不同沟道长度的IGO-TFT (a) 和PrIGO-TFT (b) SID/I2DS随频率的变化
图 4 不同沟道长度的IGO-TFT (a) 和PrIGO-TFT (b) SID/I2DS随频率的变化

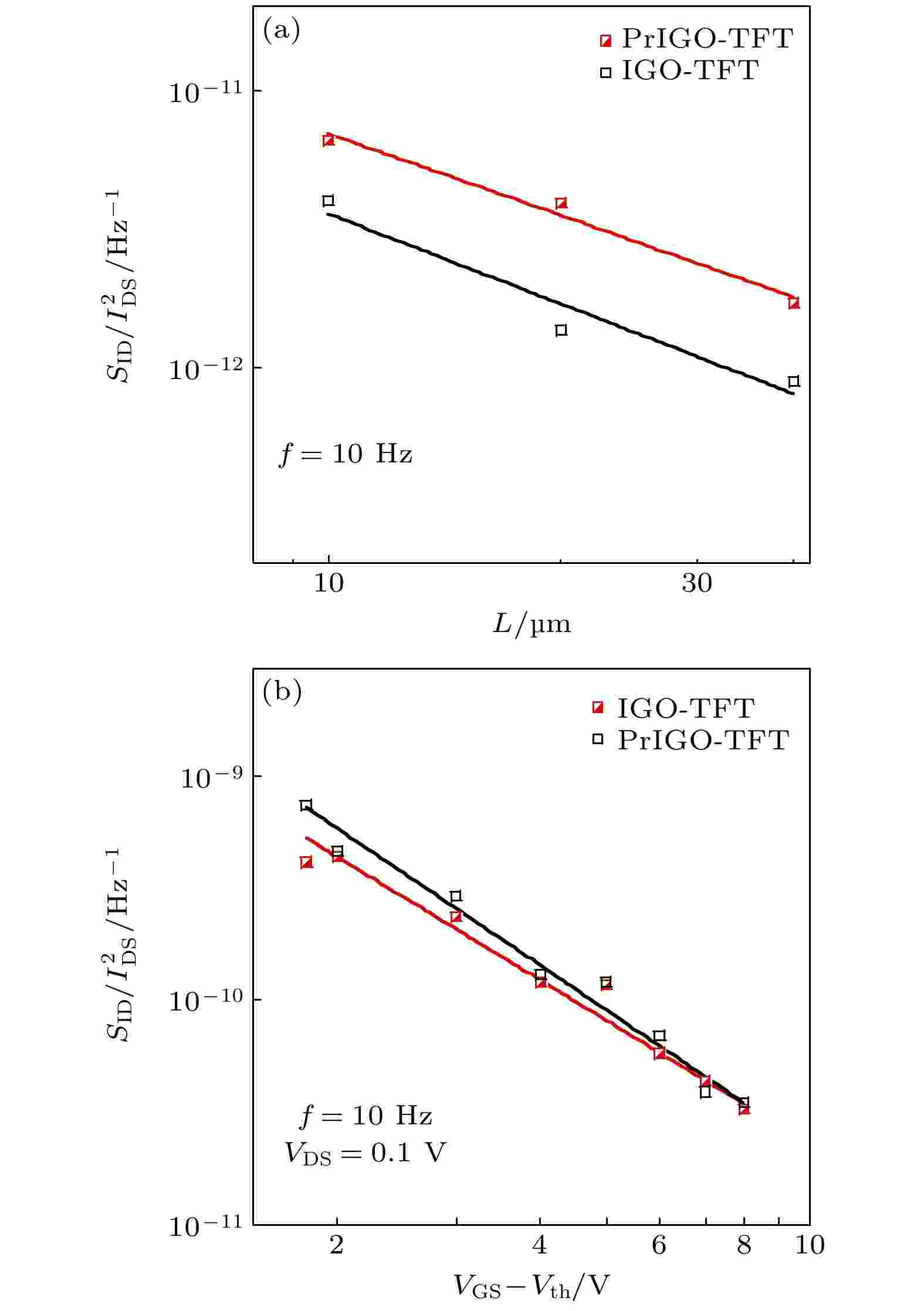 图 5 IGO-TFT和PrIGO-TFT (a) SID/I2DS随沟道长度的变化; (b) SID/IDS2随过驱动电压VGS–Vth的变化
图 5 IGO-TFT和PrIGO-TFT (a) SID/I2DS随沟道长度的变化; (b) SID/IDS2随过驱动电压VGS–Vth的变化
















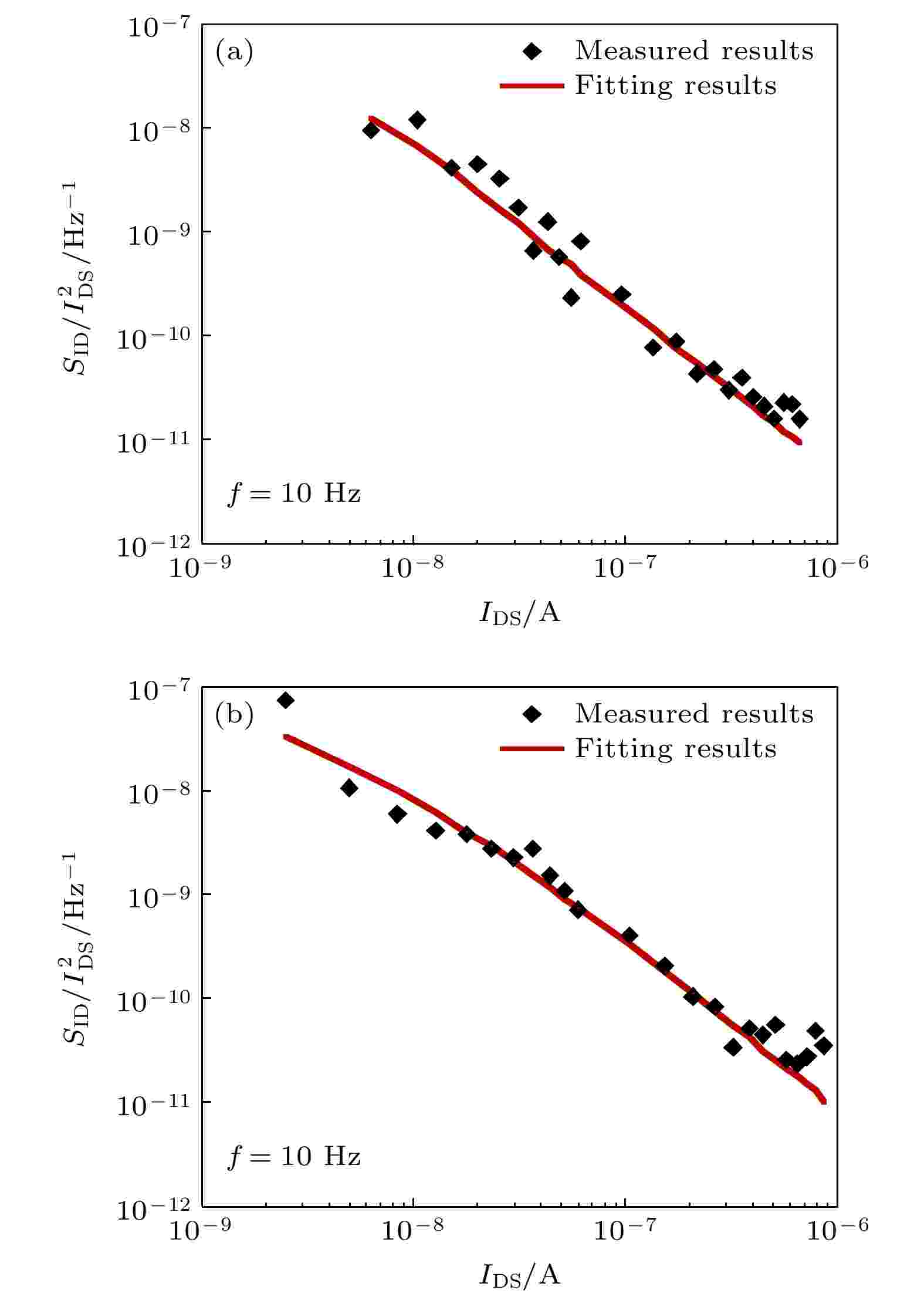 图 6 IGO-TFT (a) 和PrIGO-TFT (b) SID/I2DS随沟道电流的变化
图 6 IGO-TFT (a) 和PrIGO-TFT (b) SID/I2DS随沟道电流的变化
