全文HTML
--> --> -->目前国内外大多数VCSEL的研究集中于808, 850, 980 nm等波段[11-17], 对于905 nm VCSEL研究较少. 据了解, 只有TriLumina 公司初步报道了高峰值功率的905 nm VCSEL阵列的结果[18], 以及Zhang等[19]报道了910 nm VCSEL阵列实现了100 W峰值功率输出. 而对905 nm VCSEL的高功率转换效率的详细设计与制备的研究, 还未见报道. 在实际的应用中, VCSEL的功率转换效率(power conversion efficiency, PCE)是非常关键的指标. 因为功率转换效率越高, 器件在相同的输出功率下会产生更少的热量, 有利于提高器件的可靠性和寿命, 同时也可降低设备散热成本, 提高电池的使用时长. 因此, 在移动设备和微型激光雷达等应用均要求激光光源具有高PCE. 针对不同的应用, 不同波段的VCSEL的功率转换效率也有差别. 例如, 850 nm波段多用于短距离光互联领域, 由于短腔长、低能耗的设计, VCSEL的PCE一般在30%—35%之间[20,21]; 1310 nm和1550 nm波段可用于中远距离通信, 但由于有源区与DBR材料的不匹配, 外延和制备的难度较大, 使VCSEL的PCE一般低于35%[22,23]. 808 nm VCSEL一般用于固体激光器的泵浦源, 目前报道的大功率VCSEL阵列的PCE可达39%以上[24]. 对于980 nm波段, 由于GaAs材料对该波段透明, 因此980 nm的VCSEL可以设计成底发射结构, 很大程度上提高了器件的散热性能, 使其最大PCE可达51.2%[25].
本论文首先分析了VCSEL中影响PCE的主要因素, 然后对905 nm VCSEL的有源区、反射镜等外延结构进行了优化设计, 最后成功制备出具有高PCE的多种孔径的905 nm VCSEL器件, 并对其LIV特性、远场和光谱等进行了详细的测试分析.



















传统的VCSEL有源区一般采用GaAs/AlGaAs作为量子阱材料, 这种体系的量子阱结构简单, 易于生长. 为了提高量子阱微分增益, 采用具有应变的InxGa1–xAs/AlxGa1–xAs量子阱结构. 这是因为应变可以增大价带的曲率, 降低价带的有效质量, 使得准费米能级的间隔更为对称, 且两个准费米能级尽可能地接近带边, 降低了透明载流子浓度, 从而提高了有源区的微分增益[28]. 值得注意的是, 有源区增益谱和腔模均会随温度上升而发生红移, 而增益谱的红移速度(0.3 nm/℃左右)要比腔模的红移速度(0.065 nm/℃左右)快, 因此需要设计一定的增益谱峰值与腔膜的失谐补偿, 一般为10—15 nm. 利用8-band k·p能带理论[29]首先计算了量子阱宽度为6 nm, 势垒层宽度为8 nm的不同In组分的InxGa1–xAs /Al0.3Ga0.6As量子阱增益谱的变化趋势, 如图1所示. 可以看出, 随着In组分的增大, 增益谱峰值发生红移.
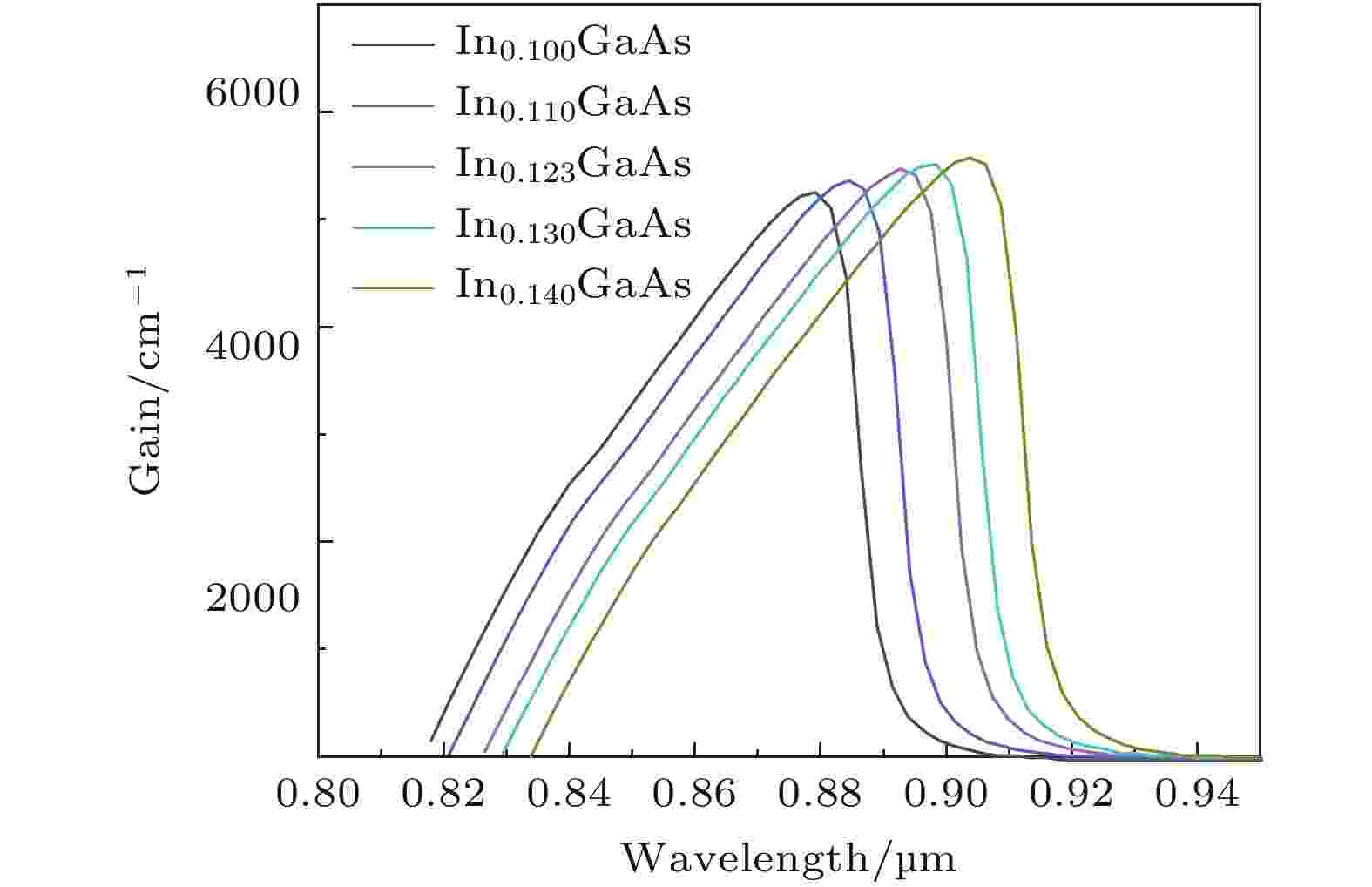 图 1 不同In组分下的InxGa1–xAs /Al0.3Ga0.6As量子阱增益谱(载流子浓度为5 × 1018 cm–3)
图 1 不同In组分下的InxGa1–xAs /Al0.3Ga0.6As量子阱增益谱(载流子浓度为5 × 1018 cm–3)Figure1. Gain spectra of InxGa1–xAs/Al0.3Ga0.6As QW with different In compositions (carrier concentration is 5 × 1018 cm–3).
量子阱层厚度的增大也会使增益谱峰值发生红移. 在设计量子阱材料时, 需要同时调节阱层厚度和In组分的大小使增益峰值位于892 nm附近, 以得到13 nm左右的失谐波长. 为了得到更大的增益, 需要对阱层厚度和In组分进行优化. 图2为计算的势垒层厚度固定为8 nm时, 不同阱层厚度和In组分下的3对量子阱的增益峰值随载流子浓度的变化关系. 图2中设计的量子阱的增益峰值均位于892 nm附近. 从图中可以看出, 当阱层较厚时, 虽然获得固定的材料增益所需的载流子密度降低, 但是材料增益曲线的斜率下降, 也更容易出现饱和现象. 当阱层较窄时, 材料增益曲线斜率增大. 但是如果阱层厚度太窄, 基态能级上升, 那么基态与垒层顶端之间的能量差会变小. 由于载流子填充时首先要填充基态, 电子跳出阱层所需要克服的势垒会进一步降低, 那么载流子发生泄漏的概率会明显增加[30]. 因此, 量子阱厚度太厚或太薄均会影响发光区的增益性能, 不利于器件的稳定工作. 经过综合考虑, 采用量子阱材料为In0.123GaAs, 阱厚度为6 nm, 势垒层为Al0.3Ga0.6As材料, 厚度为8 nm.
 图 2 不同量子阱厚度、In组分下的InxGa1–xAs/Al0.3Ga0.6As量子阱增益随载流子浓度的变化
图 2 不同量子阱厚度、In组分下的InxGa1–xAs/Al0.3Ga0.6As量子阱增益随载流子浓度的变化Figure2. Gain spectra of InxGa1–xAs/Al0.3Ga0.6As QW with different well widths and In compositions versus carrier density.
VCSEL谐振腔是由有源区、N型和P型分布布拉格反射镜(distributed Bragg reflectors, DBRs)组成. DBRs的优化设计对于VCSEL输出特性的提升也至关重要. P-DBRs和N-DBRs的对数会影响腔面的反射率以及串联电阻. 由于电子的迁移率远大于空穴, 因此N-DBRs引起的串联电阻较小, 在设计时只考虑其反射率. 为了减小腔内损耗, 将N-DBRs的对数设计为40对, 使其反射率接近100%. P-DBRs的对数会对斜率效率和串联电阻有较大影响, 如果P-DBRs的对数过多, 虽然可以减小阈值电流, 但是会使斜率效率降低, 同时也会增大串联电阻. 考虑到斜率效率是影响PCE的主要因素, 在设计时需要适当减小P-DBRs的对数来获得高斜率效率. 图3为利用传输矩阵法[28]计算的不同对数的P型DBRs的反射率. 当P-DBRs对数为16, 18, 20, 22时, 905 nm波长处对应的反射率分别为98.05%, 98.82%, 99.20%, 99.51%. P-DBRs的对数选择需保证拥有足够的反射率(一般99%以上)实现激光器的激射. 由于P-DBRs对数的减少会引起阈值电流增大, 使获得高PCE的工作电流也变大, 因此设计时也需要同时考虑VCSEL器件实际工作的电流范围. 根据实验测得, 当P型DBR对数为22对时, 阈值电流和斜率效率分别为0.55 mA和0.87 W/A. 当P型DBR对数为20对时, 阈值电流和斜率效率分别为0.85 mA和1.11 W/A. 可以看出, P型DBR减小2对后, 斜率效率获得了较大提升, 而且阈值也在合适的范围. 当P型DBR对数减小为18对时, 阈值电流增大到1.2 mA, 斜率效率稍微增大, 为1.13 W/A. 经过折中考虑, 选取的P-DBRs为20对Al0.9Ga0.1As/Al0.12Ga0.88As组成, 为减小材料间势垒, 中间插入20 nm的AlGaAs组分渐变层.
 图 3 计算的不同对数的P-DBRs的反射谱
图 3 计算的不同对数的P-DBRs的反射谱Figure3. Calculated reflection spectra of P-DBRs with different pairs.
设计完成后, 利用型号为Axitron G4 的MOCVD设备进行外延生长. 首先, 在N型掺杂的GaAs衬底上交替生长40对Al0.9Ga0.1As/Al0.12Ga0.88As的N-DBRs, 为了减小材料间势垒, 中间插入生长20 nm的AlGaAs渐变层; 然后, 生长Al0.3GaAs限制层和3对In0.123Ga0.88As/Al0.3Ga0.7As量子阱; 之后生长20 nm的Al0.98Ga0.02As层, 作为氧化限制层; 再交替生长20对Al0.9Ga0.1As/Al0.12Ga0.88As的P型DBRs, 最后, 生长重掺杂的P型欧姆接触层. 完成外延生长后, 测试了外延片的白光反射谱和PL谱, 分别如图4(a),(b)所示. 测试的腔模位置位于为903.7 nm附近, 与设计值接近. 量子阱PL谱的峰值为893.7 nm, 半高全宽(FWHM)为21.6 nm, 说明量子阱的生长质量较好.
 图 4 测试的905 nm VCSEL外延片的 (a)白光反射谱和(b) PL谱
图 4 测试的905 nm VCSEL外延片的 (a)白光反射谱和(b) PL谱Figure4. Measured (a) white light reflection spectrum and (b) PL spectrum of 905 nm VCSEL epitaxial wafer.
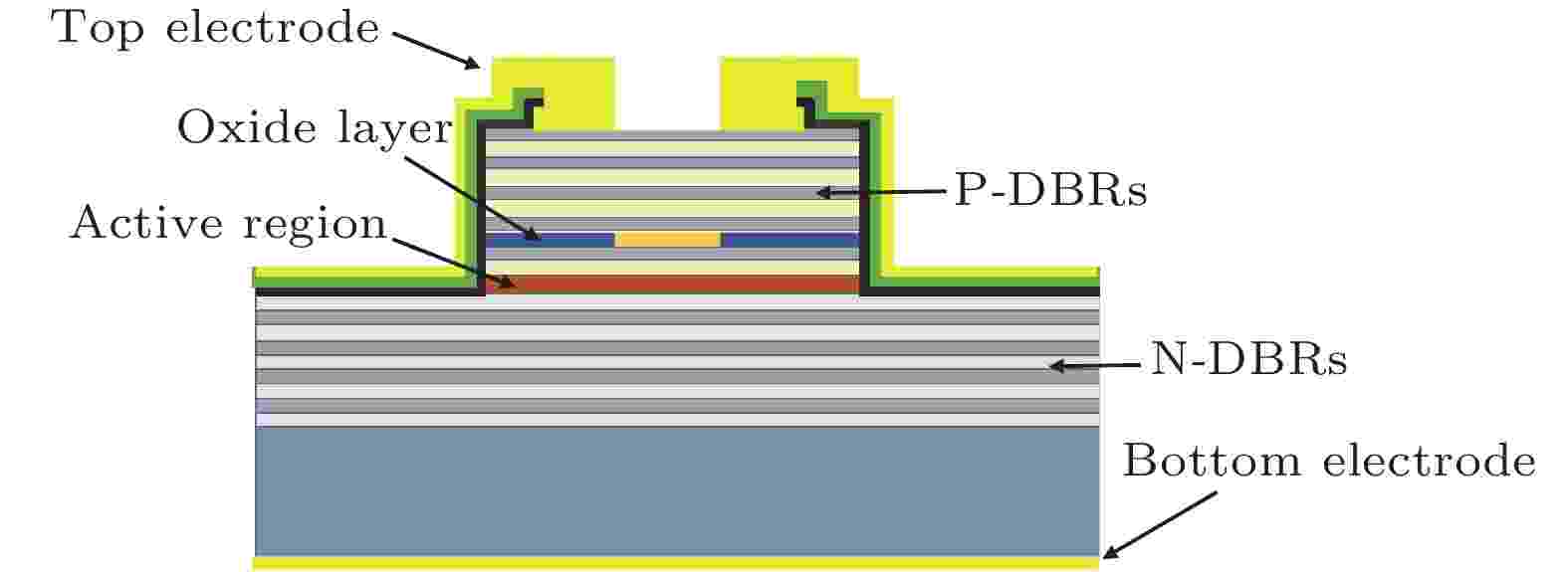 图 5 VCSEL器件结构示意图
图 5 VCSEL器件结构示意图Figure5. Schematic diagram of VCSEL device structure.
在室温下对制备的VCSEL器件进行了测试, 采用的测试系统主要包括: 探针台、校准的光电探测器、半导体参数分析仪(Keithley 236)、高精度的电流源(keithley 2601 B)、光束质量分析仪(Spiricon SP928)以及高分辨率光谱分析仪(Advanst Q8384). 测得不同氧化孔径的905 nm VCSEL器件在连续电流条件下的光功率-电流-电压(LIV)特性曲线如图6(a),(b)所示. 提取的阈值电流、最大功率、饱和电流和阈值损耗功率如图6(c)—6(f)所示. 可以看出, 阈值电流随着氧化孔径的增大而增大, 最大输出功率和饱和电流随着氧化孔径的增大呈现近似线性的变化. 当氧化孔为6 μm时, 最大出光功率达到10.5 mW, 阈值电流为0.35 mA; 当氧化孔为18 μm时, 最大出光功率达到32.8 mW, 阈值电流为2.1 mA. 氧化孔径越大, 微分电阻越小, 而且热翻转电流越大, 分别如图6(b)和6(e)所示.
 图 6 不同氧化孔径的VCSEL对应的 (a)输出功率-电流特性; (b) 电压-电流特性; (c)阈值电流; (d)最大功率; (e)饱和电流; (f)阈值损耗功率
图 6 不同氧化孔径的VCSEL对应的 (a)输出功率-电流特性; (b) 电压-电流特性; (c)阈值电流; (d)最大功率; (e)饱和电流; (f)阈值损耗功率Figure6. (a) L-I characteristics; (b) V-I characteristics; (c) threshold currents; (d) maximum output powers; (e) roll-over currents; (f) threshold power consumption of VCSELs with varied oxide apertures.
图7(a)为不同氧化孔径的VCSEL对应的斜率效率随注入电流的变化曲线, 其对应的最大斜率效率被提取在图7(b)中. 其中, 氧化孔为10 μm的VCSEL对应的峰值斜率效率最高, 达到1.12 W/A, 其他氧化孔径的峰值斜率效率也能达到1.05 W/A以上. 这说明实验制备的VCSEL具有较高的斜率效率, 与外延设计的预期结果相符. 不同氧化孔下的PCE随注入电流的变化曲线如图7(c)所示, 随着注入电流的增大, PCE的变化呈现先快速增大, 达到峰值后缓慢下降的趋势. 可以发现, 氧化孔径越大, PCE达到峰值后随注入电流的下降速度越缓慢. 不同氧化孔径下的VCSEL的最大PCE的值处于42.2%—44.8%范围内. 其中, 氧化孔为10 μm时, VCSEL的峰值PCE最大, 为44.8%. 即使在氧化孔径为18 μm时, 仍然可以得到42.2%以上的PCE, 如图7(d)所示. 可以看出, 研制的905 nm VCSEL器件具有非常高的PCE. 高PCE的905 nm VCSEL对于高性能激光雷达的应用具有重要意义. 可以观察到, PCE随氧化孔径的变化趋势与斜率效率随氧化孔径的变化趋势基本一致, 验证了前文中的结论, 即斜率效率对PCE的贡献最大.
 图 7 测试的不同氧化孔径的VCSEL的 (a)斜率效率; (b)提取的最大微分斜率效率; (c) PCE; (d)提取的最大PCE的值
图 7 测试的不同氧化孔径的VCSEL的 (a)斜率效率; (b)提取的最大微分斜率效率; (c) PCE; (d)提取的最大PCE的值Figure7. Measured (a) slope efficiency; (b) extracted maximum differential slope efficiency; (c) PCE and (d) extracted maximum PCE for VCSELs with varied oxide apertures.
通过测试不同氧化孔径下的VCSEL的远场和光谱图案. 图8所示为注入10倍阈值电流的结果. 当氧化孔径为6 μm, 注入电流为2.5 mA时, 远场光强分布较为均匀, 此时1/e2处对应的发散角为18.8°. 从激射的光谱图中可以看到, 此时仅有3个峰值, 分别为901.22, 901.8和902.5 nm. 当氧化孔径为10 μm, 注入电流为6.9 mA时, 远场中心强度相对于边缘位置变弱, 呈现类似于环状分布, 此时的发散角为23.5°. 激射的光谱图中出现多个峰值, 且每个峰值的间距变小, 这是由于大氧化孔径下会有更多的高阶模式激射的结果, 成为导致发散角增大的主要因素. 当氧化孔径为14 μm和18 μm时, 远场图的中心强度变得更弱, 发散角也变的更大, 分别为25.5°和28.0°, 这是由于更多的模式激射以及电流注入不均匀造成的. 此时的光谱出现更多的峰值, 并且间隔变得更小. 可以得出, 随着氧化孔径的增大, 远场发散角变大, 远场中心强度变弱, 光谱宽度变大, 各横向模式间隔变小. 虽然大氧化孔径可以得到更高的输出功率, 但光谱和光束质量会变差, 因此在实际应用中需要在诸多因素中权衡考虑.
 图 8 不同氧化孔径的VCSEL的远场和光谱
图 8 不同氧化孔径的VCSEL的远场和光谱Figure8. Far-field and spectra of VCSELs with different oxide apertures.
