全文HTML
--> --> -->2012年, 日本东北大学Kamada与捷克物理所Nikl等[7]根据“能带工程”的指导方法, 通过采用Gd3+与Ga3+分别对LuAG晶体中的Lu3+与Al3+进行全部或部分的置换, 首次制备出直径为2英寸的Gd3Al2Ga3O12:Ce晶体, 其光产额高达46000 photon/MeV. 2015年, 中国科学院上海硅酸盐研究所Wang等[8]首次报道了我国GAGG:Ce晶体的改性研究. 通过采用Y3+置换部分Gd3+得到的Gd2YAl2.3Ga2.7O12:Ce晶体, 其光产额高达(65000 ± 3000) photon/MeV.
在对晶体发光性能进行研究时, Chewpraditkul等[9]发现GAGG:Ce晶体中存在的浅电子陷阱严重影响晶体的发光效率. 2018年, Kitaura等[10]不仅观察到类似的现象, 且通过密度泛函理论(density functional theory, DFT)计算进一步证明GAGG:Ce晶体浅电子陷阱形式为原本应占据八配位格位的Gd3+离子占据了原本应由Al3+或Ga3+离子占据的六配位格位后所形成的GdAl/Ga反格位缺陷, 而且其形成能与晶体成分相关, 但这种反格位缺陷与晶体发光性能以及成分之间的内在关系一直缺乏合理的解释. 此外, GAGG:Ce晶体生长过程中易出现包裹体等宏观缺陷, 严重影响了GAGG:Ce晶体的透光性, 且其内在成因的研究明显不足.
为了阐明GAGG:Ce晶体缺陷的来源, 最大限度地提高晶体性能的均匀性, 本文通过X射线衍射、扫描电子显微镜EDS能谱(energy dispersive spectrometer)、荧光光谱及多道能谱等手段对晶体的物相结构、成分、光谱性质、发光及时间性能进行表征和对比分析, 阐明了包裹体宏观缺陷的来源及GdAl/Ga反格位缺陷与晶体成分、性能的内在关系, 进而提出相应的解决方案, 以期对该晶体的生长和应用提供理论依据.
2.1.样品制备
采用中频感应加热提拉法制备晶体, 中频频率约为8 kHz. 以纯度为4N的Gd2O3, Al2O3, Ga2O3,CeO2为原料, 按照化学分子式(Ce0.03Gd2.97Al2.3Ga2.7O12)称取原料, 将原料充分混合均匀后经冷等静压压制成块, 放入铱金坩埚中. 晶体生长过程中, 采用自然析晶方向的籽晶, 拉速为0.5—2 mm/h, 转速为5—13 r/min, 充入高纯N2作为气氛保护铱坩埚, 并充入少量O2以抑制组分中Ga2O3的挥发. 晶体生长经历了升温、接种、放肩、等径生长、收尾和降温过程, 最终生长出GAGG:Ce晶体.2
2.2.样品表征
晶体的物相结构通过德国Bruker公司生产的X射线衍射仪(D8 Discover)测试, 辐射源为Cu-Kα射线, 电压为40 kV, 电流为40 mA, 2θ角扫描范围为10°—90°, 扫描速度为1.2°/min; 样品的微区形貌采用TM3030型场发射扫描电子显微镜观测, 并通过其自带EDS能谱仪对晶体成分进行表征, 加速电压为5—15 kV, 放大倍数范围为15—30000, 能量分辨率优于135 eV.晶体样品的透过光谱通过日本日立公司生产的紫外分光光度计(U-3900 H)测定, 测试波长范围为200—800 nm, 步长为2 nm, 步速为600 nm/min; X射线激发发射谱通过中国科学院上海硅酸盐研究所自制X射线激发发射光谱仪测得; 为了测得不同时间门宽晶体光产额, 采用美国ORTEC公司生产的digiBASE型多道能谱仪, 光电倍增管(R878型)与晶体间采用空气耦合, 除耦合面外其余晶体表面包覆有增强型镜面反射层, 采用能量为662 keV的γ射线激发(放射源为137Cs)样品, 电压为–1000 V, 时间门宽为0.75—2 μs. 晶体样品的衰减时间测试采用脉冲X射线源, 辐射平均能量为200 keV.
以上光谱、发光及闪烁性能测试所用样品尺寸均为15 mm × 15 mm × 2 mm, 样品均六面抛光, 所有测试均在室温下进行.
 图 1 GAGG:Ce晶体及样品照片
图 1 GAGG:Ce晶体及样品照片Figure1. Photos of GAGG:Ce crystal and samples.
2
3.1.GAGG:Ce晶体的成分与物相结构
采用EDS能谱表征GAGG:Ce晶体样品1与样品2 (取样位置见图1)的成分, 以初步验证不同晶体部位样品成分的差异. 根据检测数据计算得到Gd-Al-Ga元素对应的离子数, 如表1所列, 其中晶体的理论配比为Gd3Al2.3Ga2.7O12, 可以看出, 样品1中Al与Ga的浓度和低于理论配比, 而Gd的浓度则高于理论配比. 样品2中的成分结果则与之相反. 这种晶体不同部位的基质成分差异主要有两方面原因: 一是GAGG:Ce晶体的初始析晶温度为1750 ℃, 而Ga2O3的熔点为1700 ℃, 因此推测熔体在晶体生长初期存在Ga2O3的分解并挥发的现象[12], 进而导致晶体头部(样品1)中Ga的浓度降低, 而随着晶体生长的进行, 温度下降后, 熔体中的Ga2O3的分解挥发量逐渐变少; 二是由于Ga在GAGG基质中的分凝系数为0.9—1[14], 因此随晶体生长进行, 其浓度逐渐升高. 基于此, 可以初步判定样品1的成分相比于理论配比表现为(Al, Ga)缺乏而Gd富余, 样品2为(Al, Ga)过量.| Sample | Gd | Al | Ga | Al + Ga |
| ion ratio | ||||
| 1 | 3.034 | 2.274 | 2.692 | 4.966 |
| 2 | 2.985 | 2.213 | 2.802 | 5.015 |
| Theoretical value | 3 | 2.3 | 2.7 | 5 |
表1GAGG:Ce晶体的EDS成分分析
Table1.Composition analysis data by EDS of GAGG:Ce crystal.
采用X射线衍射仪(XRD)表征GAGG:Ce晶体粉末样品的物相结构, 如图2所示. 从图2可以看出, 样品1与2的特征峰与石榴石结构的GAGG相(PDF#46-0448)完全对应, 未出现第二相衍射峰, 这表明样品中的第二相的含量未达XRD检测下限. 样品的主衍射峰位于32°—33° (2θ)之间, 对应(420)晶面. 从图2插图可知, 衍射峰位由32.8°向低角度偏移至32.73°. 根据布拉格方程及立方晶系的晶面间距公式计算GAGG:Ce样品的晶胞参数, 其公式如下:
 图 2 GAGG:Ce样品粉末XRD图谱
图 2 GAGG:Ce样品粉末XRD图谱Figure2. XRD patterns of GAGG:Ce crystal.
| Sample | 1 | 2 |
| Diffractive angle (2θ)/(°) | 32.8 | 32.73 |
| Lattice parameters/nm | 12.2492 | 12.2516 |
表2GAGG:Ce晶体的晶胞参数
Table2.Lattice parameters of GAGG:Ce crystal at different positions.
2
3.2.GAGG:Ce晶体缺陷对光谱性质的影响
图3(a)和图3(b)为Ce3+在GAGG晶体场作用下的能级结构图[15]和透过光谱. 在GAGG:Ce晶体中, Ce3+替位占据原本由Gd3+占据的十二面体格位. 受晶体场作用, Ce3+的4f基态劈裂为2F5/2和2F7/2双重态; 而5d能态劈裂为5个子能级, 其中较高能量的3个子能级被淹没于导带中, 5d1和5d2为5d的两个低子能级. 如图3(b)中透过光谱的谱线所示, 电子从4f基态2F5/2向5d1和5d2的跃迁会分别形成340和440 nm两个吸收峰, 对应的吸收能量分别为2.8 eV和3.64 eV, 这表明5d1和5d2间的能隙为0.84 eV. 从图3(b)可知, 宏观缺陷较多的GAGG:Ce晶体样品2在500—800 nm波段的直线透过率相较于样品1由82%降至70%. 此外, 位于253 nm (4.9 eV), 275 nm (4.5 eV)和317 nm (3.9 eV)处[15]的小吸收峰分别对应于Gd3+的8S7/2向6D, 6P和6I的跃迁. 图 3 GAGG:Ce晶体的能级结构图(a)与透过谱(b)
图 3 GAGG:Ce晶体的能级结构图(a)与透过谱(b)Figure3. Energy diagram (a) and transmittance (b) of GAGG:Ce crystal sample.
基于以上晶体光谱性质的分析可知, 样品2中透光性能下降的原因初步判定为: 随着生长的进行, 晶体尾部包裹体等宏观缺陷浓度高于头部, 由于杂相包裹体与GAGG相折射率不同, 因此导致晶体的透过性能下降. 为进一步揭示GAGG:Ce晶体中包裹体等宏观缺陷的来源以找到其解决方法, 通过扫描电子显微镜初步观察缺陷区域的形貌, 如图4所示. 从图4(a)和图4(b)可以看出, GAGG:Ce晶体的包裹体分为两类: 一类呈三角形或四边形的灰色包裹体; 另一类呈黑白色相间包裹体. 通过截线法统计了30个包裹体的尺寸, 得到晶体样品中片状包裹体的平均尺寸为(10 ± 3) μm, 黑白色相间包裹体的平均尺寸为(30 ± 5) μm.
 图 4 GAGG:Ce晶体微区形貌分析 (a) 片状包裹体; (b) 黑白相间状包裹体
图 4 GAGG:Ce晶体微区形貌分析 (a) 片状包裹体; (b) 黑白相间状包裹体Figure4. Micro-region morphology analysis of GAGG:Ce crystal: (a) Lamellar inclusions; (b) black and white interphase inclusions.
采用扫描电子显微镜及EDS能谱表征GAGG:Ce晶体样品的微区成分, 进一步分析两类包裹体的成因. 表3列出了各对应区域的EDS能谱成分分析结果. 检测结果表明, 在包裹体附近的基质区域(取样点2, 5)中, n(Gd)∶n(Al, Ga)∶n(O) ≈ 3∶5∶12, 与GAGG基质中四种离子的理论比例一致, 由于Ce3+在GAGG基质中分凝系数只有0.3左右, 含量很低, 未达EDS能谱检测极限, 因此在成分分析中没有检测到Ce的含量. 灰色包裹体(取样点1)中, n(Gd)∶n(Al, Ga)∶n(O) ≈ 3.5∶4.5∶12. 晶体生长过程中, 由于存在Ga2O3的挥发分解导致组分偏向富Gd一侧, 因此可以判定灰色包裹体为富Gd相包裹体, 主要存在于晶体头部. 黑白色相间的包裹体中白色部分(取样点3)中, Ce3+含量是理论值的40倍, 可以判定其为富Ce相包裹体; 而黑色部分(取样点4)中未检测到Gd3+和Ce3+, 且n(Al, Ga)∶n(O) ≈ 2∶3, 这表明该部分的主要成分为(Al,Ga)2O3. 根据晶体微区成分分析的结果可以推断晶体黑白色相间排布包裹体的形成机制: 在GAGG:Ce晶体结构中, Ce3+离子占据Gd3+离子的十二面体格位, 且Ce3+离子半径(114.3 pm)大于Gd3+离子半径(105.3 pm), 这导致Ce3+离子在GAGG基质中的分凝系数较小(0.3左右), 晶体对Ce3+离子的排杂效应较强, 进而导致熔体中Ce3+离子的浓度不断增加. 此外, 铝酸盐熔体黏度较大且对流缓慢, 使得生长界面排杂出的Ce3+离子不能及时扩散, 致使固液面局部熔体组分不均, 导致熔体表面张力梯度和流体热传递不再稳定, 该区域平整的生长界面遭到破坏进而形成凹槽, 富(Al,Ga)2O3相的组分填充至凹槽中, 最终形成富Ce相与(Al,Ga)2O3相相间排列的包裹体[16], 主要存在于晶体尾部.
| 取样点 | Gd | Ce | Al | Ga | Al + Ga | O | (Gd + Ce)∶(Al + Ga)∶O |
| Atomic percentage | 离子数之比 | ||||||
| 1 | 17.61 | — | 10.33 | 12.06 | 22.39 | 60 | 3.5∶4.5∶12 |
| 2 | 14.97 | — | 11.11 | 13.92 | 25.03 | 60 | 3∶5∶12 |
| 3 | 3.71 | 20.57 | 4.45 | 11.26 | 15.71 | 60 | 4.9∶3.1∶12 |
| 4 | 1.19 | — | 17.9 | 20.91 | 38.81 | 60 | 0.06∶2∶3 |
| 5 | 15.06 | — | 10.63 | 14.31 | 24.94 | 60 | 3∶5∶12 |
表3GAGG:Ce晶体的EDS能谱微区成分分析数据
Table3.Micro-region composition analysis data by EDS of GAGG:Ce crystal.
2
3.3.GAGG:Ce晶体缺陷对发光性能的影响
在电离辐射探测器等应用中, 为了提高信噪比、降低统计波动, 进而对闪烁发光信号进行有效提取, 此类探测器要求GAGG:Ce晶体发光波段的光学透过性能高, 且晶体的发光效率高. 在晶体光谱性质分析的基础上, 进一步研究了GAGG:Ce晶体的发光性能, 如图5所示. 从图5(a)的X射线激发发射谱中可以看出, 在X射线激发下, 位于500—700 nm波长区间出现了一个不对称的宽发光带, 这是Ce3+的电子从5d激发态向4f基态跃迁辐射引起的. 据研究, 图5(a)插图所示位于380 nm处的发射是由GAGG:Ce晶体中存在的GdAl/Ga反格位缺陷引起的, 在LuAG:Ce[17]及YAG:Ce[18]的发射光谱中也观察到相似的现象, 其形成机理如下: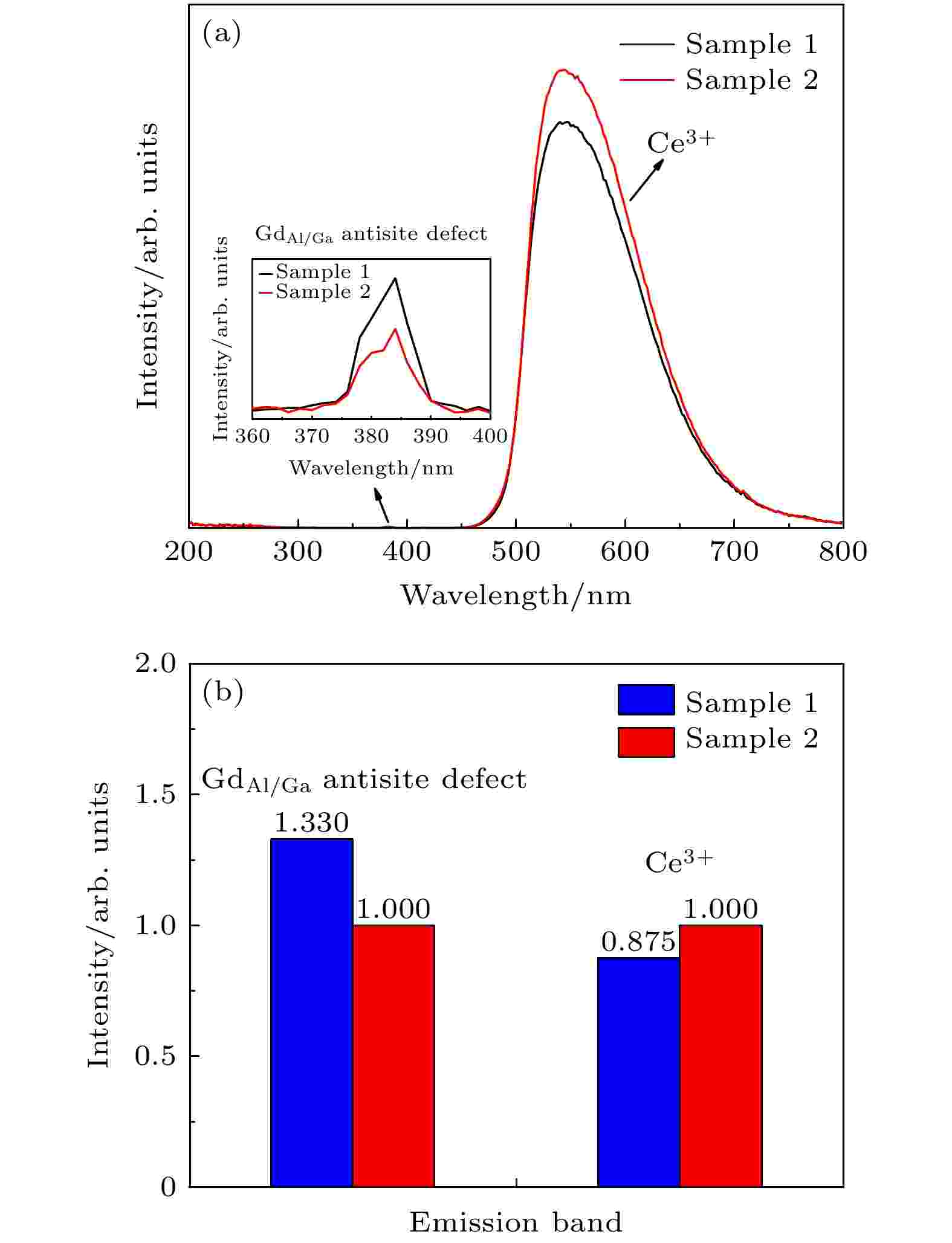 图 5 GAGG:Ce晶体的X射线激发发射谱(a)和积分强度(b)
图 5 GAGG:Ce晶体的X射线激发发射谱(a)和积分强度(b)Figure5. X-ray excited spectra (a) and integrated intensity (b) of GAGG:Ce crystal.
通过对图5(a)中Ce3+及GdAl/Ga反格位缺陷两处发光带进行积分(图5(b))可以更加清晰地看出, 样品1在位于Ce3+发光波段的积分强度为样品2的87.5%, 而380 nm处反格位缺陷发光区域样品1的积分强度则为样品2的133%. 图5(b)更直观地展示出GdAl/Ga反格位缺陷与晶体发光性能及晶体成分之间的内在关系: 随着样品1中(Al, Ga)浓度降低(Gd浓度升高), 相较于理论配比的晶体, 其Gd3+取代八面体格位中Al3+/Ga3+形成GdAl/Ga反格位缺陷的概率更高, 因此其在380 nm波段处发光更强. GdAl/Ga反格位缺陷在380 nm处的发射与GAGG:Ce在340 nm附近的吸收重叠, 这导致室温下Ce3+的发光可能被GdAl/Ga反格位缺陷的发光所激发, 进而导致GAGG:Ce晶体的发光强度降低. 这也进一步证实了相比富(Al,Ga)的晶体组分而言, GAGG:Ce晶体在(Al,Ga)组分缺乏时, 晶体中的GdAl/Ga反格位缺陷的形成能更低[10]. 此外, 晶体微区成分分析(表3)表明样品2中的Ce浓度更高, 因此其在340 nm处的吸收更强, 进而抑制了位于380 nm波段处GdAl/Ga反格位缺陷的发光, 这也是样品2中380 nm处发光强度较低的另一原因.
为进一步表征GAGG:Ce晶体的光产额及能量分辨率, 在137Cs源激发下测试了提拉法生长尺寸为15 mm × 15 mm × 2 mm的GAGG:Ce样品的多道能谱, 如图6所示. 从图6可以看出, 样品1与样品2的全能峰分别位于524, 578道, 通过比较662 keV的γ射线(137Cs源)的全能峰峰位可以得出其对应的光产额分别为52000 photon/MeV与58500 photon/MeV. 通过将全能峰拟合后可得样品1与样品2的能量分辨率分别为7.4%@662 keV与6.1%@662 keV. 以上结果表明, 本研究中Gd3Al2.3Ga2.7O12:Ce晶体样品的光输出与国际报道[19]的最高值56000—57000 photon/MeV相当, 其晶体组分分别为Gd3Al2.3Ga2.7O12:Ce与Gd3Al2Ga3O12:Ce. 能量分辨率则与目前国际报道的最优值(晶体组分为Gd3Al2.6Ga2.4O12:Ce)为3.8%@662 keV[19]还存在一定差距, 这与组分中Al/Ga配比相关. 此外, GAGG:Ce晶体的发光波长区间(500—700 nm)与硅光电二极管的探测灵敏区域(500—1000 nm)相匹配, 因此由GAGG:Ce晶体组成的新型电离辐射探测器的信噪比更高. 但宏观包裹体及反格位缺陷等因素降低了晶体闪烁性能的均匀性, 且样品的光产额与报道中[14]晶体不同部位的光产额差异为5%左右还存在一定差距.
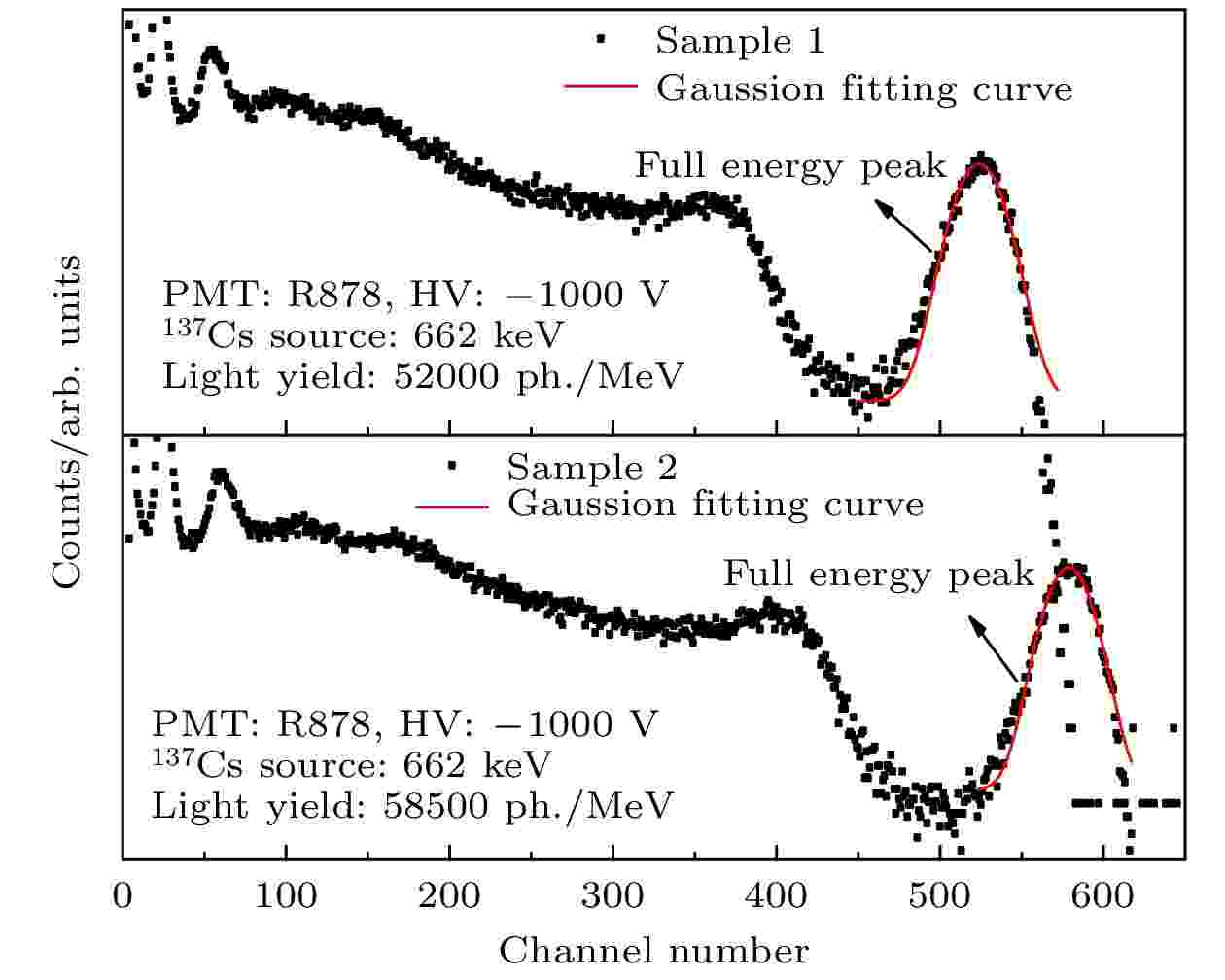 图 6 室温下GAGG:Ce样品在137Cs源激发下的多道能谱(HV, 高压)
图 6 室温下GAGG:Ce样品在137Cs源激发下的多道能谱(HV, 高压)Figure6. Multi-channel energy spectra of GAGG:Ce crystal excited by 137Cs (HV, high voltage)
在晶体发光性能研究基础上, 通过以下能级模型进一步解释图5(b)及图6中GAGG:Ce晶体发光效率差异的原因, 如下图7所示. 一方面, 反格位缺陷形成的浅电子陷阱俘获电子-空穴对, 进而导致样品1的发光效率降低; 另一方面, 样品2中的Ga浓度高于样品1, 其导带底能级降低, 进而淹没部分GdAl/Ga反格位缺陷导致的浅电子陷阱, 使得样品2中Ce3+在GAGG基质中的发光效率升高[20].
 图 7 不同基质成分的GAGG:Ce晶体能级示意图
图 7 不同基质成分的GAGG:Ce晶体能级示意图Figure7. Schematic energy level diagrams of GAGG:Ce crystal with different matrix components.
2
3.4.GAGG:Ce晶体缺陷对时间性能的影响
在662 keV的γ射线激发下, 通过测试不同成形时间(shaping time) GAGG:Ce晶体的光产额, 初步表征GAGG:Ce晶体闪烁响应时间中的快慢分量占比, 如下图8所示. 从图8可以看出, 相比于样品2, 样品1的光输出随成形时间的延长其变化幅度更大, 这表明样品1的闪烁响应中慢分量的占比更多. 在测试所得数据可通过Kamada等[20]提出的模型进行拟合:
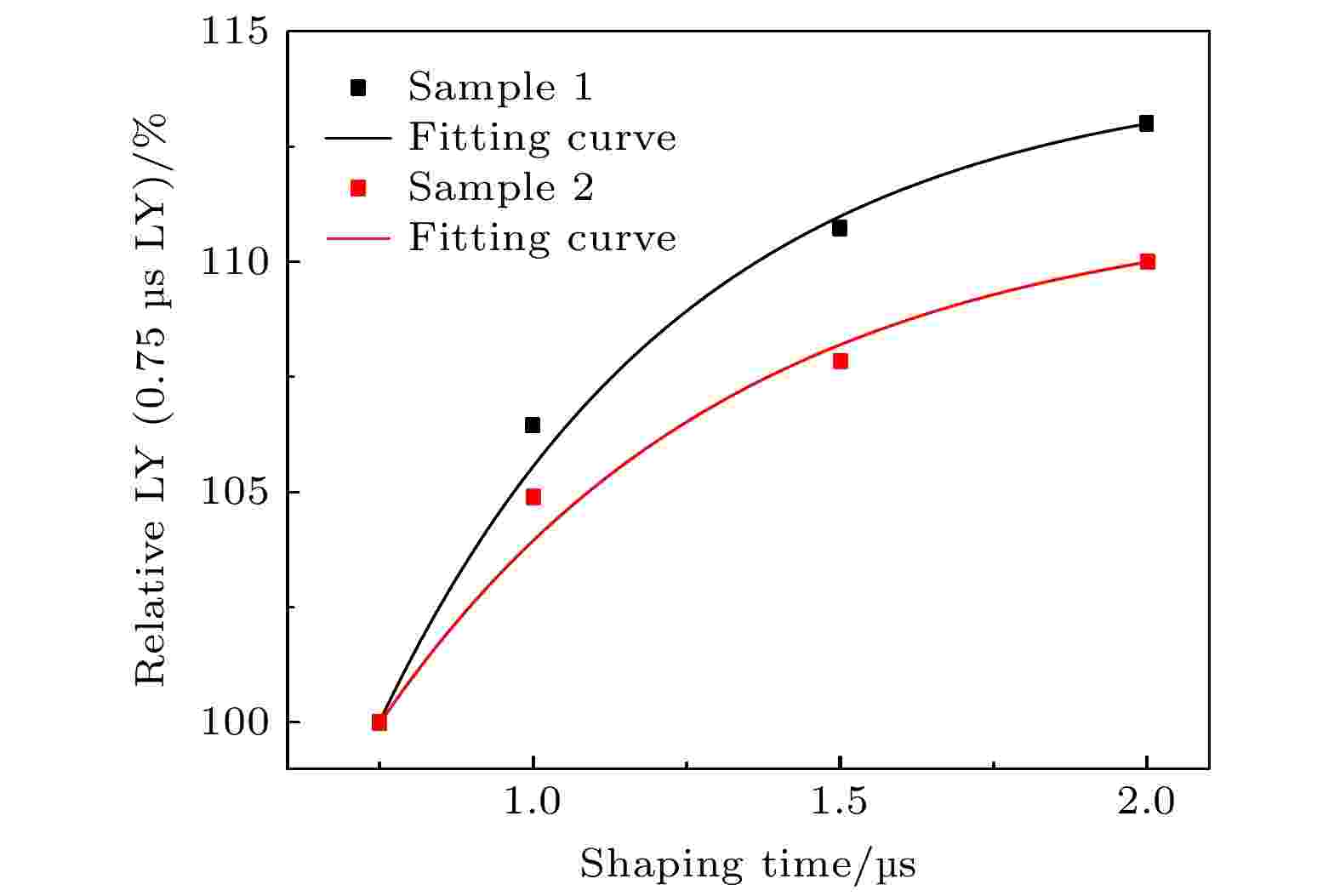 图 8 GAGG:Ce晶体归一化后的光产额与成形时间相关性. 以0.75 μs为标准, 实线为模型拟合曲线
图 8 GAGG:Ce晶体归一化后的光产额与成形时间相关性. 以0.75 μs为标准, 实线为模型拟合曲线Figure8. Light yield dependence on amplifier shaping time normalized at 0.75 μs for GAGG:Ce crystal, where solid lines are the fitting curve.
结果表明, 样品1中, m1 = 113%, Kf/e = 82.8%; 而样品2中, m1 = 110%, Kf/e = 84%. 样品1中的快、慢分量的比例分别为82.8%和17.2%, 而样品2中快、慢分量比例分别为84%和16%.
为了进一步表征GAGG:Ce晶体的时间特性, 在γ射线激发下测得GAGG:Ce晶体的闪烁衰减时间, 如图9所示. 衰减曲线可以用单指数衰减方程I(t) = I0exp(–t/τ)很好地拟合. 式中, I0为初始发光强度, τ为衰减时间. 拟合结果表明, 不同基质组分的GAGG:Ce晶体具有不同的衰减和上升时间. 样品1, 2的衰减时间分别为121.9 ns和117.7 ns, 其上升时间分别为10.7 ns和8.6 ns. 由于测试仪器误差小于1%, 且测试结果为50组数据平均值计算所得, 因此可以排除数据偶然性及测试误差的原因. 样品1相比于样品2衰减时间延长的原因为: 样品1中GdAl/Ga反格位缺陷浓度高, 反格位离子GdAl/Ga与Ce3+的距离更近, 当二者距离小于10 ?时, 该反格位离子与近邻的Ce3+形成Ce3+-GdAl/Ga离子对. Ce3+-GdAl/Ga离子对通过短距离非库仑势低能激发, 该激发态从能量带中分离, 并在禁带中形成局部能级, 其通过库仑电势捕获电子并作为辐射复合中心导致能量在Ce3+-GdAl/Ga离子对间发生无辐射能量转移, 进而导致发光中心Ce3+的复合发光过程出现延迟[21,22], 且晶体中闪烁光衰减的慢成分比例更高. 而上升时间变长的主要原因为: GAGG:Ce晶体样品1中Gd3+浓度更高, 使得Gd3+→Ce3+间的能量传递变强, 而能量激发沿Gd3+亚晶格的迁移需几纳秒时间, 进而导致GAGG:Ce晶体上升时间的变慢, 这与文献中报道的数据一致[15]. 通过组分改性研究及生长工艺的改进以抑制GAGG:Ce晶体的反格位缺陷, 进而提高晶体的性能及尺寸利用率是接下来的重点研究方向.
 图 9 GAGG:Ce晶体的闪烁衰减时间
图 9 GAGG:Ce晶体的闪烁衰减时间Figure9. Scintillation decay curve of GAGG:Ce crystal
GAGG:Ce晶体兼具高光输出(58500 photon/MeV)及高能量分辨率(6.1%@662 keV), 在核医学成像、工业物料在线监测等领域的应用前景十分广泛. 但晶体中存在的杂相包裹体引起的自吸收及GdAl/Ga反格位缺陷在380 nm处的发射与GAGG:Ce在340 nm处的吸收重叠导致GAGG:Ce晶体的发光效率下降12.5%, 相应的光产额下降至52000 photon/MeV. GdAl/Ga反格位缺陷与近邻Ce发生隧穿, 能量出现无辐射跃迁转移, 导致衰减时间由117.7 ns延长至121.9 ns, 且闪烁发光的慢分量比例由16%升高至17.2%. 同时, GAGG:Ce晶体的上升时间由8.6 ns延长至10.7 ns. GAGG:Ce晶体的闪烁衰减时间较慢, 通过合适的异价离子掺杂对GAGG:Ce晶体进行改性研究以抑制其衰减时间中的慢分量是接下来重点研究的方向.
