全文HTML
--> --> -->当MOSFET器件工作在强反型区时, 散粒噪声表现为受抑制的散粒噪声; 当器件工作在弱反型区时, 散粒噪声表现为全散粒噪声并且此时散粒噪声成为器件的主要噪声[7,8]. 随着栅源电压增大, 器件的势垒高度会随栅源电压的增大而降低[9], 散粒噪声的抑制因子随之降低, 而漏源电压对散粒噪声抑制因子的影响很小[2]. 由于在低噪声放大电路等应用中, MOSFET器件通常工作在强反型区, 因此本文主要研究MOSFET器件工作在强反型区时的散粒噪声. 通过对多种尺寸MOSFET器件的噪声进行分析, 文献[10]发现当器件尺寸减小到100 nm以内并继续减小时, 器件在强反型区中的噪声机理将从热噪声逐渐转变为散粒噪声. 并且文献[11]首次通过实验观察到散粒噪声的存在, 认为在10 nm尺寸下MOSFET器件的沟道噪声主要为全散粒噪声. 然而以往的文献对散粒噪声的研究仍然存有争议. 首先是器件尺寸对噪声机理的影响, 一些文献认为当MOSFET器件的尺寸减小到40 nm或以下时, 器件在强反型区中的噪声主要表现为受抑制的散粒噪声[12-14]; 也有一些文献认为器件尺寸在45 nm甚至在60 nm时, 受抑制的散粒噪声开始显著影响器件的噪声性能, 是产生过量噪声的主要因素[5]. 文献中另一个争议为当受抑制的散粒噪声开始成为主要噪声, 是否还需要考虑热噪声的影响. 一些文献认为当MOSFET器件的尺寸减小到上述尺寸节点后, 可以仅由受抑制的散粒噪声来表征沟道噪声, 不需要考虑热噪声的影响[15,16]; 也有一些文献认为需要同时考虑两种噪声的影响, 但是受抑制的散粒噪声为主要的噪声[17,18].
散粒噪声的机理建立在弹道输运理论的基础上, 该理论认为电子进入器件的沟道后经历少量散射甚至不经历散射直接到达漏极[19]. 对于40 nm尺寸的n型MOSFET(NMOSFET)器件, 由于电子在沟道中的平均自由程约为7 nm, 那么每个电子从源极进入沟道运动到漏极平均会经历6次散射, 并且考虑Si-SiO2界面散射, 电子散射的次数会进一步增加[20]. 因此即使电子的输运开始由漂移-扩散输运向准弹道输运过渡, 器件的沟道中仍然存在沟道电阻, 沟道热噪声的影响依然存在. 当器件尺寸减小到散粒噪声开始对噪声机理产生影响, 现有文献采用的传统热噪声模型已不能准确表征器件的热噪声, 导致在分析热噪声与散粒噪声对沟道噪声的影响时出现偏差, 影响到对器件噪声机理的分析. 此外, 器件中强电场导致的短沟道效应也会影响漏源电流的计算, 进而影响到散粒噪声抑制因子计算的精度.
本文通过解能量平衡方程建立沟道电子的温度模型与速度模型, 进而建立漏源电流模型, 并在该模型的基础上建立散粒噪声模型和热噪声模型, 计算了散粒噪声抑制因子; 研究了在不同偏置电压下, 器件尺寸对散粒噪声、散粒噪声抑制因子和噪声机理的影响.
2
2.1.漏源电流模型
NMOSFET器件的结构示意图如图1所示, y轴的方向设为由源极沿器件沟道指向漏极, 取源极与沟道的交界处为原点, x轴的方向为垂直于y轴的纵向方向, 由SiO2与衬底间的界面指向衬底方向. 图1中, Lelec表示电学沟道长度, Leff表示有效沟道长度, 受沟道长度调制效应的影响, Leff = Lelec – ΔL. 在NMOSFET器件中, 通常将沟道分为两个区域: 线性沟道区(0 ≤ y ≤ Lelec)与速度饱和区(Lelec ≤ y ≤ Leff)[22,23], 其中y = Lelec为夹断点, 该点的电压VDS(y = Lelec) = VDSAT被称为饱和电压, 因此该点也被称为饱和电压点. 由于器件的沟道噪声出现在线性沟道区[24], 因此本文主要研究线性沟道区中的噪声.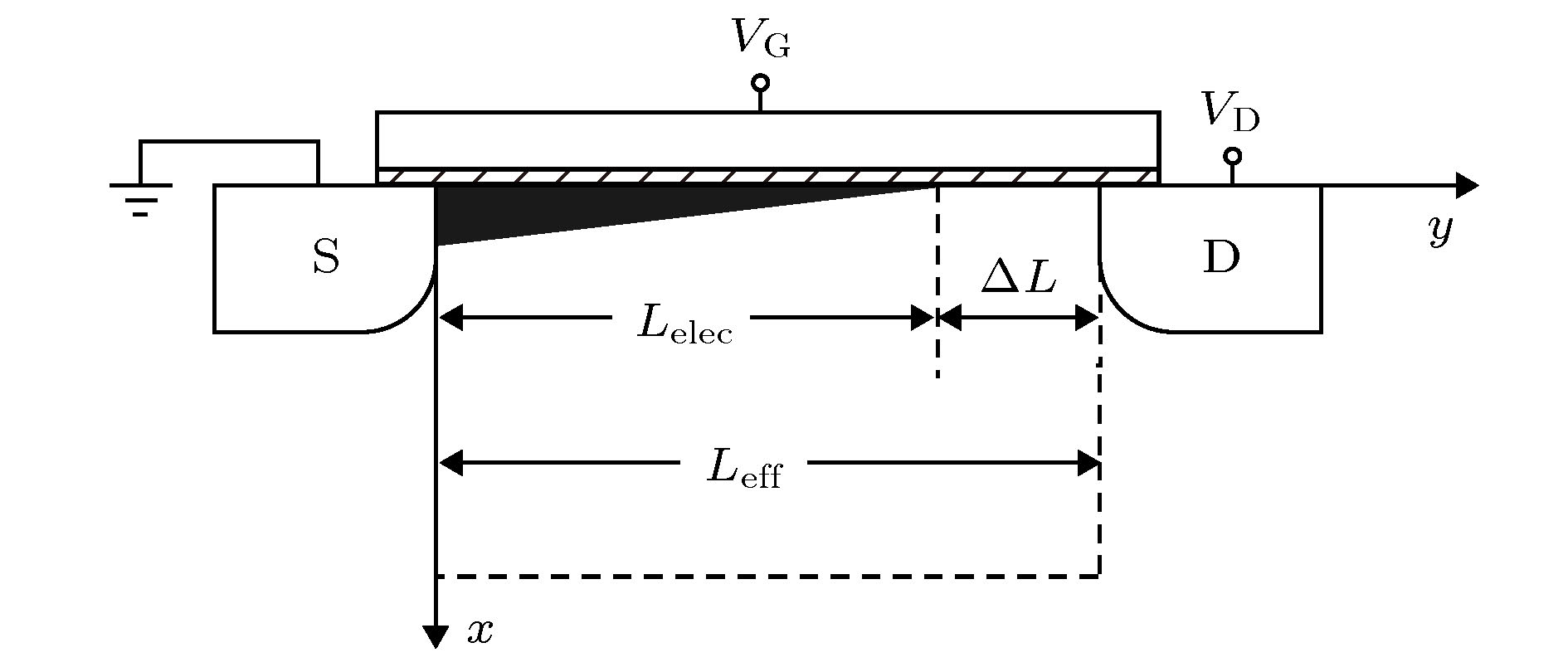 图 1 NMOSFET器件的结构示意图
图 1 NMOSFET器件的结构示意图Figure1. Structure diagram of the NMOSFET device.
在MOSFET器件的线性沟道区中, 通常认为电流的表达式可以看作一维表达式, 电流只沿y方向流动, 器件的漏源电流方程可以表示为[25]
对于纳米级MOSFET器件, 需要在计算电流密度和电子速度时考虑电子温度梯度的影响. 考虑了电子温度梯度项的电流密度如(6)式所示[26], 其中第一项与第三项为传统的漂移-扩散表达式, 第二项为电子温度梯度表征的电流. 当器件工作在强反型区时, 忽略(6)式中的扩散电流项, 得到电子速度如(7)式所示, 其中kB为玻尔兹曼常数; Ey表示沟道横向电场, Te表示电子温度. (6)式与(7)式中的Jn, vd与Ey等均表示该物理量的绝对值.
为结合(4)式与(7)式计算漏源电流, 需要通过解(9)式中的能量平衡方程[29]计算电子温度:


2
2.2.热噪声模型
计算热噪声的器件结构示意图如图2所示[31]. 假设在NMOSFET器件的沟道线性区中, 对任意一点y = y1, 在长度为Δy的小分段(y1, y1 + Δy)内存在一个忽略长度的噪声电压源Δv. MOSFET器件的线性沟道区由此可以被分成两部分: 第一部分为从y = 0到y = y1; 第二部分为从y = y1到夹断点y = Lelec. 图2(a)中噪声电压源Δv与无噪声电阻ΔR的串联电路可以转化为图2(b)中噪声电流源Δi与无噪声电阻ΔR的并联电路. 在带宽为Δf时, 噪声电压源Δv的功率谱密度为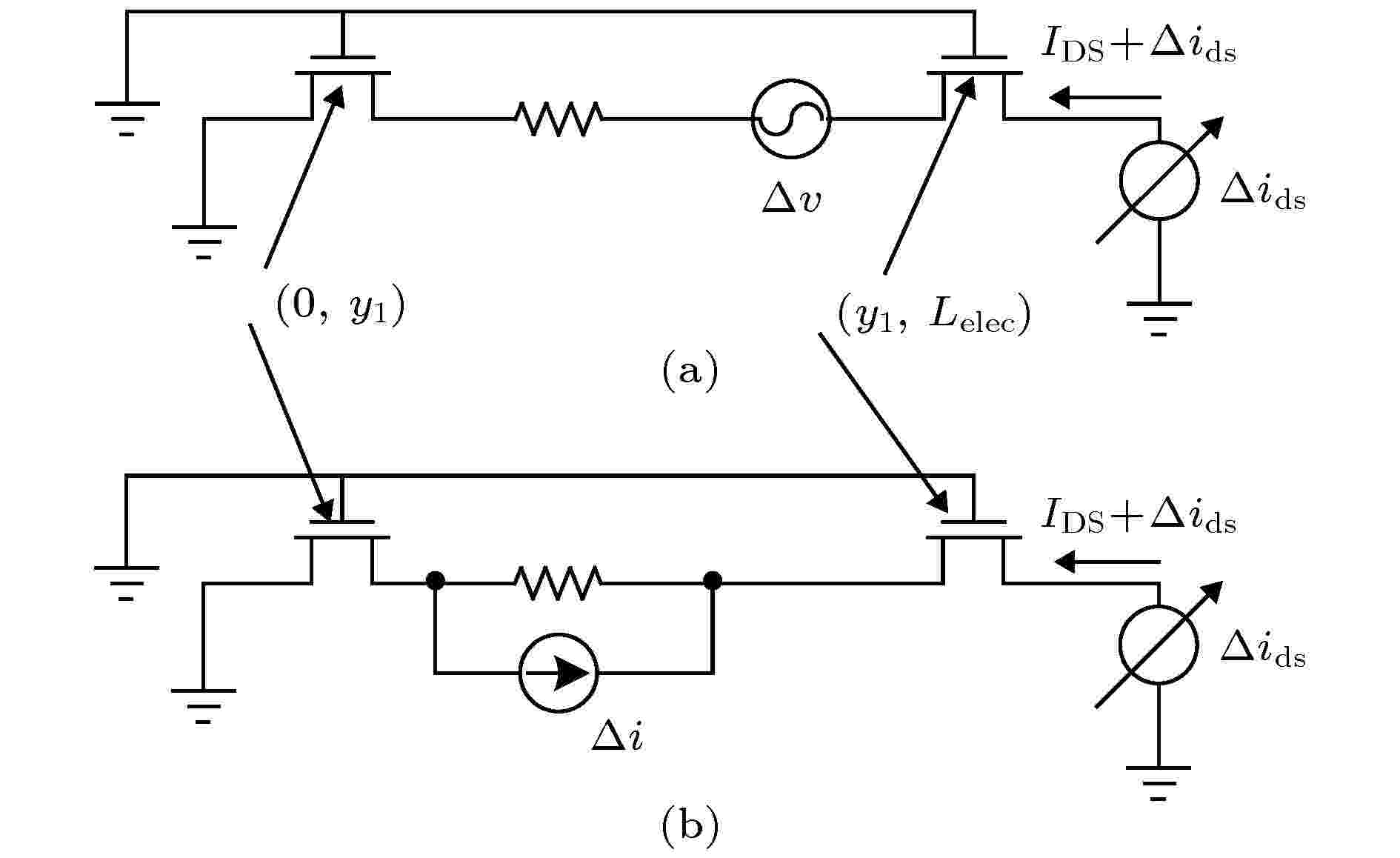 图 2 沟道中含虚拟直流源的晶体管结构图
图 2 沟道中含虚拟直流源的晶体管结构图Figure2. Schematic diagram of the transistor with a fictitious dc source in the channel.
结合图2与漏源电流方程(15)式推导热噪声电流, 考虑横向电场沿沟道方向显著升高的影响, (15)式中的(1 + ECB/EC)项需要放在等号的右边. 在(0, y1)与(y1, Lelec)两个分段内包含噪声电流的总漏源电流为
2
2.3.散粒噪声模型
通过(1)式与漏源电流(16)式, 计算出散粒噪声的表达式为沟道横向电场和电子温度也影响到散粒噪声抑制因子的计算. 将(16)式、(21)式与(22)式代入(3)式中计算抑制因子, 其计算结果反映了上述物理效应对散粒噪声抑制因子的影响, 也反映了在这些物理效应的影响下, 散粒噪声在过量噪声中的比重, 以及短沟道MOSFET器件的噪声机理随器件尺寸的变化.
3.1.传统噪声模型
(23)式和(25)式为传统的漏源电流表达式, (23)式考虑了沟道长度调制效应, (25)式考虑了沟道长度调制效应和迁移率降低效应. (24)式和(26)式分别为基于(23)式和(25)式的沟道热噪声表达式[10,31,32], (24)式仅考虑了沟道长度调制效应的影响, (26)式考虑了迁移率降低效应, 并且基于传统电子温度模型Te = T0(1 + Ey/Ec)n (n = 1或2)[33]考虑了热载流子效应.2
3.2.散粒噪声模型的计算与分析
为了进一步研究与分析MOSFET器件工作在强反型区时, 器件尺寸对噪声机理的影响, 对全散粒噪声、沟道热噪声以及散粒噪声的抑制因子进行计算. 在计算与讨论中采用的漏源电流模型分别为: 仅考虑沟道长度调制效应的IDS0((23)式)、考虑了沟道长度调制效应与电场导致迁移率降低的IDS1((25)式)以及本文建立的漏源电流模型IDS((16)式). 基于以上漏源电流模型, 通过(1)式计算的全散粒噪声分别为Sshot0, Sshot1以及Sshot, 其中Sshot通过散粒噪声模型(22)式取F = 1计算. 基于以上漏源电流模型, 相对应的沟道热噪声模型分别为Sid0((24)式), Sid1与Sid2 (分别表示(26)式采用传统电子温度模型取n = 1和n = 2)以及建立的热噪声模型Sid ((21)式). 相对应地, 结合(3)式计算出的散粒噪声的抑制因子分别为F0 (通过Sshot0与Sid0计算), F1 (通过Sshot1与Sid1计算), F2 (通过Sshot1与Sid2计算)和F (通过Sshot与Sid计算), 其中F0, F1和F2采用传统模型进行计算, F通过提出的模型进行计算.为了分析和研究不同尺寸下的MOSFET器件的散粒噪声特性, 基于文献[35,36]中NMOSFET器件的参数分别计算了尺寸为40, 20和10 nm器件的沟道热噪声、全散粒噪声和散粒噪声抑制因子. 由于MOSFET器件沟道与源极界面的势垒高度主要受栅源电压的影响, 进而影响到散粒噪声和散粒噪声抑制因子, 因此在考虑偏置电压的影响时主要考虑栅源电压的影响.
图3为有效沟道长度为Leff = 40 nm时, NMOSFET器件的沟道热噪声与全散粒噪声随栅源偏置电压变化的曲线. 图4为散粒噪声抑制因子随栅源偏置电压变化的曲线. 图3中的实验数据Sid(exp.)来源于文献[14].
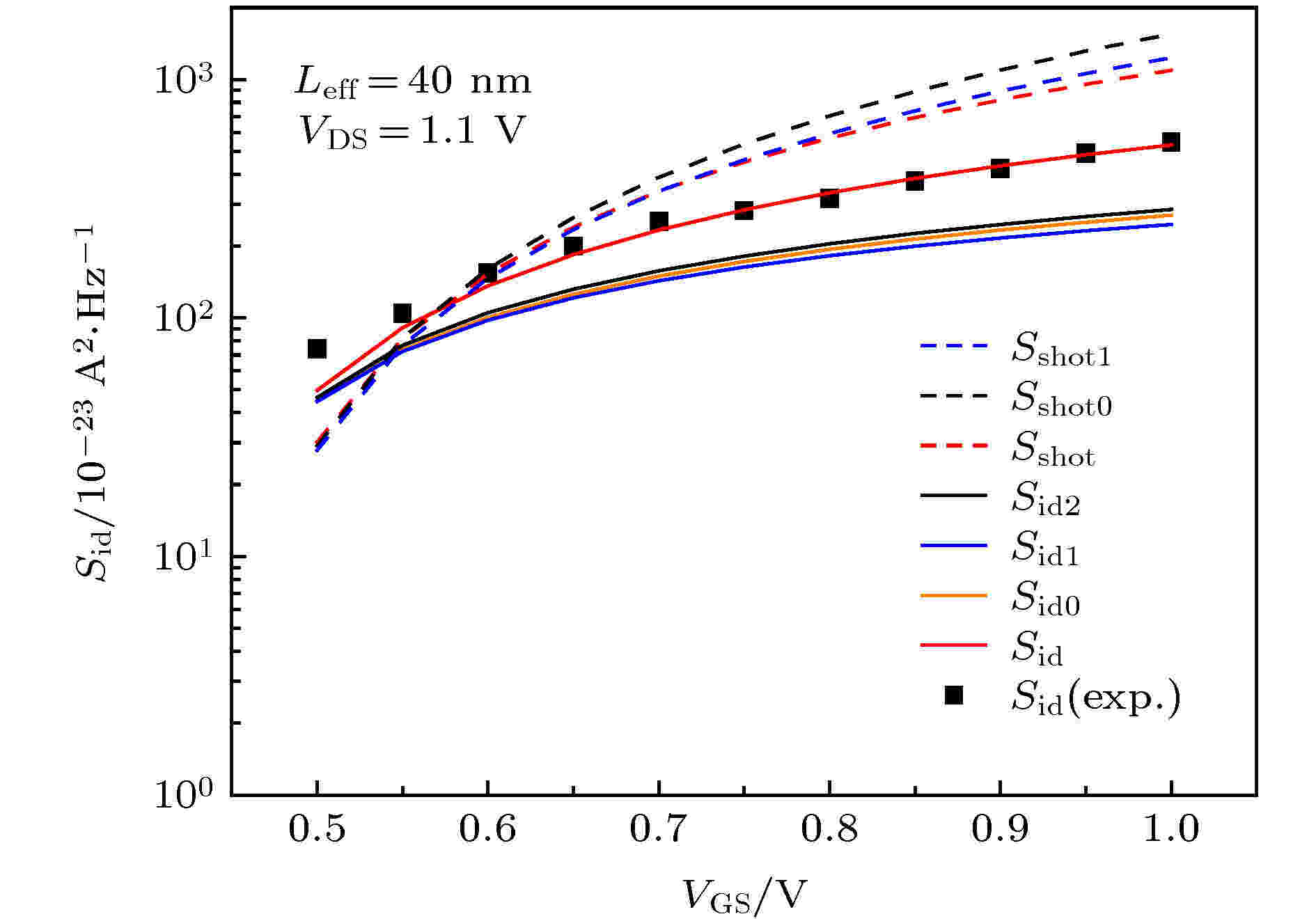 图 3 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 40 nm)
图 3 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 40 nm)Figure3. Full-shot noise and thermal noise vs. gate-source bias voltage (Leff = 40 nm).
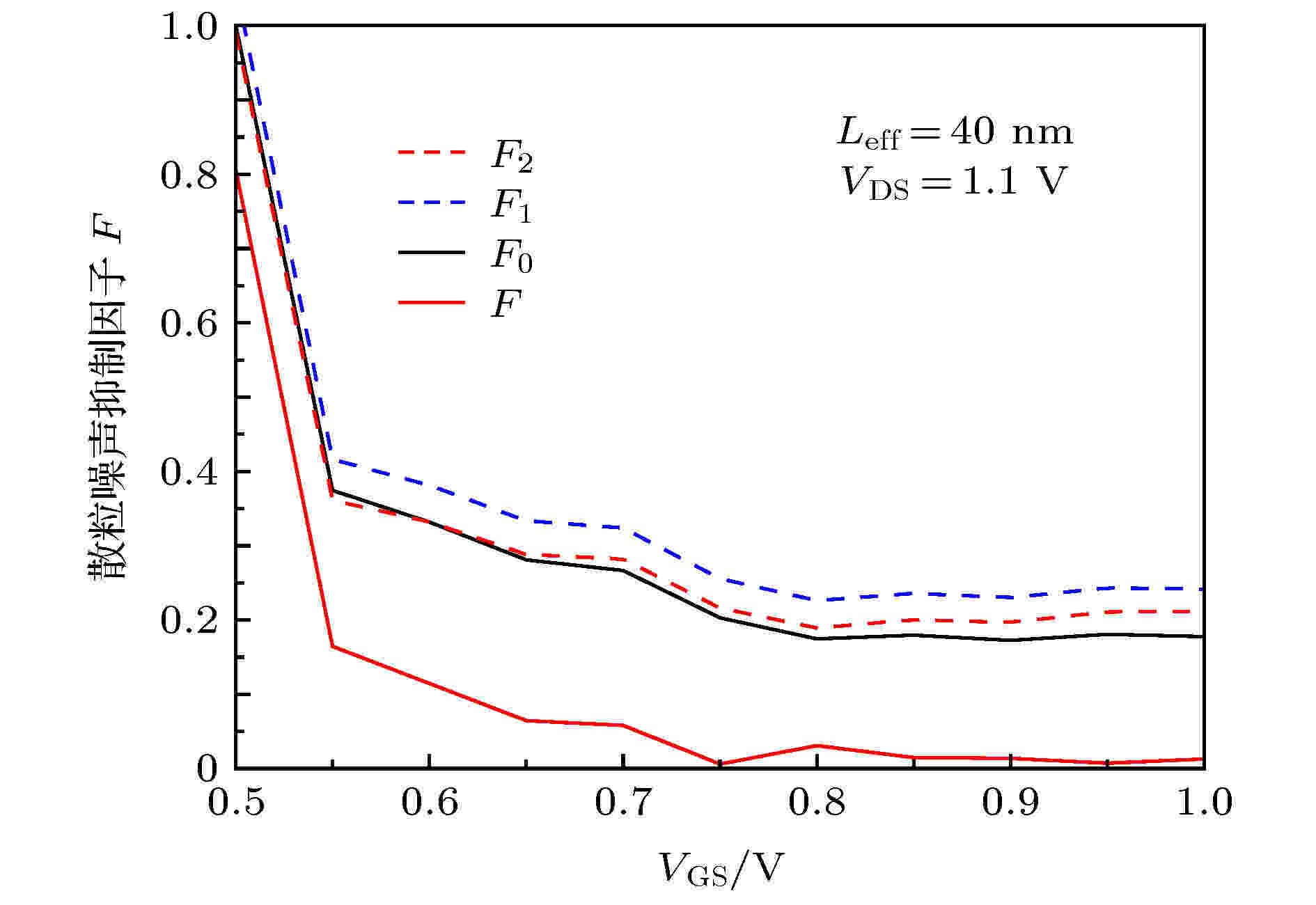 图 4 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 40 nm)
图 4 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 40 nm)Figure4. Fano factor of shot noise vs. gate-source bias voltage (Leff = 40 nm).
由图3所示, 热噪声模型Sid((21)式)的计算结果随偏置电压的变化规律, 与实验数据Sid(exp.)基本一致. 在以往的文献中, Leff = 40 nm被认为是散粒噪声的一个重要节点, 有文献认为在该节点下, NMOSFET器件的噪声机理开始由沟道热噪声转变为受抑制的散粒噪声[12,15], 可通过(1)式来表征器件的沟道噪声. 结合图3中传统噪声模型的计算结果与图4中对应的散粒噪声抑制因子可知, 如果采用现有的噪声与电流模型来计算, 散粒噪声已经开始显著影响器件的噪声性能, 成为器件出现过量噪声的主要因素. 结合图3中由(21)式计算的热噪声Sid与图4中对应的散粒噪声抑制因子F, 如图所示,在计算中考虑进电子温度梯度项后, 除了在NMOSFET器件刚进入强反型区, Sid基本能够用于预测器件的沟道噪声, 相对应的散粒噪声抑制因子也较低并且会随VGS增大而迅速降低. 由图3可知, 现有的热噪声模型在一定程度上低估了热噪声, 使得散粒噪声抑制因子在一定程度上被高估, 导致在分析散粒噪声对过量噪声的影响时, 出现较大的偏差.
Leff = 40 nm时, 在现有的一些文献中,采用受抑制的散粒噪声来表征器件的沟道噪声, 但是受噪声模型精度的影响, 这一方法存在一定程度的偏差. 由图3与图4可知, 热噪声基本上仍然可以用来表征器件的沟道噪声, 而且是主要的噪声. 但是,在器件刚进入强反型区时, 图4中散粒噪声的抑制因子F很高, 散粒噪声成为主要噪声之一. 因此虽然Leff = 40 nm时, 在器件的强反型区中, 器件的主要噪声仍为沟道热噪声, 但是在低偏置电压下NMOSFET器件的噪声机理出现了向散粒噪声过渡的倾向, 这说明, 尽管散粒噪声对器件噪声的影响仍然较小, 但是对器件噪声性能的影响已经开始不能忽视.
图5为有效沟道长度为Leff = 20 nm时, NMOSFET器件的沟道热噪声与全散粒噪声随栅源偏置电压VGS变化的曲线. 图6为采用(3)式计算的散粒噪声抑制因子随栅源偏置电压VGS变化的曲线. 图5中的实验数据Sid(exp.)来源于文献[11].
 图 5 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 20 nm)
图 5 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 20 nm)Figure5. Full-shot noise and thermal noise vs. gate-source bias voltage (Leff = 20 nm).
 图 6 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 20 nm)
图 6 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 20 nm)Figure6. Fano factor of shot noise vs. gate-source bias voltage (Leff = 20 nm).
在图5与图6中, 若采用现有的热噪声模型与漏源电流模型, 由于现有的热噪声模型低估了沟道热噪声, 散粒噪声的影响被高估. 对比图5与图3, 可以发现随着NMOSFET器件尺寸的减小, 图5中热噪声模型Sid((21)式)与Sid(exp.)之间的偏差也开始逐渐增大. 这说明除了器件的短沟道效应, 散粒噪声也开始导致器件产生过量噪声, 仅依靠沟道热噪声已经不足以表征器件的沟道噪声, NMOSFET器件的噪声机理由热噪声向同时存在热噪声与散粒噪声过渡. 尤其是在VGS较低时, 散粒噪声的影响不断增大. 对比图4与图6, 散粒噪声抑制因子F随NMOSFET器件尺寸减小而升高.
图5与图6所示的计算结果表明, 当NMOSFET器件尺寸减小至20 nm时, 散粒噪声已经开始成为导致器件出现过量噪声的原因之一, 器件的噪声机理随尺寸减小开始由热噪声向散粒噪声过渡.
图7为有效沟道长度为Leff = 10 nm时, NMOSFET器件的沟道热噪声与全散粒噪声随栅源偏置电压VGS变化的曲线. 图8为采用(3)式计算的散粒噪声抑制因子随栅源偏置电压VGS变化的曲线. 图7中的实验数据Sid(exp.)来源于文献[11].
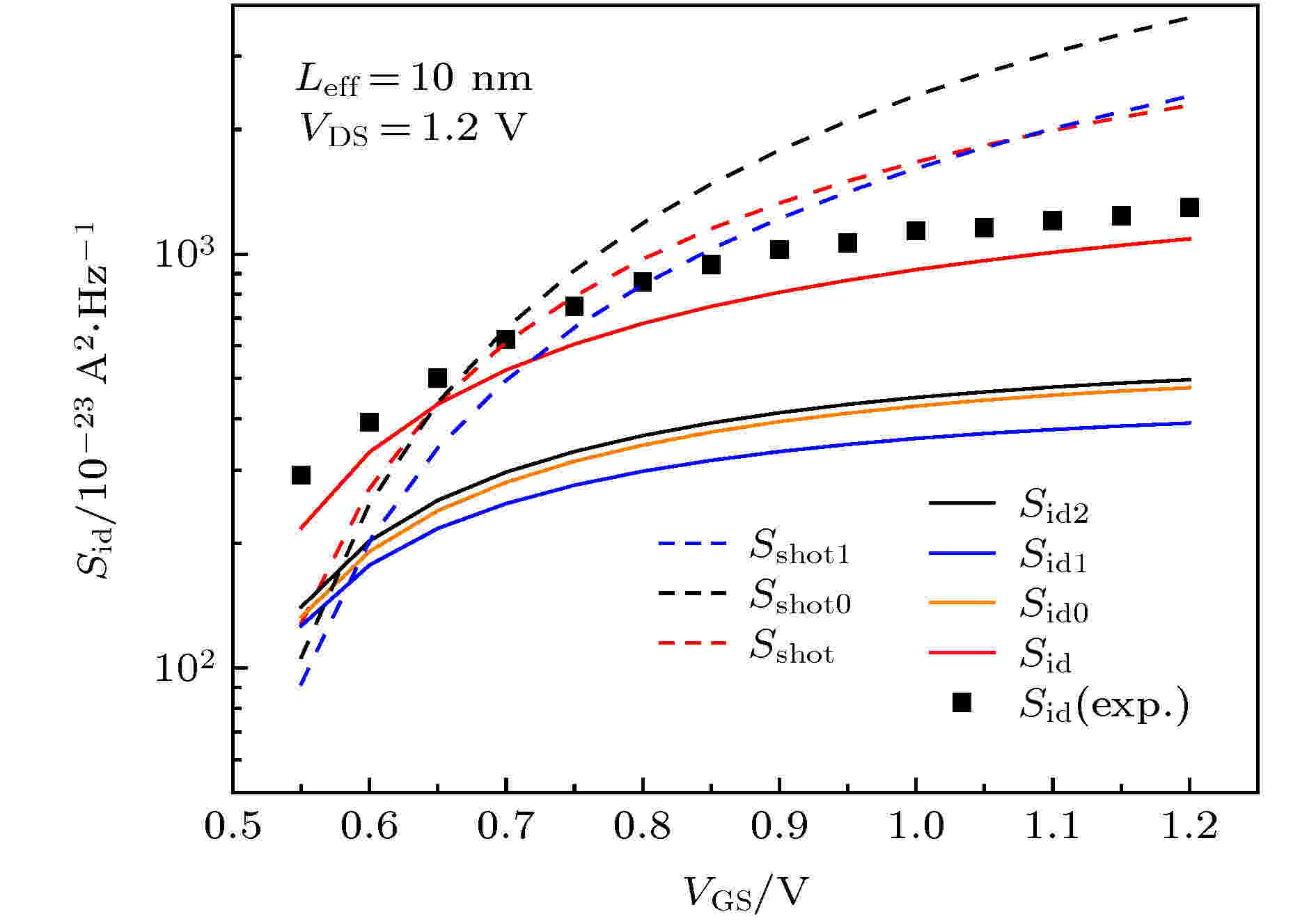 图 7 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 10 nm)
图 7 全散粒噪声和热噪声随栅源偏置电压的变化(Leff = 10 nm)Figure7. Full-shot noise and thermal noise vs. gate-source bias voltage (Leff = 10 nm).
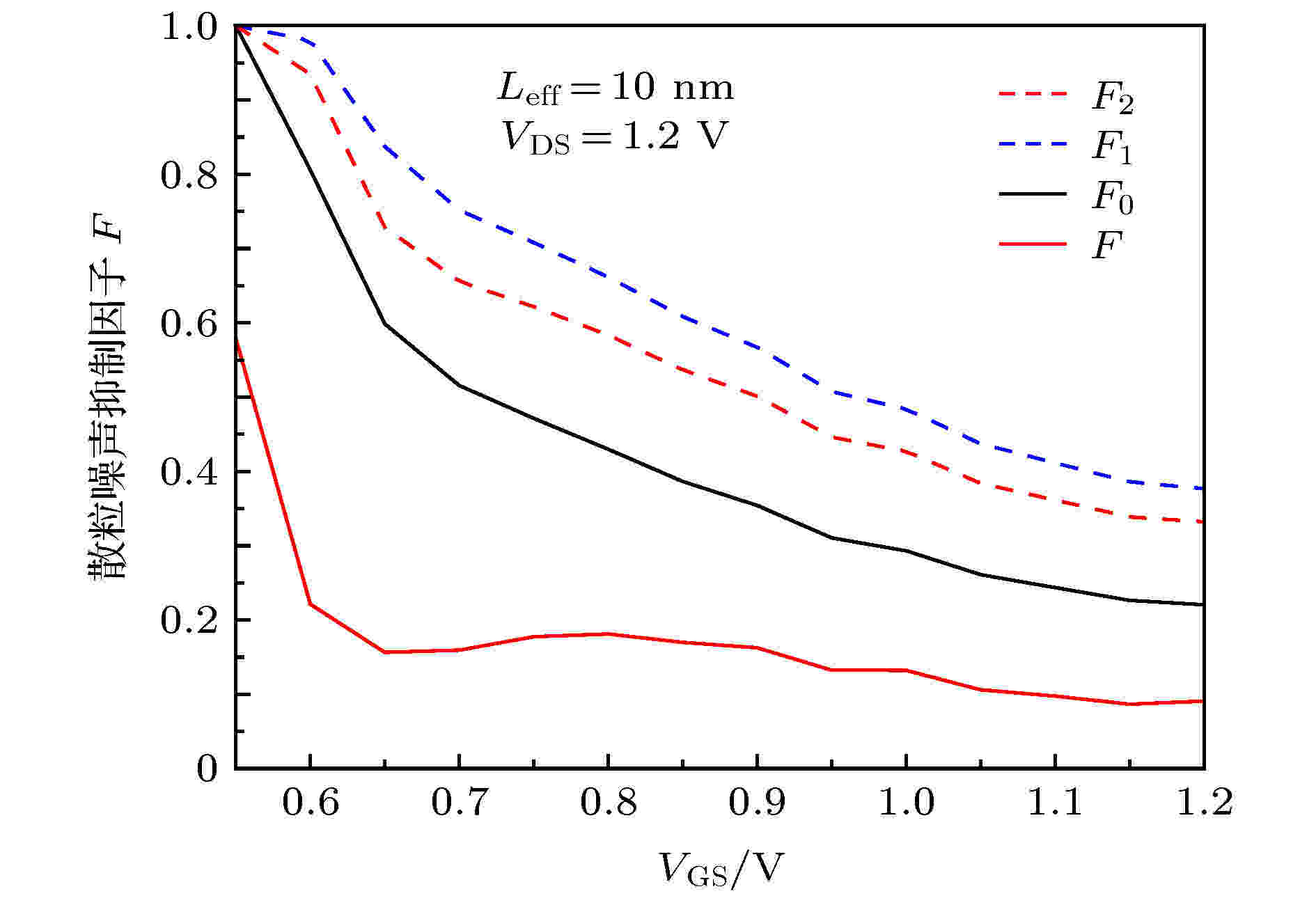 图 8 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 10 nm)
图 8 散粒噪声抑制因子随栅源偏置电压的变化(Leff = 10 nm)Figure8. Fano factor of shot noise vs. gate-source bias voltage (Leff = 10 nm).
对比图7与图5, 可以发现图7中Sid((21)式)的计算结果与Sid(exp.)出现较大偏差, Sid与Sid(exp.)的偏差随器件尺寸减小而增大, Sid计算出的沟道热噪声已无法单独表征NMOSFET器件的沟道噪声. 对比图6与图8, 散粒噪声的抑制因子随器件尺寸减小而显著升高. 以上分析表明, 随着NMOSFET器件尺寸的减小, 热噪声模型Sid的计算结果与实验数据出现偏差,并逐渐加大,散粒噪声对NMOSFET器件的过量噪声影响逐渐增大,已成为重要影响因素. 尽管在图7中, Sid的计算结果随偏置电压变化的趋势与实验数据相近, 但是Sid明显低估了器件的沟道噪声. 计算沟道噪声仅考虑短沟道效应已无法准确表征器件的过量噪声, 散粒噪声已成为表征器件过量噪声的重要因素. NMOSFET器件的噪声机理过渡到由热噪声和受抑制的散粒噪声共同表征.
通过对比图4、图6和图8中散粒噪声抑制因子的变化, 虽然对于不同尺寸的NMOSFET器件, 受阈值电压与漏源电压的影响, 器件进入强反型区时的栅源电压并不相同, 但是散粒噪声抑制因子变化的趋势是相同的. 散粒噪声抑制因子随器件尺寸减小而增大, 由此反映了散粒噪声在过量噪声中的比重随器件尺寸减小在不断增大. 据此可以预料, 随着NMOSFET器件尺寸的持续减小, 散粒噪声对沟道噪声的影响会进一步加大.
虽然文献[10,11]认为在10 nm尺寸下, NMOSFET器件的主要噪声为全散粒噪声. 但是通过对不同器件尺寸下的热噪声和散粒噪声进行分析可知, 这主要是因为现有热噪声模型的精度随器件尺寸减小出现了一定程度的下降,导致器件的沟道热噪声被低估. 10 nm尺寸器件的沟道噪声不能仅由热噪声或者散粒噪声单独表征, 需要同时考虑两种噪声的影响, 沟道热噪声的影响会随器件尺寸减小而降低, 散粒噪声的影响会增大.
