全文HTML
--> --> -->目前主要采用化学气相沉积(chemical vapor deposition, CVD)法[5,6]、金属有机物化合物化学气相沉积(metallic organic compounds chemical vapor deposition, MOCVD)法[7,8]以及分子束外延(molecular beam epitaxy, MBE)法[9,10] 制备GaN纳米线[11]. CVD法制备GaN纳米线多采用NH3作为N源, 对设备有一定的腐蚀性, 尾气处理不当会对环境造成损害. MOCVD和MBE两种方式生长条件可控性高、样品纯度及形貌较好, 但其工艺较为复杂, 制备成本较高. 近年来, 我们发展了一种基于等离子体增强化学气相沉积(plasma enhance chemical vapor deposition, PECVD)的无氨法制备GaN纳米线[12-14]工艺, 采用N2取代NH3作为N源, 降低NH3对设备的损伤, 简化纳米线制备流程, 有效降低其制备成本. GaN晶体结构属于六方晶系[15], 所以目前制备的GaN纳米线形貌多为三方结构以及六方结构[13,16], 四方结构纳米线较难制备. 纳米线形貌可以通过控制反应体系中的衬底种类[17], 催化剂[18,19], 气体环境[13]等方式进行调控. Schoo等[6]通过调节GaN纳米线升温速度以及N源浓度, 调控GaN纳米线形核过程, 使之生长为特殊形貌, 进而得到三方结构、六方结构以及四方结构的GaN纳米线. 由于四方结构GaN纳米线制备难度较大, 缺乏实验制备基础, 故当前主要采用第一性原理计算对其性能进行研究. Srivastav等[20]通过对比生长方向为[





使用Hitachi S4800型号场发射扫描电子显微镜(field emission scanning electron microscope, FESEM)对样品形貌进行分析; 使用BRUKER D8 ADVANCE型号X射线衍射仪(X-ray diffractometer, XRD)对样品结晶质量及纯度进行分析; 使用ESCALAB 250 Xi型号X射线光电子能谱(X-ray photoelectron spectroscopy, XPS)对样品元素组成进行分析; 使用透射电镜对样品微观形貌及原子排布进行分析; 最后对样品进行PL性能测试及场发射性能测试.
3.1.Mg掺杂调控GaN纳米线结构
为了探究Mg掺杂对于GaN纳米线生长的影响, 将不同摩尔配比的原料在玛瑙研体中充分研磨30 min制备成为前驱粉体, 具体参数如表1所示.| 编号 | N2/sccm | 气压/Torr | T/℃ | t/min | 微波功率/W | C∶Ga2O3∶MgO |
| A-a | 13 | 10 | 870 | 30 | 300 | 12∶1∶0 |
| A-b | 13 | 10 | 870 | 30 | 300 | 12:1:0.2 |
| A-c | 13 | 10 | 870 | 30 | 300 | 12∶1∶0.5 |
| A-d | 13 | 10 | 870 | 30 | 300 | 12∶1∶1 |
| A-e | 13 | 10 | 870 | 30 | 300 | 12∶1∶1.5 |
表1不同原料配比制备Mg掺杂GaN纳米线的实验参数
Table1.The experimental parameter of preparing Mg doped GaN nanowiresat different source materials ratio.
图1为不同原料配比制备Mg掺杂GaN纳米线的FESEM图. 如图1(a) 所示, 前驱粉体中没有引入MgO所制备的样品A-a直径约为60—100 nm, 长度10—20 μm, 形貌为细长的三角锥状纳米线, 纳米线表面光滑且没有弯曲扭着现象. 纳米线顶端未观察到催化液滴, 是由于腔体内高能N等离子刻蚀催化剂液滴, 使其逐渐消失[32]. 如图1(b) 所示, 引入少量Mg掺杂的样品A-b相较于样品A-a直径增长为200—250 nm, 纳米线形貌大多为三方金字塔结构, 少部分为四方结构纳米线. 随着MgO的投入比例增加, 纳米线直径增大, 样品中三方结构纳米线比例逐渐降低而四方结构纳米线比例逐渐上升, 推测其形貌转变与Mg元素掺杂有关. Lymperakis等[33]采用密度泛函理论计算得出非极性GaN表面对于N原子吸附不稳定, 使得GaN在生长过程中在趋于向极性生长, 生长过程中沉积在衬底及纳米线侧壁的Ga原子和N原子延纳米线轴向进行迁移至顶部. 而Mg掺杂对N原子起到稳定作用, 降低了GaN纳米线生长的各向异性[34], 使得其径向生长速度上升, 对纳米线侧壁生长产生促进作用. Mg掺杂同时降低GaN中Ga原子的结合能, 使其在Mg掺杂表面更容易附着[30,35], 因此纳米线侧壁变厚并改变其截面形貌. 如图1(c) 所示, 样品A-c形貌均匀一致且生长笔直, 纳米线延孪晶界非对称生长, 孪晶界一侧为三棱柱状结构, 另一侧延孪晶界面向上呈三角形阶梯状结构, 纳米线侧壁有锯齿状边缘, 直径为300—400 nm. 如图1(d) 所示, 样品A-d直径为350—400 nm, 长度10—20 μm, 截面形貌为四方形结构, 侧壁有较多锯齿状沟槽; 如图1(e) 所示, 样品A-e直径为400—450 nm, 长度10—20 μm, 其形貌呈现四方形堆叠结构, 侧壁锯齿结构较为均匀, 顶端为四方形金字塔结构, 纳米线保持笔直生长.
 图 1 不同原料配比制备Mg掺杂GaN纳米线的FESEM图 (a)样品A-a; (b)样品A-b; (c)样品A-c; (d)样品A-d; (e)样品A-e
图 1 不同原料配比制备Mg掺杂GaN纳米线的FESEM图 (a)样品A-a; (b)样品A-b; (c)样品A-c; (d)样品A-d; (e)样品A-eFigure1. FESEM images Mg doped GaN nanowires prepared at different source materials ratio. (a) Sample A-a; (b) sample A-b; (c) sample A-c; (d) sample A-d; (e) sample A-e.
表2为不同生长时间制备Mg掺杂GaN纳米线的实验参数, 进一步探究Mg掺杂GaN纳米线的形核和生长过程.
| 编号 | N2/sccm | 气压/Torr | T/℃ | t/min | 微波功率/W | C∶Ga2O3∶MgO |
| B-a | 13 | 10 | 870 | 10 | 300 | 12∶1∶1.5 |
| B-b | 13 | 10 | 870 | 20 | 300 | 12∶1∶1.5 |
| B-c | 13 | 10 | 870 | 30 | 300 | 12∶1∶1.5 |
| B-d | 13 | 10 | 870 | 40 | 300 | 12∶1∶1.5 |
表2不同生长时间制备Mg掺杂GaN纳米线的实验参数
Table2.The experimental parameter of preparing Mg doped GaN nanowiresat different growth time.
图2是不同生长时间制备Mg掺杂GaN纳米线的FESEM图. 如图2(a) 所示, 样品B-a直径为30—50 nm, 生长较为稀疏, 纳米线顶端存在球形催化剂液滴, 这是由于N等离子体刻蚀时间较短, 催化剂液滴未被完全刻蚀, 同时也表明在纳米线的形核阶段为气-液-固(VLS)生长机制[36]. 如图2(b) 所示, 样品B-b尖端几乎观查不到球状Au催化液滴, 这说明Au被等离子体完全刻蚀. 纳米线呈现锥形生长, 其截面形貌大多为四方形, 并存在较少部分三方截面. 如图2(c)(d)所示, 样品B-c和样品B-d形貌均匀, 纳米线截面形貌为四方形, 长度为20—25 μm, 直径为450—500 nm. 反应体系中N等离子体对纳米线存在一定的刻蚀作用[37], 表现为纳米线侧壁产生凹槽结构[38]. 纳米线顶端形貌由三角锥形结构转变为四方金字塔结构, 是在Au催化液滴被刻蚀消失的情况下, Mg掺杂诱导GaN纳米线侧壁生长速度上升, 纳米线进行自催化生长, 金字塔结构可以有效释放纳米线生长过程中产生的残余应力[39], 故纳米线顶端形貌自发向金字塔形貌转变.
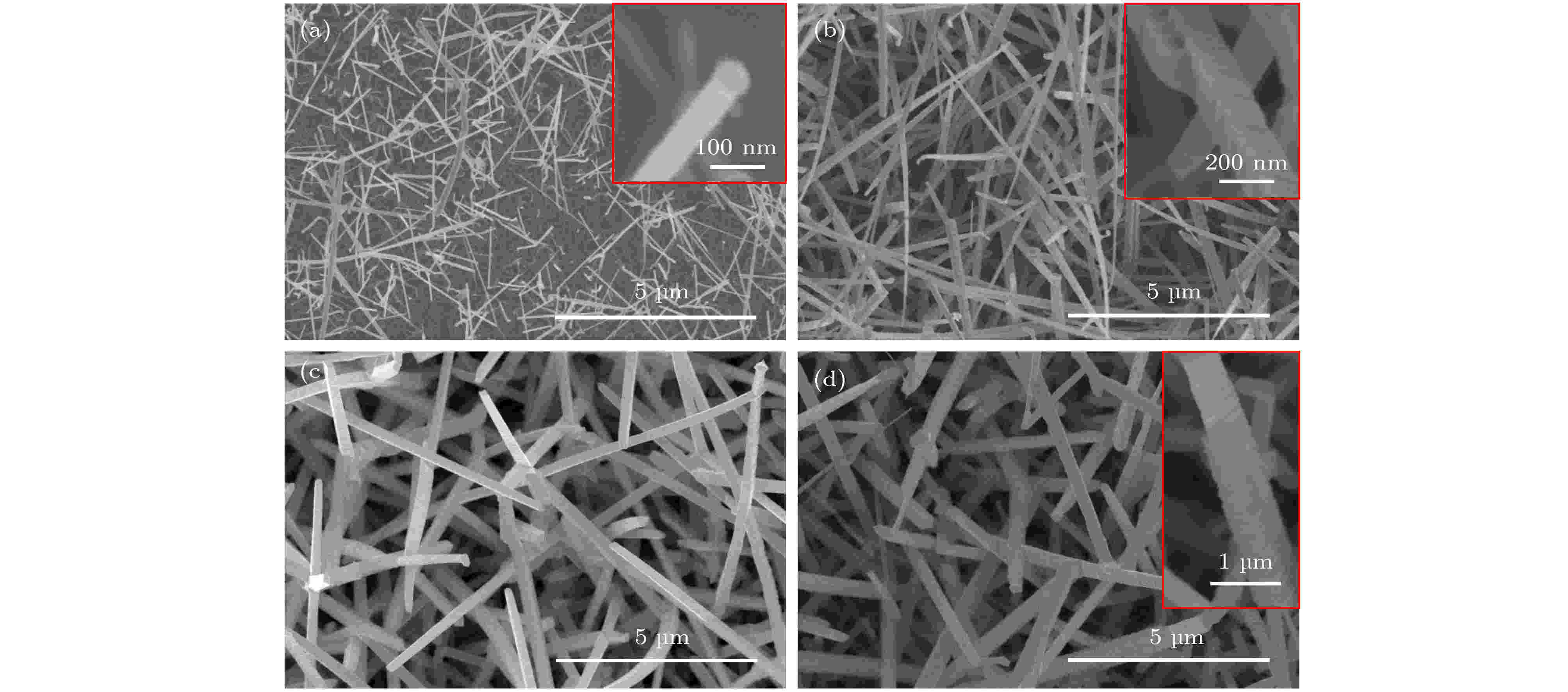 图 2 不同生长时间制备Mg掺杂GaN纳米线的FESEM图 (a)样品B-a; (b)样品B-b; (c)样品B-c; (d)样品B-d
图 2 不同生长时间制备Mg掺杂GaN纳米线的FESEM图 (a)样品B-a; (b)样品B-b; (c)样品B-c; (d)样品B-dFigure2. FESEM images Mg doped GaN nanowires prepared at different growth times. (a) Sample B-a; (b) sample B-b; (c) sample B-c; (d) sample B-d.
图3为样品A-e的XRD图谱. 从图中可以明显观察到三个强度高且尖锐的衍射峰, 其2θ角度分别为32.3°, 34.5°和36.8°, 对应于六方纤锌矿结构GaN纳米线的(100), (002)和(101)晶面(JCPDS 50-0792). 图谱中没有观察到Ga2O3或MgO的峰值, 表明纳米线纯度较高, 并且衍射峰半峰宽度较小, 表明纳米线具有良好的结晶性. 在此XRD图谱中未能观察到Mg元素对应的特征峰, 其原因是Mg元素掺杂含量较低且其特征峰对应衍射角度与GaN的(101)晶面对应衍射角度接近[40, 41]. 同时在XRD的图谱中也未观察到Au催化剂对应的特征峰, 表明经过30 min高能量的N等离子体不断轰击, 衬底及纳米线顶端的Au催化液滴被持续剥离, 最终被完全被刻蚀. 样品 A-e 的 XPS 图谱如图4所示.
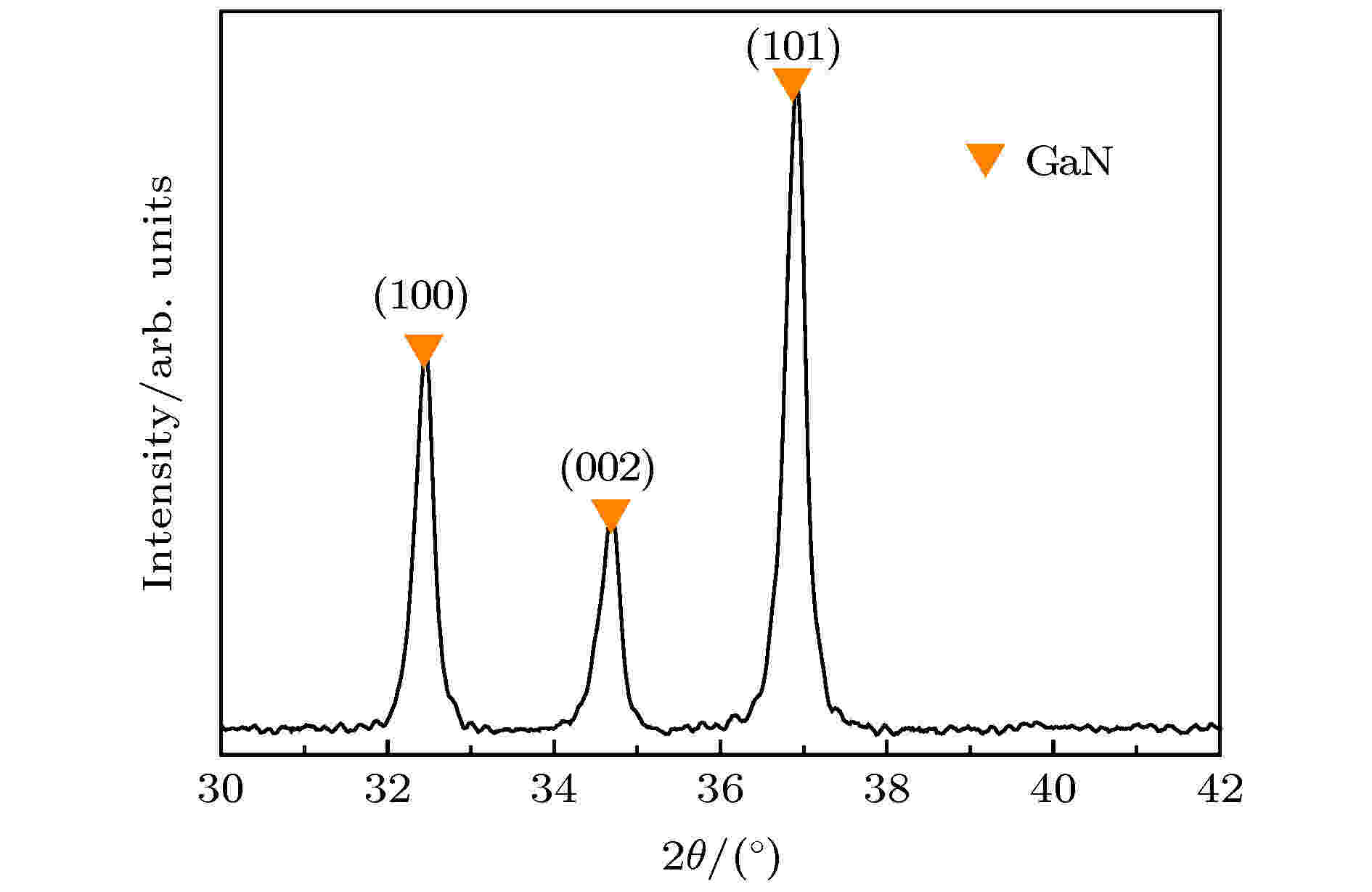 图 3 样品A-e的XRD图谱
图 3 样品A-e的XRD图谱Figure3. XRD spectra of sample A-e.
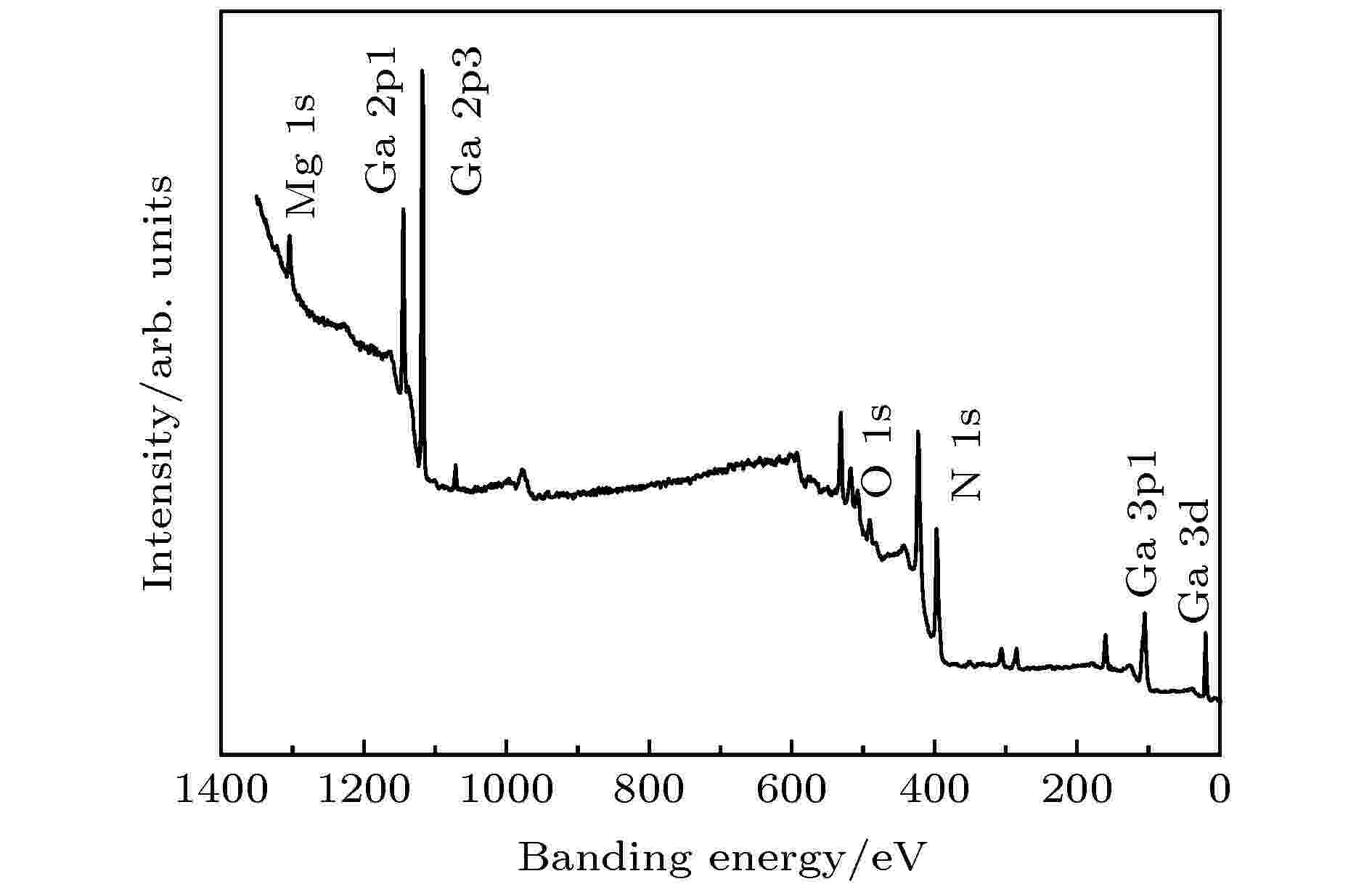 图 4 样品A-e的XPS图谱
图 4 样品A-e的XPS图谱Figure4. XPS spectra of sample A-e.
由图5(a) 可知, TEM图谱表明样品A-e沿轴向垂直生长, 直径约为400 nm. 由图5(b)可知, 高分辨透射电子显微镜(high resolution transmission electron microscope, HRTEM)图像表面纳米线原子排布整齐, 由于Mg原子半径为0.65 ?, 与原子半径为0.62 ?的Ga原子十分接近, 在掺杂过程中Mg原子发生取代掺杂, 对晶格结构影响较小[25]. 垂直轴向方向原子层间距为0.258 nm, 近似于GaN的(002)方向晶面间距. 由选区电子衍射(selected area electron diffraction, SAED)图可知, 纳米线衍射光斑清晰整齐, 纳米线生长方向为[


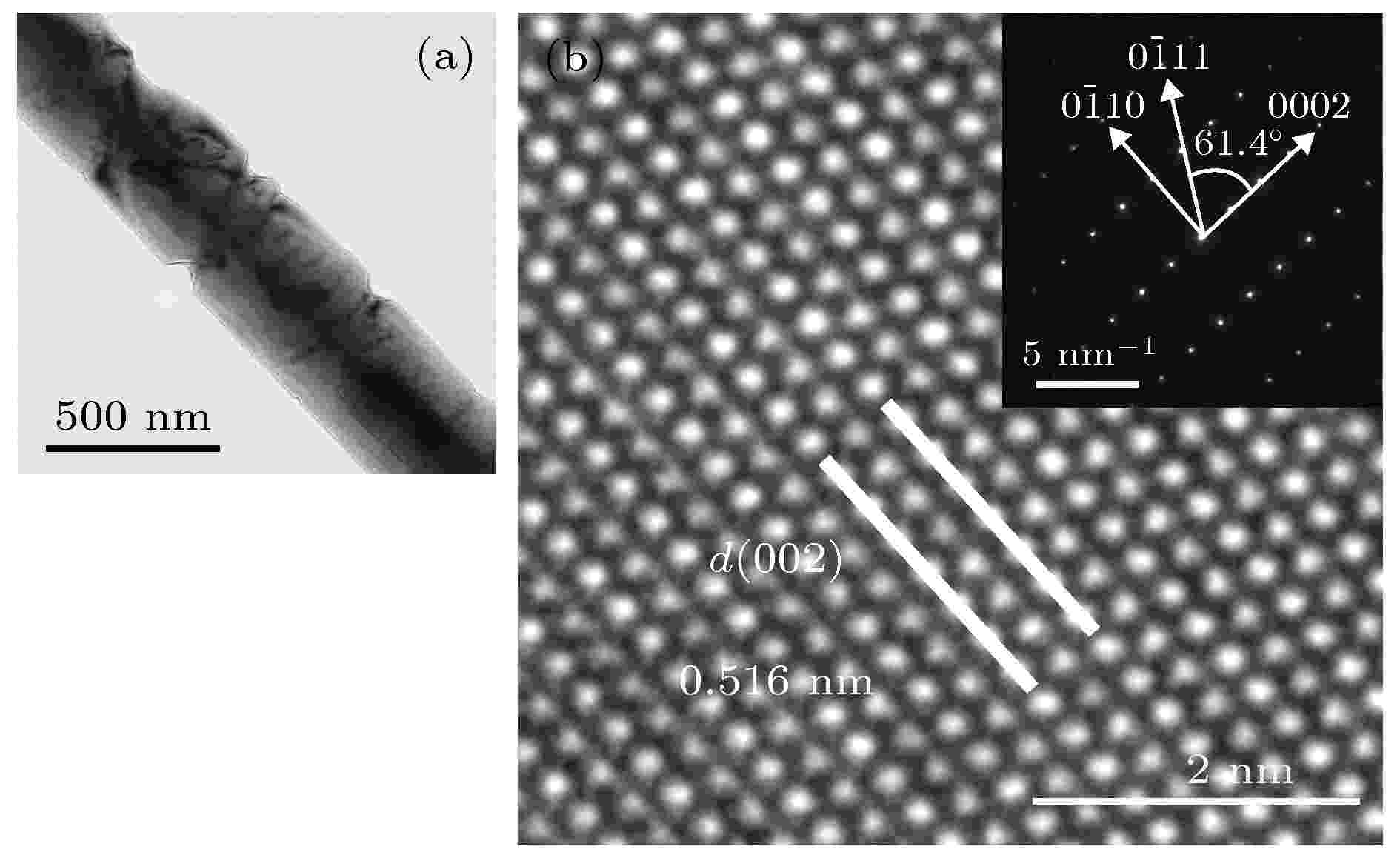 图 5 样品A-e的(a) TEM图; (b) HRTEM图插图为样品A-e的SAED图
图 5 样品A-e的(a) TEM图; (b) HRTEM图插图为样品A-e的SAED图Figure5. (a) TEM image; (b) HRTEM image and SAED pattern (inset) of sample A-e.
2
3.2.四方结构Mg掺杂GaN纳米线生长机制
通过分析不同生长时间制备样品的FESEM图(图2)可知, Mg掺杂纳米线的形核过程是遵循VLS生长机制, 由Au形成的催化液滴参与纳米线形核以及一定时间的生长过程. 当Au催化液滴被N等离子体完全刻蚀, 纳米线VLS生长过程结束. 随反应时间延长, 纳米线直径增大, 表明在没有催化剂的条件下Mg掺杂GaN纳米线可以进行自催化气-固(VS)生长. 通过分析不同投料比例制备样品的FESEM图(图1)可知, 没有引入Mg掺杂的GaN纳米线为纤细的三角锥型形貌, 而随着前驱粉体中MgO投入比例的增加, 纳米线截面形貌由三方转变为四方结构, 且直径也增长了近10倍左右, 表明纳米线自催化VS生长能否实现与Mg掺杂含量有关, 只有在引入Mg掺杂的体系中, GaN纳米线才会出现自催化VS生长. 进而我们提出四方结构GaN 纳米线的成核和生长机制的模型, 其示意图见图6. 成核和生长机制详细分为如下步骤.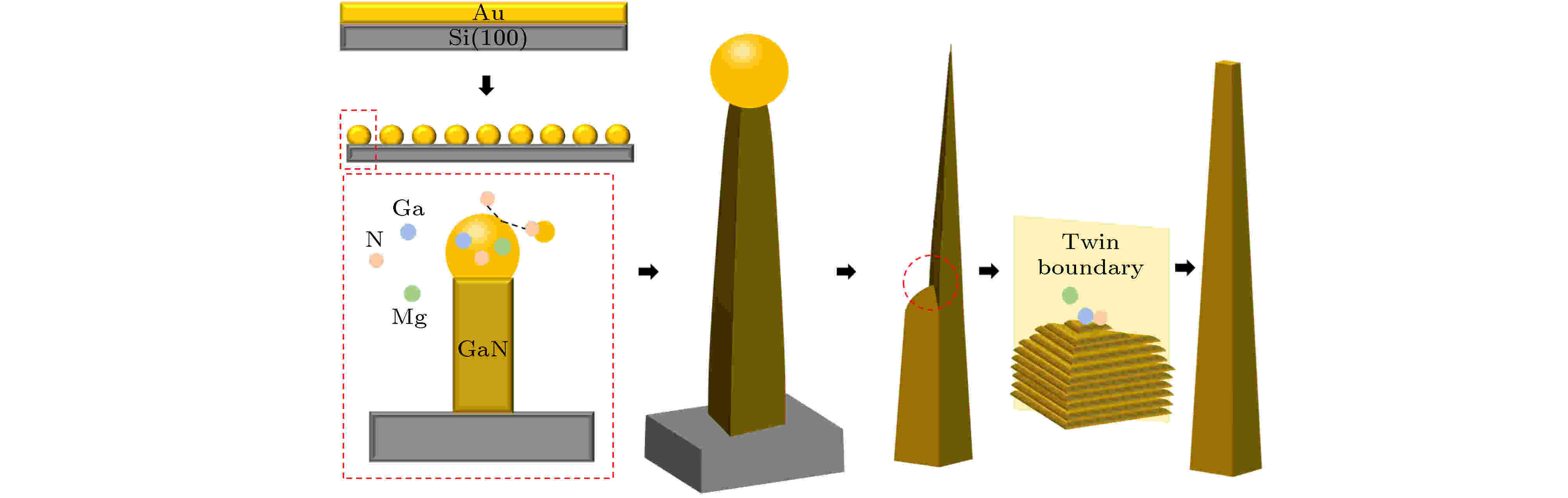 图 6 四方结构GaN纳米线的成核和生长过程示意图
图 6 四方结构GaN纳米线的成核和生长过程示意图Figure6. Schematic diagram of nucleation and growth for square-shaped GaN nanowires.
1) 在Si衬底表面的Au薄膜在加热过程中由于热膨胀系数差异较大, 裂解为Au催化液滴, 分散在衬底表面.
2) 前驱粉体受热还原出Ga原子和Mg原子, 与N等离子体一同被Au催化液滴吸收, 当Au催化液滴内溶解度达到饱和, 在小液滴与衬底接触位置析出为纤细的三方纳米线. 与此同时高能量的N等离子体轰击Au液滴, 使Au液滴体积逐渐减少.
3) 随着Au催化液滴体积下降, 其与纳米线接触角度逐渐增大, 液滴表面张力促使其维持原始接触角度, 因而在Au催化液滴与纳米线顶端的液-固接触面产生一个向内的应力, 这个向内的应力作用于纳米线顶端, 减少了催化剂对于侧壁的润湿, 抑制了纳米线侧壁的生长速度, 使其直径逐渐变窄.
4) 随着N等离子体将Au催化液滴完全刻蚀, 纳米线VLS生长机制结束, 其形貌为三方金字塔状. 腔体中高浓度的Ga、Mg原子接触衬底以及纳米线表面, 通过VS生长机制, 在低形核势垒位点沉积来降低其自由能. 本征GaN纳米线趋向于延轴向生长, 其侧壁形核势垒较高, 不利于自催化生长, 而纳米线金字塔尖端难以拓展为平面产生稳定形核位点, 故本征GaN纳米线维持三方金字塔形貌. 而Mg掺杂降低了GaN纳米线生长的各向异性, 降低了侧壁生长的势垒, 使得纳米线可以延径向自催化VS生长, 纳米线直径也逐渐增大. 与此同时, 纳米线侧壁充当孪晶界面, 与衬底平面接触角位置提供了较低的形核势垒[42,43], Ga、Mg原子和氮等离子体延孪晶界径向堆积成为三角形平面. 在此新形成的平面之上, 势垒更低的形核位点在孪晶界夹角处产生, 纳米线将保持这种延孪晶界面逐层堆叠的方式向上自催化生长.
5) 随着纳米线孪晶界两侧完全对称, 其截面形貌由三方转变为四方形. 随着纳米线顶端孪晶界的消失, 轴向生长速度降低, 侧壁生长速度逐渐提升. 由于自催化生长过程中各晶向生长速度不一致, 导致纳米线侧壁出现择优取向生长, 形成锯齿状结构[44]. 随着Mg掺杂浓度的上升, 纳米线各向异性降低, 其侧壁锯齿状结构也就更加均匀一致.
2
3.3.四方结构Mg掺杂GaN纳米线PL性能研究
由图7(a)可知, 样品A-a发光峰波长约为360 nm, 对应于GaN本征发光峰[45], 其峰值强度较高, 380 nm附近存在微小凸起, 表明存在一定含量O杂质峰[14], 除外几乎观察不到其他波段的发光峰, 表面纳米线缺陷较少, 结晶质量较高. 样品A-e在波长为386 nm处有明显的发光峰, 相较于A-a的发光峰出现了明显的红移, 并且其峰值强度也有了一定程度的下降, 在可见光区范围内有明显的发光峰, 表明有较多杂质能级产生. 将样品A-e的PL谱线置换为对应带隙图谱, 并采用高斯函数对其进行分峰拟合, 其结果如图7(b) 所示, 从图中可以明显观察到3.21 eV带隙, 这是由于Mg掺杂形成的MgGa受主能级对应的带隙[46], 使得纳米线发光峰红移, 对应发光峰位置为386 nm. 在3.39 eV存在GaN本征发光峰, 由于元素掺杂使得其峰值强度较低. 在生长过程中一定数量的Mg受主会与掺杂进入GaN晶格的MgGa结合, 形成能级更深的施主受主对, 其发光峰位置约为400—440 nm, 对应图中2.96 eV带隙[47,48]. Mg-O共掺杂形成2.47 eV的施主能级, 其发光峰位置约为502 nm[46]. 2.12 eV附近的缺陷能级可能为GaN纳米线自催化生长过程中产生的缺陷[49], 其发光峰位置为584 nm. 1.87 eV附近带隙可能为Mg掺杂产生的红光带隙, 其形成原因为电子由深能级施主向深能级受主跃迁而产生, 其发光峰位置约为663 nm[46,50,51].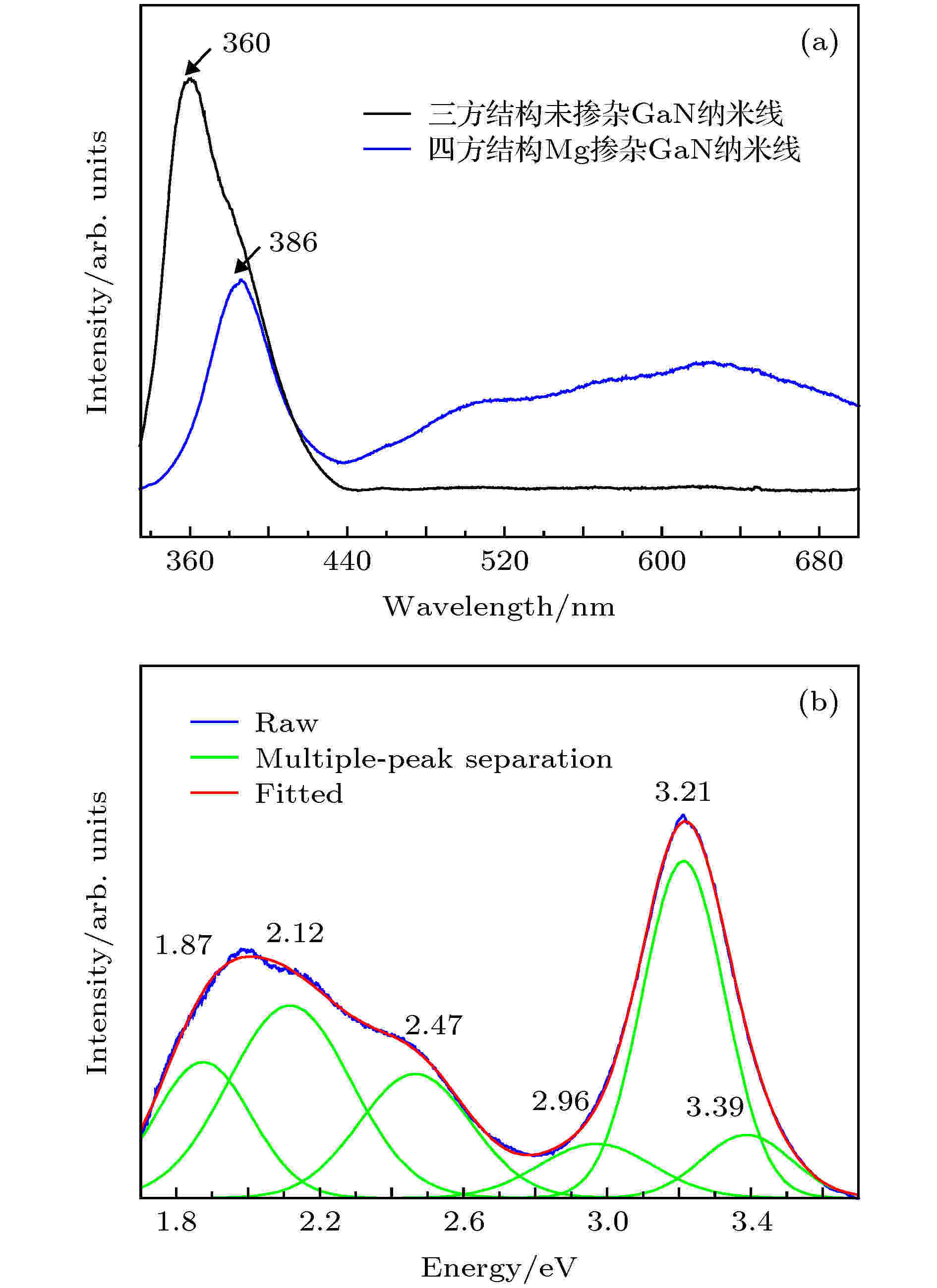 图 7 (a)样品A-a及样品A-e的PL图谱;(b)样品A-e的带隙分析图
图 7 (a)样品A-a及样品A-e的PL图谱;(b)样品A-e的带隙分析图Figure7. (a) PL spectra of sample A-a and sample A-e; (b) band gap analysis spectra of sample A-e.
2
3.4.四方结构Mg掺杂GaN纳米线场发射性能研究
图8为样品A-a和样品A-e的场发射性能测试结果. 依照分析惯例, 我们规定样品的开启电场为其发射电流密度达到10 μA/cm2时所对应的电场强度. 如图8(a) 所示, 样品A-a和样品A-e开启电场分别为6.4 V/μm和5.2 V/μm. 且随着电场强度的增加, 样品A-e可以产生更高的电流密度. 如图8(b) 所示, 样品A-a和样品A-e的 F-N曲线在较高场强可以拟合为一条直线, 这表明电子通过量子遂穿效应逸出样品表面. 采用经典F-N (Fowler-Nordheim)理论[52]来对样品的场发射性能进行分析, 其表达式如下: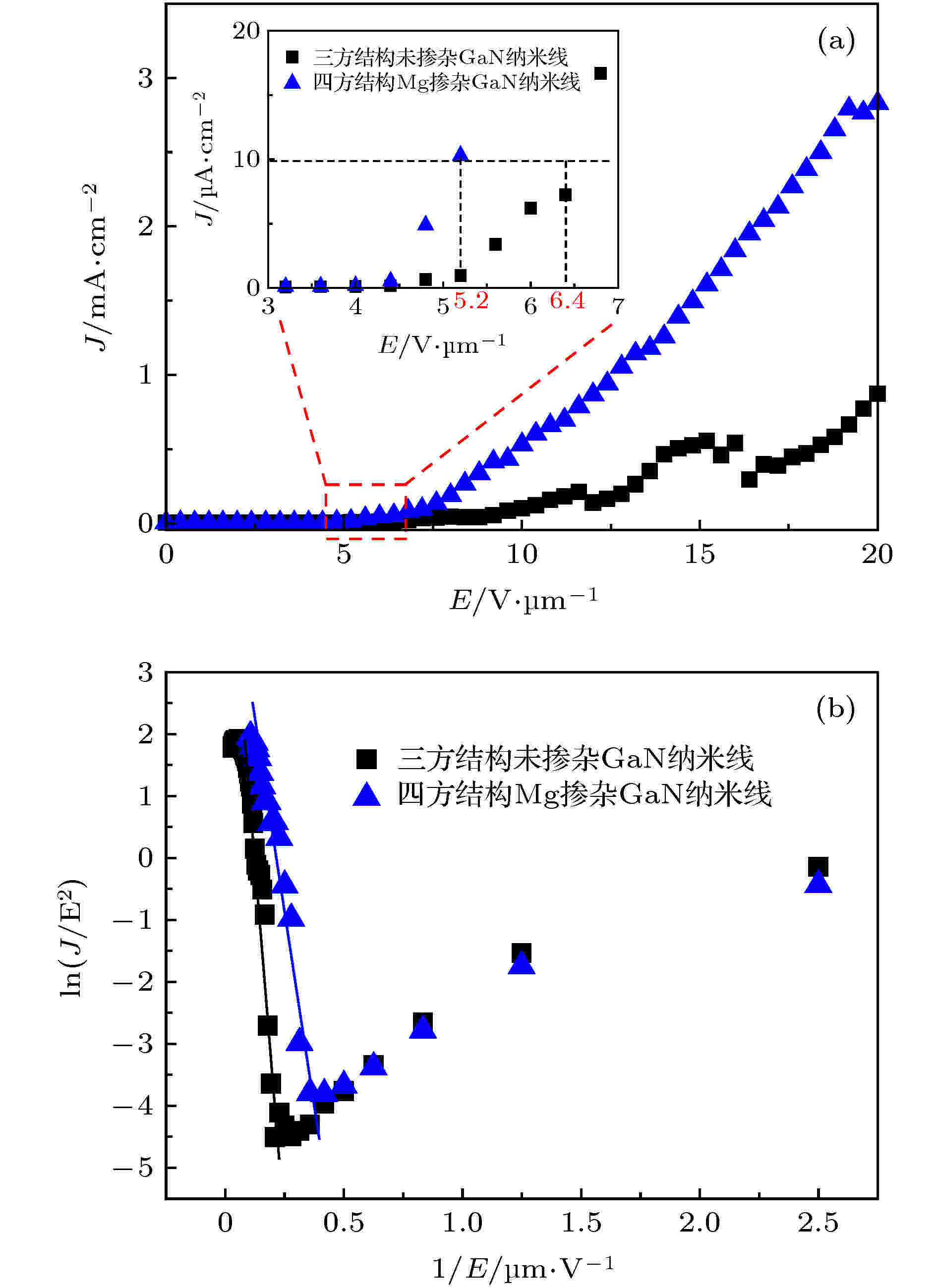 图 8 样品A-a及样品A-e的(a) J-E曲线; (b) F-N曲线
图 8 样品A-a及样品A-e的(a) J-E曲线; (b) F-N曲线Figure8. (a) J-E curves; (b) F-N curves of sample A-a and sample A-e.
由(1)式可以得到F-N曲线中的直线部分斜率的表达公式[53]:

