全文HTML
--> --> -->然而在高温测量领域中, 使用传统的半导体材料制作的温度传感器已经逐渐不能满足社会对它的需求. 例如当涉及高热预算时, Si的半导体特性会发生变化, 从而使得大部分Si基器件的工作温度不适合超过150 ℃[2,3]. GaN材料具有优良的特性: 大禁带宽度、高电子饱和速率和高击穿电场; 制作的器件具有良好的电学特性: 高击穿电压和低的漏电流等, 可以在高温、高压、高频与强辐照的环境中工作[4,5]. GaN基器件的工作温度可以达到600 ℃以上, 这是传统Si材料器件无法比拟的. 而与其他的一些半导体温度传感器相比, GaN基高电子迁移率晶体管(HEMT)温度传感器的主要优势是由于高的二维电子气(2DEG)浓度和高的载流子迁移率[6,7]带来的高灵敏度. 由于近年来GaN基器件的快速发展, GaN基HEMT温度传感器在航空航天、化学工业、矿物开采加工等领域也有着广泛的应用前景.
2014年, Kwan等[8]展示了利用单片集成的GaN器件得到了高度线性的温度-电压关系. 2016年, Rao等[9]设计并制造了一个基于4H-SiC的p-i-n二极管温度传感器, 测量温度高达300 ℃, 最大灵敏度为2.66 mV/℃. 2017年, Matthus等[10]制造的4H-SiC p-i-n二极管具有4.5 mV/℃的极高灵敏度, 测温范围为室温到460 ℃. 同年, Madhusoodhanan等[11]制作了GaN-on-SiC异质结二极管并在室温到400 ℃进行了测试, 灵敏度最高为2.25 mV/℃. 2019年, Pristavu等[12]制备了Ni/4H-SiC肖特基二极管温度传感器, 并在室温到450 ℃内进行了测试, 器件表现出了稳定的灵敏度(最高2.33 mV/℃)和出色的线性度. 表1列出了近年来发表的一些高温半导体温度传感器的器件参数.
| 文献 | 结构 | 灵敏度/ mV/℃ | 温度/℃ |
| [8] | 单片集成的AlGaN/GaN HEMT | 0.38 | 25—250 |
| [9] | 4H-SiC p-i-n二极管 | 2.66 | 20—300 |
| [10] | 4H-SiC p-i-n二极管 | 4.5 | 25—460 |
| [11] | GaN-on-SiC异质结二极管 | 2.25 | 25—400 |
| [12] | Ni/4H-SiC肖特基二极管 | 2.33 | 25—450 |
| 本文工作 | 无栅AlGaN/GaN HEMT | 44.5 | 50—400 |
表1一些不同结构的半导体高温温度传感器
Table1.Some semiconductor high temperature sensors in various structures.
本文设计并制造了无栅AlGaN/GaN HEMT温度传感器, 并对其特性进行了表征, 这在目前发表的一些GaN HEMT器件相关的文章中是很少见的. 该器件由具有GaN帽层的AlGaN/GaN异质结构材料制备而成. 文中给出了器件随温度变化的输出特性曲线, 并利用实验与理论分析结合的方式给出了器件灵敏度随沟道长度的变化关系, 同时研究了器件的高温保持稳定性.
2.1.材料的生长与器件的制备
实验中使用的AlGaN/GaN异质结材料是在蓝宝石衬底上外延生长的, 外延层从下至上包括大于1 μm 的GaN缓冲层, 大于150 nm的GaN沟道层, 20 nm的Al0.25Ga0.75N层和2.5 nm的GaN帽层. 经室温下的霍尔测试得到: 外延片的方块电阻为300 Ω/□, 2DEG浓度为1.4 × 1013 cm–2, 霍尔迁移率为1350 cm2/(V·s). 器件结构为无栅HEMT结构. 用热蒸发的方法制备了Ti/Al/Ni/Au (20 nm/100 nm/50 nm/100 nm)源漏电极, 电极形状为直径0.8 mm的圆形, 在N2氛围下830 ℃退火50 s形成了欧姆接触. 器件结构示意图如下图1所示.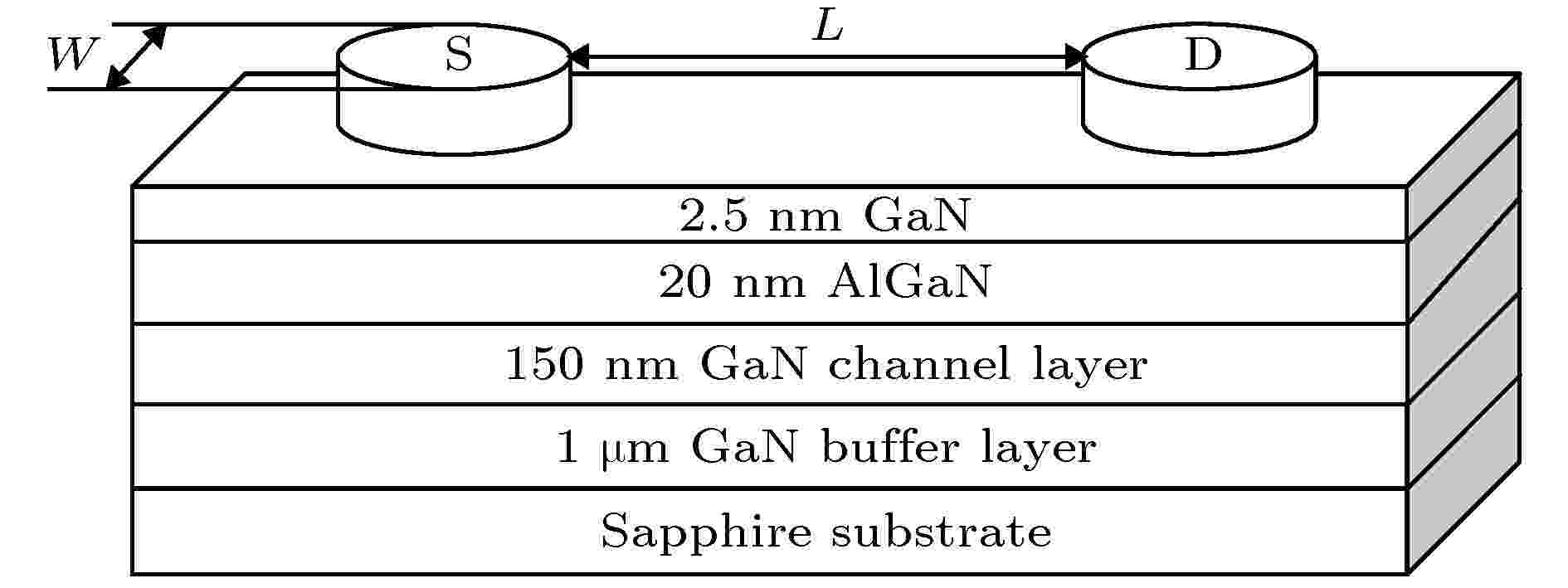 图 1 器件结构示意图
图 1 器件结构示意图Figure1. Schematic diagram of the device structure.
2
2.2.测试与表征
实验中利用kethely2611源表对器件的电学特性进行了测试. 使用HP-1010加热台为器件加热, 在50—400 ℃范围内测试器件的变温电流-电压(I-V)特性. 在研究器件的高温保持稳定性过程中, 将器件在管式炉中分别加热到300 ℃, 400 ℃, 500 ℃并保持1 h, 比较了加热前后样品电学特性的变化.3.1.HEMT器件的电流电压特性与温度关系的理论模型
对HEMT器件, 在漏源之间施加电压后, 设沿沟道方向电势为V(x), 则有
当器件在线性区时, 迁移率随温度的变化可以用下述公式来简单描述[15]:
利用上述模型对器件特性随温度变化进行了模拟计算, 考虑到材料的晶格常数随温度的变化较小(小于千分之一)[17], 因此计算中忽略了温度对AlGaN层厚度以及极化电荷面密度的影响, 表2中为拟合中一些参数的设定. 图2为器件的理论模拟结果, 可以看出固定电流(0.01 A)的情况下, 器件两端电压随温度不是线性变化的, 而使用E指数拟合方法可以很好的对器件电压随温度的变化进行拟合.
| 参数 | μ300 K | φB(m) | Nd | dAlGaN | εAlGaN(m) |
| 单位 | cm2/(V·s) | eV | cm–3 | nm | ε0 |
| 值 | 1100 | 0.85+1.3 m | 3 × 1017 | 20 | 10.4–0.3 m |
表2拟合参数列表
Table2.List of fitting parameters.
 图 2 HEMT器件两端电压在电流固定时随温度的变化
图 2 HEMT器件两端电压在电流固定时随温度的变化Figure2. The voltage change across the HEMT device with temperature when the current is fixed.
2
3.2.实验研究
图3显示了HEMT器件在50—400 ℃范围内不同温度下的I-V特性曲线, 可以看出随着温度的升高, 漏电流随之逐渐降低, 这与相关文献中报导的结果相符[18,19]. 为了获得更高的器件灵敏度, 也考虑到分立器件对于功耗没有十分严苛的要求, 固定电流选择了尽可能大的0.01 A. 图4显示了器件在0.01 A时两端压降随温度的变化及E指数的拟合曲线, 由图中的数据可以计算得到拟合优度R2 图 3 HEMT器件在50?400 ℃下的I-V特性曲线
图 3 HEMT器件在50?400 ℃下的I-V特性曲线Figure3. I-V characteristic curve of HEMT device at 50?400 °C
 图 4 固定电流(0.01 A)下电压随温度的变化曲线与其拟合曲线
图 4 固定电流(0.01 A)下电压随温度的变化曲线与其拟合曲线Figure4. Curve and fitting curve of voltage changes with temperature at fixed current (0.01 A).
由(6)式可推知, 改变器件的L/W可以使器件的灵敏度随之变化, 随着L/W的增加, 器件的灵敏度也会随之增加, 而实验结果也证明了这一点. 如图5所示, HEMT温度传感器沟道长度从1.5 mm增加为2.3 mm时, L/W变为原来的1.53倍, 灵敏度也变为原来的1.39倍; 沟道长度从2.3 mm增加为4.5 mm时, L/W变为原来的1.96倍, 灵敏度也变为原来的1.59倍.
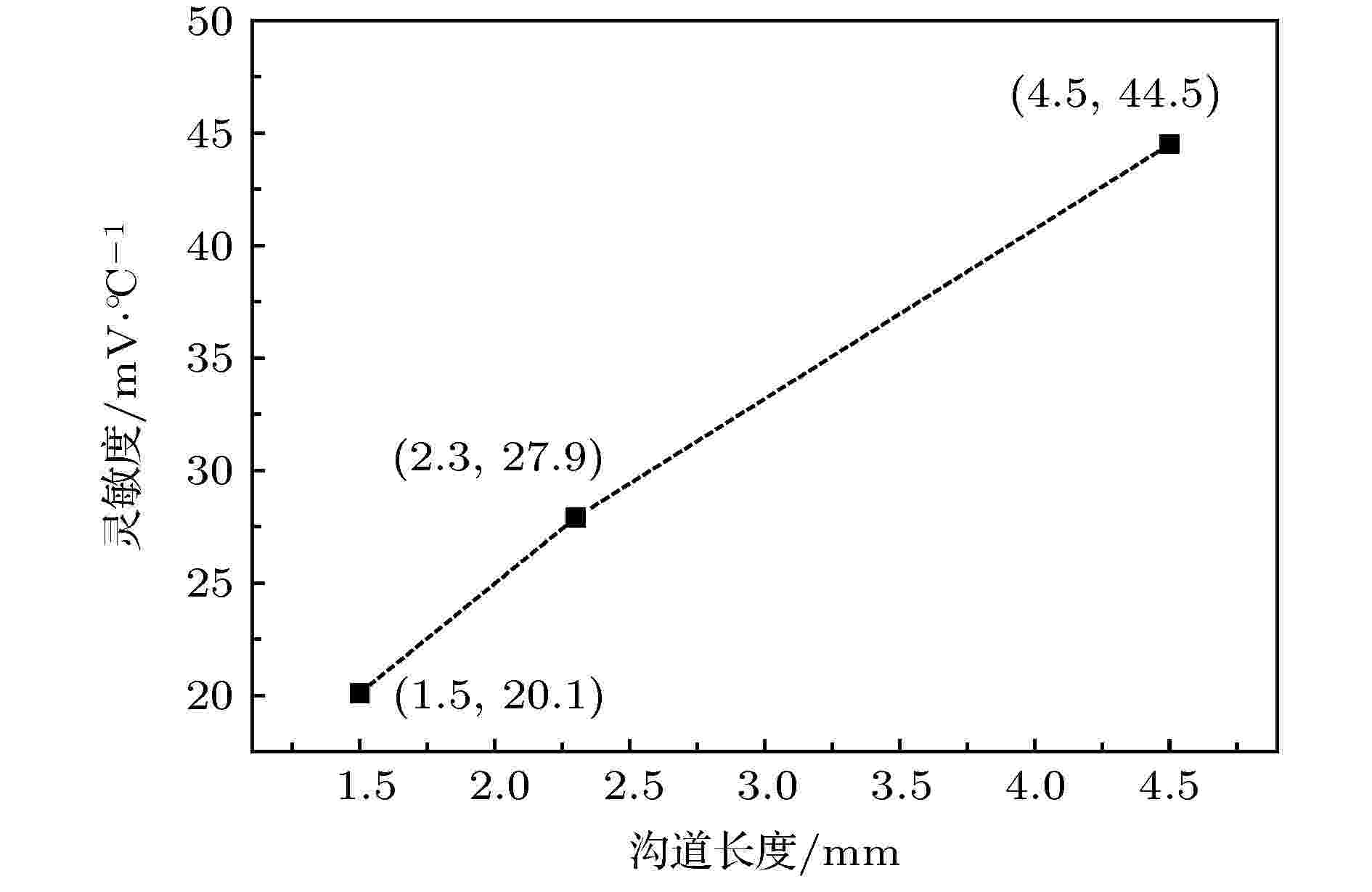 图 5 器件灵敏度随沟道长度的变化
图 5 器件灵敏度随沟道长度的变化Figure5. Device sensitivity as a function of channel length.
本文还研究了器件的高温保持稳定性问题. 图6与图7分别显示了器件在N2氛围和空气氛围中的高温保持稳定性, 分别测试了器件在300 ℃, 400 ℃和500 ℃下保持1 h后的I-V特性变化. 可以看出器件在高温下保持1 h后电学特性的变化范围在10%以内, 器件具有较好的高温保持稳定性. 器件性能的变化可能是由于热载流子效应或是金属电极与材料的相互扩散引起的[21,22], 具体的变化机制还需要进一步研究.
 图 6 器件在N2氛围中的高温保持稳定性
图 6 器件在N2氛围中的高温保持稳定性Figure6. Temperature stability of the device in N2 atmosphere.
 图 7 器件在空气氛围中的高温保持稳定性
图 7 器件在空气氛围中的高温保持稳定性Figure7. Temperature stability of the device in an air atmosphere.
