全文HTML
--> --> -->纵观半导体的研究与开发历程, 针对杂质与缺陷的有效调控一直是性能开发的基础. 目前, 超大规模集成电路的实现需要保证Si的纯度高于99.9999999%(单晶Si纯度已超过11个9)[1]. 而为了保证激光器的高性能, GaAs的位错密度(腐蚀坑密度EPD)现已经低于102 cm–2[2,3]. 宽禁带半导体材料也不例外, 对其电学性能的调控本质上是对相关缺陷及杂质的研究及控制, 即缺陷决定性能. 具体来说, 便是在实现相对较高结晶质量的基础之上, 通过寻找合适的掺杂剂进行掺杂, 进而实现材料导电类型及性能的调控. 这一点在GaN的研究历程中体现得尤为明显, 即通过低温缓冲层技术的成功引入, 使GaN外延薄膜的结晶质量得到了大幅度的提升, 因而实现了p型GaN的成功掺杂, 提升了蓝光发光二极管效率, 使固态白光照明成为可能, 进而实现了对传统照明方式的颠覆, 因此, 2014年诺贝尔物理学奖授予Isamu Akasaki, Hiroshi Amano, Shuji Nakamura三位科学家以表彰他们在该方向的贡献[4-6]. 但是, 随着带隙的增大, 导带边与价带边的移动使得原有的受主(施主)态的能级位置逐渐深化, 最终导致室温等效的热能(26 meV)无法实现对杂质能级上的空穴(电子)有效离化, 例如, 镁(Mg)的受主能态在氮化铝(AlN)中约为630 meV, 硅的施主能态则约为320 meV[7]. 同时, 普遍存在于宽禁带半导体掺杂过程中的自补偿效应更容易发生, 进一步降低了杂质态的效能[8]. 这些本质上的物理因素是宽禁带半导体体系所共同面对的难题, 特别地, 目前以ZnO为代表的II族氧化物半导体的p型掺杂仍是世界性难题. 因此, 针对宽禁带半导体中缺陷态的基础性研究及调控是解决该材料体系在应用中所面对难题的关键, 同时也已成为国际上相关领域的科学前沿问题.
本文将从高质量外延生长、杂质与点缺陷、p型掺杂及紫外电致发光三个方面阐述以ZnO为代表的II族氧化物半导体近期研究结果, 期望通过对相关研究工作的概览, 阐明该体系作为深紫外光源材料的独特优势, 同时指明未来针对电学性能调控关键在于对点缺陷的调控. 文章第2部分着重阐述ZnO及MgZnO, BeZnO, BeMgZnO的外延生长过程, 概述高质量异质、同质外延的有效技术手段, 以及目前所达到的结晶质量水平; 第3部分概述外来杂质以及点缺陷的相应研究结果, 从非故意引入杂质及点缺陷两个方面说明ZnO中较高残余电子浓度的可能来源, 明确引起自补偿效应的施主型点缺陷形成机理, 同时指出受主型点缺陷的类型与将来可能的选择; 第4部分着重概述ZnO在p型掺杂过程中所选择的杂质种类, 单一杂质掺杂与复合型掺杂的相关研究结果, 明确构建复合型受主态是实现p型掺杂的有效方法. 最后, 本文将展望未来II族氧化物半导体p型掺杂的研究途径及前景.
2
2.1.异质外延生长
目前, 蓝宝石是ZnO异质外延的常用衬底, 晶面有c, a, r等, 其中在c面上进行外延生长已有二十多年的历程, 同时在其上进行的缓冲层及界面研究也较为充分. 研究初期, Chen等利用MBE方法在蓝宝石(0001)衬底上, 通过引入薄层MgO作为成核及缓冲层实现了ZnO薄膜的二维生长模式, 并获得了较高结晶质量的ZnO单晶薄膜[9]. 图1所示为生长初始阶段的反射高能电子衍射(RHEED)对外延过程的监控, 其说明了因晶格失配所产生的应力在缓冲层区被释放. 该研究组进一步通过优化低温ZnO缓冲层的生长条件, 获得了高结晶质量的ZnO薄膜, 消除了30°的面内旋转孪生缺陷, 降低了总体位错密度, 使外延薄膜(0002)和(
 图 1 ZnO外延生长过程中缓冲层的RHEED线条图像演变过程 (a)氧等离子体处理后的蓝宝石(0001)表面; (b) 二维成核阶段的MgO缓冲层表面; (c) MgO缓冲层开始三维成岛状生长; (d) 薄层低温ZnO缓冲层生长在MgO上; (e) 退火后的ZnO缓冲层表现出平整二维表面[9]
图 1 ZnO外延生长过程中缓冲层的RHEED线条图像演变过程 (a)氧等离子体处理后的蓝宝石(0001)表面; (b) 二维成核阶段的MgO缓冲层表面; (c) MgO缓冲层开始三维成岛状生长; (d) 薄层低温ZnO缓冲层生长在MgO上; (e) 退火后的ZnO缓冲层表现出平整二维表面[9]Figure1. Evolution of RHEED line image of buffer layer during epitaxial growth of ZnO: (a) Oxygen plasma treated sapphire (0001) surface; (b) MgO buffer layer surface in two-dimensional nucleation stage; (c) the MgO buffer layer begins to grow into three-dimensional islands; (d) thin layer low temperature ZnO buffer layer grown on MgO; (e) annealed ZnO buffer layer exhibits a flat two-dimensional surface[9]
在外延生长过程中, 另一关键问题是c轴方向ZnO两个面(Zn极性面、O极性面)之间的极性差异, 以及其对生长模式、杂质掺入和位错形成的相关影响. 当在异质衬底上外延生长薄膜时, 合适的初始外延层是定义和维持极性的基础, 否则, 两个极性方向可能会共存, 形成倒反畴边界, 从而引入缺陷. 目前, 通过采用各种表面处理技术, 可以在ZnO生长的初始阶段或者在外延生长中很快实现极性控制. 如前所述, 薄层MgO的引入使得在c面蓝宝石上实现了ZnO的高质量外延, Kato等[14]进一步发现, 通过精确控制MgO层的厚度, 可以使其在临界厚度前后实现对上层ZnO外延层的极性控制, 原理如图2所示. 此外, 利用表面氧化技术, 构建具有中心对称性的氧化插入层, 也可以实现从金属极性面向O极性面的转变. 例如, Hong等[15]通过O束流对Ga极性GaN衬底表面进行预处理, 获得了具有3.5 nm厚的Ga2O3插入层, 实现了ZnO外延层中O极性的均一控制; 同时利用Zn束流的预处理过程, 阻止了GaN的表面氧化, 实现了Zn极性的均一控制. Park等[16] 在c面蓝宝石上预外延了2.5 nm厚的CrN薄层, 实现了Zn极性的均一生长, 同时利用O束流预处理方式构建出3.5 nm厚Cr2O3层, 实现了O极性的均一外延生长. Xie等[17]也在(0001)GaN/c面蓝宝石的复合衬底上, 利用Zn束流保护方式, 实现了清晰陡峭的ZnO/GaN界面, 如图3所示, 保证了ZnO外延层的Zn极性均一生长. 总之, 通过缓冲层设计、表面处理等技术手段, 目前已使得在异质衬底上外延的ZnO薄膜结晶质量得到了保证, 为进一步的掺杂与电学调控奠定了坚实的基础.
 图 2 ZnO在c面蓝宝石上的原子排列示意图 (a)厚度为1 nm的MgO缓冲层; (b)厚度大于3 nm的MgO缓冲层[14]
图 2 ZnO在c面蓝宝石上的原子排列示意图 (a)厚度为1 nm的MgO缓冲层; (b)厚度大于3 nm的MgO缓冲层[14]Figure2. Schematic diagram of atomic arrangement of ZnO on c-sapphire: (a) MgO buffer layer with a thickness of 1 nm; (b) MgO buffer layer with a thickness greater than 3 nm[14]
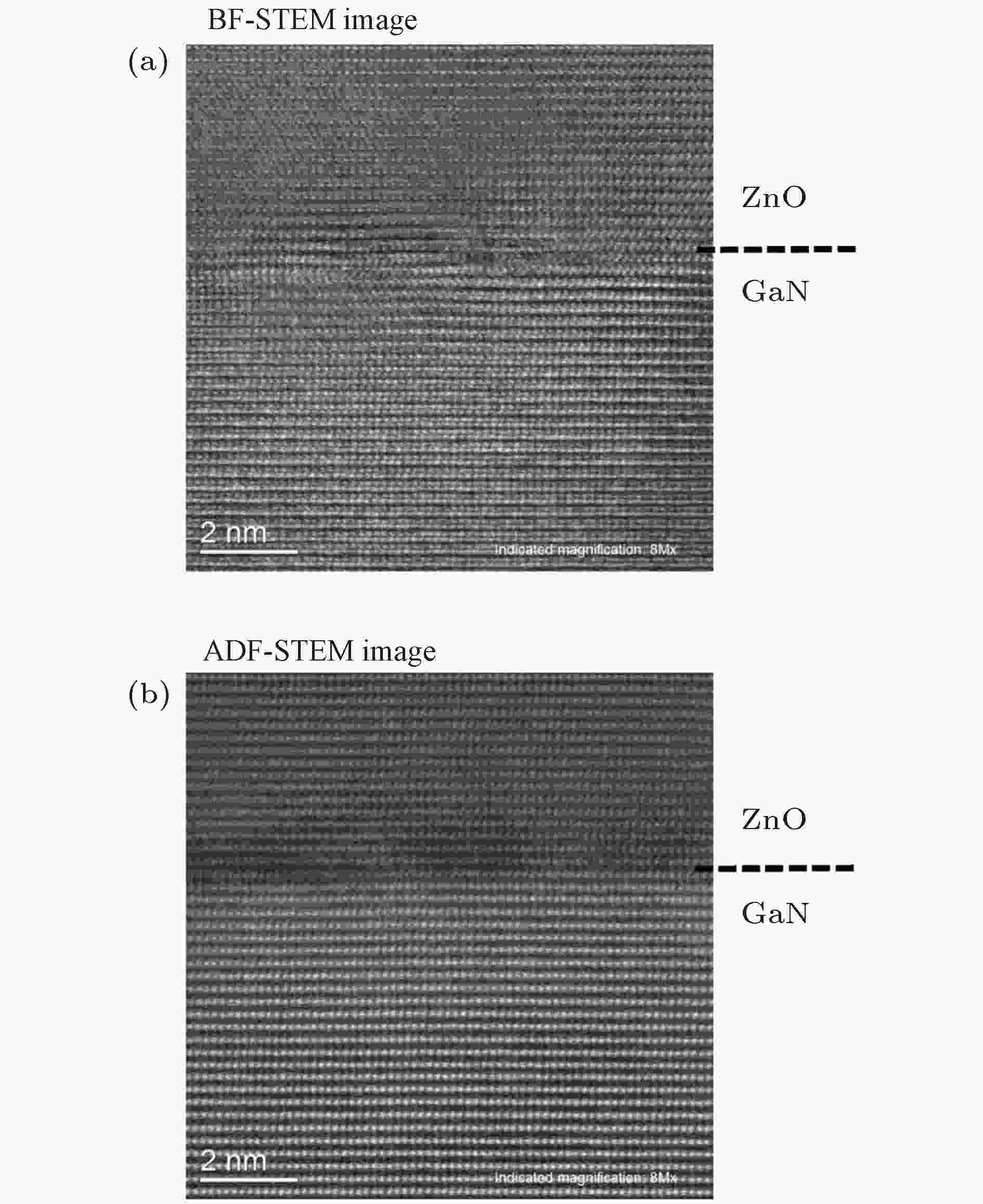 图 3 ZnO与GaN异质界面的STEM图像, 通过Zn束流保护, 获得了清晰陡峭的界面, 保证了外延层的Zn极性均一[17]
图 3 ZnO与GaN异质界面的STEM图像, 通过Zn束流保护, 获得了清晰陡峭的界面, 保证了外延层的Zn极性均一[17]Figure3. The STEM image of the hetero interface between ZnO and GaN, and it is protected by Zn beam, which obtains a clear and sharp interface and ensures uniformity of Zn polarity in the epitaxial layer[17]
2
2.2.同质外延生长
如前所述, 理想的外延衬底选择是同质的ZnO单晶衬底, 其除了满足晶格匹配和热匹配的条件, 使衬底与外延层界面处缺陷得到抑制之外, 通过衬底特定Zn/O极性面的选择, 可较为容易地控制外延的均一极性生长. 早在20世纪70年代, Helbig[18]就利用Zn蒸气热氧化的方法, 获得了重量达20g的大尺寸ZnO块体材料; 到20世纪90年代末, Look等[19]利用气相传输的方法获得了直径达2英寸的ZnO衬底基板, 这均为ZnO的同质外延奠定了基础. 但是, 为了获得结晶质量更高的单晶薄膜, 衬底基板的要求必须为单晶且杂质含量更低. 此后, 日本东京电波公司(Tokyo Denpa Co. Ltd.)与日本东北大学(Tohoku University)及日本三菱化工(Mitsubishi Chemical Corporation) 合作, 利用水热法合成了ZnO的块体单晶, 并在此基础上制备出了2英寸的ZnO单晶衬底[20,21]. 该ZnO单晶衬底具有较高的结晶质量, (0002)摇摆曲线FWHM为18 arcsec, 经退火后的衬底表面腐蚀坑密度EPD仅为80 cm–2, 这已达到开盒即用(epi-ready)级要求. 然而, 需要特别注意的是, 由于水热生长过程中使用了矿化剂, 这些ZnO单晶基片都不可避免地含有非常大浓度(ppm级)的非故意掺杂元素, 包括Li, K, Al, Fe等. 为降低外延过程中, 该类杂质元素等影响, 需要进一步优化水热合成条件[22]或者对衬底基片进行必要的表面处理过程[23,24]. 因为在同质外延条件下, 衬底的匹配性有了保证, 故而外延过程中, Zn/O的束流比例以及极性面的选择变成了实现高质量生长的关键参量. Kato等[25,26]在Zn极性ZnO单晶衬底表面, 利用富O束流条件, 实现了ZnO外延的二维生长过程, 获得了残余电子为2.2 × 1016 cm–3, 载流子迁移率为158 cm2/Vs的ZnO单晶薄膜. 通过进一步提升O/Zn的束流比例, 在Zn极性面上构建极其富O的外延环境, Park等[27]获得(0002)摇摆曲线的FWHM仅为13 arcsec, 且表面粗糙度仅为0.9 nm的高结晶质量ZnO单晶薄膜. 得益于ZnO单晶衬底的应用, 使外延薄膜的结晶质量与极性均一得到了保证, Tsukazaki等[28]在Zn极性的ZnO单晶衬底上构建了MgZnO/ZnO异质结界面, 获得了电子迁移率高达180000 cm2/Vs的二维电子气系统, 实现了分数量子霍尔效应, 为将来量子器件的开发构建了一个新的材料研究平台. 在较高结晶质量的保证下, 如图4所示, Nakahara等[29]在Zn极性ZnO单晶衬底上, 利用氨气(NH3)为氮(N)源, 实现了p型N:MgZnO薄膜制备, 获得了发光波长约382 nm, 输出功率达70 μW的发光二极管. 这一系列的结果均说明了ZnO单晶衬底为外延较高结晶质量的II族氧化物半导体薄膜提供了重要保证. 图 4 N掺杂MgZnO薄膜原子力图像, 粗糙度为0.72 nm[29]
图 4 N掺杂MgZnO薄膜原子力图像, 粗糙度为0.72 nm[29]Figure4. Atomic force image of N-doped MgZnO film with roughness of 0.72 nm[29]
2
2.3.合金外延生长
深紫外波段光电子器件的实现关键在于利用能带工程调节带隙进入更宽范围, 同时构建出量子阱、异质结等核心结构单元. 通过合金组分调节, 是实现带隙可调的有效途径. 以ZnO为代表的II族氧化物半导体材料, 目前可通过MgxZn1-x O[30-46], BexZn1-xO[47-53]以及BexMgyZn1-x-yO[54-62]的合金化过程实现在紫外波段的大范围覆盖, 如图5所示. 由于MgO的热力学稳定晶相是立方岩盐结构, 因此通常情况下, 当Mg含量超过0.4—0.5时, MgZnO会从六角纤锌矿结构向立方岩盐矿结构转变. 更值得关注的是, 立方相MgZnO在带隙对应深紫外波段范围内是稳定晶相, 同时, MgO的激子结合能为80 meV[63], 因此, 立方相MgZnO作为深紫外发光、激光材料的候选项, 也具有重要研究价值. 如文献[43—45]在MgO单晶衬底上外延Mg组分大于0.5的立方MgZnO薄膜, 并通过电子束激发获得了带边深紫外发光, 为该晶相体系的研究开辟了新的方向. 近些年来, 我们研究组在蓝宝石、MgO等衬底上, 也开展了立方晶系下Mg组分调节、高结晶质量外延生长、n型掺杂等一系列基础性研究工作[39-42]. BeO带隙为10.6 eV, 具有与ZnO相同的纤锌矿结构, 因此BeZnO合金体系, 具有比MgZnO体系更大的带隙调节范围, 且原则上不存在分相的情况. 然而, 由于存在较大的共价键半径差, Be(0.96 ?), Zn(1.22 ?)[64], BeO的晶格常数(a = 2.698 ?; c = 4.38 ?)比ZnO小得多[65], 导致Be含量在中间范围(35%—70%)时, BeZnO合金是不稳定的, 并且倾向于分离成较高和较低的Be含量相[66,67]. 因此, 当Be含量超过10%时, 大多数增加的Be原子取代间隙位置而不是取代Zn位[59], 使得BeZnO的晶格常数和带隙几乎保持不变. 近年来, 为了克服MgZnO的分相以及BeZnO体系的中间组分相不稳定等不足, BeMgZnO体系的研究受到了越来越多的关注. 考虑到, Mg的共价半径为1.41 ?[64], 可以补偿由于掺入具有更小共价半径的Be(0.96 ?) 而引起的内部应变. 因此在纤锌矿BeMgZnO合金体系中, 可以通过选择合适的Mg, Be, Zn组分比例提高合金晶相的稳定性, 同时兼顾带隙与晶格常数的调节范围(与ZnO晶格匹配)[55,57,58,61,62]. 此外, 在BeMgZnO/ZnO等异质结界面处, 可以通过Be, Mg比例的调节, 实现应变外延层中在张应变与压应变之间的转变, 使自发极化与压电极化方向相同, 进而增强以该合金体系为基础的二维电子气系统, 如图6所示[56]. 总之, 利用BeO, MgO, ZnO的合金化过程, 使II族氧化物半导体材料的带隙可以覆盖紫外波段的较大部分, 同时薄膜结晶质量的提升为进一步的光电特性研究打下了基础. 图 5 II族氧化物半导体带隙与晶格常数关系
图 5 II族氧化物半导体带隙与晶格常数关系Figure5. Relationship between band gap and lattice constant of group II oxide semiconductors.
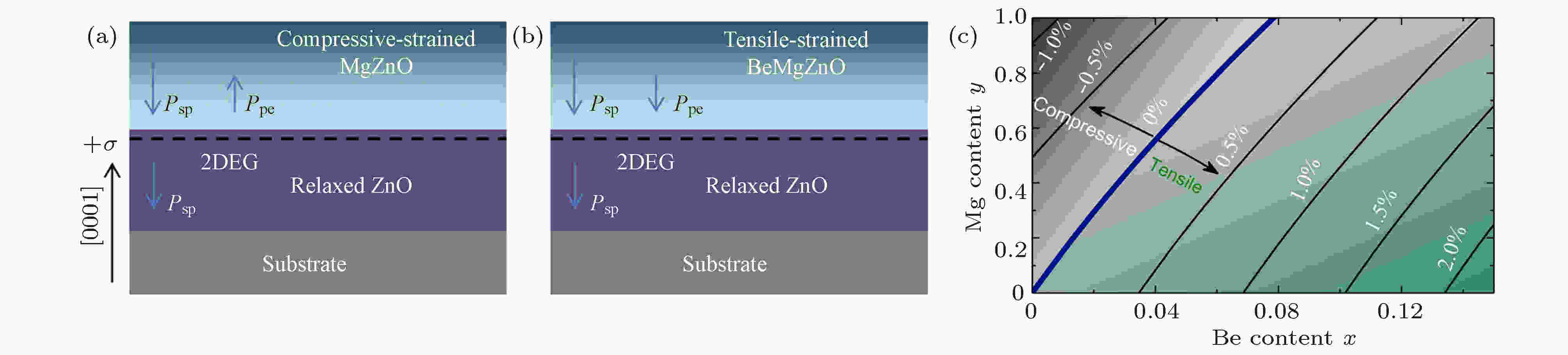 图 6 (a), (b)二维电子气系统中应变层应力类型与压电极化方向; (c) BeMgZnO体系下应变类型随组分比例的变化情况[56]
图 6 (a), (b)二维电子气系统中应变层应力类型与压电极化方向; (c) BeMgZnO体系下应变类型随组分比例的变化情况[56]Figure6. (a), (b) Strain stress type and piezoelectric polarization direction in two-dimensional electron gas system; (c) variation of strain type with composition ratio in BeMgZnO system[56]
基于第一性原理对点缺陷及杂质的形成能与缺陷转变能级的研究具有较大的灵活性和前瞻性, 因此在宽禁带II族氧化物半导体材料掺杂的研究中, 针对丰富的缺陷类型有着较为充分的理论研究. 特别是针对ZnO的p型掺杂研究中, 单一替位型及团簇复合型缺陷的研究更为丰富. 在具体的理论研究中, 特定缺陷(包括其在不同的带电状态下)的形成能是体系费米能级(EF)及其反应物化学势(μi)的函数. 当生长化学环境较为稳定时, 缺陷及杂质形成的难易程度与体系EF直接相关, 即当EF水平较高时, 体系电子浓度水平较高, 此时施主型缺陷及杂质较难形成; 反之亦然[68]. 理论计算表明, ZnO中在富锌的条件下, 氧空位与锌间隙具有较低形成能; 而在富氧条件下, 锌空位具有较低形成能[69]. 此外, 由于ZnO的价带主要成分为O的2p轨道构成, 所以其价带顶具有较低的能级水平, 进而造成了多数常规的单一替位掺杂具有较深的受主离化能级[70,71]. 因此, 在理论计算上, 研究者们构建了许多新颖的复合型缺陷类型, 以此力求寻找到离化能相对较浅的受主型缺陷态, 比如施主-受主复合型[72-74]、第五主族元素替位或间隙位-锌空位复合型[75,76]、等电子杂质-氮替氧[77](4MgZn + NO)以及在ZnO的价带顶附近构建杂质带[78] 等途径. 这一系列富有创造性的理论研究结合针对性的实验探索将会为ZnO的p型掺杂研究提供更为有力的技术手段.
2
3.1.非故意引入杂质的抑制
非故意引入杂质的来源主要有三方面, 即衬底扩散、外延原料、生长环境. 目前, 常用的蓝宝石衬底制备工艺较为成熟, 通过外延生长之前适当的清洗与预处理过程便可以得到较为干净、平整的表面, 同时, 考虑到II族氧化物半导体外延生长所需衬底温度不高, 来自衬底中Al元素的扩散并不明显, 如我们外延的高结晶质量ZnO薄膜的二次离子质谱(SIMS)数据所示[79](图7(a)), 因此, 蓝宝石上外延的薄膜基本可以避免来自衬底的污染. 如前所述, 虽然ZnO单晶衬底具有晶格匹配与热匹配的优势, 但是水热合成过程中矿化剂的使用, 使其具有种类较多且浓度较高的杂质元素, 导致杂质元素不可避免地扩散到外延薄膜层中形成污染, 如图8所示[80]. 因此, 在外延生长之前, 采用必要的表面处理过程就显得尤为重要. 目前, 针对ZnO单晶衬底, 主要有O极性表面在氧环境中高温退火过程, 以及Zn极性表面的化学机械抛光过程. 如图9所示, O极性面ZnO单晶衬底在氧环境中1150 ℃退火1h后, 衬底中如Li, Na等元素的含量降低[23]. 对于Zn极性面来说, 虽然化学机械抛光过程会把由于退火后易向表面富集的杂质元素去除, 但是经过抛光和漂洗的Zn极性表面会粘附上来自抛光溶液中的二氧化硅颗粒, 并且不能通过用去离子水冲洗表面来除去, 主要原因是在抛光过程中表面可能形成了氢氧化锌层[81]. 利用稀盐酸(HCl:H2O = 7:200)进行表面刻蚀, 不但可以去除表面氢氧化锌层并消除残留硅元素的影响, 而且能够恢复出阶梯状原子台阶的平整表面, 如图10所示[81,82]. 总之, 结合高温退火和稀盐酸刻蚀过程对于在ZnO单晶衬底上制造高质量薄膜至关重要.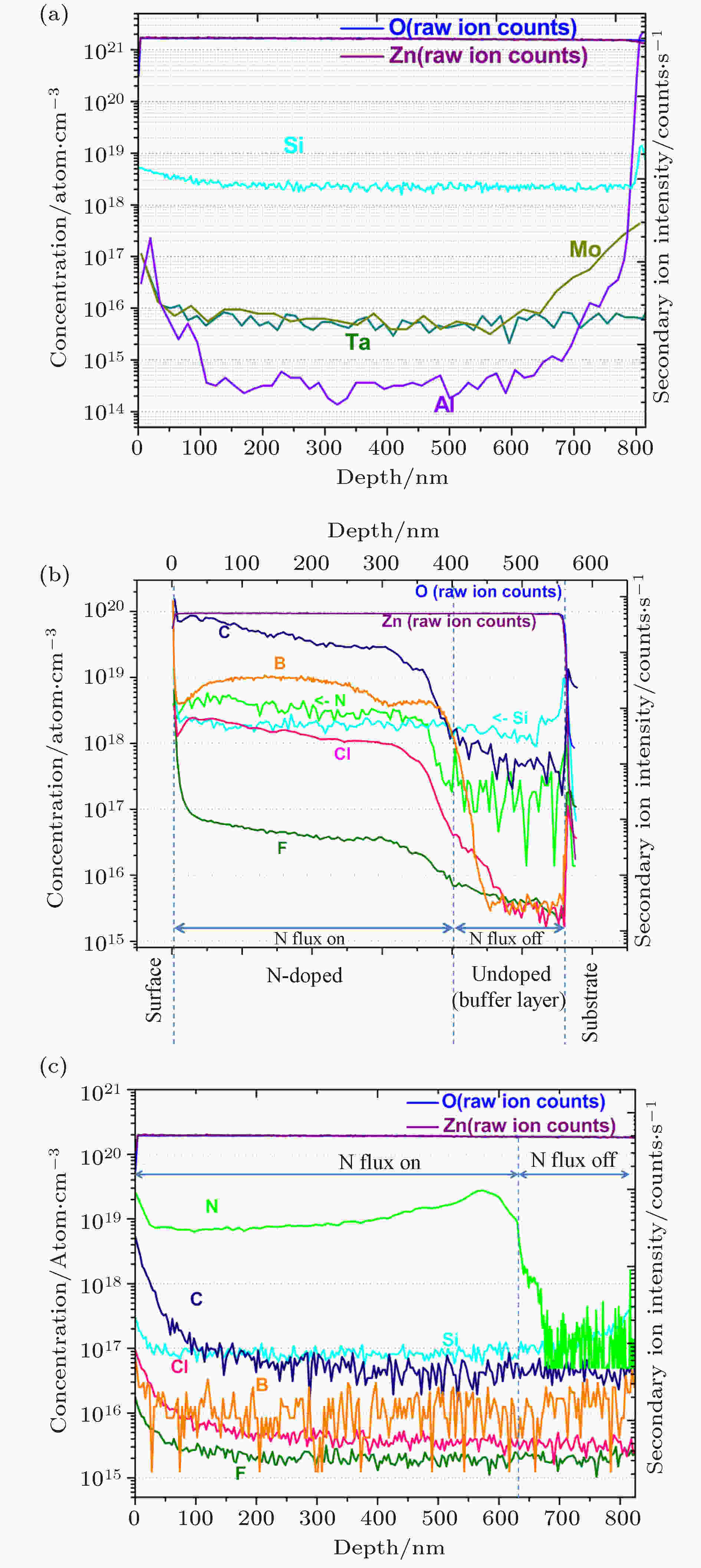 图 7 ZnO薄膜中杂质浓度的深度分布情况 (a)非故意掺杂层中Si, Mo, Ta, Al的分布情况; (b)氮掺杂层中C, B, N, Cl, F的分布情况; (c) 施主型杂质元素经抑制后的纵向分布情况[79]
图 7 ZnO薄膜中杂质浓度的深度分布情况 (a)非故意掺杂层中Si, Mo, Ta, Al的分布情况; (b)氮掺杂层中C, B, N, Cl, F的分布情况; (c) 施主型杂质元素经抑制后的纵向分布情况[79]Figure7. Depth distribution of impurity concentration in ZnO thin films: (a) Distribution of Si, Mo, Ta and Al in unintentionally doped layers; (b) longitudinal distribution of donor-type impurity elements after suppression[79]
 图 8 ZnO单晶衬底上外延层中杂质元素的SIMS数据[80]
图 8 ZnO单晶衬底上外延层中杂质元素的SIMS数据[80]Figure8. SIMS data of impurity elements in epitaxial layers on ZnO single crystal substrates[80]
 图 9 极性面ZnO单晶衬底在氧环境下经1150 ℃退火1h前后, 杂质种类及含量变化情况[23]
图 9 极性面ZnO单晶衬底在氧环境下经1150 ℃退火1h前后, 杂质种类及含量变化情况[23]Figure9. Changes in impurity types and contents of O-polar ZnO single crystal substrate after annealing at 1150 ℃ for 1 hour in an oxygen atmosphere[23]
 图 10 (a)稀盐酸刻蚀后的ZnO单晶Zn极性表面; (b)稀盐酸刻蚀前后, Si元素的深度分布[81,82]
图 10 (a)稀盐酸刻蚀后的ZnO单晶Zn极性表面; (b)稀盐酸刻蚀前后, Si元素的深度分布[81,82]Figure10. (a) Zn polar surface of ZnO single crystal after being etched by dilute hydrochloric acid; (b) depth distribution of Si element before and after being etched dilute hydrochloric acid[81,82]
利用MBE技术外延的ZnO基薄膜, 通常采用的是高纯金属源, 如高纯金属Zn(纯度7N)、高纯金属Mg(纯度6N); 氧源一般是高纯的氧气经过纯化器后纯度能达到9N, 所以, 来自原料的杂质元素基本可以排除. 然而, MBE系统中, 承装或者激活这些原料的区域则有可能引入外来杂质, 比如, 基片操作器(包括样品衬底托和加热区的热屏蔽层)、Knudsen束源炉中的坩锅(一般为热解氮化硼PBN)、射频原子源中的放电管(氧气一般使用石英材料, 氮气一般使用PBN材料). 首先, 考虑样品托和热屏蔽层引入杂质的可能性, 我们的样品托材质为高纯钼(Mo), 热屏蔽层材质为钽(Ta), 从图7(a)中SIMS的深度分布可以看出, ZnO薄膜中Ta的含量极低(< 1016 cm–3), 而Mo只在外延层与衬底的界面处存在较低含量(1017 cm–3), 且在外延层内部含量极低(< 1016 cm–3), 因此, Mo的污染可能来自生长前的真空高温处理过程, 但并不影响上层薄膜[79]. Kozuka等[82]起初使用的样品托材质为高温下抗氧化能力较强的铬镍铁合金, 他们利用SIMS发现了ZnO外延薄膜中存在着如锰(Mn)之类的构成样品托材质的杂质元素, 然后, 通过更换成石英作为衬底托的材料, 消除了过渡族金属杂质的影响, 从而获得了在SIMS检测下没有镍(Ni), Mn, 钴(Co)和Mo等污染元素的ZnO薄膜. 另一个最有可能的杂质引入源便是源炉坩锅和射频放电管, 因此, 我们对ZnO薄膜进行了非故意掺杂与氮掺杂外延生长, 对薄膜中的杂质元素(Si, C, B, N, Cl, F)的深度分布做了系统分析[79]. 如图7(a)和图7(b)所示, 非故意掺杂层中主要的杂质类型为Si(1018 cm–3), 且其含量与氮掺杂与否无关, 因此, 我们认为Si杂质的来源为氧射频原子源中的石英放电管. Akasaka等[83]的相关研究结果也同样认为Si的污染来自氧等离子源. 氮掺杂的ZnO薄膜中, C, B, N, Cl, F杂质都随着氮源快门的打开而出现, 如图7(b)所示, 因此, 我们认为这些杂质元素的来源可能为氮射频原子源中的PBN放电管. 随后, 通过对放电管进行有针对性的处理, 如图7(c)所示, 获得了Si, C, B, Cl, F等失主型杂质含量均低于1017 cm–3的ZnO薄膜, 凸显了受主掺杂剂氮的浓度水平, 同时, 使非故意掺杂的ZnO的残余电子浓度降至1015 cm–3, 为下一步的p型掺杂奠定了基础.
2
3.2.原生点缺陷
原生点缺陷是指仅涉及到材料构成元素的缺陷, 包括空位、间隙及反位. II族氧化物半导体作为化合物半导体材料具有丰富的点缺陷类型, 比如在ZnO中, 存在氧空位(VO)、锌空位(VZn)、氧间隙(Oi)、锌间隙(Zni)、反位氧(OZn)、反位锌(ZnO), 其中Oi, OZn, ZnO具有较高的形成能, 因此, 在通常情况下, 在ZnO中的浓度较低, 一般不予考虑. VO与Zni起到施主的作用, 在p型掺杂的过程中往往对受主杂质起到补偿的作用, 降低掺杂效率; VZn为受主型缺陷, 其在n型重掺杂的ZnO中同样起到了补偿中心的作用, 进而限制了ZnO基透明导电薄膜电导率的进一步提升. 此外, 近年来, 与VZn有关的复合型受主缺陷态被认为是实现有效p型掺杂的可能途径. 正因为原生点缺陷起到如此重要的作用, 多年来, 许多重要的实验与理论相关结果被相继报道[84-99], 包括缺陷能级结构、实验表征手段、复合型缺陷的构建等等.3
3.2.1.施主型原生点缺陷
相关研究结果表明, 虽然Zni为浅施主态[85,86,100], 但是其在n型ZnO中的形成能较高, 且扩散迁移势垒较低[100-102], 因此在外延生长过程中, 会向表面扩散, 使得薄膜内部含量较低. 相较之下, 另一种施主型点缺陷VO的相关研究则相对较多, 其在ZnO中具有较低的形成能, 曾一度被认为是非故意掺杂ZnO的n型导电来源, 但是一些结果表明, VO在ZnO中的能级较深, 不易离化产生足够的电子[86,87]. 然而, 无论Zni与VO的能级深度如何, 其在p掺杂ZnO中均具有较低的形成能, 起到补偿受主杂质的作用, 是实现空穴导电的不利因素. 因此, 如何在外延生长的过程中, 对其实现有效的抑制也是十分重要的研究方向. 除了调节O/Zn束流比, 营造富氧的生长环境等常规手段以外, 我们提出利用非平衡电子富集Zn极性外延面的手段(如 图11所示), 构建施主型缺陷形成能较高的外延层环境, 实现了对VO的抑制, 降低了其对氮的补偿作用[17]. 图 11 沿极性表面外延时, Zn极性与O极性表面极化电荷分布情况以及利用光生非平衡载流子构建Zn极性表面层富电子环境[17]
图 11 沿极性表面外延时, Zn极性与O极性表面极化电荷分布情况以及利用光生非平衡载流子构建Zn极性表面层富电子环境[17]Figure11. Zn polar and O polar surface polarized charge distribution along epitaxial surface and Zn polar surface layer rich electronic environment using photogenerated unbalanced carriers[17]
3
3.2.2.受主型原生点缺陷
在ZnO中VZn具有双受主缺陷态, 但其能级较深, 且在p型掺杂ZnO中的形成能较高, 因此很难直接引入VZn并以此实现空穴型导电[87]. 与VZn相结合的复合型缺陷态在ZnO中则表现出较浅的受主能态, 例如第五主族元素与VZn形成的复合体[103,104]. 对VZn的有效调控, 将是实现p型ZnO的一个有价值的途径. 因此, 在外延生长过程中对VZn形成过程的有效控制便显得尤为重要, 我们提出了基于Zn极性面(2 × 2) + VZn重构的外延表面来实现锌空位的可控引入过程, 如图12所示[105], 通过充分的表面弛豫, 实现了富VZn的外延表面层环境, 为进一步与受主杂质结合提供了可行途径.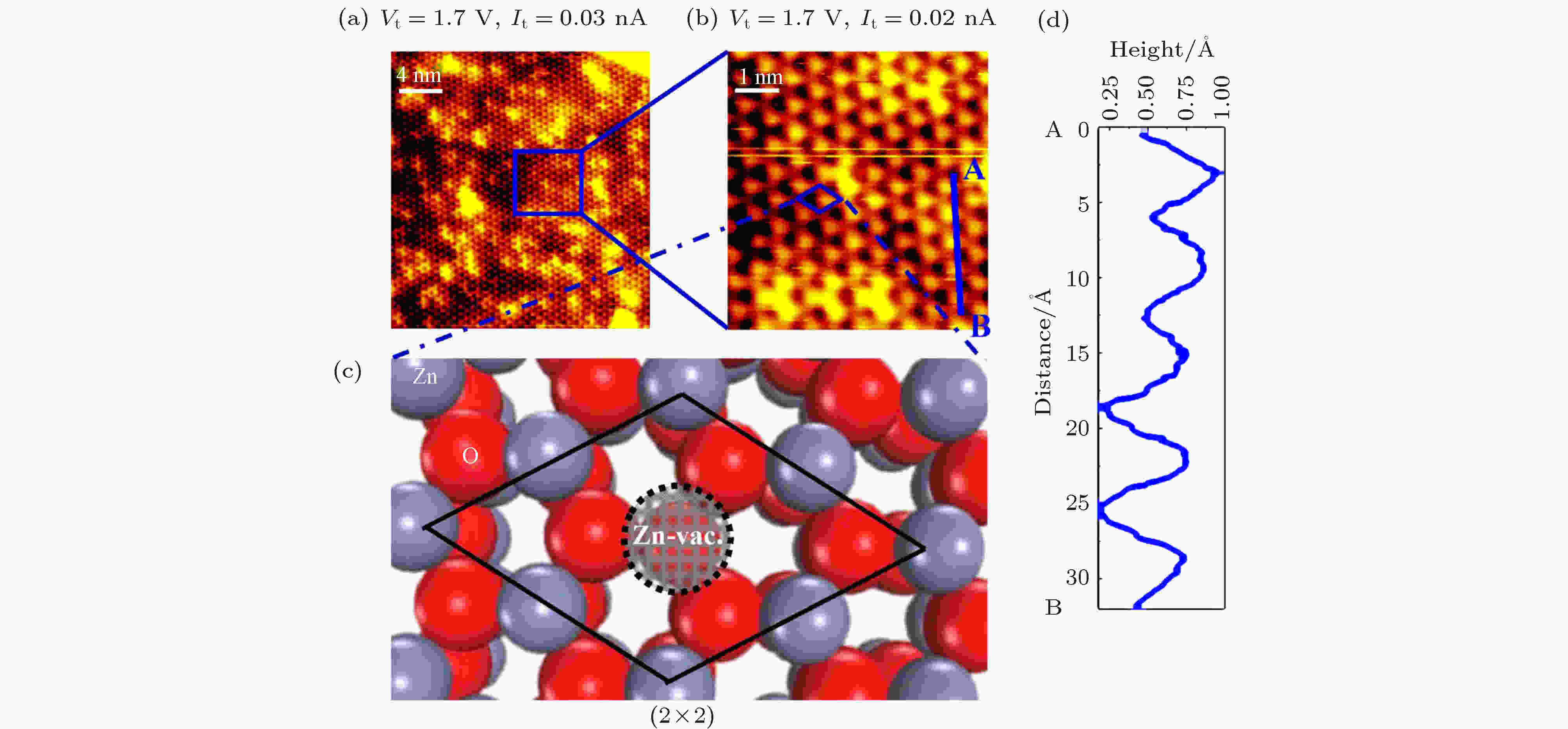 图 12 Zn极性表面(2 × 2) + VZn重构的STM图像及结构示意图[105]
图 12 Zn极性表面(2 × 2) + VZn重构的STM图像及结构示意图[105]Figure12. STM image and structure diagram of Zn polar surface (2 × 2) + VZn reconstruction[105]
如前所述, ZnO中空位型点缺陷(VO与VZn)对掺杂及电学性能具有十分重要的影响. 目前, 可以通过正电子湮没谱(positron annihilation spectroscopy, PAS)[106-113]、电子顺磁共振(electron paramagnetic resonance, EPR)[114-118]、扫描隧道显微镜(scanning tunneling microscope, STM)[119-122]等技术手段, 对空位型点缺陷进行表征. 此外, 还可以通过变温度、变激发功率的常规发光光谱(photoluminescence, PL; Cathodoluminescence, CL)等方法[123-128], 对与缺陷相关的发光特性进行表征, 进而确定缺陷态的相关特性(如离化能等). PAS是一种用于定性与定量识别固体中具有开放体积缺陷的有效方法, 其对空位型缺陷十分敏感, 灵敏度在1016—1019 cm–3范围; EPR对具有未配对电子的缺陷中心有广泛的选择性和灵敏度, 即使在非常低的浓度下也能对缺陷中心及其环境进行表征. 但是与常规发光光谱手段相同的是, 这些表征手段给出的都是统计后结果, 随着进入更宽带隙范围, 如随着BeMgZnO等合金体系研究的深入, 点缺陷类型及组合将变得更为丰富, 为避免遗漏, 针对特定点缺陷及组合的精准表征将有望实现对较浅缺陷能级的确定, 进而可以通过后续外延过程构建相应能量环境使得特定缺陷浓度占主导地位, 达到调控电学性能的目的. STM虽然可以针对单一点缺陷进行表征, 但其作用范围为表面层, 体内特定点缺陷的信息获取仍存在难度.
总体上来说, 当前ZnO的p型掺杂研究在理论以及实验上已经比较充分, 目前也已经实现了较为稳定的空穴导电性能, 获得了近紫外的电致发光器件, 然而, 若要实现高性能的紫外激光器件, 则对空穴的浓度, 或者说p型电导率提出了更高要求. 此外, 更为重要的是, 在能带工程中随着带隙的增大, 相应受主(施主)离化能级进一步深化, 加之掺杂过程中自补偿效应变得更为显著, 使导电类型及电阻率的调控难度加剧, 进而阻碍了该材料体系在深紫外波段的应用. 这一系列的难题也是其他类型宽禁带半导体材料共同面对的. 因此, 在宽带隙半导体掺杂的研究中, 针对特定缺陷的表征十分重要, 包括点缺陷的元素组成、成键与能级情况, 即通过针对缺陷物理的研究过程, 使得后续电学调控的技术参数调整具有精准的目标.
