全文HTML
--> --> -->在1999年spin LED概念已被提出[5,6], 在GaAs基半导体异质结中利用顺磁半导体[5]或者磁性半导体[6]作为自旋注入端, 低温下通过自旋极化的载流子注入到半导体中, 自旋极化载流子在半导体激活区与空穴(或电子)复合产生左旋或右旋的圆偏振光, 以偏振光信息表达自旋量子信息. Spin LED为读取半导体和量子阱(点)中自旋相干态的信息提供了可能. 但由于自旋注入效率及工作温度等问题, 在较长时间内困扰着spin LED的进一步发展. 为此, 半导体自旋电子学领域针对spin LED的研究历程也主要围绕着自旋注入端而开展, 以达到在零磁场下和室温条件下能够有效进行自旋注入来实现较大圆偏振光极化率. 为此, 本文将回顾spin LED的研究历程, 总结spin LED中自旋、电学和光学性质及其之间的物理关系; 介绍spin LED研究过程中所涉及的自旋注入端材料、结构和物理; 最后进一步对未来研究趋势进行展望.
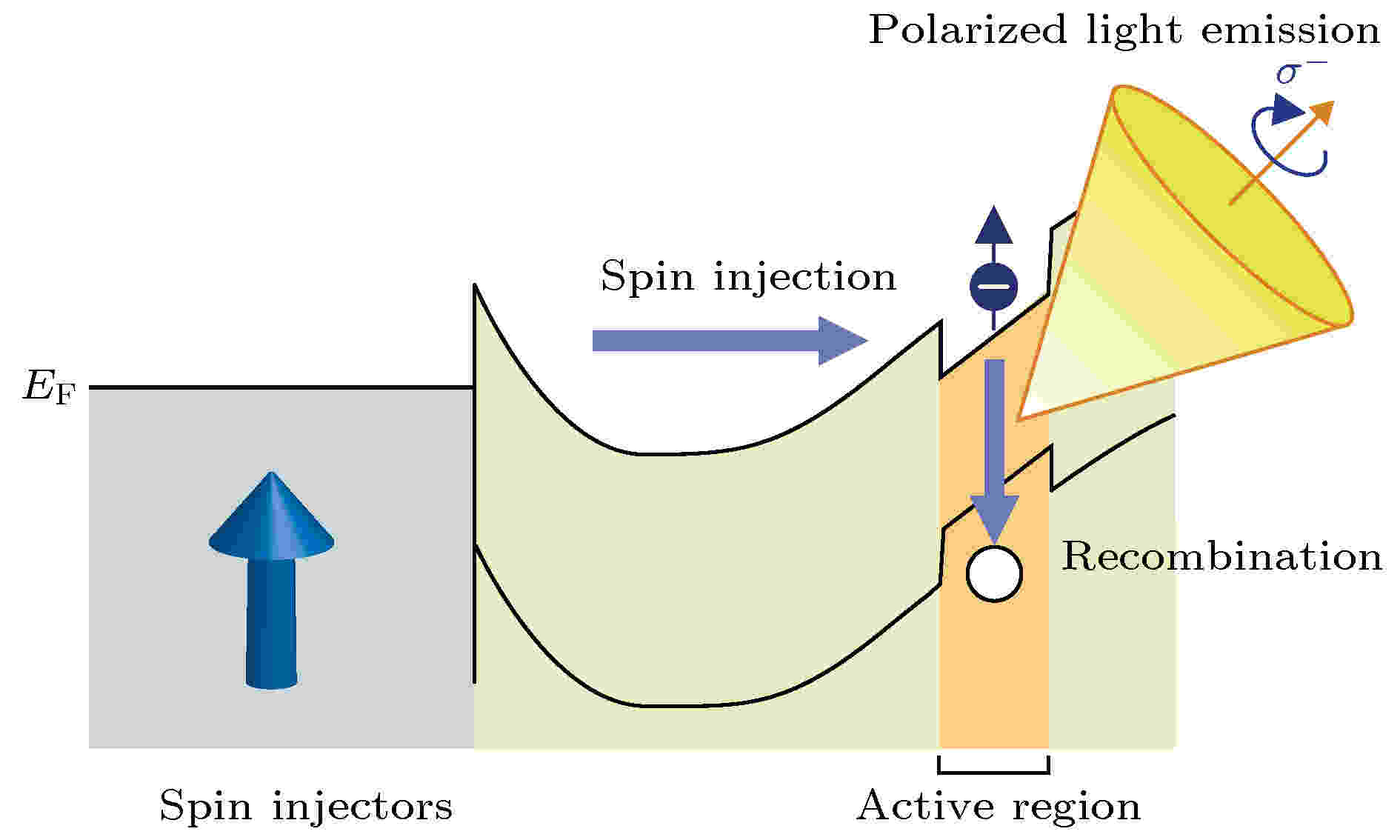 图 1 Spin LED能带结构示意图[7]
图 1 Spin LED能带结构示意图[7]Figure1. Schematic of band diagram of spin LED[7]
Spin LED中圆偏振光可以通过电学注入以电致发光方式进行检测, 其测量系统如图2所示, 自旋极化电子注入所产生的圆偏振光通过聚焦准直后经过1/4玻片, 经线偏振片后进入单色仪, 然后在CCD上进行成像. 通过测量产生的左旋及右旋圆偏振发光强度(



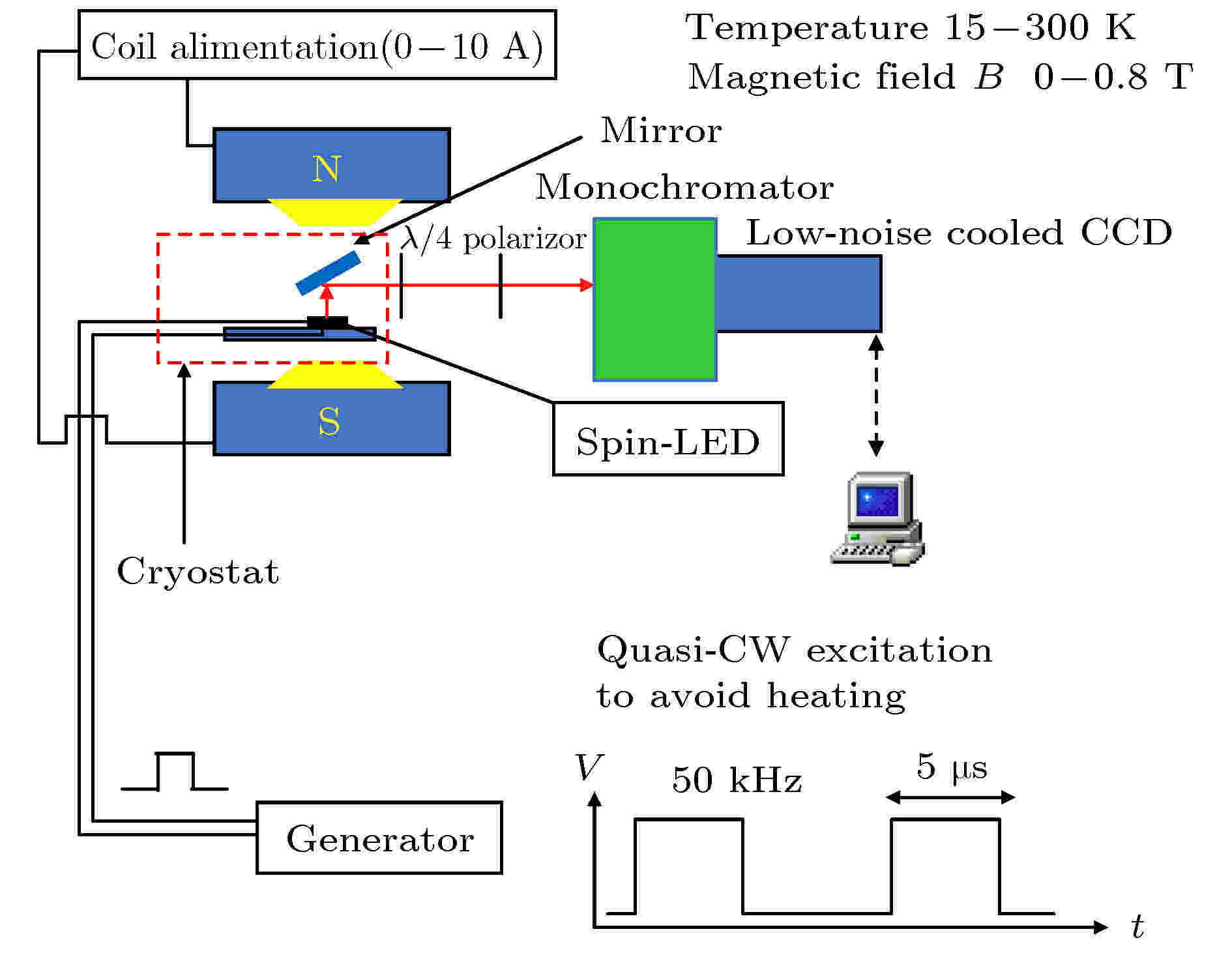 图 2 自旋发光二极管的电致发光中偏振光测量系统原理示意图
图 2 自旋发光二极管的电致发光中偏振光测量系统原理示意图Figure2. Schematic diagram of electroluminescence measurement system for spin LED


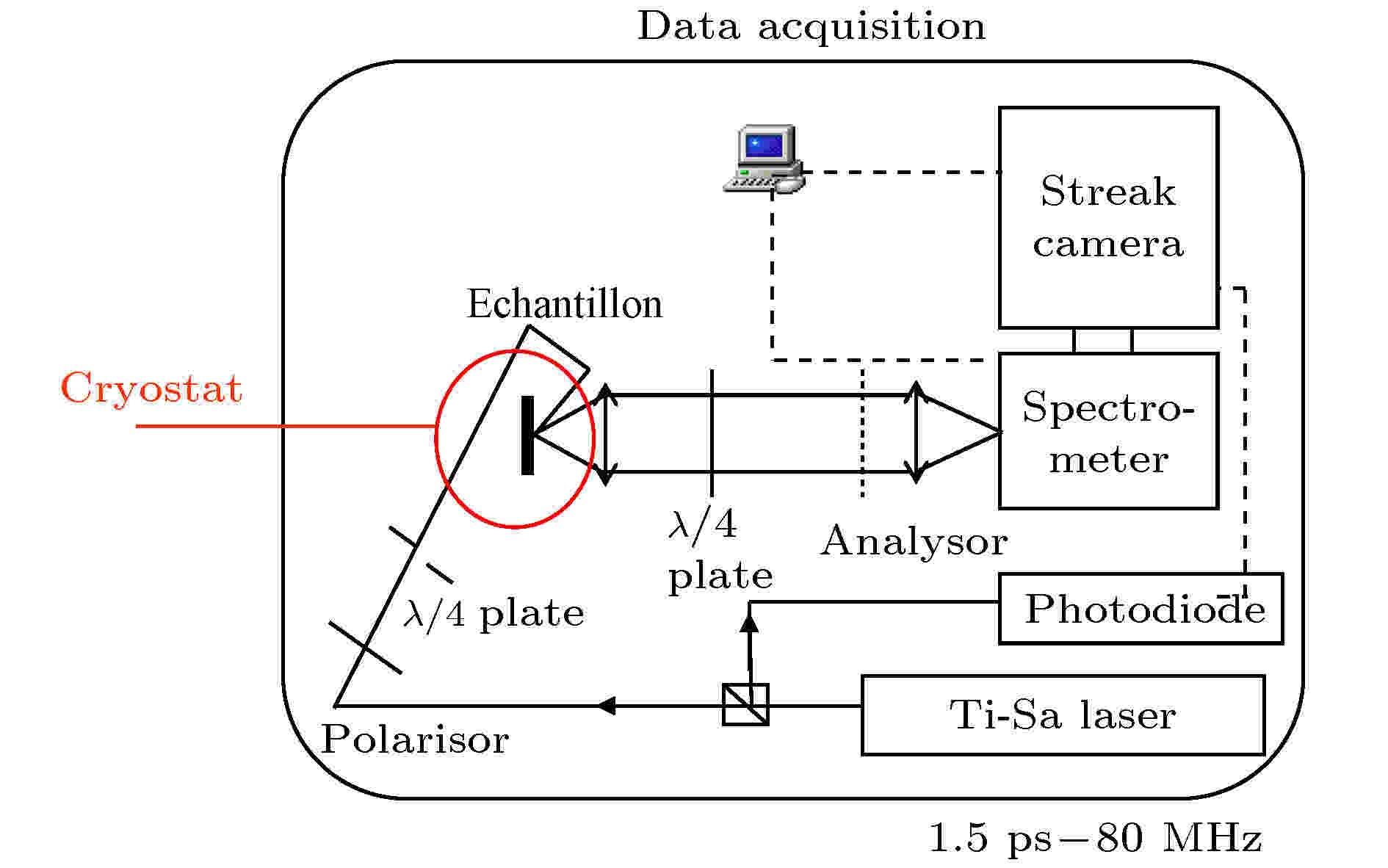 图 3 Spin LED中时间分辨光致发光系统原理示意图
图 3 Spin LED中时间分辨光致发光系统原理示意图Figure3. Schematic diagram of time-resolved photoluminescence system






2
3.1.自旋注入
自旋注入是指将自旋极化电流注入到非磁性金属或者半导体中. 首先要考虑怎样产生自旋极化电流, 目前主要有电学注入、光学注入及自旋霍尔效应等方法. 对于spin LED中的电致发光研究用到的是电学注入. 利用铁磁材料层作为自旋注入端, 电子在铁磁层内会进行自旋极化, 利用电学方法将自旋极化的电子从铁磁层注入到半导体中. 其次, 自旋注入中主要考虑的问题是自旋注入的效率, 自旋注入效率定义为注入的电子极化率与铁磁体自旋极化率的比值. 自旋注入层/半导体的界面质量、缺陷杂质和能带结构等因素都会对自旋进行散射从而影响到自旋的注入效率. 另外, 铁磁体与半导体的电导不匹配也会影响到自旋的注入效率.最早研究的自旋发光二极管是基于“磁性半导体/半导体”结构, 如以GaMnAs和ZnMnSe等磁性半导体作为自旋注入端[5,6], 该结构的优点是能够避免电导不匹配的问题, 但是由于磁性半导体的居里温度较低, 其在室温下不能进行有效的自旋注入. 后来人们用到居里温度较高的铁磁体作为自旋注入端, 如“铁磁体/半导体”结构, 但由于存在严重的电导不匹配而不能实现较高的自旋注入效率. 为此Rashba提出[9]用隧穿势垒层的方法, 即在铁磁体及半导体间插入势垒层构成“铁磁体/势垒层/半导体”结构, 从而解决了电导不匹配的问题, 因此在后续研究中自旋的注入效率得以显著提高.
2
3.2.自旋输运
自旋输运过程主要涉及电子在输运过程自旋弛豫等物理问题. 在spin LED中, 影响自旋输运过程的自旋弛豫机制主要有三种: Elliott-Yafet (EY)机制、Dyakonov-Perel (DP)机制和Bir-Aronov-Pikus (BAP)机制.1954年Elliott[10]研究表明, 材料中自旋轨道耦合可以将电子的波函数分为空间和时间反演对称的两个简并态: 一个为自旋向上态, 另一个为自旋向下态. 这种混合态会导致电子在动量散射过程中发生自旋翻转, 如电子-杂质散射和电子-声子散射等, 如图4(a)所示. EY机制中对于III-V半导体Γ点附近的自旋弛豫


 图 4 (a) EY和(b) DP自旋弛豫机制示意图[11]
图 4 (a) EY和(b) DP自旋弛豫机制示意图[11]Figure4. Spin relaxation by scattering in (a) EY and (b) DP mechanisms[11].
DP机制主要来源于半导体材料晶格结构的非对称中心反演特性, 它在III-V族半导体(如GaAs)及II-VI族半导体中的自旋弛豫过程起主导作用[1]. 在非对称中心反演半导体材料中的电子会受到一个有效磁场的作用, 从而绕着该有效场进行Larmor 进动. 该有效场的强度和方向依赖于电子的波矢K, 具有较强的各向异性. 当电子发生动量散射时, 电子的进动频率及有效磁场也会发生改变, 从而导致电子自旋相位退相干, 如图4(b)所示. DP机制的自旋弛豫率可以表述为[1]


Soldat等[12]研究了室温下电子在spin LED中的自旋弛豫长度, 通过FeTb/MgO自旋注入端将自旋极化电子注入到GaAs有源区, 他们发现圆偏振光极化率随自旋注入层到有源发光区之间长度的增加而呈指数衰减. 为此可以通过拟合得到自旋弛豫长度(如图5所示). 通过该实验得到的室温下GaAs中电子自旋弛豫长度为26 nm, 这与Saikin等[13]基于DP自旋弛豫机制计算得到的GaAs中25—50 nm的自旋弛豫长度理论值一致.
 图 5 圆偏振光极化率随自旋注入层到有源发光区之间长度关系[12]
图 5 圆偏振光极化率随自旋注入层到有源发光区之间长度关系[12]Figure5. Calculated circular polarization for fully perpendicular magnetization in remanence over injection path length[12].
此外, 比较(4)式和(5)式, 可以发现DP机制中自旋弛豫率






BAP机制来源于电子空穴的相互作用, 该机制在p型半导体中对于电子自旋的弛豫占主导作用. 当电子与空穴即将进行复合时, 电子和空穴间的散射会形成自旋交换作用, 因此当电子把自旋转移给空穴时, 会引起电子的自旋弛豫.
2
3.3.自旋探测
关于自旋探测有一系列方法, 包括磁电阻方法、自旋霍尔效应和Hanle效应的电探测方法、光致发光及电致发光的光探测等方法. Spin LED正是利用了光探测以表达自旋信息. 根据光学选择定则, 当电子与空穴复合后所产生圆偏振光的极化率与电子(空穴)的自旋极化率直接相关, 如图6所示. 如对于GaAs半导体体材料, 由于重空穴是三重简并态, 轻空穴是单态, 所以电子与重空穴的复合几率是其与轻空穴复合几率的3倍, 电子空穴复合发光的圆偏振极化率为[1] 图 6 在闪锌矿GaAs直接带隙能带中的光选择定则 (a)体材料及(b)量子阱中的电子空穴复合选择定则. 上边蓝色球代表电子, 下边的红色球代表空穴, 箭头代表自旋方向. 其中CB代表导带, HH代表重空穴带, LH代表轻空穴带, HH是三重简并态, LH是单态.
图 6 在闪锌矿GaAs直接带隙能带中的光选择定则 (a)体材料及(b)量子阱中的电子空穴复合选择定则. 上边蓝色球代表电子, 下边的红色球代表空穴, 箭头代表自旋方向. 其中CB代表导带, HH代表重空穴带, LH代表轻空穴带, HH是三重简并态, LH是单态. 

Figure6. Electric dipole allowed radiative inter-band transitions and corresponding optical polarization for the cases of (a) bulk material with degenerate heavy- and light-hole bands and (b) a quantum well in which epitaxial strain and quantum confinement have lifted the heavy- and light-hole band degeneracy[1].







对于量子阱结构如In1–xGaxAs/GaAs 量子阱, 由于结构限制及应变等约束作用, 其轻空穴能级下移与重空穴能级解除简并, 所以电子与轻空穴的复合被大大抑制. 此时, 电子空穴复合发光的圆偏振极化率为[1]
上述(6)式和(7)式中考虑到的是理想情况, 实际电致发光的极化率
















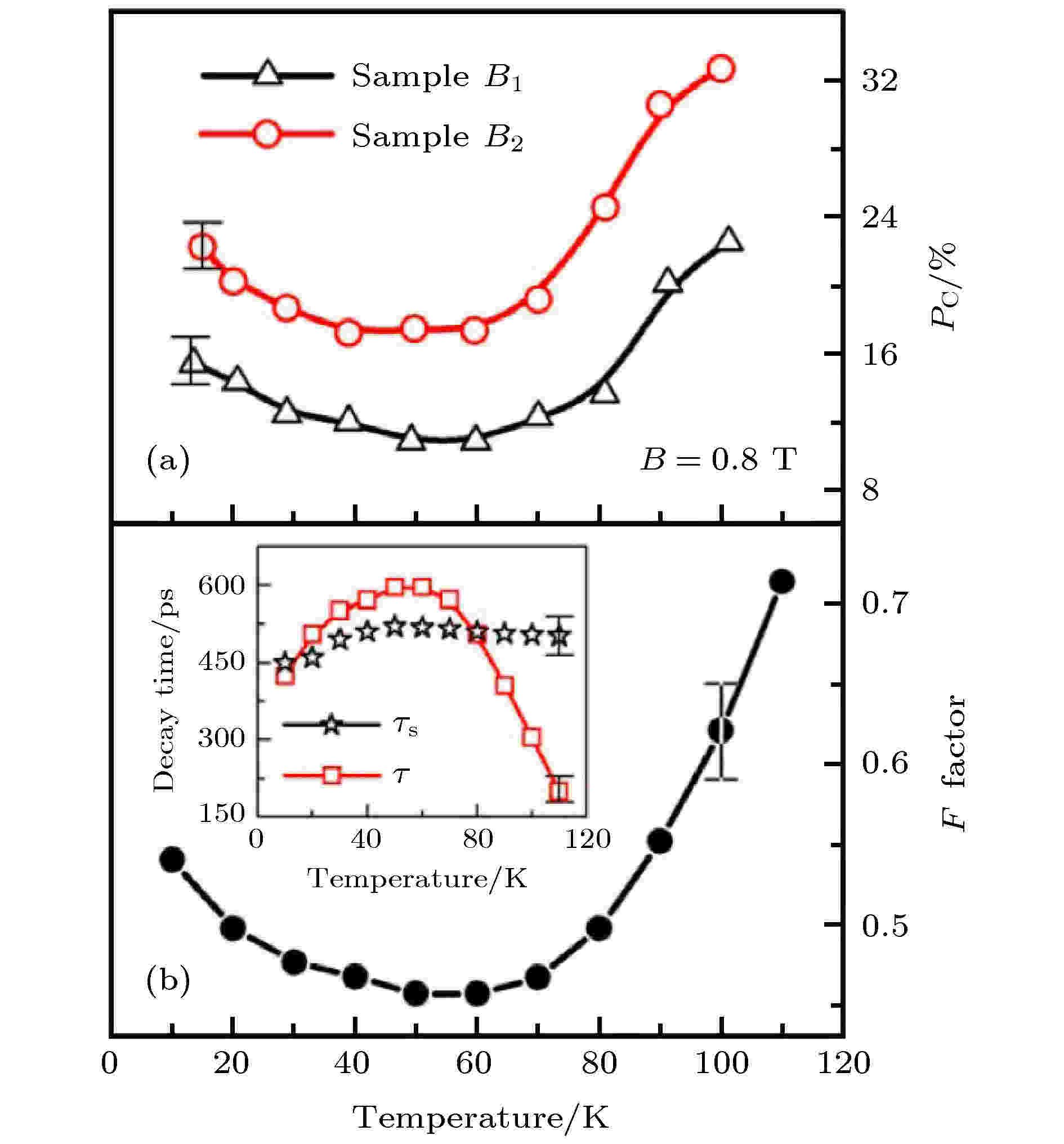 图 7 GaAs量子阱自旋发光二极管中 (a)温度依赖的PC特性和(b)温度依赖的τs, τ及F因子特性[8]
图 7 GaAs量子阱自旋发光二极管中 (a)温度依赖的PC特性和(b)温度依赖的τs, τ及F因子特性[8]Figure7. (a) Temperature dependence of PC, (b) temperature dependence of τs, τ, and the F factor in GaAs quantum well spin LED[8].
4.1.面内磁各向异性自旋注入端
Spin LED中自旋注入端有磁性半导体、铁磁性材料及磁性半金属等类型. 在较早的spin LED研究中, 主要使用的是磁性半导体(如GaMnAs, ZnMnSe, CdCr2Se4等)[5,6,14], 磁性半导体能够避免自旋注入层与发光区层的电导失配问题, 但由于磁性半导体的居里温度较低, 室温下则不能进行有效的自旋注入. 为此, 居里温度较高的铁磁金属被研究用于自旋注入端, 但是由于金属与半导体之间的电导失配, 自旋注入效率也较低. 在此之后, 人们发现在铁磁金属和半导体间插入势垒层构成“铁磁体/势垒层/半导体”结构, 可以解决电导不匹配的问题, 从而大大提高自旋注入效率. 目前在CoFe/MgO/GaAs半导体量子阱结构中, 在室温下已经观测到了32%的圆偏振光极化率[15]. 这里, 我们将重点介绍以铁磁金属材料为自旋注入端的spin LED研究进展.2001年, Zhu等[16]在以Fe为自旋注入端、InGaAs量子阱为发光区的结构中, 在室温300 K下观测到2%的电致发光极化率. 2005年, Jiang等[15]在基于CoFe/MgO为自旋注入端, 通过利用MgO势垒及CoFe的高自旋极化率实现较高自旋极化率的电子注入, 他们在以GaAs量子阱为发光区的结构中低温下观测到高达52%的电致发光极化率. 2008年Ikeda等[17]于室温在CoFeB/MgO/CoFeB磁性隧道结中观测到高达600%的TMR, 这说明CoFeB/MgO可以提供具有更高的隧穿电子自旋极化率, 同年Lu等[8]在基于面内磁各向异性CoFeB/MgO自旋注入端、以GaAs 量子阱为发光区的结构中, 低温下观测到了32%的电致发光极化率. 此后, Barate等[18]通过对比磁控溅射和分子束外延制备的不同界面质量自旋注入端, 证明了CoFeB/MgO界面对于自旋电子注入起到关键的影响作用. 表1给出了基于面内磁各向异性自旋注入端的spin LED研究的主要历程中自旋注入端材料结构及对应的圆偏振光极化率结果.
| 自旋注入端 | LED结构 | PC/T | 文献 | 时间 |
| Fe | InGaAs QW | 2%/300 K | Zhu等[16] | 2001 |
| Fe/(Al)GaAs | GaAs QW | 32%/4.5 K | Hanbicki等[19] | 2002 |
| CoFe/Al2O3 | GaAs bulk | 21%/80 K | Motsnyi等.[20] | 2002 |
| CoFe/MgO | GaAs QW | 52%/100 K | Jiang等[15] | 2005 |
| Co/Al2O3 | InAs QD | 15%/1.7 K | Lombez等[21] | 2007 |
| CoFeB/MgO | GaAs QW | 32%/100 K | Lu等[8] | 2008 |
| Fe/AlOx | GaAs QW | 18%/80 K | Wu等[22] | 2010 |
| CoFeB/MgO | GaAs QW | 25%/25 K | Barate等[18] | 2014 |
| CoFeB/MgO | GaAs QW | 23%(Sputtering), 18%(MBE)/25 K | Barate等[23] | 2017 |
表1基于面内磁各向异性自旋注入端的自旋发光二极管
Table1.Spin LED based on spin injector with in-plane magnetic anisotropic.
2
4.2.垂直磁各向异性自旋注入端
如果自旋注入端磁矩位于面内方向, 根据光选择定则, 需要在沿薄膜法线方向施加磁场使自旋注入端的磁矩位于垂直膜面方向, 才可以在法向方向测量所产生光的圆偏振极化率, 如图8所示.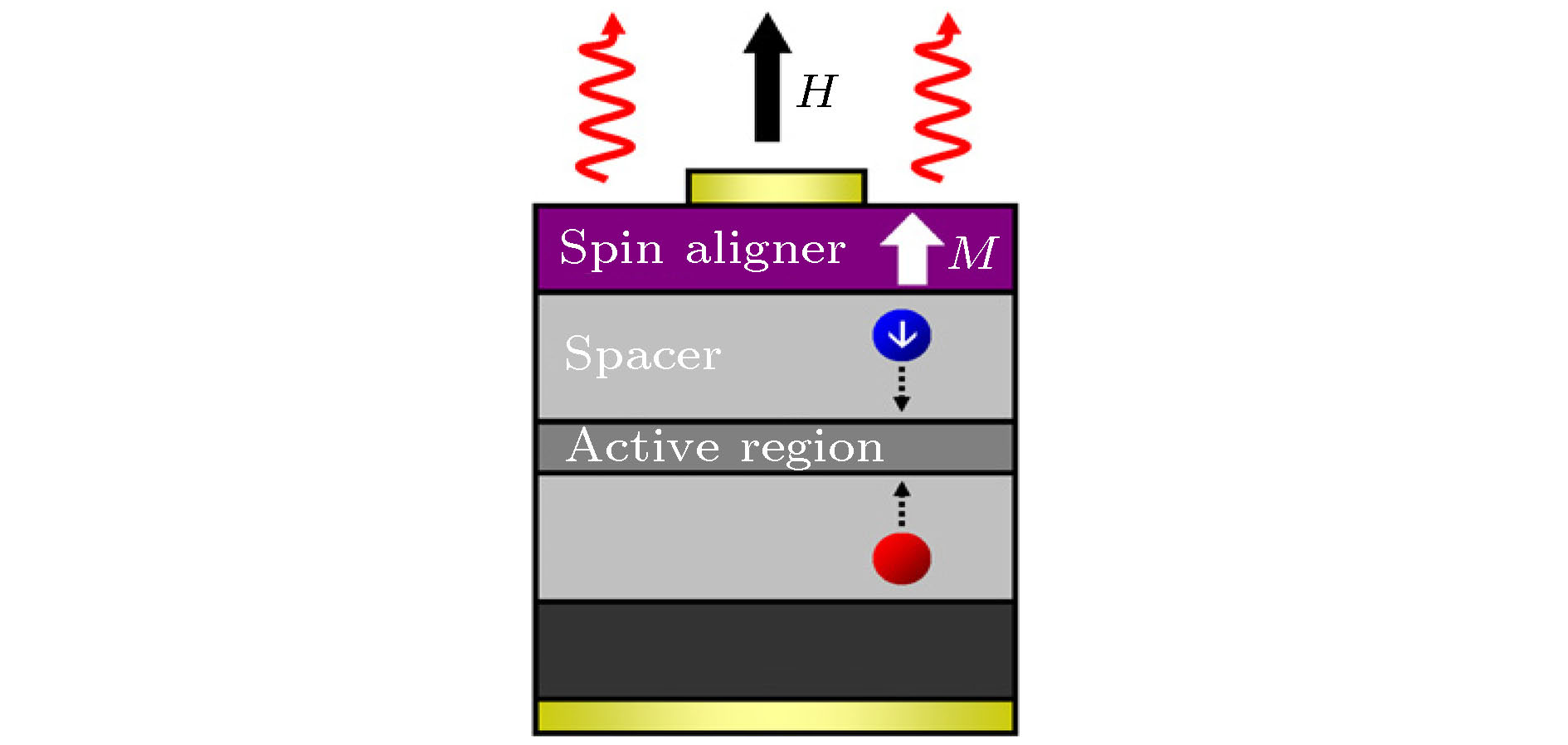 图 8 自旋发光二极管的Faraday测试方法示意图[1]
图 8 自旋发光二极管的Faraday测试方法示意图[1]Figure8. Schematic representation of a spin LED under the Faraday geometries[1].
由于需要外加磁场设备提供垂直膜面方向的磁场, 这在实际应用中十分不便. 为此更加突显具有垂直磁各向异性的自旋注入端的优势, 即在不施加垂直磁场的情况下, 自旋注入端的磁矩就垂直于薄膜膜面. 2005年, Gerhardt等[24]利用具有垂直磁各向异性的FeTb作为自旋注入端, 他们在零磁场90 K下得到了0.7%的圆偏振光极化率, 如图9所示. 此后Adelmann等[25]、H?vel等[26]、Grenet等[27]及Zarpellon等[28]等分别利用具有垂直磁各向异性的MnGa, FeTb, CoPt等作为自旋注入端, 成功制备了具有垂直磁各向异性自旋特性的spin LED(圆偏振光极化率见表2).
| 自旋注入端 | LED结构 | Pc/T | 文献 | 时间 |
| FeTb | InGaAs QW | 0.75%/90 K | Gerhardt等[24] | 2005 |
| MnGa | AlGaAs QW | ~3%/20 K | Adelmann等[25] | 2006 |
| FeTb | AlGaAs QW | ~3%/300 K | H?vel等[26] | 2008 |
| CoPt | SiGe QW | ~3%/5 K | Grenet等[27] | 2009 |
| CoPt | GaAs QW | ~2.5%/20 K | Zarpellon等[28] | 2012 |
| Ta/CoFeB/MgO | GaAs QW | ~20%/25 K, ~8%/RT | Liang等[29] | 2014 |
| MgO/CoFeB/Ta/CoFeB/MgO | GaAs QW | ~10%/10 K | Tao等[30] | 2016 |
| Mo/CoFeB/MgO | GaAs QW | ~9.5%/10 K | Tao等[31] | 2018 |
| Ta/CoFeB/MgO | GaAs QD | 35%/9 K | Cadiz等[32] | 2018 |
表2基于垂直磁各向异性的自旋注入端的自旋发光二极管
Table2.Spin LED based on spin injector with out-plane magnetic anisotropic.
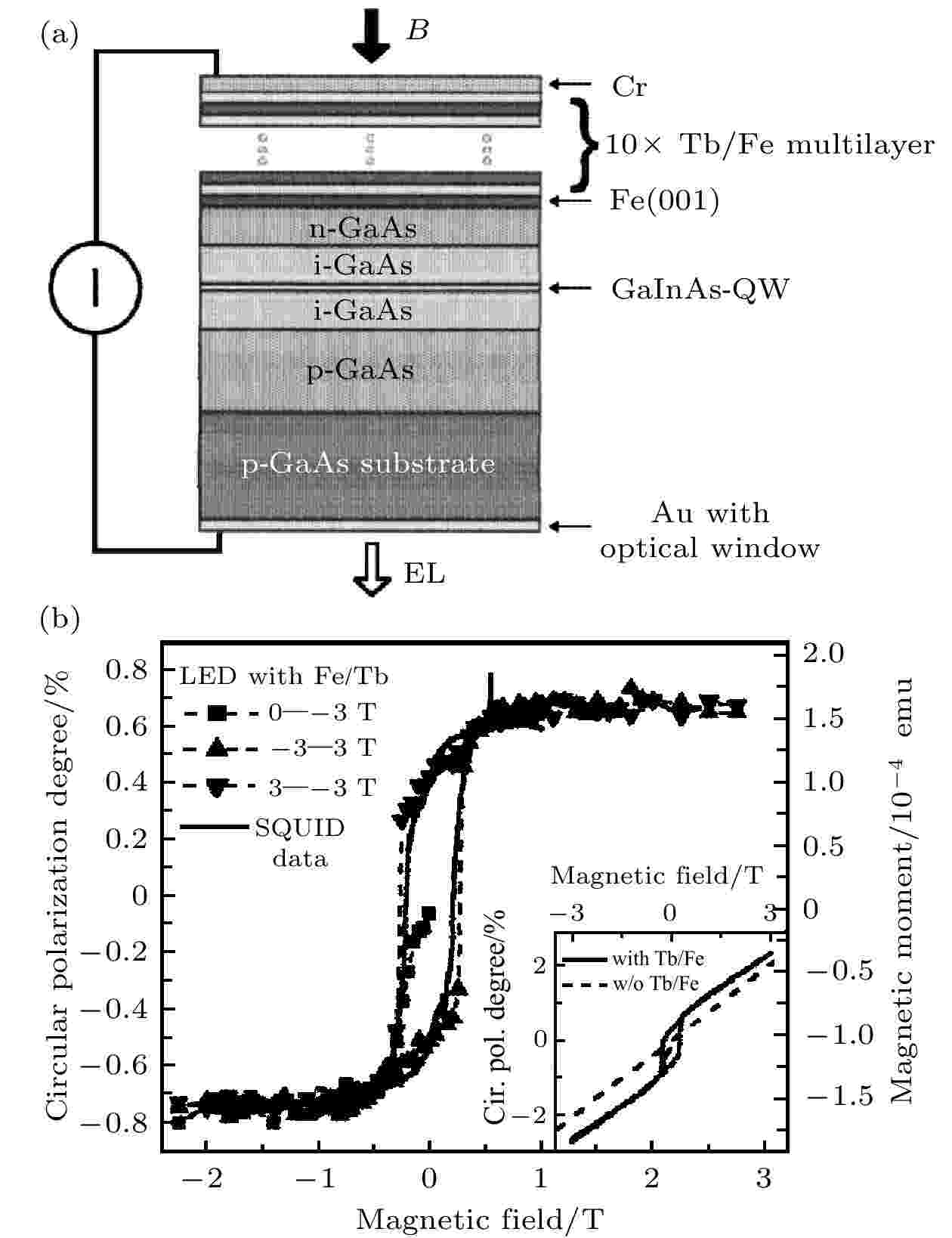 图 9 Gerhardt等[24]利用具有垂直磁各向异性的FeTb作为自旋注入端的自旋发光二极管 (a)结构示意图; (b)电致发光与磁场的关系, 他们在未加磁场剩余磁态下, 在90 K下得到了0.7%的圆偏振光极化率
图 9 Gerhardt等[24]利用具有垂直磁各向异性的FeTb作为自旋注入端的自旋发光二极管 (a)结构示意图; (b)电致发光与磁场的关系, 他们在未加磁场剩余磁态下, 在90 K下得到了0.7%的圆偏振光极化率Figure9. Schematic Spin LED device structure of the LED with Tb/Fe multilayer (a) reported by Gerhardt et al.[24], Circular polarization as a function of the applied magnetic field at 90 K (b), they observed PC of 0.7%
虽然上述报道实现了基于垂直磁各向异性自旋注入端的自旋极化电子注入, 但是自旋注入效率较低(圆偏振率小于3%). 研究人员思考和设计更加优化的垂直磁各向异性自旋注入端: 自旋极化率越高越好、厚度越薄越好. 自旋极化率高可以使得注入到二极管半导体中的电子自旋极化率较高; 薄膜自身厚度越薄其对发出光的吸收就越少, 这样spin LED发出光的强度就越强, 同时由于铁磁金属引起的磁圆二色性也会越小. 2014年, Liang等[29]报道了采用界面诱导的垂直磁各向异性Ta/CoFeB/MgO自旋注入端的自旋发光二极管(如图10所示). 相比于先前的结果, 由于CoFeB具有较高的自旋极化率, 并且所用到的CoFeB厚度也较薄(约1.2 nm), 在零磁场下测量到低温(10 K)13%和室温下8%的圆偏振光极化率. 他们同时研究了温度依赖


































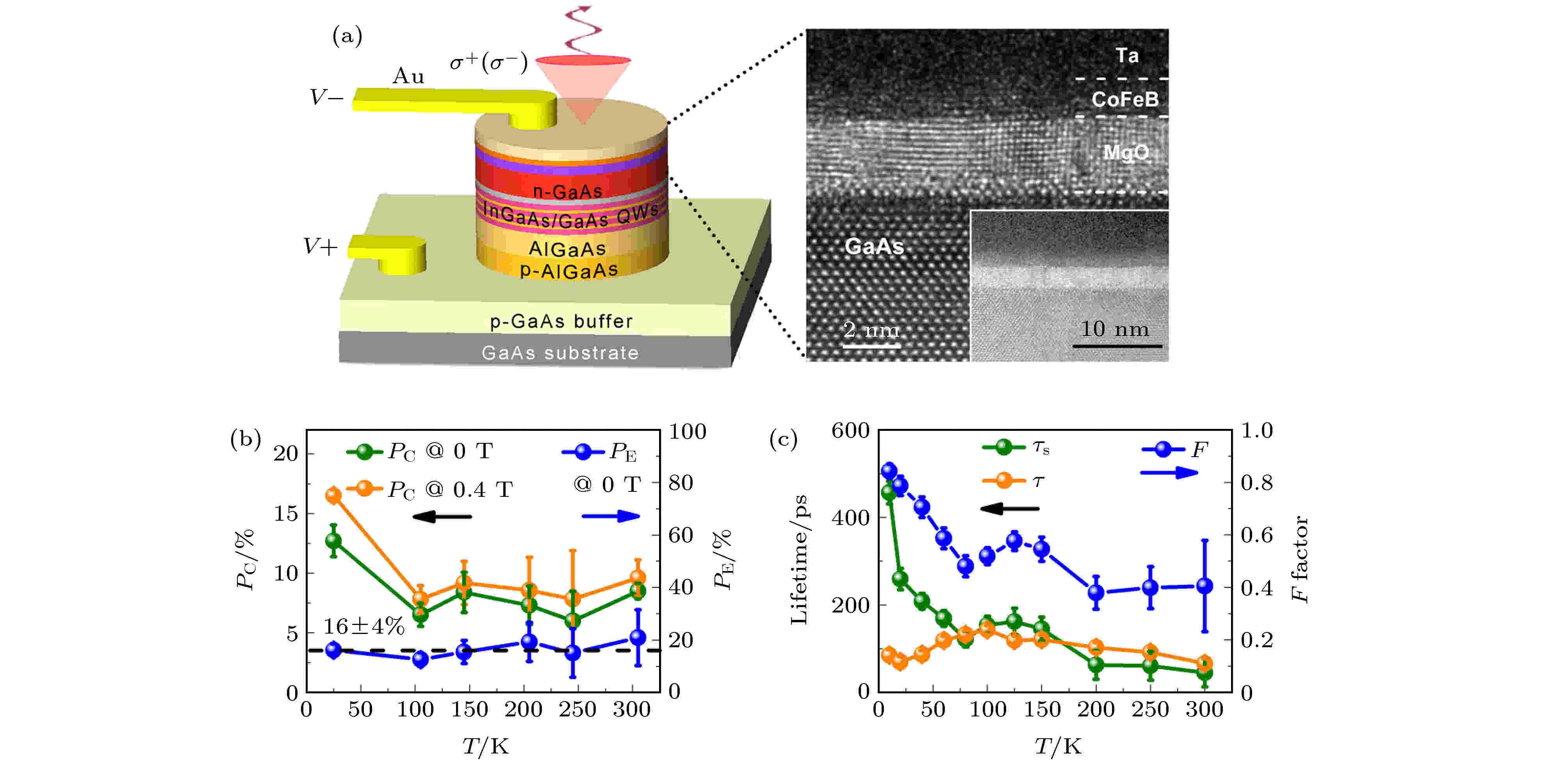 图 10 (a) 基于垂直磁各向异性Ta/CoFeB/MgO为自旋注入端的自旋发光二极管结构示意图, 虚线选定区对应的TEM照片, 其中插图为缩小后的TEM照片; (b)温度依赖的圆偏振极化率及注入电子极化率; (c)温度依赖的F因子及载流子寿命
图 10 (a) 基于垂直磁各向异性Ta/CoFeB/MgO为自旋注入端的自旋发光二极管结构示意图, 虚线选定区对应的TEM照片, 其中插图为缩小后的TEM照片; (b)温度依赖的圆偏振极化率及注入电子极化率; (c)温度依赖的F因子及载流子寿命

Figure10. (a) Schematic device structure of Spin LED and HR-TEM image of CoFeB/MgO PMA injector; (b) temperature dependence of PC without magnetic field and with 0.4 T field. Temperature dependence of PE is calculated by PE = PC/F from the data without field; (c) temperature dependence of τS, τ, and F factor deduced from the TRPL measurements
2018年, Tao等[31]利用具有垂直各向异性的Mo/CoFeB/MgO作为自旋注入端, 通过利用高分辨扫描透射电镜(HR-STEM)及电子能量损失谱(EELS), 从原子尺度分析了利用Ta和Mo作为覆盖层的垂直磁各向异性自旋注入层的结构和化学性质. 相比较Ta/CoFeB/MgO自旋注入端, Mo/CoFeB/MgO中CoFeB层元素与Mo元素不会相互扩散(如图11所示), 因此其磁学性能具有耐高温退火稳定性(400 °C以内), 并且注入的电子可以保持较高的自旋极化状态. 2018年, Cadiz等[32]利用具有垂直磁各向异性的Ta/CoFeB/MgO作为自旋注入端, 同时优化了spin LED有源区的结构设计, 采用p型InGaAs量子点, 在零磁场下观测到单量子点~35%圆偏振光极化率(如图12所示), 这是迄今为止采用垂直各向异性自旋二极管观测到的最好的结果. 表2给出了基于垂直磁各向异性自旋注入端的spin LED研究历程中主要的自旋注入端材料、结构及对应的圆偏振光极化率结果.
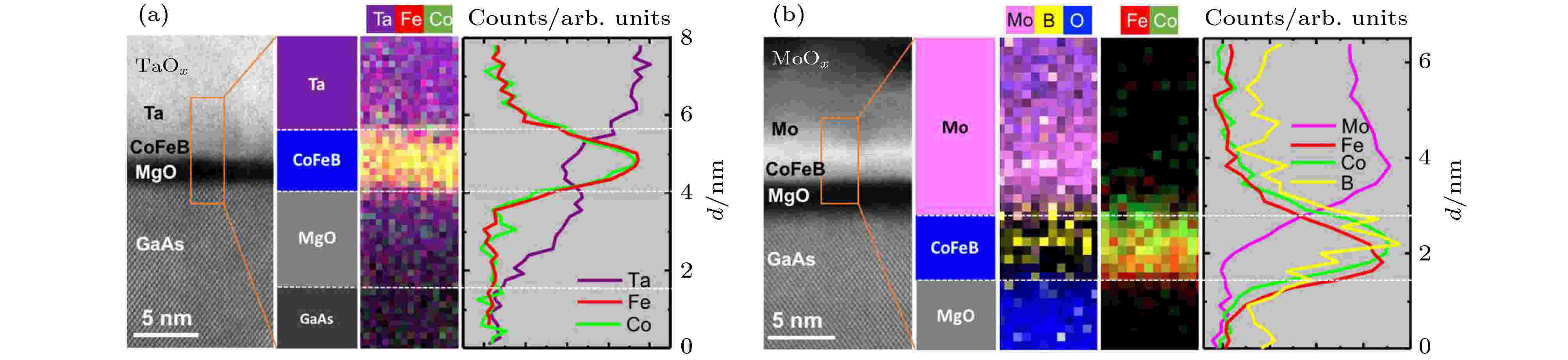 图 11 退火400 °C后, 具有垂直磁各向异性的Ta/CoFeB/MgO (a)和Mo/CoFeB/MgO (b)自旋注入端中由HR-STEM-EELS测量的空间元素分布[31]
图 11 退火400 °C后, 具有垂直磁各向异性的Ta/CoFeB/MgO (a)和Mo/CoFeB/MgO (b)自旋注入端中由HR-STEM-EELS测量的空间元素分布[31]Figure11. Chemical characterization of spin-injectors annealed at 400 °C. Dark field HR-STEM images and corresponding EELS mappings and profiles for (a) Ta and (b) Mo injectors annealed at 400 °C[31].
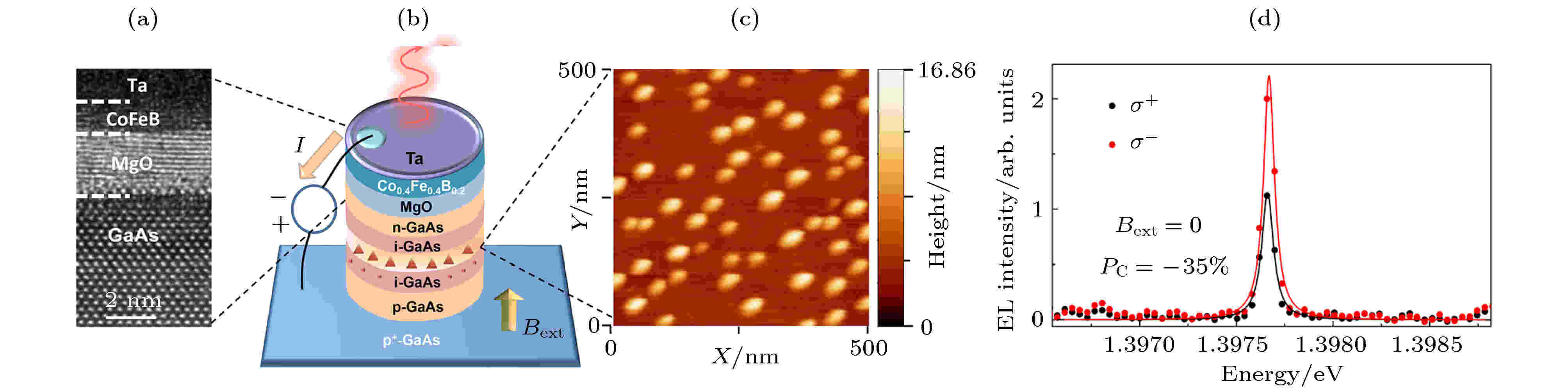 图 12 (a), (b)基于垂直各向异性的Ta/CoFeB/MgO作为自旋注入端InGaAs/GaAs量子点spin LED 的TEM及其结构示意图; (c) InGaAs/GaAs量子点AFM图; (d)零磁场下9 K观测到了约35%电致发光圆偏振光极化率[32]
图 12 (a), (b)基于垂直各向异性的Ta/CoFeB/MgO作为自旋注入端InGaAs/GaAs量子点spin LED 的TEM及其结构示意图; (c) InGaAs/GaAs量子点AFM图; (d)零磁场下9 K观测到了约35%电致发光圆偏振光极化率[32]Figure12. Spin LED device with p-doped InAs/GaAs quantum dots and polarization resolved electroluminescence of an ensemble of quantum dots: (a) High resolution-transmission electron microscope image of the injector Ta/CoFeB/MgO/GaAs; (b) schematic structure of the spin LED device. A single layer of InAs QDs is embedded in the intrinsic region of the p-i-n junction of the LED; (c) AFM image of InAs QDs; (d) strongly polarized single dot emission at zero applied field[32].
伴随着自旋电子学发展的同时, spin LED的研究范围也不断地在拓展, 尤其是第三代半导体材料和低维半导体材料可以在其中发挥重要作用. 其中GaN不但具有较大的能隙(室温下约3.4 eV), 而且具有较弱的自旋轨道耦合(Δso ≈ 15 meV)[33], 因此GaN中的自旋弛豫时间(5 K温度下约20 ns; 室温下约几百ns)[34]比GaAs中的自旋弛豫时间大3个数量级(10 K温度下约500 ps)[8,35]. 较长的自旋相干时间也为GaN在半导体自旋电子器件中的应用提供了优势. 最近基于GaN基的可见光spin LED和自旋激光器(spin lasers)已被研究报道[36-42]. 在该类spin LED和自旋激光器中, 室温下已分别实现6%[40]及25%[41]圆偏振光极化率. 此外, 二维材料由于新奇的物理性质也受到了广泛关注, 2016年Ye等[43]利用电学注入方式实现了从具有垂直磁各向异性的GaMnAs中将自旋极化的空穴注入到WS2中, 实现了基于二维材料的spin LED, 如图13所示. 同年Sanchez等[44]实现了基于MoS2/WeS2异质结构为有源区的spin LED.
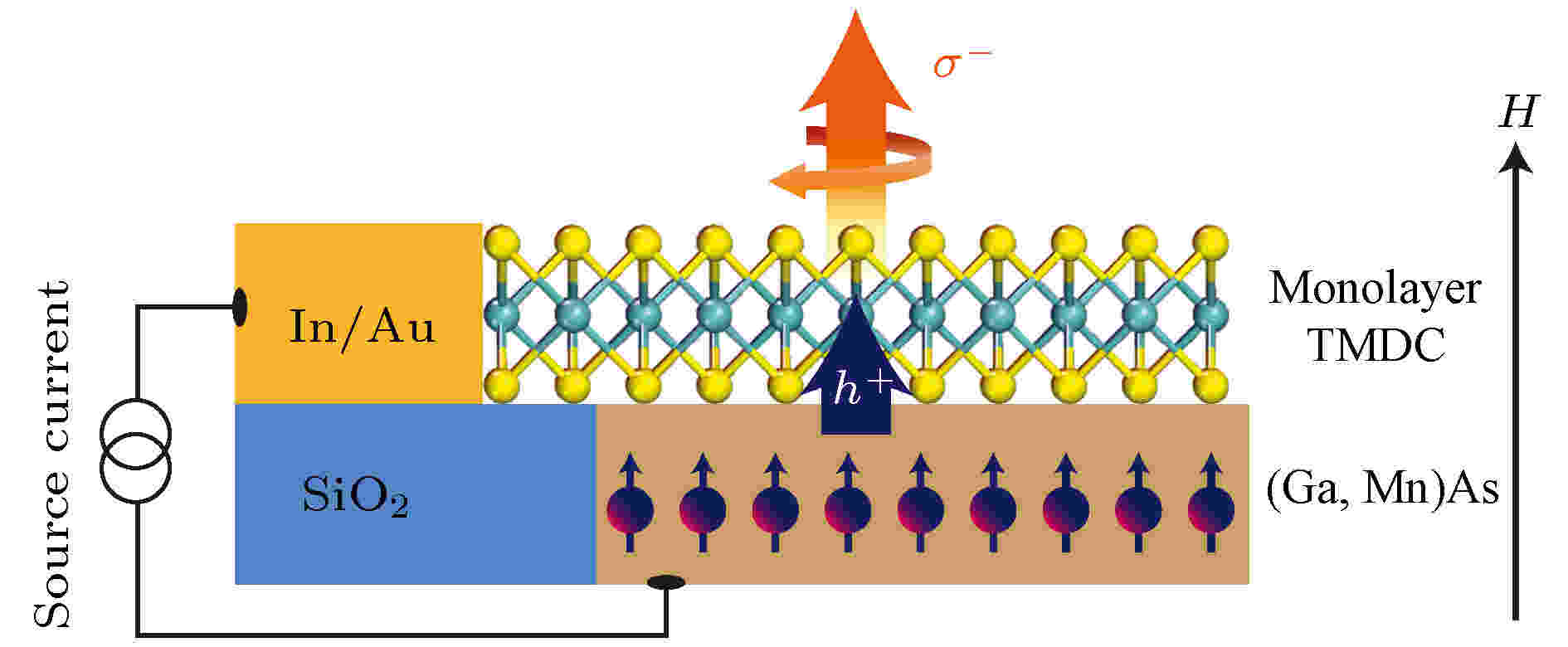 图 13 基于(Ga, Mn)As自旋注入端、MoS2/WeS2有源区的自旋发光二极管结构示意图[43]
图 13 基于(Ga, Mn)As自旋注入端、MoS2/WeS2有源区的自旋发光二极管结构示意图[43]Figure13. Schematic of the monolayer TMDC/(Ga, Mn)As heterojunction for electrical valley polarization devices. (Ga, Mn)As was used as a spin aligner under an external magnetic field[43].
综上所述, 未来通过对spin LED器件自旋注入端及其有源区的进一步深入系统研究和优化, 自旋发光二级管的器件功能特性将在自旋?光信息传输与显示方面展现出巨大的应用价值和发展前景.
