全文HTML
--> --> -->单粒子效应实验是研究大气中子单粒子效应的最直接手段, 对评估电子器件抗中子单粒子效应水平具有不可替代的作用. 但由于自然界中大气中子通量低, 利用中子源开展地面加速模拟实验, 已成为研究大气中子单粒子效应的主要方式[12]. 可以用于地面加速实验的模拟源包括(准)单能中子源[13,14]、脉冲反应堆[15]和散裂中子源[12,16,17]. 利用(准)单能中子源可以获得器件在不同中子能量下的单粒子效应截面, 进而可以预估器件的抗大气中子单粒子效应水平, 但需要在不同能量的中子源开展多轮次辐照实验; 此外, 利用不同能量获得的器件中子单粒子翻转(single event upset, SEU)截面差异可能很大, 如我们前期利用西安脉冲反应堆获得的中子SEU截面随器件特征尺寸的变化关系与在2.5和14 MeV单能中子源获得的变化关系相反[10], 因此如果不补充实验数据则很难评估这些器件实际的抗大气中子单粒子效应水平.
散裂中子源能谱与大气中子能谱接近, 是器件抗大气中子单粒子效应水平考核与评估最理想的模拟源. 但是, 由于前期缺少可用的散裂中子源, 国内在大气中子单粒子效应研究方面主要依靠(准)单能中子源和脉冲反应堆开展实验. 随着中国散裂中子源(China spallation neutron source, CSNS)通过国家验收, 使得在国内利用散裂中子源开展中子单粒子效应研究成为可能. 目前, CSNS已经建成的束线中, 反角白光中子源(Back-n)可以开展中子单粒子效应实验[12]. 此外还有一些在建束线也可以开展大气中子单粒子效应实验[16,17]. 前期, 我们利用在西藏羊八井开展的大气辐照实验结果, 对CSNS Back-n的实验结果进行了评估[12], 结果与JEDEC标准[18]基本一致, 即选择10 MeV左右的能量作为阈值时, 利用CSNS Back-n得到的中子SEU截面与大气辐照获得的结果较为一致.
本文在CSNS Back-n现有实验条件下, 以多款商用静态随机存取存储器(static random-access memory, SRAM)为样品开展大气中子单粒子效应实验, 获取了13款器件的中子单粒子效应数据, 对比分析了不同器件的SEU截面; 在物理版图信息未知的情况下, 利用概率统计的方法提取了单粒子多单元翻转(multiple cell upsets, MCU)信息, 研究了不同特征尺寸、版图工艺、工作频率设计对SRAM器件SEU截面、MCU的影响. 同时对比了相同器件在CSNS Back-n和羊八井大气中子实验中获得的MCU占比.
2.1.实验对象
SRAM存储器是电子系统中常见且对大气中子单粒子效应敏感的电子器件, 本文选择多款CMOS 工艺商用SRAM存储器为实验对象开展大气中子单粒子效应实验. 包括: HITACHI/RENESAS 公司HM系列3款, ISSI公司IS6X系列3款, Cypress公司CY62126系列3款, CY7C1318系列3款, 国产器件1款. 特征尺寸涵盖40—500 nm. 13款器件详细参数如表1所列.| 型号 | 制造商 | 容量/bits | 特征尺寸/nm | 工作电压/V |
| HM628512A | HITACHI | 4 M (512 K × 8) | 500 | 5 |
| HM628512B | HITACHI | 4 M (512 K × 8) | 350 | 3.3 |
| HM62V8100 | RENESAS | 8 M (1 M × 8) | 180 | 3.3 |
| IS62WV1288 | ISSI | 1 M (128 K × 8) | 130 | 3.3 |
| IS64WV25616 | ISSI | 4 M (256 K × 16) | 65 | 3.3 |
| IS61WV204816 | ISSI | 32 M (2 M × 16) | 40 | 3.3 |
| CY62126V | Cypress | 1 M (64 K × 16) | 350 | 3.0 |
| CY62126BV | Cypress | 1 M (64 K × 16) | 250 | 3.0 |
| CY62126DV | Cypress | 1 M (64 K × 16) | 130 | 3.0 |
| CY7C1318AV18 | Cypress | 18 M (1 M × 18) | 150 | 1.8 |
| CY7C1318BV18 | Cypress | 18 M (1 M × 18) | 90 | 1.8 |
| CY7C1318KV18 | Cypress | 18 M (1 M × 18) | 65 | 1.8 |
| M328C | 国产 | 256 K (32 K × 8) | 65 | 1.8 |
表1待测SRAM器件参数
Table1.Parameters of the SRAM devices for test.
2
2.2.测试系统
本文使用的测试系统包括辐照板、测试板和上位机三个模块. 其中辐照板上接插待测器件, 接受中子束流辐照; 测试板响应上位机指令, 对辐照板上的待测器件进行读写, 通过对比读出与写入数据判断器件是否发生SEU, 并实时向上位机回传测量到的SEU地址和数据; 上位机用于监控整个实验流程.2
2.3.实验源及条件
CSNS利用高能质子轰击钨靶产生宽谱中子, CSNS Back-n位于质子入射方向的反方向, 终端布局如图1所示. 包括两个实验厅: 终端1和终端2[19].本文在终端2中开展SRAM中子单粒子辐照实验, 终端2束流的中子能量范围是0.1 eV—200 MeV. 实验过程中CSNS运行在20 kW左右, 注量率约为1.6 × 106 n/(cm2·s), 其中10 MeV以上中子占比为18.3%. 图2给出20 kW运行时终端2处的中子微分能谱与羊八井大气中子微分能谱的对比. 可以看出, 与真实的大气中子能谱相比, CSNS反角白光中子源在100 MeV以内符合较好, 但在100 MeV以上下降较快.
 图 1 CSNS反角白光中子源实验终端布局[19]
图 1 CSNS反角白光中子源实验终端布局[19]Figure1. Layout of back-n at CSNS[19].
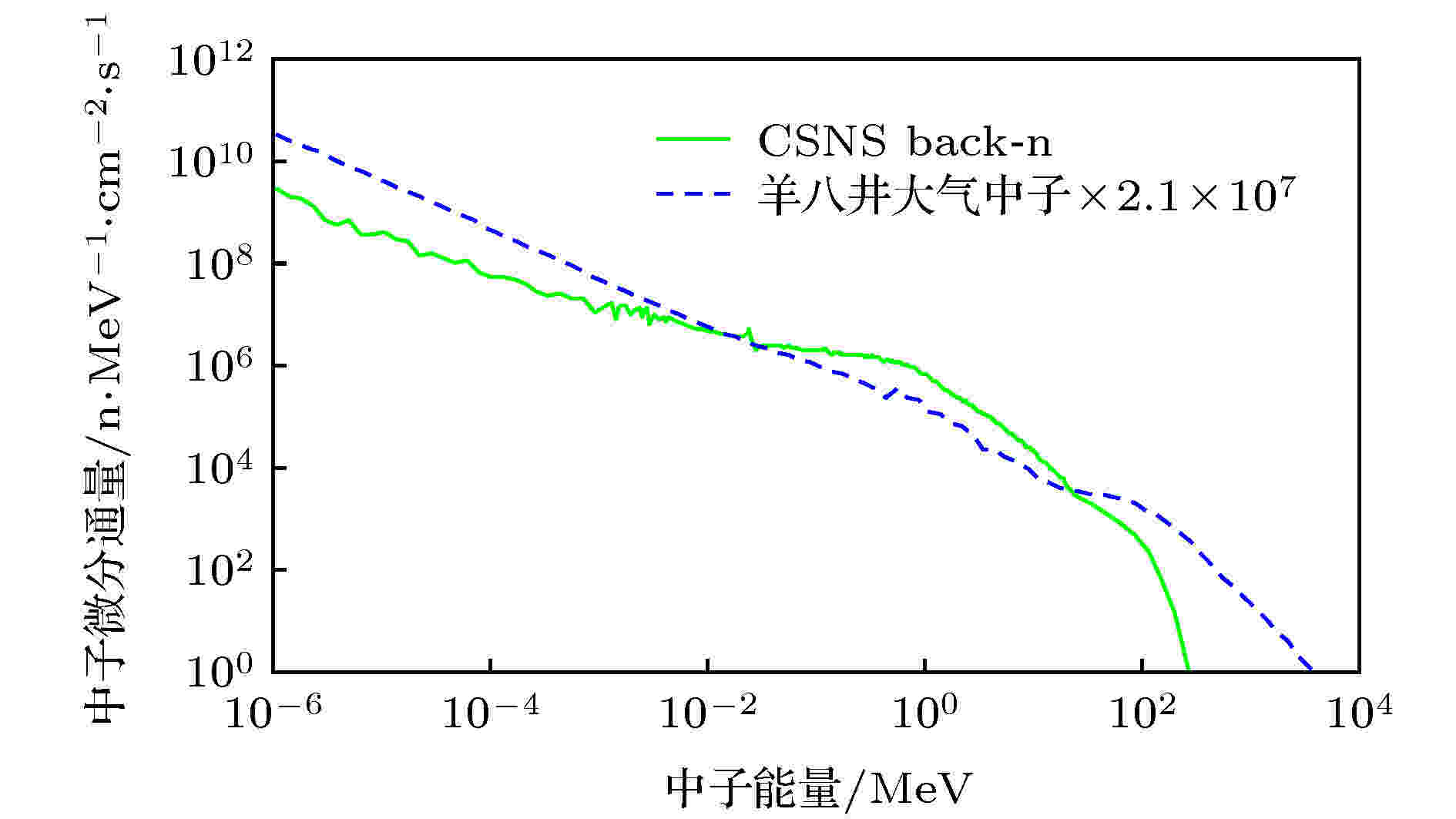 图 2 CSNS反角白光中子源终端2与羊八井大气中子微分能谱对比
图 2 CSNS反角白光中子源终端2与羊八井大气中子微分能谱对比Figure2. Comparison between the differential neutron energy spectra of CSNS back-n and Yangbajing.
2
2.4.实验方法
实验现场包括位于地下的实验厅(终端2)和地上控制间, 两个区域垂直距离约25 m, 以保障人员的安全. 由于实验厅内本底较低, 实验过程中直接将测试板置于实验厅内, 另一方面为了减小人员受到的辐照剂量, 测试人员在控制间通过远程计算机控制整个实验流程, 实验厅和控制间通过以太网进行连接, 如图3所示.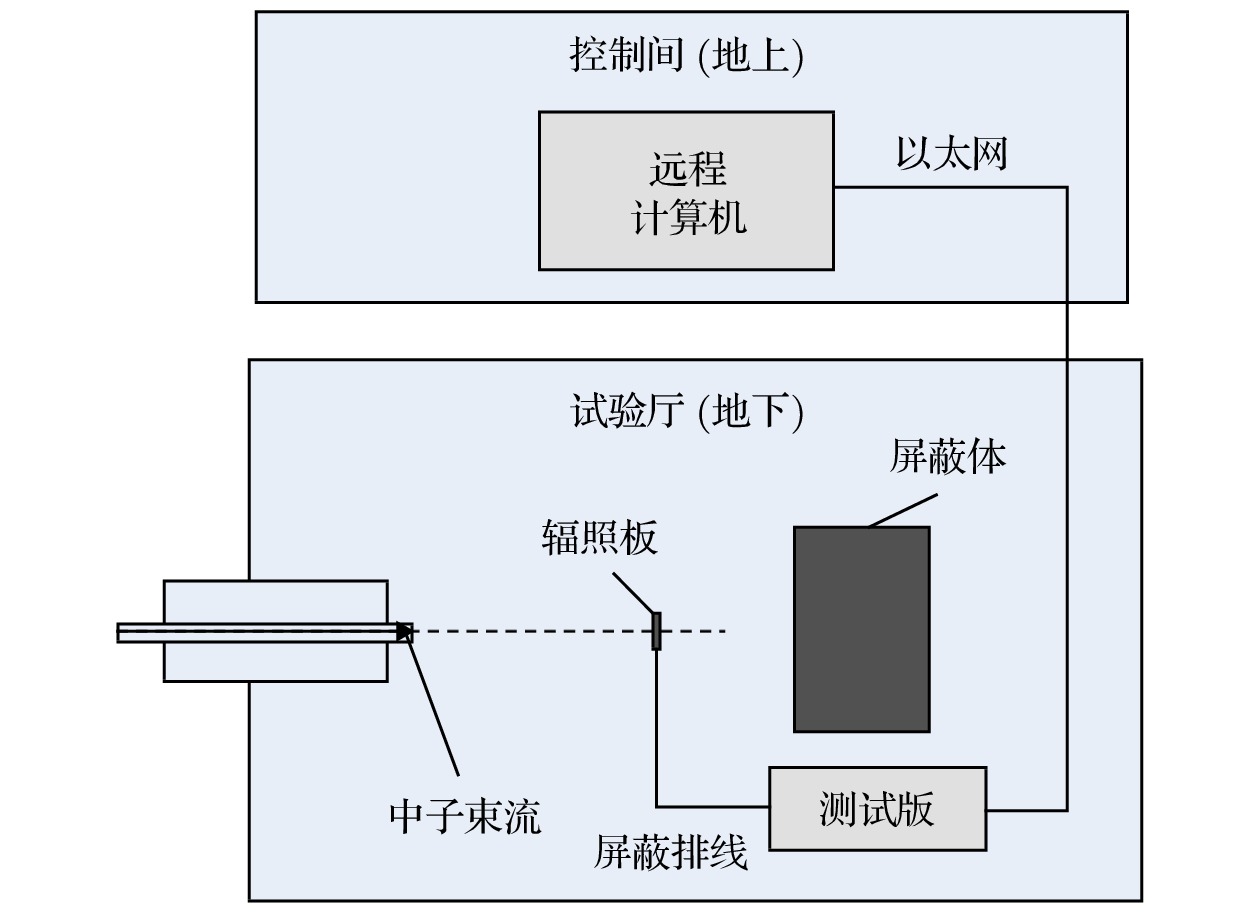 图 3 CSNS反角白光中子源辐照实验布局示意图
图 3 CSNS反角白光中子源辐照实验布局示意图Figure3. Layout of the irradiation experiment at CSNS back-n
本文选择直径为6 cm的束流开展单粒子效应辐照实验. 为保证实验数据的可靠性, 每种型号均选择多器件同时进行辐照. 考虑到器件尺寸大小, HM62V8100, HM628512B, HM628512A, IS62WV1288, CY62126V, CY62126BV, CY62126DV和M328C采用3只相同型号器件上下均匀排列的方式同时辐照, IS64WV25616, IS61WV204816和CY7C1318系列器件采用2只相同型号器件上下排列的方式同时辐照.
实验过程中, 所有器件均工作在标称电压下, 中子束流垂直入射. 测试图形包括0x00H, 0x55H, 0xAAH和0xFFH四种情况, 其中0x00H是写入全“0”进行测试, 0x55H和0xAAH是写入“0”“1”相间数据, 区别在于写入“0”和“1”的位置对调, 0xFFH是写入全“1”. 监测方法是通过对比中子辐照前后被测SRAM器件中的数据变化来统计SEU数. 为实时掌握测试情况, 本文采用动态监测方法, 即辐照前向存储单元写入数据, 每隔固定时间间隔回读数据, 并与写入数据进行逐位比对统计错误的比特位数. 实验过程中实时监测辐照板电流, 当超过一定阈值时认为发生单粒子闩锁, 立即切断电源, 然后给辐照板重新上电, 重新写入数据进行测试.
2
2.5.实验结果
中子SEU截面计算公式为



| 型号 | 特征尺寸/nm | 测试图形 | 容量/Mbit | 注量(>10 MeV)/108 n·cm–2 | 翻转数/# | 翻转截面/10-14cm2·bit–1 | 不确定度/% |
| HM628512A | 500 | 0x00H | 12 | 5.54 | 176 | 2.52 | 12.88 |
| 0x55H | 12 | 7.21 | 262 | 2.89 | 12.13 | ||
| 0xAAH | 12 | 5.38 | 215 | 3.18 | 12.47 | ||
| 0xFFH | 12 | 5.36 | 205 | 3.04 | 12.56 | ||
| HM628512B | 350 | 0x00H | 12 | 5.71 | 207 | 2.88 | 12.54 |
| 0x55H | 8 | 7.03 | 197 | 3.34 | 12.64 | ||
| 0xAAH | 12 | 8.97 | 303 | 2.69 | 11.92 | ||
| 0xFFH | 12 | 3.26 | 114 | 2.78 | 14.03 | ||
| HM62V8100 | 180 | 0x00H | 24 | 5.31 | 343 | 2.57 | 11.75 |
| 0x55H | 24 | 5.29 | 367 | 2.76 | 11.67 | ||
| 0xAAH | 24 | 5.29 | 387 | 2.91 | 11.61 | ||
| 0xFFH | 24 | 5.36 | 342 | 2.53 | 11.76 | ||
| IS62WV1288 | 130 | 0x00H | 1 | 9.52 | 55 | 5.51 | 17.05 |
| 0xAAH | 3 | 8.05 | 116 | 4.58 | 13.97 | ||
| 0xFFH | 3 | 10.20 | 151 | 4.68 | 13.24 | ||
| IS64WV25616 | 65 | 0x00H | 8 | 4.76 | 271 | 6.79 | 12.08 |
| 0x55H | 8 | 4.76 | 339 | 8.49 | 11.77 | ||
| 0xAAH | 8 | 5.23 | 381 | 8.68 | 11.63 | ||
| 0xFFH | 8 | 4.50 | 275 | 7.28 | 12.06 | ||
| IS61WV204816 | 40 | 0x00H | 64 | 4.76 | 534 | 1.67 | 11.30 |
| 0x55H | 64 | 4.76 | 523 | 1.64 | 11.32 | ||
| 0xAAH | 64 | 4.76 | 589 | 1.84 | 11.22 | ||
| 0xFFH | 64 | 6.35 | 707 | 1.66 | 11.10 | ||
| CY62126V | 350 | 0x55H | 3 | 9.88 | 64 | 2.06 | 16.29 |
| 0xAAH | 3 | 9.88 | 71 | 2.28 | 15.81 | ||
| CY62126BV | 250 | 0x55H | 3 | 128.00 | 516 | 1.28 | 11.33 |
| CY62126DV | 130 | 0x00H | 3 | 10.40 | 115 | 3.53 | 14.00 |
| 0x55H | 3 | 10.60 | 139 | 4.16 | 13.45 | ||
| 0xAAH | 3 | 10.40 | 141 | 4.30 | 13.41 | ||
| 0xFFH | 3 | 9.04 | 106 | 3.73 | 14.26 | ||
| CY7C1318AV18 | 150 | 0X55H | 32 | 5.12 | 1293 | 7.52 | 10.80 |
| CY7C1318BV18 | 90 | 0X55H | 32 | 4.69 | 381 | 2.42 | 11.63 |
| CY7C1318KV18 | 65 | 0X55H | 32 | 5.09 | 374 | 2.19 | 11.65 |
| M328C | 65 | 0X55H | 0.75 | 116 | 167 | 1.84 | 13.00 |
表2在CSNS反角白光中子源的SEU测试结果
Table2.Test results of the SEUs at CSNS back-n.








3.1.SRAM器件大气中子SEU截面影响因素
(1)测试图形的影响器件在不同测试图形下的SEU截面由图4给出. 考虑到(2)式中不确定度的影响, 偏差基本都在误差棒范围以内. 因此, 认为测试图形对SEU截面的影响不大. 为降低不同器件之间对比时的不确定度, 后续截面对比中将利用不同测试图形的均值.
 图 4 不同测试图形下测得的器件SEU截面对比
图 4 不同测试图形下测得的器件SEU截面对比Figure4. Comparison between the SEE cross sections of devices with different test patterns.
(2)版图工艺差异的影响
考虑不同厂商相同特征尺寸的器件, 厂商不同导致版图和工艺存在较大差异, 图5对比了相同特征尺寸不同厂商器件的SEU截面. 对于350 nm的2款器件, 截面相对偏差为32.7%; 对于130 nm的2款器件, 截面相对偏差为35.5%; 对于65 nm的3款器件, 截面相对偏差高达426.1%. 实验结果显示, 版图及工艺的差异对器件的SEU敏感性有影响, 而且特征尺寸越小影响越大. 版图和工艺对器件单粒子效应敏感性的影响比较复杂. 以版图设计为例, 改变器件的阱接触面积[21]、晶体管的放置位置[22]和放置方向[23]、布局布线[24]等都可以改变器件的单粒子效应敏感性. 由于使用商用器件开展实验, 缺少版图和工艺信息, 无法对导致截面不同的原因进行更为具体的分析.
 图 5 不同厂商相同特征尺寸SRAM器件SEU截面对比 (a) 350 nm SRAM; (b) 130 nm SRAM; (c) 65 nm SRAM
图 5 不同厂商相同特征尺寸SRAM器件SEU截面对比 (a) 350 nm SRAM; (b) 130 nm SRAM; (c) 65 nm SRAMFigure5. Comparison of the SEE cross sections of the devices with the same feature sizes from different manufacturer: (a) 350 nm SRAM; (b) 130 nm SRAM; (c) 65 nm SRAM.
(3)特征尺寸的影响
为降低版图和工艺差异对SEU截面的影响, 只在相同厂商的同系列器件之间进行对比. 图6给出了4个产品系列不同特征尺寸器件的SEU截面. 对于HM系列中的3款SRAM, 当特征尺寸从500 nm逐渐降低到180 nm时SEU截面略微下降; 对于Cypress公司CY7C1318系列的3款SRAM, 当特征尺寸从150 nm逐渐降低到65 nm时SEU截面降低比较明显; 对于Cypress公司CY62126系列的3款SRAM, 特征尺寸从350 nm降到250 nm时SEU截面降低, 当继续降低到130 nm时SEU截面增加; 对于ISSI公司IS6X系列3款SRAM, 特征尺寸从130 nm降到65 nm时SEU截面增加, 当继续降低到40 nm时SEU截面降低. 可见商用SRAM器件的SEU截面并没有严格按照特征尺寸的缩小而减小. 这是因为器件特征尺寸降低导致器件敏感体积和临界电荷都降低, 两者对器件SEU截面的贡献是相反的. 随着特征尺寸的降低, MCU出现的可能性增大, 但版图设计对敏感体积的电荷收集和不同节点之间的电荷共享都有很大的影响. 尽管实验中选择相同厂商系列不同特征尺寸的SRAM器件进行比较, 版图设计的影响仍然无法完全避免. 因此, 实验中不同系列的SRAM器件SEU截面呈现出不同的变化规律.
 图 6 同一厂商系列不同特征尺寸SRAM器件SEU截面对比 (a) HITECHI/RENESAS HM系列SRAM; (b) Cypress CY1318系列SRAM;(c) Cypress CY62126系列SRAM; (d) ISSI IS6X系列SRAM
图 6 同一厂商系列不同特征尺寸SRAM器件SEU截面对比 (a) HITECHI/RENESAS HM系列SRAM; (b) Cypress CY1318系列SRAM;(c) Cypress CY62126系列SRAM; (d) ISSI IS6X系列SRAMFigure6. Comparison of the SEE cross sections of devices from the same manufacturer with different feature sizes: (a) HITECHI/RENESAS HM SRAM; (b) Cypress CY1318SRAM; (c) Cypress CY62126SRAM; (d) ISSI IS6X SRAM
2
3.2.器件中子单粒子MCU情况
(1) MCU信息的提取对于商用器件, MCU提取面临的最大问题是缺少版图信息, 其内部物理地址与逻辑地址的映射关系未知. 本文采用基于概率统计的方法[25,26]提取SEU数据中的 MCU信息. 该方法能够以较高精度提取出SEU数据中的MCU信息. 对方法的具体思路、步骤和验证评估已在文献[25]和文献[26]中给出. 表3中列出从SEU数据中提取出的 MCU信息.
| 型号 | 特征尺寸/nm | 不同测试图形时MCU占比 | 最大MCU位数 | |||
| 0x00 | 0x55H | 0xAAH | 0xFFH | |||
| HM628512A | 500 | 0 | 0 | 0 | 0 | 1 |
| HM628512B | 350 | 0 | 0 | 0 | 0 | 1 |
| HM62V8100 | 180 | 2.33% | 5.94% | 1.09% | 4.68% | 2 |
| IS62WV1288 | 130 | — | 0 | 4.65% | 0 | 2 |
| IS64WV25616 | 65 | 9.59% | 9.14% | 6.01% | 0.73% | 3 |
| IS61WV204816 | 40 | 28.29% | 24.09% | 28.52% | 25.00% | 7 |
| CY62126V | 350 | 0 | 0 | 0 | 0 | 1 |
| CY62126BV | 250 | 0 | 0 | 0 | 0 | 1 |
| CY62126DV | 130 | 40.00% | 35.97% | 35.46% | 45.28% | 3 |
| CY7C1318AV18 | 150 | — | 36.13% | — | — | 4 |
| CY7C1318BV18 | 90 | — | 42.31% | — | — | 6 |
| CY7C1318KV18 | 65 | — | 56.80% | — | — | 7 |
| M328C | 65 | — | 14.37% | — | — | 2 |
表3单粒子MCU提取结果
Table3.Extraction results of the single event multiple cell upsets.
(2)测试图形的影响
针对表3中4款SRAM器件, 分析测试图形对MCU占比的影响, 结果如图7所示, 所有器件的MCU占比均受测试图形的影响. 在4款器件中, IS61WV204816和CY62126DV两款器件的MCU占比受测试图形影响较小, 不同测试图形下MCU最大和最小占比的绝对偏差分别为4.43%和9.82%, 相对偏差分别为18.39%和27.69%. HM62V8100和IS64WV25616两款器件的MCU占比受测试图形影响相对较大, MCU最大和最小占比的相对偏差分别为444.95%和1213.70%, 但绝对偏差与前两款器件类似, 分别为4.85%和8.86%. 测试图形对MCU占比的影响与器件内部电场的分布有关, 不同的测试图形下器件内部的电场分布不同, 电场分布能够影响电荷共享, 从而影响器件MCU发生的概率.
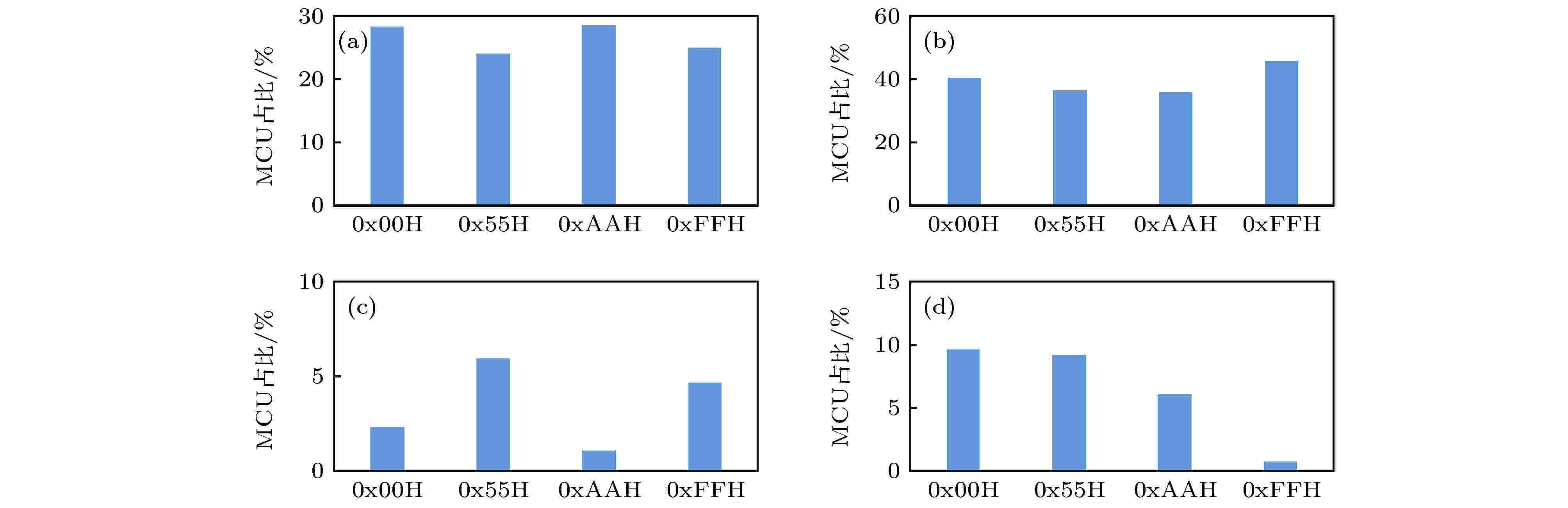 图 7 不同测试图形下MCU占比 (a) IS61WV204816(40 nm); (b) CY62126DV(130 nm); (c) HM62V8100 (180 nm); (d) IS64WV25616 (65 nm)
图 7 不同测试图形下MCU占比 (a) IS61WV204816(40 nm); (b) CY62126DV(130 nm); (c) HM62V8100 (180 nm); (d) IS64WV25616 (65 nm)Figure7. MCU rates of the devices with different test patterns: (a) IS61WV204816(40 nm); (b) CY62126DV(130 nm); (c) HM62V8100 (180 nm); (d) IS64WV25616 (65 nm)
(3)版图工艺差异的影响
考虑3款不同厂商的65 nm SRAM器件IS64WV25616, CY7C1318KV18和M328C. 这3款器件具有相同的特征尺寸, 但不同厂商的版图和工艺存在较大差异, 图8对比了SEU中的MCU占比. 3款器件的MCU占比各不相同, 相对偏差高达521.44%, 最大MCU位数随着MCU占比的增大近似呈增大趋势. 此外, 与图5(c)中的结果对比可以发现, IS64WV25616 (65 nm)比CY7C1318KV18 (65 nm)的翻转截面大近4倍, 但MCU占比约为后者的16%. 可见, MCU占比并不与器件的SEU截面正相关. 这说明版图和工艺对器件的单粒子效应截面和MCU情况的影响非常复杂. 以版图设计为例, 改变器件的阱接触面积[21]、晶体管的放置位置[22]和放置方向[23]、布局布线[24]等都可以改变器件的单粒子效应敏感性. 这增加了从版图优化设计层面提高器件的抗大气中子单粒子效应水平的空间和难度.
 图 8 不同厂商相同特征尺寸SRAM器件MCU情况
图 8 不同厂商相同特征尺寸SRAM器件MCU情况Figure8. MCU rates and sizes of the devices with the same feature sizes from different manufacturer.
(4)特征尺寸的影响
为降低版图工艺因素的影响, 只在相同厂商相同系列器件之间进行对比. 对于HM 系列的3款器件和CY62126系列的3款器件均是仅在最小特征尺寸器件的SEU数据中提取到MCU, 特征尺寸250 nm以上的器件中均没有提取到MCU信息. 图9给出了CY7C1318系列和IS6X系列不同特征尺寸SRAM器件的MCU情况. 可以看出, 对于这两个系列的器件, MCU占比和最大MCU位数均随特征尺寸的降低而增加. 对于65 nm的CY7C1318和40 nm的IS61WV204816均出现了最大达7位的MCU. 可见, 尽管单粒子位翻转截面可能随特征尺寸的降低而降低(如图6(b)), 但MCU的影响会越来越严重. 因为随着器件特征尺寸的降低, 单位面积内集成的存储单元数量增加, 使得单个粒子入射时沉积能量能够影响的存储单元个数增加. 因此, MCU问题应该成为小尺寸存储器着重考虑的一个可靠性问题.
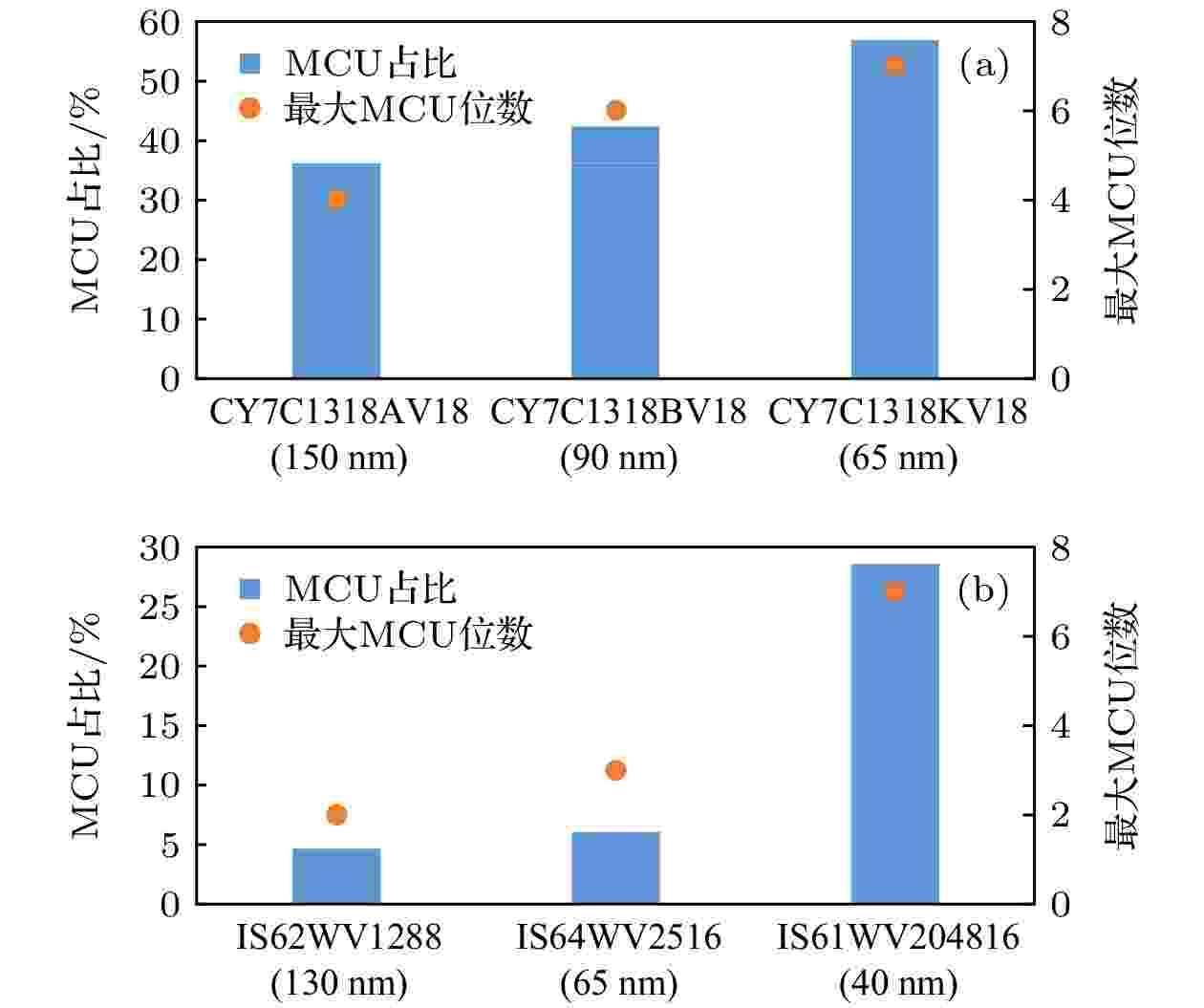 图 9 同一厂商系列不同特征尺寸SRAM器件MCU情况 (a) CY7C1318系列不同特征尺寸MCU情况; (b) IS6X系列不同特征尺寸MCU情况
图 9 同一厂商系列不同特征尺寸SRAM器件MCU情况 (a) CY7C1318系列不同特征尺寸MCU情况; (b) IS6X系列不同特征尺寸MCU情况Figure9. MCU rates and sizes of the devices from the same manufacturer with different feature sizes: (a) CY7C1318; (b) IS6X
(5) MCU与高原实验结果的差异
早期利用上述HITACHI/RENESAS的HM系列3款SRAM在西藏羊八井国际宇宙射线观测站开展了SRAM大气中子单粒子效应辐照实验. 羊八井国际宇宙射线观测站位于东经90.5°, 北纬30.1°, 海拔4300 m. 采用大规模存储矩构建测试系统, 待测存储器中写入数据0x55H, 辐照实验持续数千小时. 详细的实验结果和分析见文献[12]. 在数据分析中, 从HM62 V8100的195位翻转中提取得到20位MCU, 其中14位多位翻转(multiple bit upsets, MBU). 高原大气辐照实验中MCU占比为10.26%, 比CSNS back-n的实验结果5.94%高. 此外, 高原大气辐照的实验结果中还出现了CSNS back-n实验中没有的MBU. 可见, 尽管可以通过在计算时选择较大的中子能量阈值用CSNS back-n评估器件的大气中子SEU截面[12], 但是对器件的MCU进行评估时, 仍会低估大气中子单粒子效应的影响.
1) 测试图形对器件的SEU截面影响不大, 但对部分器件的MCU占比有较大的影响, 其原因与器件内部电场分布有关. 不同的测试图形下器件内部的电场分布不同, 电场分布能够影响电荷共享, 从而影响器件MCU发生的概率. 该现象的原因与文献[22]中的类似, 即单元中的晶体管放置位置和电场满足一定条件时, 共享电荷在同一个单元的P管和N管中同时产生正负电流脉冲, 脉冲抵消能够降低电荷共享的影响, 从而降低MCU发生的概率.
2) 版图和工艺的差异对SEU截面和MCU情况的影响都很大. 特征尺寸越小, SEU截面的差异越大, 说明版图的设计对小尺寸器件的中子单粒子效应的敏感性影响更大. 且MCU占比与SEU截面之间没有明显的相关性. 版图和工艺对器件单粒子效应敏感性的影响比较复杂. 以版图设计为例, 改变器件的阱接触面积、晶体管的放置位置和放置方向、布局布线等都可以改变器件的单粒子效应敏感性. 如增加N阱接触面积可以降低单粒子瞬态脉冲的宽度和截面, 从而降低单粒子效应的敏感性, 达到加固的目的[21]. 通过优化P管和N管的放置位置, 利用正负脉冲抵消的思路, 可以降低电荷共享的影响, 从而降低器件的MCU敏感性[22]. 由于脉冲窄化效应的存在, 将反相器水平放置比垂直放置能够显著减小单粒子瞬态脉冲的宽度和截面[23]. 因此, 一些文献利用脉冲的窄化效应探索能够缓解单粒子效应的版图设计技术[24]. 由于文中使用商用器件开展实验, 缺少具体的版图和工艺信息, 无法对导致截面不同的原因进行更为具体的分析.
3)特征尺寸对SEU截面和MCU占比都有影响. 特征尺寸对SEU截面的影响没有明显的规律, 由于特征尺寸同时影响敏感体积和临界电荷, 二者对SEU截面的贡献是相反的. 另一方面, 特征尺寸对MCU的影响具有明显的规律性, MCU占比和最大MCU位数都随特征尺寸的减小而增大. 这是因为特征尺寸减小使得临界电荷和敏感体积变小, 电荷共享加剧, 单个粒子能够同时影响的存储单元个数增加. 这也说明MCU问题将成为小尺寸存储器着重考虑的一个可靠性问题.
4)相同的器件在CSNS Back-n获得的MCU占比小于高原辐照实验的结果. 原因有两个, 首先, 由于CSNS Back-n的中子能谱相对于真实的大气中子能谱偏软, 中子的最高能量和高能成分占比都偏小(如图2所示), 单能中子实验研究表明, MCU比例随入射中子能量的增高而升高[27,28]. 其次, CSNS back-n实验中, 中子束流垂直芯片入射, 而在高原大气辐照实验中, 大气中子从各个方向入射, 相关研究表明侧向入射能够增加MCU占比[29,30]. 此外, 高原大气辐照的实验结果中还出现了CSNS back-n实验中没有的MBU, 原因是该器件列向MCU的敏感性高于行向, CSNS back-n的中子最高能量尚未达到其MBU发生的阈值.
感谢中国散裂中子源提供束流机时, 感谢反角白光中子源的同志的支持和帮助.
