全文HTML
--> --> -->二维材料的研究热潮从2004年单层石墨烯的成功剥离开始[1]. 由于石墨烯具有超高的电子迁移率、导热系数、光学透过率、机械强度等优异性能和广泛的应用前景, 在世界范围内迅速掀起了一股石墨烯的研究热潮, 但石墨烯零带隙的特点限制了它在电子器件中的应用. 紧接着, 其它新型二维材料如过渡金属硫族化合物(transition metal dichalcogenides, TMDCs)[2-5]、黑磷(black phosphorus, BP)[6]、六方氮化硼(h-BN)[7]、磷烯[8]等也引起了科学家的广泛关注. TMDCs是一个庞大的二维材料家族, 分子式可表示为MX2 (M = W, Mo, Pd等, X = S, Se, Te等), 是继石墨烯之后研究最广泛的二维材料体系. 因在垂直于平面方向上存在量子限制效应, TMDCs具有不同于块体材料的优异性能, 不仅涵盖了半导体、金属、绝缘体、半金属、超导体、拓扑绝缘体等形态, 而且还展现了电输运各向异性、能带拓扑保护、电荷密度波等奇异特性, 是制备光电探测器、太阳能电池、传感器、存储器的理想材料[9]. 因为二维材料层间一般由较弱的范德华力结合, 因此可通过改变二维材料的层数、厚度或者中间插层等方式优化二维材料的性能(图1(a))[10]. 除此之外, 将二维材料与各种功能材料(例如, 传统绝缘电介质、半导体、金属、有机材料等)复合也可以深化和扩展基于二维材料的基础和应用研究. 在这些功能材料中, 铁电材料具有介电系数大、自发极化、剩余极化强度大、逆压电效应强等特点, 在铁电场效应晶体管、信息存储、压电换能、热释电红外探测、电声换能等高新技术领域有广泛的应用前景. 将二维材料与铁电材料复合, 可兼顾二者的优点对材料进行改性, 满足器件多功能化的要求. 通过对二维/铁电异质结构施加电场, 人们可实现二维材料物理性能原位、动态、可逆调控, 而不需要制备一系列二维材料(不同层数、厚度或中间插层)进行材料改性. 例如, 利用铁电材料的逆压电效应, 可以原位调控与其层状复合的二维材料的晶格常数和应变等, 进而改进二维材料的结构和相关性能(图1(b))[11]; 利用铁电材料的自发极化特性, 可调控二维材料的载流子浓度、迁移率和带隙, 实现对二维材料光电性能的非易失性调控, 是构建铁电场效应晶体管(ferroelectric field effect transistor, FeFET)、非易失性存储器的理想元件(图1(c))[5]. 近年来, 石墨烯和TMDCs作为最有应用前景和最庞大的二维材料家族体系, 研究者从理论和实验上都对这两类二维材料/铁电异质结构进行了不少研究. 本文概述了近几年基于二维材料/铁电异质结构的层状复合材料的研究进展, 主要包括铁电材料对二维材料薄膜/单晶物性调控的机制、代表性的二维/铁电层状复合材料的性能和应用前景, 并在文章的最后对未来二维/铁电复合材料的研究重点进行了展望.
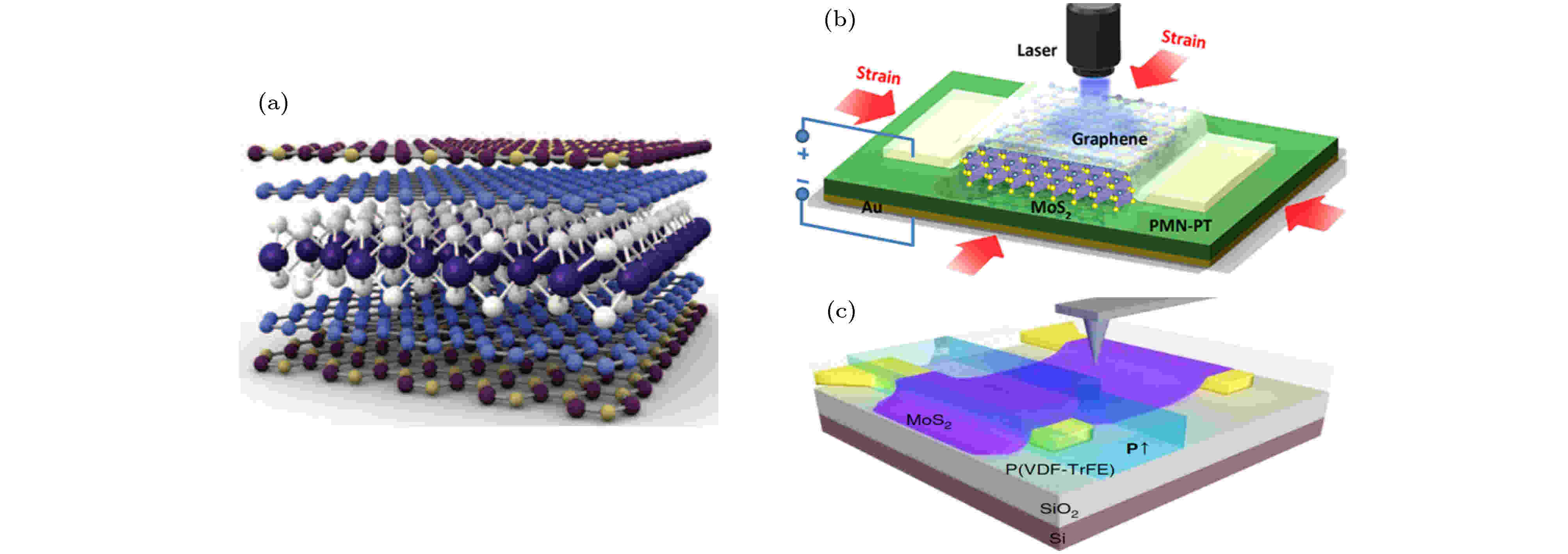 图 1 结构示意图 (a) 中间插层的二维材料[10]; (b) 石墨烯/MoS2/PMN-PT异质结[11]; (c) MoS2/P(VDF-TrFE)/SiO2/Si异质结[5]
图 1 结构示意图 (a) 中间插层的二维材料[10]; (b) 石墨烯/MoS2/PMN-PT异质结[11]; (c) MoS2/P(VDF-TrFE)/SiO2/Si异质结[5]Figure1. The schematic diagrams: (a) 2D Materials with intercalation[10]; (b) graphene/MoS2/PMN-PT heterostructure[11]; (c) MoS2/P(VDF-TrFE)/SiO2/Si heterostructure[5].
未极化时, PMN-PT铁电单晶内的电偶极子无序排列, 处于自发极化态, 此时有r1+, r2+, r3+, r4+, r1–, r2–, r3–, r4–这8个自发极化方向[12](图2(a)). 当对PMN-PT施加电场时, 电偶极子逐渐趋向电场方向排列, 引起晶格在某一方向的收缩或膨胀. PMN-PT的面内应变通过界面传递给相邻层的薄膜, 从而引起薄膜的晶格应变和物性发生变化, 这就是晶格应变效应[13,14]. 如图2(b)所示, 对初始未极化状态的PMN-PT(001)单晶施加沿厚度方向的电场, 随着电场逐渐增大, 其电偶极子方向趋向于沿平行于电场方向排列, 导致晶格沿垂直于电场的方向收缩, 沿平行于电场的方向膨胀[13]. 对PMN-PT(001)施加大于其矫顽场的双极性电场时, 将呈现如图2(b)中插图所示的蝴蝶型面内应变曲线. 因为二维材料只有一个或几个原子层厚度, 因此其相比于块体材料对界面应变更敏感. 2013年, Hui等[11]在PMN-PT单晶衬底上生长了三层MoS2薄膜, 利用晶格应变效应, 实现了电场对MoS2薄膜带隙和发光强度的原位、定量调控(图2(c)). 然而利用PMN-PT(001)单晶进行应变调控的一个明显缺陷是撤去外加电场后, PMN-PT的面内应变将消失, 因此对于薄膜的调控具有易失性.
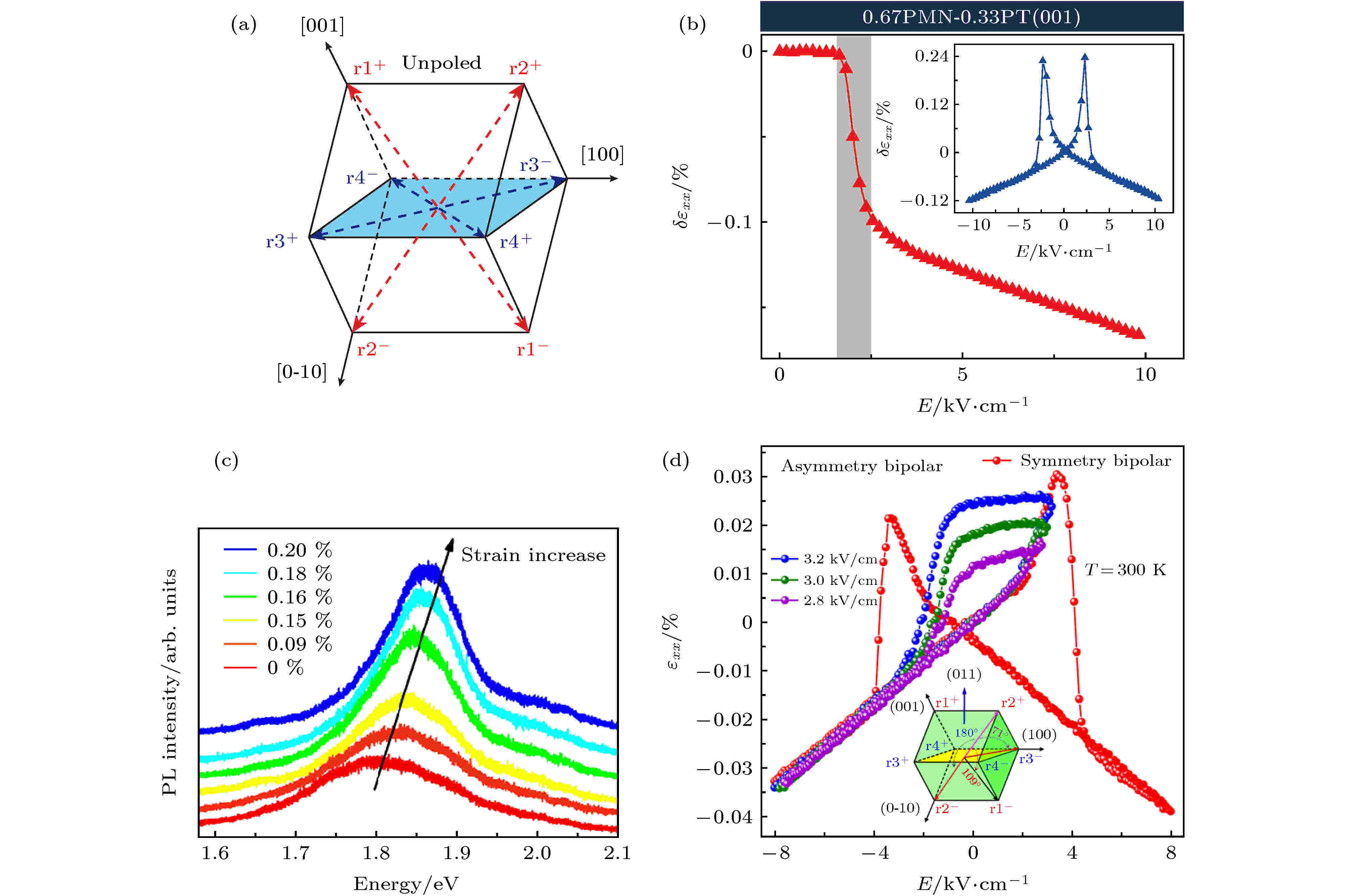 图 2 (a) PMN-PT未被极化时具有8个自发极化方向: r1+, r2+, r3+, r4+, r1–, r2–, r3–, r4–[12]; (b) PMN-PT(001)单晶的应变-电场曲线[13]; (c) 不同应变状态下, MoS2的光致发光谱[11]; (d) 不同外加电场下, PMN-PT(011)单晶的应变-电场曲线[15]
图 2 (a) PMN-PT未被极化时具有8个自发极化方向: r1+, r2+, r3+, r4+, r1–, r2–, r3–, r4–[12]; (b) PMN-PT(001)单晶的应变-电场曲线[13]; (c) 不同应变状态下, MoS2的光致发光谱[11]; (d) 不同外加电场下, PMN-PT(011)单晶的应变-电场曲线[15]Figure2. (a) The eight possible polarization directions for an unpoled PMN-PT single crystal: r1+, r2+, r3+, r4+, r1–, r2–, r3–, r4–[12]; (b) εxx – E curves for PMN-PT(001) single crystals[13]; (c) photoluminescence spectra of the MoS2 under various strains[11]; (d) εxx – E curves for PMN-PT(011) single crystals[15].
与PMN-PT(001)的情况不同, 对PMN-PT(011)单晶施加沿(011)方向的电场时, 面内应变呈现各向异性变化, 即晶格在[100]方向收缩, 而在[01-1]方向膨胀[14]. 当施加大于PMN-PT矫顽场的对称双极性电场时, 应变-电场曲线仍呈现蝴蝶型. 但当外加电场小于其矫顽场时, 铁电畴将发生71°/109°的翻转, 如图2(d)中插图所示, 撤去外加电场后, 单晶的应变状态可以保持不变[15]. PMN-PT(111)的情况与PMN-PT(011)类似, 对其施加非对称的单极性电场时, 撤去电场后单晶内部同样存在剩余应变, 并且剩余应变的值随外加电场的大小而呈规律性改变. 利用PMN-PT单晶的面内应变各向异性和残余应变特性, 可以实现对薄膜性能的各向异性和非易失性调控[14,15].
另一方面, 界面电荷效应(或称铁电场效应)也可以对PMN-PT衬底上的二维薄膜进行非易失性能调控. 在外加电场的作用下, PMN-PT内部的铁电极化在上下表面产生极化电荷. 通过库仑作用, PMN-PT的极化电荷会在界面处吸引或排斥薄膜内部的载流子, 从而在界面处形成电荷累积或者耗尽层, 进而影响薄膜中与载流子相关的物理性能. 因为PMN-PT具有剩余极化的特征, 界面电荷效应对薄膜性能的调控具有非易失性. 2006年, 接文静等[16]构建了石墨烯/PMN-PT铁电场效应晶体管. 如图3(a)所示, 在外加电场的影响下, PMN-PT的极化强度将呈现类磁滞回线形状的电滞回线(P-E loop)[16]. 在不同的外加电场下, PMN-PT处于不同的极化状态, 界面处的极化电荷正负和大小均不同(图3(a)中i, ii, iii, iv态). 当电场为0时, PMN-PT的剩余极化强度2Pr ~ 50 μC/cm2, 对应铁电极化电荷面电荷密度为3.1 × 1014 cm–2, 这就是PMN-PT对其上的薄膜产生调控作用的最大面载流子浓度. 如图3(b)所示, 对PMN-PT施加不同幅度的双极性电场的同时测量石墨烯/PMN-PT FeFET的漏极电流, 发现漏极电流-电压(Ids-V)曲线的形状与PMN-PT的电滞回线相类似, 这表明界面电荷效应在此石墨烯/PMN-PT异质结中起决定作用. 当外加电场足够大时, 漏极电流在电场撤去后基本保持不变. 而在图3(b)插图中石墨烯/SiO2异质结构所测的Ids-V曲线则显示电场对Ids的调控具有易失性, 显然二维材料/铁电材料异质结构具有显著的优势. 利用二维材料/铁电材料异质结中的界面电荷效应可实现对材料性能的非易失性调控, 在非易失存储领域有应用前景.
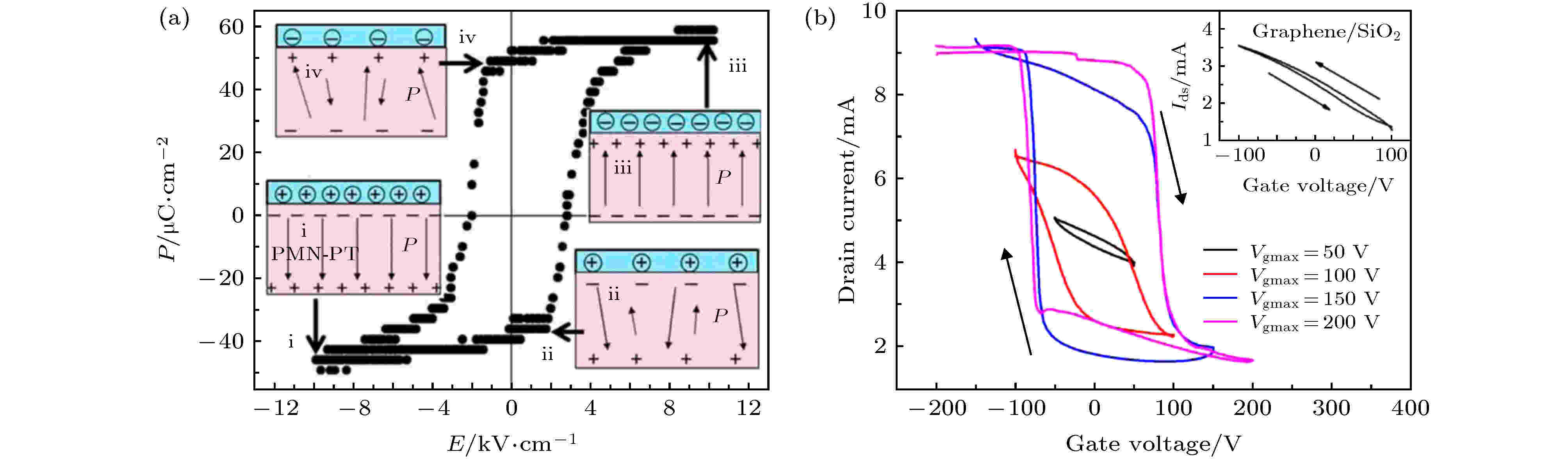 图 3 (a) PMN-PT铁电单晶衬底的极化-电场(P-E)曲线, 及外加电场下石墨烯/PMN-PT铁电场效应晶体管的界面电荷效应示意图[16]; (b) 石墨烯/PMN-PT铁电场效应晶体管的Ids–Vg曲线[16]
图 3 (a) PMN-PT铁电单晶衬底的极化-电场(P-E)曲线, 及外加电场下石墨烯/PMN-PT铁电场效应晶体管的界面电荷效应示意图[16]; (b) 石墨烯/PMN-PT铁电场效应晶体管的Ids–Vg曲线[16]Figure3. (a) Polarization-Electric field (P-E) hysteresis loop of PMN-PT substrate, and schematic diagrams of interface charge effects in graphene/PMN-PT FeFET[16]; (b) the Ids–Vg curves of graphene on PMN-PT[16].
3.1.石墨烯/铁电材料异质结
石墨烯作为一种新兴材料, 被广泛应用于场效应晶体管(field effect transistor, FET)的研究. 传统的FET主要利用Si, SiO2, Si3N4, Al2O3等绝缘材料作为栅级, 但这种FET的缺点主要有两点: 首先, 该器件对于信息的存储具有易失性; 其次, 传统电介质材料如Si, SiO2, Al2O3, SrTiO3的介电常数较小(εSiO2 = 3.9, εAl2O3 = 9), 对石墨烯载流子浓度的调控能力较小. 此外, 最常见的石墨烯/SiO2 FET存在迁移率较低的问题(2 × 103 — 2 × 104 cm2/V s)[17-19]. 这些问题均限制了基于石墨烯的场效应晶体管的应用. 采用介电常数较大的铁电材料作为栅极介质制作的铁电场效应晶体管可有效解决以上问题, 不仅增强了对石墨烯载流子浓度的调控, 而且可实现对石墨烯性能的非易失调控. 此外, 研究证明石墨烯也是一种应力可调的材料[13], 因此利用石墨烯/铁电材料异质结中的晶格应变效应也可实现石墨烯性能的调控和改进. 下面将选取典型研究成果对近年来的石墨烯/铁电材料异质结进行介绍.3
3.1.1.石墨烯/PZT异质结
2009年, 美国宾夕法尼亚州立大学Hong等[20]首次采用PZT薄膜作为铁电栅极介质, 以机械剥离法所得的单层石墨烯为沟道材料制备了FeFET器件(图4(a)). 该方法所得的石墨烯FeFET在室温下呈现n型导电行为, 面载流子浓度为2.4 × 1012 cm–2, 迁移率高达7 × 104 cm2/(V·s), 100 K时达到1.5 × 104 cm2/(V·s), 是当时所报道的石墨烯器件的最大迁移率值, 相较于石墨烯/SiO2 FET有很大的提升. 随后他们发现在栅压大于2 V时, 石墨烯的电阻率出现了与PZT铁电极化引起的电阻率变化趋势相反的滞后现象(antihysteresis), 如图4(c)所示[21]. Hong等将石墨烯异常的电阻变化趋势归因于石墨烯-PZT界面吸附的水分子在界面处的分解、扩散作用. 但用机械剥离法制备的器件界面缺陷较多, 性能也不太稳定, 给基础研究带来了不小的困难和许多不确定因素.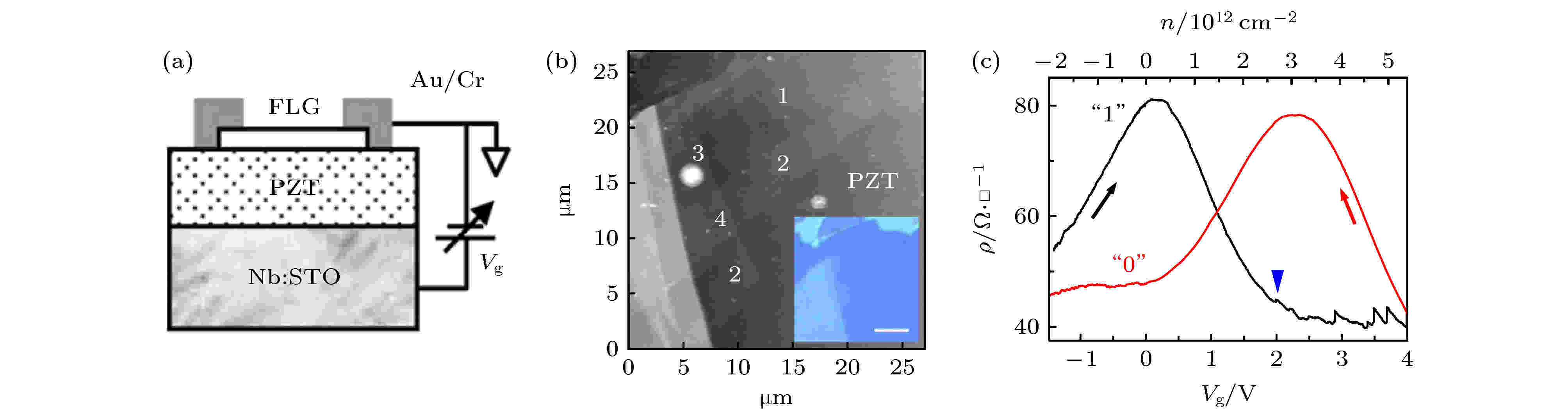 图 4 (a) 石墨烯/PZT/STO异质结的示意图[20]; (b) 300 nm PZT上的多层石墨烯AFM图[21]; (c) 不同栅压走向下, 石墨烯/PZT FeFET的电阻率ρ随栅压Vg的变化曲线[21]
图 4 (a) 石墨烯/PZT/STO异质结的示意图[20]; (b) 300 nm PZT上的多层石墨烯AFM图[21]; (c) 不同栅压走向下, 石墨烯/PZT FeFET的电阻率ρ随栅压Vg的变化曲线[21]Figure4. (a) Schematic of the graphene/PZT/STO heterostructure[20]; (b) AFM image of a multilayer graphene sheet on a 300 nm PZT film[21]; (c) the channel resistivity of graphene/PZT FeFET as a function of the gate voltage with different memory operation[21].
相较于机械剥离法制备石墨烯, 化学气相沉积法(chemical vapor deposition, CVD)制备的石墨烯性能更稳定. 因此更多的研究者利用CVD法制备石墨烯/PZT复合材料, 并对其进行研究[22-29]. 2011年, 新加坡国立大学?zyilmaz课题组[22]通过CVD法制备了大尺寸的高质量单层和双层石墨烯, 并将其转移到PZT薄膜上制备了石墨烯/PZT结构FeFET器件. 在工作电压低于 ± 1 V时, 该器件的面电荷注入量大于1013 cm–2, 开关比可达10以上. 他们认为在此异质结中, 界面电荷效应起决定性作用. 随着对石墨烯-FeFET研究的深入, 越来越多的研究者观察到界面处分子作用与界面电荷效应的共同调控行为[23-29]. 如2011年, 美国加州大学洛杉矶分校Song等[23]分别通过机械剥离法和CVD得到单层石墨烯, 其中机械剥离-石墨烯/PZT FeFET在较低的工作电压下具有较宽的存储窗口, 但CVD-石墨烯/PZT FET的两个工作电流状态(“ON”态和“OFF”态)具有更长的持续时间, 稳定性更高, 分别如图5(a)和(b)所示. 在此研究中测得的电流-栅压曲线变化趋势与PZT极化曲线相反, Song等认为这是由界面电荷载流子的束缚或者逃逸造成的. 2013年, 伊利诺伊大学的Baeumer等[25]将石墨烯转移到PZT/SrRuO3/SrTiO3异质结上, 制备了FeFET器件(图5(c)). 在器件的顶层插入了SiO2绝缘层, 该绝缘层的作用是减小PZT在栅压下产生的漏电流. 如图5(d)所示, 他们在空气中对PZT施加小于其矫顽场(EC)的负向脉冲电压, 石墨烯受到铁电极化、界面电荷陷阱态、外部空气分子等作用的共同影响, 展现出p型导电行为, 此时狄拉克点VG ≈ 1 V. 而在真空中对PZT施加小于矫顽场的负向脉冲电压时, 石墨烯将呈现出狄拉克点在VG ≈ 0 V的本征态, 施加正向脉冲电压后狄拉克点VG ≈ –1 V, 此时为n型导电. 在真空环境中的测试排除了外源分子(例如H2O, O2)对漏极电流的影响, 确证了铁电场效应对石墨烯导电性能的调控作用. 通过施加脉冲栅电压, 可以实现对石墨烯在高电导态和低电导态之间的可逆、非易失性调控, 且使得石墨烯在n-型、p-型和本征态之间可逆切换.
 图 5 (a) 机械剥离-石墨烯/PZT FeFET的IDS-VG曲线[23]; (b) CVD-石墨烯/PZT FeFET的IDS-VG曲线[23]; (c) VDS = 50 mV时, 石墨烯/PZT FeFET中的IDS-VG曲线[25]; (d) 不同栅压下, 真空和空气中分别测得的IDS-VG曲线[25]
图 5 (a) 机械剥离-石墨烯/PZT FeFET的IDS-VG曲线[23]; (b) CVD-石墨烯/PZT FeFET的IDS-VG曲线[23]; (c) VDS = 50 mV时, 石墨烯/PZT FeFET中的IDS-VG曲线[25]; (d) 不同栅压下, 真空和空气中分别测得的IDS-VG曲线[25]Figure5. (a) IDS-VG characteristics of the exfoliated-graphene/PZT FeFET[23]; (b) IDS-VG characteristics of the CVD-graphene/PZT FeFET[23]; (c) IDS-VG of the graphene/PZT FeFET under a drain voltage at 50 mV[25]; (d) drain current as a function of gate voltage of graphene/PZT FeFET in air and vacuum, respectively[25].
为了避免界面态对铁电场效应的干扰[26], 清华大学谢丹课题组[27]同样选择在真空环境进行测试. 2015年, 谢丹课题组[27]构建了Au/Cr/石墨烯/PZT(260 nm) /Pt/Ti/SiO2/Si铁电场效应晶体管, 在真空环境下研究了栅压和温度对此FeFET存储窗口、狄拉克点、电阻等电学性能的影响. 研究结果表明, 栅压增大和温度升高都能导致存储窗口的扩大. 2017年, 美国内布拉斯加大学林肯分校Lipatov等[28]制备了Cr/Au/石墨烯/TiO2/Ir/SiO2/Si铁电场效应晶体管. 他们提出一种新的实验测试手段, 可最大程度排除界面态对调控行为的干扰, 得到石墨烯电阻被铁电极化调控的电阻变化回线. 即在曲线测试过程中, 每次施加栅极电压后立即撤去电压并静置一段时间, 等待界面电荷陷阱对电荷的束缚效应消失, 再读取Ids值(图6(a)). 在此方法的基础上, 以VG = –6 V为“写入”电压, VG = +6 V为“擦除”电压, 以VG = 0 V为“读”电压. 如图6(b)所示, 该FeFET最大开关比为7.6, 开关窗口约为5.3, 其性能稳定且实现了非易失性存储. 同年, 美国伊利诺伊大学厄巴纳-尚佩恩分校的Rogers等[29]构建了以石墨烯/PZT异质结构为基础的FeFET, 其具体结构如图6(c)所示. 他们观察到此FeFET中的电阻弛豫现象会导致石墨烯的ON态和OFF态合并(图6(d)), 而在真空中该弛豫现象受到抑制, 表明该弛豫现象可能与空气中的杂质分子有关.
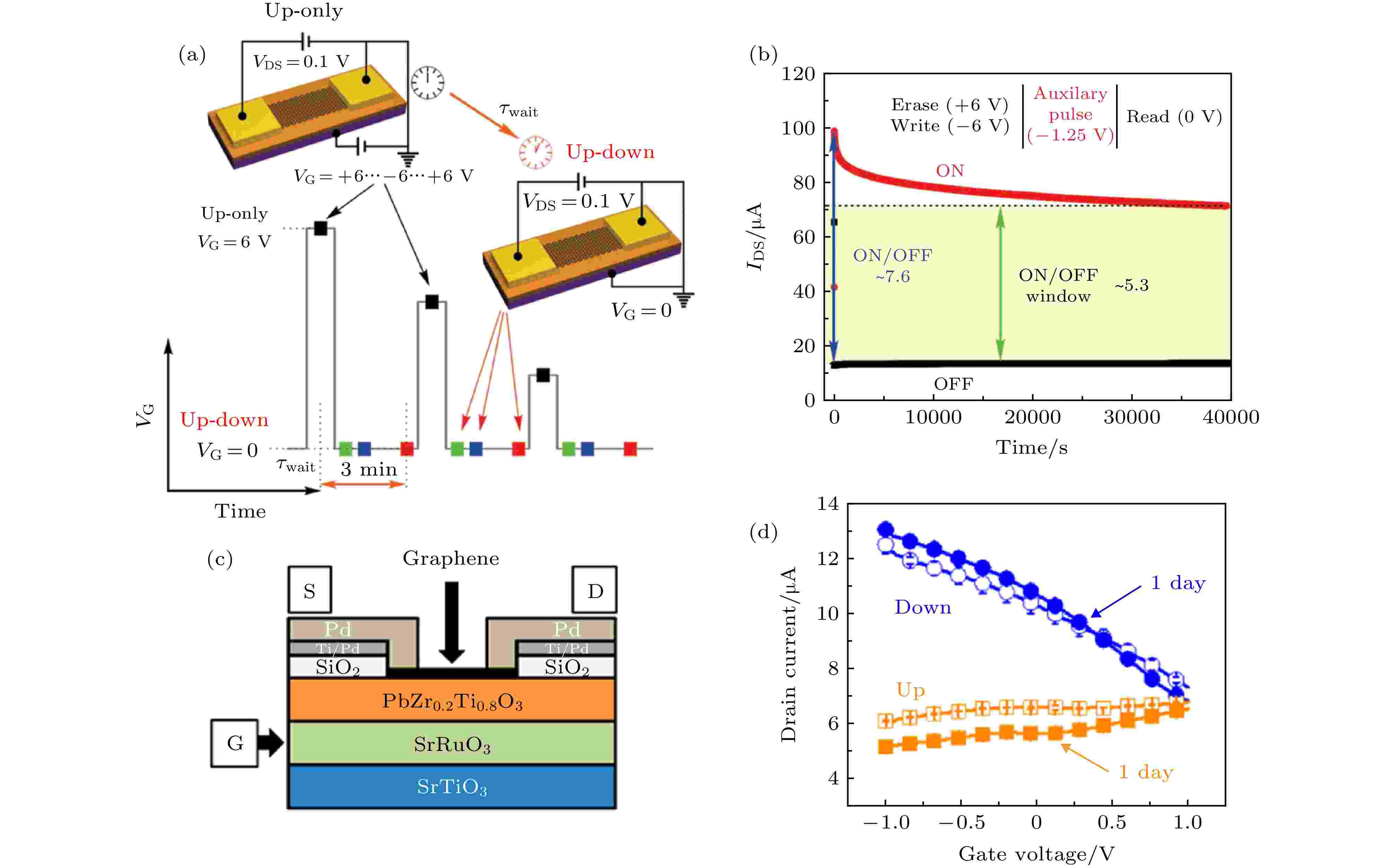 图 6 (a) PZT处于不同极化状态时, 石墨烯/PZT的IDS-VG曲线[28]; (b) 在施加VG = –6 V和VG = 6 V的擦写电压后, 石墨烯/PZT FET分别处于“ON”态和“OFF”时的漏极电流随时间的变化曲线[28]; (c) 石墨烯/PZT FET结构示意图[29]; (d) 在PZT薄膜翻转为向上和向下的极化状态后, 分别在真空中放置250 s和24 h后测得的Id-VG曲线[29]
图 6 (a) PZT处于不同极化状态时, 石墨烯/PZT的IDS-VG曲线[28]; (b) 在施加VG = –6 V和VG = 6 V的擦写电压后, 石墨烯/PZT FET分别处于“ON”态和“OFF”时的漏极电流随时间的变化曲线[28]; (c) 石墨烯/PZT FET结构示意图[29]; (d) 在PZT薄膜翻转为向上和向下的极化状态后, 分别在真空中放置250 s和24 h后测得的Id-VG曲线[29]Figure6. (a) Scheme of the electrical measurements of graphene/PZT FeFETs at different polarization state of PZT[28]; (b) after application of the write (VG = –6 V) or erase (VG = +6 V) voltages, the ON and OFF drain–source currents at the read voltage (VG = 0) and an auxiliary pulse (VG = –1.25 V) were measured as a function of time[28]; (c) schematic device structure of the graphene/PZT FeFET[29]; (d) Id-VG characteristics measured in vacuum 250 s and 24 h after switching for both the UP and DOWN polarization states[29].
3
3.1.2.石墨烯/PMN-PT异质结
与PZT铁电材料相比, PMN-PT单晶具有更优异的铁电(Pr ~ 30—40 μC/cm2)和压电性能(d33 ~ 2000 pC/N)[30-32], 因此一些研究者构建了石墨烯/PMN-PT复合结构, 通过晶格应变效应或者铁电场效应调控石墨烯性能[16,33-36]. 石墨烯零带隙的特点是制约其实现应用的最主要因素, 而相关研究表明通过应变调控有望在石墨烯的能带结构中引入带隙和改善相关物理性能[37,38]. 2010年, 丁飞等[33]采用机械剥离法制备了石墨烯并将其转移到PMMA/SiO2/La0.7Sr0.3MnO3(LSMO)/PMN-PT基底上, 利用电场在PMN-PT中诱导的晶格应变调控石墨烯性能, 如图7(a)所示, 他们在对衬底施加电场的同时测试石墨烯的拉曼光谱, 发现外加电场诱导PMN-PT产生双轴应变, 应变通过界面传递给石墨烯, 引起石墨烯拉曼峰位随面内应变线性偏移(图7(b)).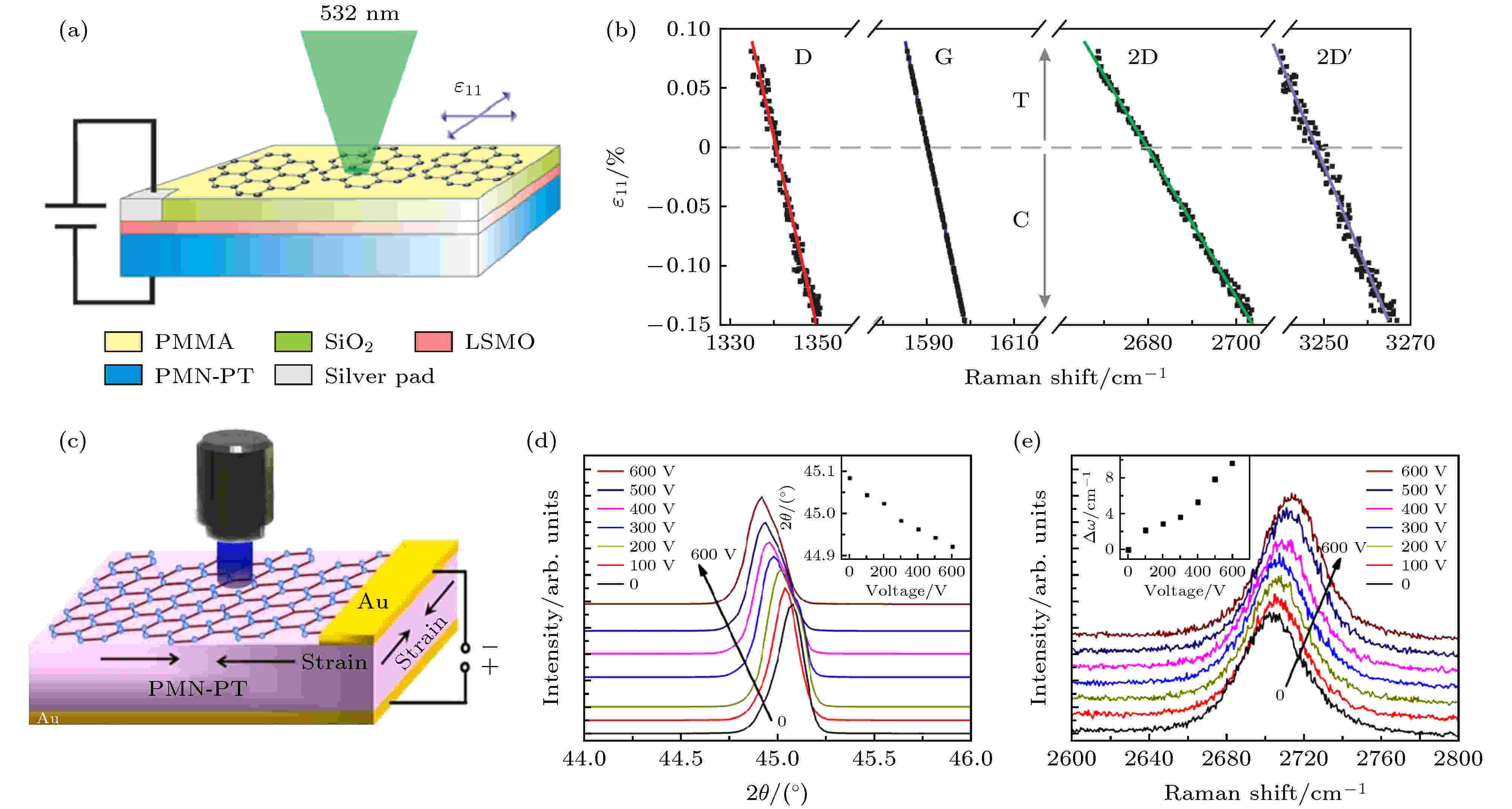 图 7 (a)对石墨烯/PMN-PT施加电场的示意图[33]; (b) 石墨烯的D, G, 2D和2D’峰位随面内应变的变化曲线[33]; (c) 石墨烯/PMN-PT异质结构示意图[34]; (d) 不同外场下PMN-PT(002)峰的XRD图[34]; (e) 不同外场下石墨烯的2D拉曼峰图[34]
图 7 (a)对石墨烯/PMN-PT施加电场的示意图[33]; (b) 石墨烯的D, G, 2D和2D’峰位随面内应变的变化曲线[33]; (c) 石墨烯/PMN-PT异质结构示意图[34]; (d) 不同外场下PMN-PT(002)峰的XRD图[34]; (e) 不同外场下石墨烯的2D拉曼峰图[34]Figure7. (a) Schematic of the electro-mechanical device used to apply in-plane biaxial strain to the graphene[33]; (b) D, G, 2D and 2D’ peaks plotted as a function of the biaxial strain ε||[33]; (c) schematic of graphene/PMNPT heterostructure[34]; (d) the PMN-PT (002) peaks of XRD 2θ scanning patterns with different bias voltage[34]; (e) 2D peaks of graphene under different bias voltage[34].
2013年, 香港理工大学的郝建华课题组[34]利用CVD法沉积了石墨烯薄膜并将其转移到PMN-PT(001)单晶衬底上(图7(c)), 同样发现电场诱导的晶格应变(图7(d))对石墨烯的拉曼光谱有显著影响(图7(e)). 他们通过计算发现每100 V电压下PMN-PT产生–0.04%的应变, 而石墨烯只接收了–0.011%的应变, 通过增大二者间的作用力有望提高应变的有效传递. 目前, 人们通过施加应变调控石墨烯性能的衬底主要有PDMS, PMMA, PET等[39-41], 但这些衬底需要进行弯曲, 应力较大, 而且通常只能产生单轴应变, 而利用压电系数较大的PMN-PT单晶衬底则可以引入较小的双轴应变, 且应变大小可调, 更易实现石墨烯性能的原位、定量调控.
在石墨烯/PMN-PT异质结构中同样存在界面电荷效应. 2013年, 郝建华课题组[16]制备了石墨烯/PMN-PT铁电场效应晶体管, 他们对PMN-PT施加不同幅度电场的同时测量石墨烯/PMN-PT FeFET的漏极电流, 发现漏极电流-门电压(Ids-VG)曲线的形状与PMN-PT的电滞回线相类似, 这是典型的铁电场效应调控机制的体现(图8(a)). 进一步, 他们测量了不同栅极电压下石墨烯的载流子浓度[35], 发现电场诱导的铁电极化翻转可引起载流子浓度和类型(n型或p型)发生变化, 进一步显示了铁电场效应的巨大调控作用(图8(b)). 此外, Park等[36]构建了石墨烯/h-BN/PMN-PT异质结(图8(c)). 对PMN-PT施加较宽范围的栅极电压(VG)时, 铁电极化翻转可以影响石墨烯的沟道电导及其回滞行为(图8(d)).
 图 8 (a) 石墨烯/PMN-PT FeFET的Ids-Vg曲线[16]; (b) 石墨烯的载流子浓度随栅压的变化曲线[35]; (c) 石墨烯/h-BN/PMN-PT FET示意图[36]; (d) 不同栅压范围下的Ids-Vg曲线[36]
图 8 (a) 石墨烯/PMN-PT FeFET的Ids-Vg曲线[16]; (b) 石墨烯的载流子浓度随栅压的变化曲线[35]; (c) 石墨烯/h-BN/PMN-PT FET示意图[36]; (d) 不同栅压范围下的Ids-Vg曲线[36]Figure8. (a) The Ids-Vg curves of graphene on PMN-PT[16]; (b) charge carrier density of graphene on PMN-PT as a function of the gate voltage[35]; (c) schematic diagrams of the graphene/h-BN/PMN-PT FET[36]; (d) Ids-Vg curves of graphene at different gate-voltage sweep ranges[36].
3
3.1.3.石墨烯/P(VDF-TrFE)异质结
相比于无机铁电材料, 聚偏氟乙烯铁电共聚物(P(VDF-TrFE))拥有很多有机材料特有的优势, 如易弯折、透明度高、便于大面积制备等, 因此很多研究者选择将石墨烯生长在P(VDF-TrFE)上, 取得了诸多成果[42-52]. 2009年, 新加坡国立大学的?zyilmaz课题组[42]采用铁电共聚物P(VDF-TrFE)薄膜作为栅极介质, SiO2作为底电极和衬底, 制备了非易失FeFET存储器. 如图9(a)所示, 石墨烯/P(VDF-TrFE)器件界面处电位移场D (D = ε0 + P)随极化电场E的变化曲线与P(VDF-TrFE)薄膜自身的D'-E曲线相类似, 表明P(VDF-TrFE)薄膜的铁电极化翻转诱导的极化电荷可有效调控石墨烯的电阻, 该器件的“ON”和“OFF”态的电阻改变率为350%, 利用不同的导电状态作为二进制存储器的“0”和“1”进行读写, 可实现非易失存储功能. 随后?zyilmaz课题组[43]进一步优化制备工艺, 使得该石墨烯/P(VDF-TrFE) FeFET的电阻相对变化超过500%, 并且经过105次读写后依然能够保持稳定的读写性能(图9(b)). 利用P(VDF-TrFE)的可见光透过率高和易弯折的特点, 2012年, 他们研究了石墨烯/P(VDF-TrFE)柔性透明导电器件(GFeTCs)的光学性能和应力下的电学性能, 器件如图9(c)所示[44]. 该复合结构的可见光区透过率 > 95%. 通过P(VDF-TrFE)的极化翻转, 薄膜的方阻由1500 Ω/□降低为120 Ω/□, 且弯折衬底也可以有效调控薄膜的电阻. 此外, 研究者在类似的石墨烯/P(VDF-TrFE)异质结构中, 通过电场诱导的铁电极化翻转, 实现了对薄膜载流子浓度、载流子迁移率和狄拉克点的调控(图9(d))[45,46].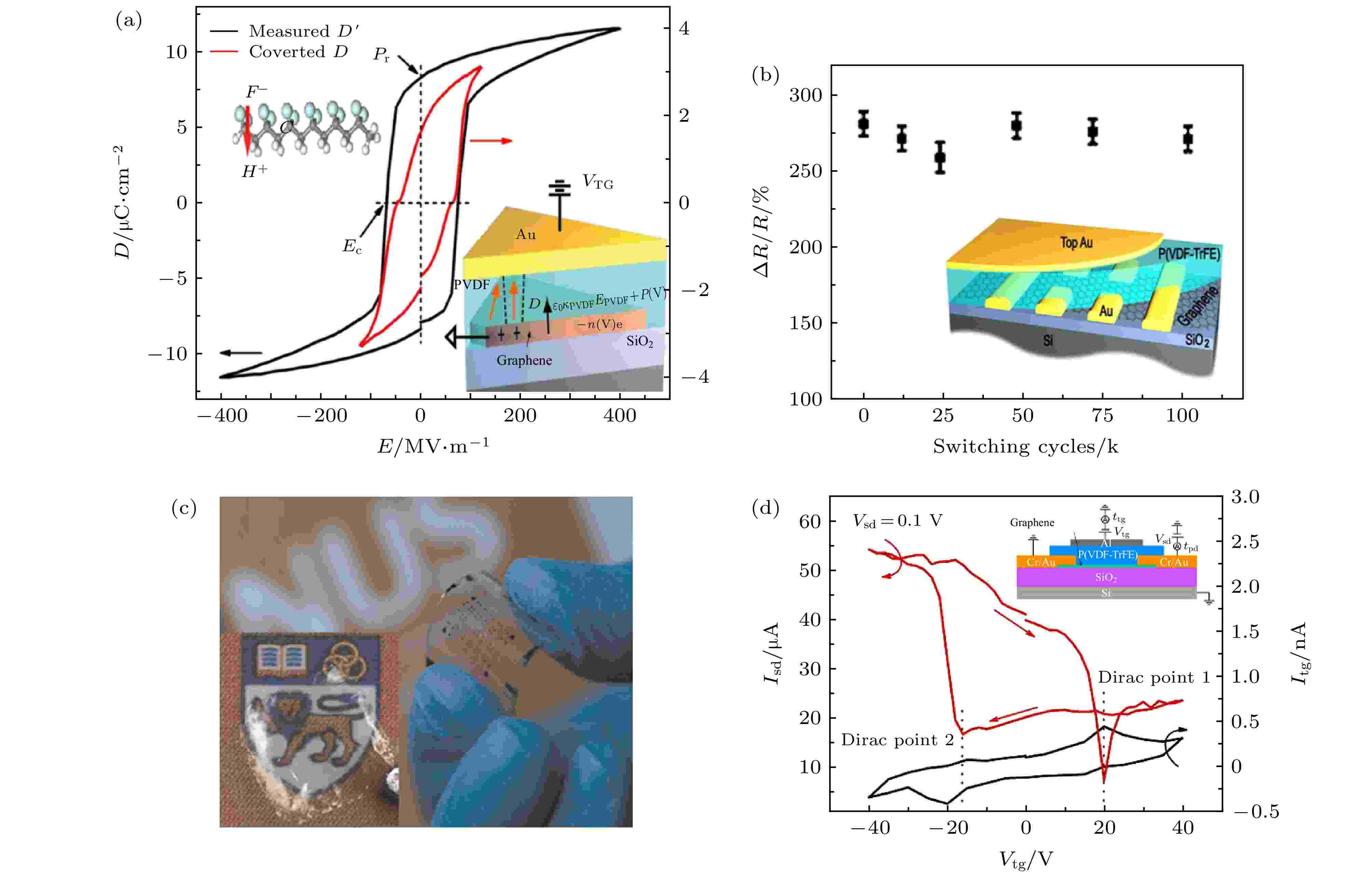 图 9 (a) 石墨烯/P(VDF-TrFE)的电位移D和P(VDF-TrFE)的电位移D’随外加电场的变化曲线[42]; (b) 石墨烯/P(VDF-TrFE)的电阻持久性能[43]; (c) 石墨烯/P(VDF-TrFE)柔性透明导电器件光学照片[44]; (d) 石墨烯/P(VDF-TrFE)的Isd和Itg随栅极电压的变化曲线[46]
图 9 (a) 石墨烯/P(VDF-TrFE)的电位移D和P(VDF-TrFE)的电位移D’随外加电场的变化曲线[42]; (b) 石墨烯/P(VDF-TrFE)的电阻持久性能[43]; (c) 石墨烯/P(VDF-TrFE)柔性透明导电器件光学照片[44]; (d) 石墨烯/P(VDF-TrFE)的Isd和Itg随栅极电压的变化曲线[46]Figure9. (a) The electric displacement field D of the graphene/P(VDF-TrFE) FeFET and D’ of P(VDF-TrFE) thin film as a function of the applied electric field[42]; (b) the resistance endurance property of the graphene/P(VDF-TrFE) FeFET[43]; (c) optical image of the flexible transparent graphene/P(VDF-TrFE) FeFET device[44]; (d) Isd and Itg vs Vtg curves of the graphene/P(VDF-TrFE) FeFET[46].
因为P(VDF-TrFE)本身具有良好的柔性、可延展性以及可见光区透过率高等优点, 所以石墨烯/P(VDF-TrFE)复合结构在很多应用场景具有很高的实用性, 一些研究者将其与集成电路相结合制成了基于石墨烯/P(VDF-TrFE)结构的电子元器件[47-49]. 例如2013年, 韩国成均馆大学的Bae等[47]研究了基于石墨烯/P(VDF-TrFE)/石墨烯复合结构的声压驱动器和纳米发电机元件, 测试回路实物图如图10(a)所示. 接受电信号后, 石墨烯/P(VDF-TrFE)复合结构可产生声压或机械振动, 实验线路中的移动手机感应到机械振动后进行记录(图10(b)). 此外, 通过外力弯曲石墨烯/P(VDF-TrFE)复合结构可在回路中产生感应电压, 输出电压最高约为3 V, 输出电流密度约为0.37 μA/cm2, 可点亮一盏LED灯. 2017年, 韩国世宗大学的Park等[48]制备了基于石墨烯/PVDF/石墨烯的发电机和扬声器元件, 当外加声压施加于复合薄膜时, 薄膜产生形变会输出相应的电压(图10(c)). 2019年, Kim等[49]利用P(VDF-TrFE)的高压电系数和石墨烯优异的电学性能制成了高灵敏度的压力传感器(图10(d)), 其原理是通过弯折石墨烯/P(VDF-TrFE)/PDMS元件, 产生应变诱导的压电电荷, 进而改变石墨烯的载流子浓度和迁移率, 该器件具有高灵敏度和生物兼容性, 在可穿戴电子监测设备中存在很大的应用前景.
 图 10 (a) 基于石墨烯/P(VDF-TrFE)/石墨烯复合结构的声压器件和测试回路照片[47]; (b) 基于石墨烯/P(VDF-TrFE)/石墨烯复合结构的声压驱动器和纳米发电机的示意图[47]; (c) 基于P(VDF-TrFE)/石墨烯复合结构的发电机和话筒的示意图和照片[48]; (d) 基于P(VDF-TrFE)/石墨烯复合结构的压力测试装置[49]; (e) 当被粘贴在手上时P(VDF-TrFE)/PMN-PT/GO薄膜的短路电流[51]; (f) 用PFM探针在GO/P(VDF-TrFE)上写入和读取数据的示意图[52]
图 10 (a) 基于石墨烯/P(VDF-TrFE)/石墨烯复合结构的声压器件和测试回路照片[47]; (b) 基于石墨烯/P(VDF-TrFE)/石墨烯复合结构的声压驱动器和纳米发电机的示意图[47]; (c) 基于P(VDF-TrFE)/石墨烯复合结构的发电机和话筒的示意图和照片[48]; (d) 基于P(VDF-TrFE)/石墨烯复合结构的压力测试装置[49]; (e) 当被粘贴在手上时P(VDF-TrFE)/PMN-PT/GO薄膜的短路电流[51]; (f) 用PFM探针在GO/P(VDF-TrFE)上写入和读取数据的示意图[52]Figure10. (a) Photograph of the graphene/P(VDF-TrFE)/graphene based acoustic device and the measurement circuit[47]; (b) schematic depiction showing graphene/P(VDF-TrFE)/graphene-based device can work as an actuator as well as a nanogenerator[47]; (c) schematics and photograph of graphene/PVDF/graphene based generator and loudspeaker[48]; (d) photographic image of the pressure measurement setup showing the pressurized gas inlet, the sensor mounting, and the data acquisition system[49]; (e) short-circuit current of the P(VDF-TrFE)/PMN-PT/GO film when attached on the human hand[51]; (f) a schematic of data writing and reading on GO/P(VDF-TrFE) Multilayer film by a PFM tip[52].
氧化石墨烯(graphene oxide, GO)是石墨烯的氧化物, 仍保持石墨的层状结构, 但在每一层的石墨烯单片上引入了许多氧基功能团. P(VDF-TrFE)中的C-F偶极子与GO中的羰基、羟基或环氧基等官能团之间的静电相互作用可提高铁电薄膜的结晶度和促进铁电相的成核[53,54], 因此一些研究者将二者相结合进行研究[50-52]. 2017年, 俄罗斯的Silibin等[50]测试了GO/P(VDF-TrFE)复合薄膜的介电、压电和机械性能, 分析了P(VDF-TrFE)与GO界面处的成键规律, 并建立理论模型定量计算了复合薄膜的压电性能参数, 与实验结果基本吻合. 2018年, 韩国蔚山大学的Yaqoob等[51]构建了P(VDF-TrFE)/PMN-PT/GO复合薄膜, 该复合材料的相对介电常数高达60, 通过手掌弯折或手指敲击可产生电压, 其输出的电压最高为8 V, 能量密度为6.5 mW/cm2, 是制备压力传感器和能量收集器的理想材料(图10(e)). 2019年, 南京大学的沈群东课题组[52]制备了GO/P(VDF-TrFE)多层薄膜, 该薄膜展现了优异的存储特性, 如超过300 Gbits in–2的超高存储密度、良好的写入和擦除重复性、非易失性和温度稳定性, 有望成为下一代纳米存储器(图10(f)).
2
3.2.TMDC/铁电材料异质结
石墨烯的一大致命缺点在于它是一个零带隙的材料[1], 无法同时兼顾高迁移率和高开关比, 极大地限制了实际应用. 过渡金属硫族化合物(TMDCs)作为典型的二维材料, 结构与石墨烯相近, 具有非零带隙, 解决了石墨烯的最大瓶颈, 因此被视为石墨烯的潜在替代材料. TMDCs分子式为MX2 (M = W, Mo, Pd等, X = S, Se, Te等), 层间由范德华力结合, 层内由共价键结合. 早期研究表明TMDCs是应变可调的[55,56], 因此由少层原子层构成的TMDC薄膜对应变工程(strain engineering)非常适用, 通过薄膜与铁电衬底之间的晶格失配或者衬底弯折所产生的内应力增加薄膜了的迁移率, 同时对薄膜的声子、电输运、光电性能都将产生影响[5]. 此外, 通过铁电场效应调控和改善TMDCs的性能也是一种常见的研究手段[11].3
3.2.1.TMDC/PZT异质结
PZT作为研究较成熟的铁电材料, 仍然是众多研究者在构建TMDC/铁电异质结构的重要候选材料[57-66]. 2015年, 清华大学朱宏伟课题组[57]将剥离法所得的MoS2纳米片转移到厚度为260 nm的PZT薄膜上, 制备了以PZT为底栅的MoS2-FET(图11(a)). 当施加栅极电压时, 沟道电流被调控, PZT-MoS2 FET的转移特性曲线(ID-VG)出现类似铁电滞回线的形状, 方向与电滞回线相反, 如图11(b)所示, 该FET的开关比约为104, 开关态保存时间达104 s, 可循环使用100次. 同年, 香港理工大学柴杨课题组[58]将CVD法生长的MoS2薄层转移到100 nm厚的PZT薄膜上, 制备了Au/Ti/MoS2/PZT/Pt/Ti/ SiO2/Si结构FET, 开关比提高到108, 因PZT薄膜厚度的降低使阈值电压减小到0.5 V以下, 亚阈值摆幅为85.9 mV/dec, 场效应迁移率在1—10 cm2·V–1·s–1. 2017年, 美国加州大学Lu等[59]将n型MoS2转移至100 nm厚的PZT (001)铁电薄膜上, 构建了背栅MoS2 FET, 开态电流为19 μA/μm, 开关比为107, 亚阈值摆幅SS约为92 mV/dec. 该研究还表明, 界面的粗糙度是影响铁电调控的关键, 粗糙的界面会屏蔽铁电翻转诱导的极化电荷, 使MoS2的转移特性曲线出现与PZT电滞回线相反的顺时针走向(图11(c)). 2019年, 印度理工学院Ganapathi等[60]进一步验证了以上结论, 他们分别使用多晶和单晶PZT为背栅介质构建了MoS2 FET, 压电力显微镜(piezo response force microscopy, PFM)测试表明多晶PZT背栅内部存在的不均匀极化偶极子分布、氧空位和较大的表面粗糙度影响了极化翻转, 导致FET转移特性曲线的回滞方向为顺时针. 采用单晶PZT作为背栅的FET的性能只受铁电极化的影响, 其转移特性曲线回滞方向为逆时针, 且在较低工作电压(≤ 2 V)下就可实现开关转换, 开关比为104, 200次循环后回滞曲线依然稳定. 清华大学谢丹课题组[61]构建了MoS2/PZT FET, 研究了温度(300—380 K)对FET电学性能的影响, 如图11(d)所示, 随着温度的升高, 铁电材料界面态俘获、释放电荷等动态过程的影响增大, 由铁电极化引起的本征逆时针回滞曲线走向进一步被掩盖, 导致FET电输运顺时针回滞曲线的面积扩大. 南洋理工大学Li等[62]采用Mn掺杂PZT作为背栅材料构建了MoS2/PZT FET, Mn掺杂使PZT/MoS2界面处的氧空位减少, 输出特性曲线呈现为本征的逆时针走向, 随着最大背栅电压的增加, FET存储窗口(?V)随PZT矫顽电压(2VC)的增大呈线性增大的趋势, 与之前的研究结果一致[57,61].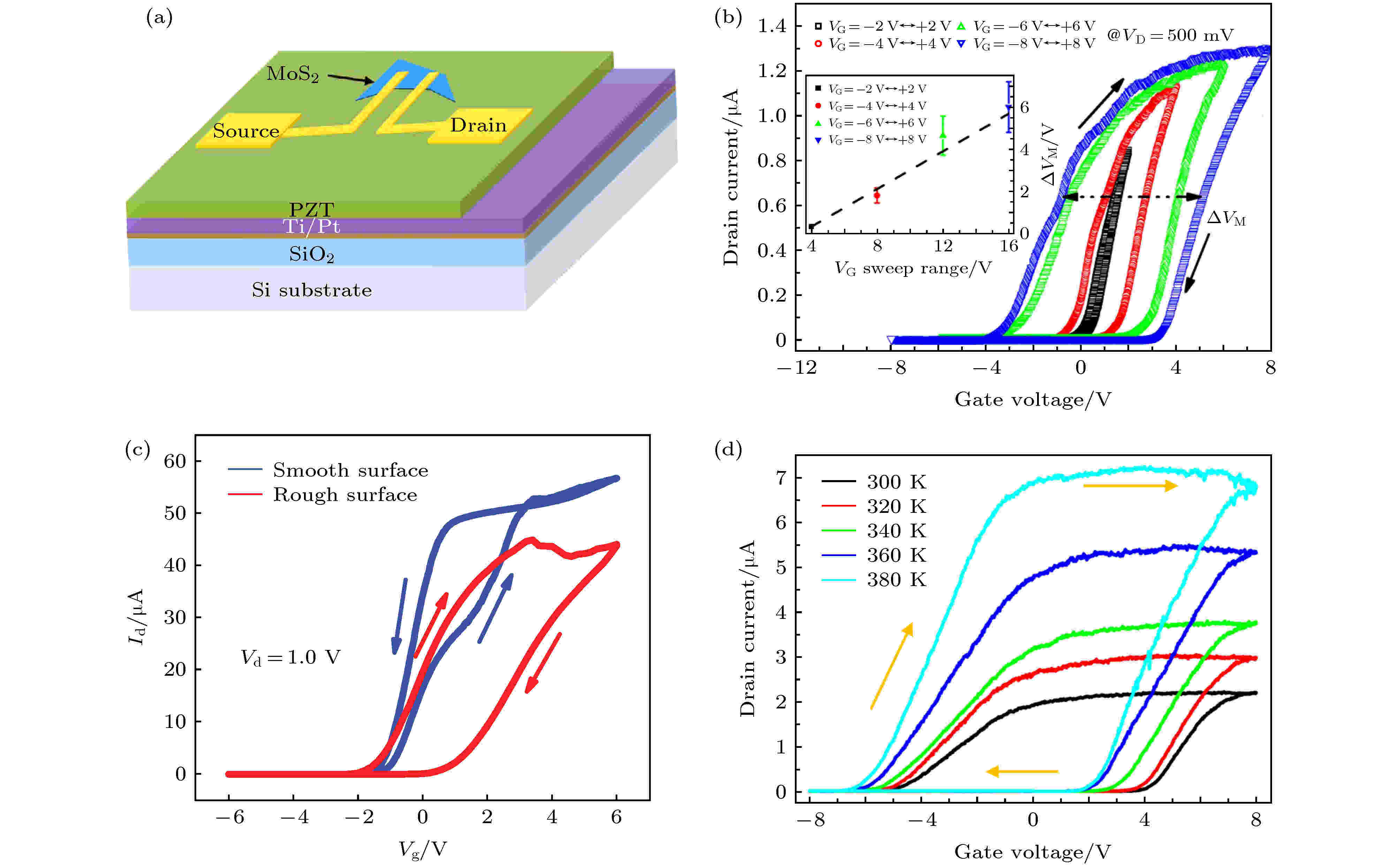 图 11 (a) 以PZT为背栅的MoS2 FET示意图[57]; (b) MoS2/PZT FET的转移特性曲线, 插图为存储窗口随最大扫描电压的变化曲线[57]; (c) 不同表面粗糙度的MoS2/PZT FET转移特性曲线[59]; (d) MoS2/PZT FET在不同温度下的转移特性曲线[61]
图 11 (a) 以PZT为背栅的MoS2 FET示意图[57]; (b) MoS2/PZT FET的转移特性曲线, 插图为存储窗口随最大扫描电压的变化曲线[57]; (c) 不同表面粗糙度的MoS2/PZT FET转移特性曲线[59]; (d) MoS2/PZT FET在不同温度下的转移特性曲线[61]Figure11. (a) Schematic diagram of the PZT back gated MoS2 FeFET[57]; (b) the transfer curves of MoS2/PZT FET. Memory window variation with increasing VG sweep range as shown in the inset[57]; (c) the transfer characteristics of MoS2 transistors fabricated on PZT films with different surface qualities[59]; (d) the Ids-Vgs curves of MoS2/PZT FETs under different temperatures rising from 300 to 380 K and Vgmax at 8 V[61].
美国内布拉斯加大学Sinitskii课题组[63,64]擅长用PFM研究二维/铁电复合材料, 可以直观地观察极化电压对铁电畴的影响. 2015年, 他们以(001)取向PZT铁电薄膜为栅极材料, 构建了MoS2/PZT FeFET[63], 如图12(a)所示, 他们分别测量了加栅压的同时和加栅压静置5 min后的电流-栅压曲线, 分别得到了顺时针(黑色)和逆时针方向(红色) IDS-VG曲线, 加栅压后静置5 min, 界面电荷对MoS2薄膜电导的影响基本消失, 铁电场效应占主导地位, IDS-VG曲线呈现如图12(a)中红线所示的逆时针走向. 无光照条件下该MoS2/PZT FeFET的稳定开关比约为22, 读写循环次数超过500次. 此外, 研究者还发现白光照射可分别对ON态和OFF态的通道电流进行不可逆调控, 最终两态的通道电流将逐渐趋于一致, 实现了“电写入-光擦除”模式(图12(b)). PFM测试进一步表明, 在白光照射下, 只有覆盖有MoS2部分的PZT极化方向发生转向. 2019年, 他们引入了可编程铁电器件的概念[64], 利用PFM探针, 可以调控PZT上纳米级图案的极化翻转, 进而改变其上MoS2薄膜的电导. 因此, 通过改变源漏极之间MoS2通道的数量和长度, 可以改变整个MoS2/PZT FeFET的输出电导(图12(c), 和图12(d)).
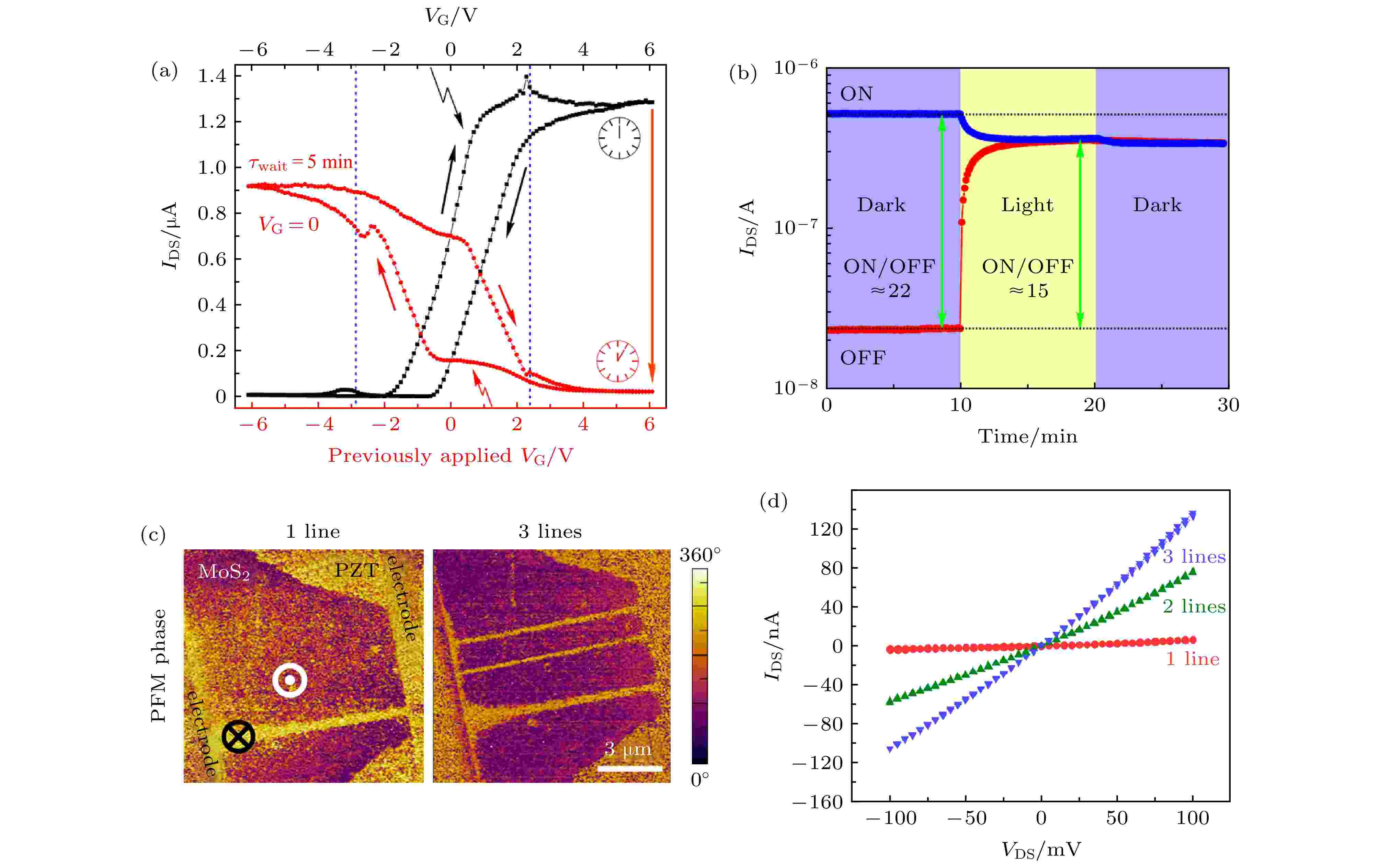 图 12 (a) 同一个MoS2/PZT FeFET在加栅压的同时和加栅压静置5 min后的IDS-VG曲线[63]; (b) 光照对FeFET器件开关持续能力的影响[63]; (c) 以向下的铁电畴为栅极的MoS2-PZT FeFET的PFM相位图[64]; (d) 不同数量导电通道的IDS-VDS曲线[64]
图 12 (a) 同一个MoS2/PZT FeFET在加栅压的同时和加栅压静置5 min后的IDS-VG曲线[63]; (b) 光照对FeFET器件开关持续能力的影响[63]; (c) 以向下的铁电畴为栅极的MoS2-PZT FeFET的PFM相位图[64]; (d) 不同数量导电通道的IDS-VDS曲线[64]Figure12. (a) IDS-VG characteristics for the same MoS2/PZT FeFET measured while VG was applied and 5 min after the corresponding gate voltages were applied, respectively[63]; (b) effect of light illumination on the retention properties of the FeFET[63]; (c) PFM phase images of a MoS2-PZT FeFET with one and three conductive paths gated by the domains with the downward polarization[64]; (d) IDS-VDS curves for different numbers of conductive paths[64].
尽管TMDCs材料体系十分庞大, 2015年以前用于制备FeFET器件的TMDCs材料大部分为MoS2, 但随着研究的深入, 更多的TMDC材料逐渐进入研究者的视野. 2016年, 美国加利福尼亚大学的Ko等[65]在PZT铁电薄膜上分别转移了WSe2和MoS2薄膜, 制备了TMDC/PZT FeFET非易失存储器件(图13(a)). WSe2/PZT FeFET具有更优异的存储性能, 在VG = 0 V时测得的开关比约为104, 施加正向辅助栅压时测得的开关比可提高至105, 性能可与当时报道的最优异的FeFET比拟. 由于PZT的介电常数较大, 该器件可在小于2.5 V的电压下工作, 且电压脉冲作用时间可降低至1 ms, 意味着该器件有很快的存储速度且功耗较低. 此外, PZT的极化翻转还可调控TMDC薄膜的光致发光强度, 如图13(b)—(d)所示, 当PZT薄膜的极化方向由向上翻转为向下时, MoS2薄膜的发光强度增强了700%, 且10天后光强也能保持稳定, 显示了比铁电存储器更高的稳定性. 同年, 美国海军研究室Li等[66]将CVD法生长的单层WS2转移至分区极化的PZT铁电薄膜上, 发现不同区域上WS2的发光性能具有很大差异(图13(e)). 图13(f)显示, PZT铁电畴极化方向向上的区域内WS2 PL光谱峰强明显高于PZT向下极化畴区内WS2 PL光谱峰强, 谱峰的半高宽也更窄.
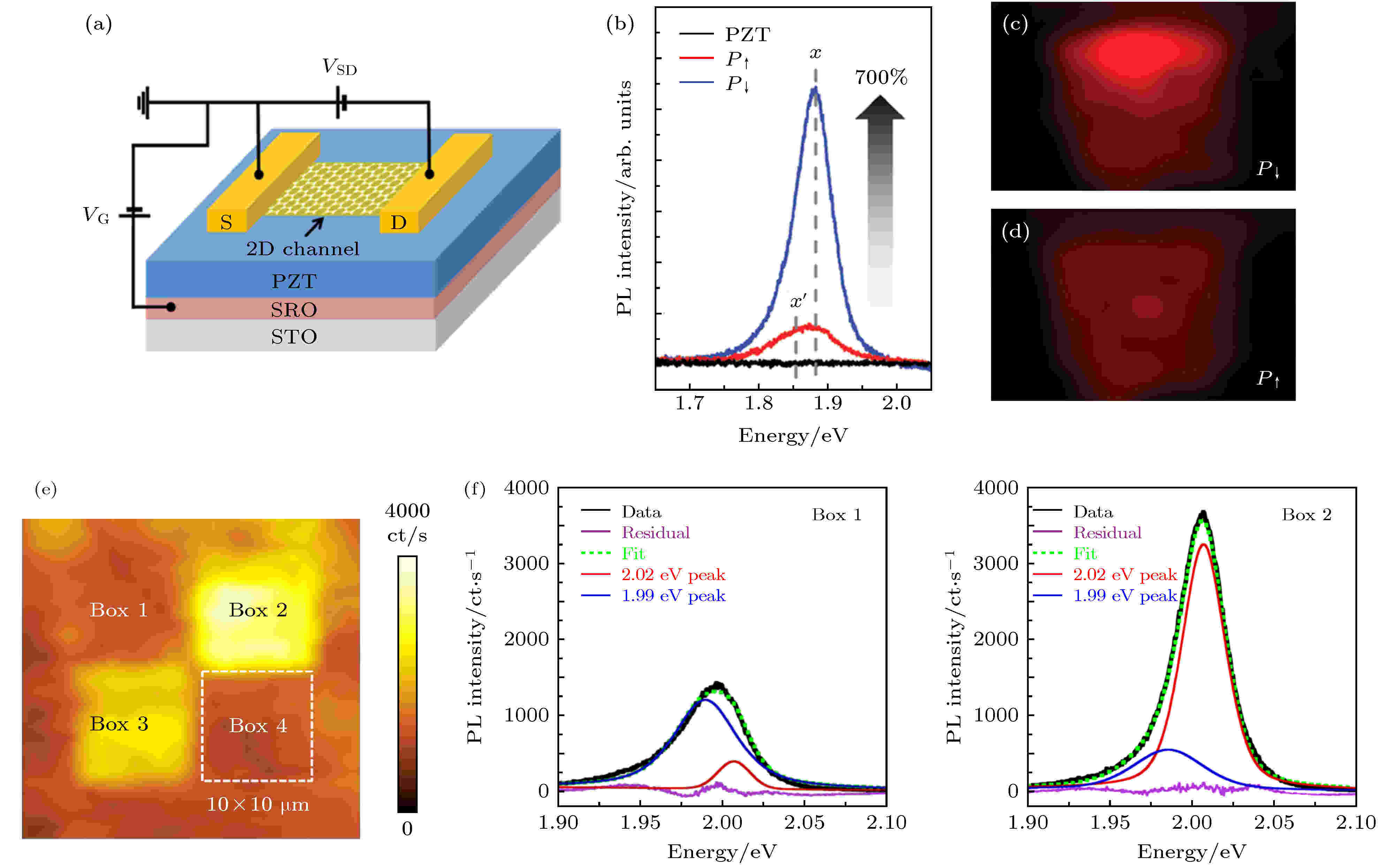 图 13 (a) 2D/PZT FeFET的结构示意图[65]; (b) PZT不同极化态对WSe2 PL光谱的影响[65]; (c, d) PZT不同极化态下, WSe2的PL发光分布图[65]; (e) PZT不同极化态下, WS2的PL发光分布图[66]; (f) PZT不同极化态下, WS2的PL光谱及拟合曲线[66]
图 13 (a) 2D/PZT FeFET的结构示意图[65]; (b) PZT不同极化态对WSe2 PL光谱的影响[65]; (c, d) PZT不同极化态下, WSe2的PL发光分布图[65]; (e) PZT不同极化态下, WS2的PL发光分布图[66]; (f) PZT不同极化态下, WS2的PL光谱及拟合曲线[66]Figure13. (a) Device schematic of the 2D TMD/PZT heterostructure[65]; (b) effect of different polarization state for PZT on the PL spectra of WSe2[65]; (c, d) the maps of integrated PL intensity under down- and up-polarized states, respectively[64]; (e) PL peak intensity map obtained from the WS2 monolayer over a 30 × 30 μm2 area under different polarized states[66]; (f) raw PL spectra (solid black line) and fits (dashed green line) using two Lorentzians centered at 2.01 eV (red line) and 1.99 eV (blue line)[66].
3
3.2.2.TMDC/PMN-PT异质结
2013年, 香港理工大学Hui等[11]通过机械剥离法在未极化的PMN-PT(001)铁电衬底上转移了3层MoS2, 以石墨烯为电极材料, 对MoS2进行应变调控研究, 如图14(a)所示, XRD图谱表明, 在正、负500 V外加电压下, PMN-PT均产生0.2%的面内压应力. MoS2薄膜的光致发光峰和Raman谱峰可显著被0—0.2%的应变调控, 如图14(b)所示, 每增加0.1%的应变, 三层MoS2的直接带隙都将蓝移约300 meV, 是当时应变调控变化最大的, 远胜于GaAs/AlGaSs量子点(~70 meV/%)和GaAs纳米线(~85 meV/%). 并且施加0.2%的应变时, MoS2的PL光谱强度增加200%. 第一性原理计算表明随着面内压应力增强至0.2%, 导带底和价带顶皆上移, 直接带隙发射能和间接带隙分别蓝移18和36 meV(图14(c)). 2015年, 香港理工大学戴吉岩课题组[67]制备了MoS2/PMN-PT FeFET, 并研究了红外光照对其光电性能的调控规律, 他们通过CVD法制备了结晶良好的单层MoS2薄膜, 随后将薄膜移至已极化的0.74 PMN-0.26 PT(111)铁电单晶衬底上, 如图14(d)所示, 利用PMN-PT的热释电效应, 可实现红外光对该器件的电阻的调控. 图14(e)为无栅极电压时MoS2/PMN-PT复合结构在不同功率红外光照下的伏安特性曲线, 可以看出, 随光照功率增强, FET的通道电流逐渐增大. 并且这种光调控是可逆的, 通过红外光照的开关, 可以实现该FET的源漏在ON态和OFF态之间来回切换(图14(f)). 图 14 (a) MoS2/PMN-PT的结构示意图[11]; (b) 不同应力作用下MoS2的光致发光光谱[11]; (c) 不同应力作用下MoS2的能带示意图[11]; (d) PMN-PT/MoS2 FET的结构示意图[67]; (e) 无栅极电压时, PMN-PT/MoS2 FET在不同强度光照下的伏安特性曲线[67]; (f) PMN-PT/MoS2 FET的沟道电流随红外光照开/关的响应曲线[67]
图 14 (a) MoS2/PMN-PT的结构示意图[11]; (b) 不同应力作用下MoS2的光致发光光谱[11]; (c) 不同应力作用下MoS2的能带示意图[11]; (d) PMN-PT/MoS2 FET的结构示意图[67]; (e) 无栅极电压时, PMN-PT/MoS2 FET在不同强度光照下的伏安特性曲线[67]; (f) PMN-PT/MoS2 FET的沟道电流随红外光照开/关的响应曲线[67]Figure14. (a) Schematic diagram of MoS2/PMN-PT composite[11]; (b) in-situ photoluminescence (PL) spectra of MoS2/PMN-PT composite under different strain states[11]; (c) calculated band structure of trilayer MoS2 as a function of the strain[11]; (d) schematic of MoS2/PMN-PT FET[67]; (e) Ids – Vds curves of MoS2/PMN-PT FET under different light illumination with gate voltage VG = 0 V[67]; (f) the time-resolved photocurrent in response to IR on/off at an irradiance of 6 mW/mm2[67].
2018年, 中国科学院北京纳米能源与系统研究所王中林课题组[68]制备了一种新型磁感应压电门控场效应晶体管(magnetic-induced-piezo- potential gated field-effect-transistor, MIPG-FET), 这种MIPG-FET由铁电单晶PMN-PT, MoS2纳米片和Terfenol-D组成(图15(b)). 在外加磁场下, Terfenol-D因磁致伸缩效应产生极大应变, 该应变通过界面传递给相邻的PMN-PT, PMN-PT的压电效应产生压电势, 即为调控沟道材料电输运特性的栅压(图15(a)). PMN-PT处于正极化(Pr+)态时, 对FET施加33 mT外加磁场, 沟道电流由9.56 μA减小至2.9 μA(Vds = 3 V), 开关电流比为330%(图15(c)). PMN-PT处于负极化(Pr–)态时, 施加42 mT外加磁场, 沟道电流由1.41 μA增加至4.93 μA, 电流开关比为432% (图15(d)). 这项工作提供了一种新型的在磁性、半导体性和压电性之间的非接触耦合方式, 在磁传感器、存储器和逻辑器件中有巨大应用价值.
 图 15 (a) 磁性、半导体性、压电性相互耦合示意图[68]; (b) MoS2基MIPG-FET的3D示意图[68]; (c) PMN-PT正向极化态下, MoS2基MIPG-FET对H = 33 mT的瞬态响应[68]; (d) PMN-PT负向极化态下, MoS2基MIPG-FET对H = 42 mT的瞬态响应[68]
图 15 (a) 磁性、半导体性、压电性相互耦合示意图[68]; (b) MoS2基MIPG-FET的3D示意图[68]; (c) PMN-PT正向极化态下, MoS2基MIPG-FET对H = 33 mT的瞬态响应[68]; (d) PMN-PT负向极化态下, MoS2基MIPG-FET对H = 42 mT的瞬态响应[68]Figure15. (a) Schematic showing the three-phase coupling among magnetism, semiconductor, and piezoelectricity[68]; (b) 3D schematic illustration of an MoS2-based MIPG-FET[68]; (c) transient response of the MIPG-FET at H = 33 mT at Pr+ state[68]; (d) transient response of the MIPG-FET at H = 42 mT at Pr– state[68].
3
3.2.3.TMDC/铁电共聚物异质结
TMDCs/铁电共聚物异质结因透明度高、延展性好等优点具有很高的实用价值, 成为很多课题组的研究热点. 2012年, 韩国延世大学Lee等[69]采用共聚铁电化合物P(VDF-TrFE)为顶栅介质, 以SiO2/Si为底栅介质, 制备MoS2基非易失存储器件(图16(a)). 在背栅驱动模式下, 没有底栅的单层MoS2 FET的场效应迁移率仅为22 cm2/(V·s), 电流开关比为105. 在双栅驱动模式下, 单层MoS2基FET场效应迁移率高达220 cm2/(V·s), 电流开关比超过105, 存储窗口为14 V, 使用1000 s后开关比维持在5 × 103. 但双栅结构下亚阈值摆幅较大, 约为300 mV/dec, 比HfO2/MoS2 FET的亚阈值摆幅(74 mV/dec)高[70]. 2016年, 日本金泽大学Kobayashi等[71]在150 nm P(VDF-TrFE)衬底上转移了少层MoS2薄片, 制备了MoS2 FET, 存储窗口约16 V, 开关比为104, 最大线性迁移率为625 cm2/(V·s). 与PZT为背栅的MoS2 FET不同, 以P(VDF-TrFE)为背栅的MoS2 FET的输出特性曲线走向为逆时针方向, 与P(VDF-TrFE)的极化回滞曲线方向相同, 推测是由MoS2/P(VDF-TrFE)的界面态俘获/去俘获与极化屏蔽效应导致. 图 16 (a) MoS2基FET的3D模型图[69]; (b) 亚阈值摆幅和电导随沟道长度的变化曲线[73]; (c) 以P(VDF-TrFE)为顶栅的MoSe2基FeFET的3D模型图[74]; (b) MoSe2基FeFET在写入和擦除状态下的持久性能[74]
图 16 (a) MoS2基FET的3D模型图[69]; (b) 亚阈值摆幅和电导随沟道长度的变化曲线[73]; (c) 以P(VDF-TrFE)为顶栅的MoSe2基FeFET的3D模型图[74]; (b) MoSe2基FeFET在写入和擦除状态下的持久性能[74]Figure16. (a) Schematic 3D top-view of the MoS2-FET[69]; (b) Detailed plots of SS and gm as a function of Lch[73]; (c) 3D schematic diagram of the P(VDF-TrFE) top gated MoSe2 FeFET[74]; (d) retention performance of this device at the write and erase states[74].
上海师范大学刘岚等[72]比较了铁电材料P(VDF-TrFE)和传统绝缘栅极材料PMMA分别作为顶栅的双栅MoS2 FET的性能, 在铁电剩余极化产生的内建电场作用下, 前者的有效场效应迁移率为95.6 cm2/(V·s), 而后者仅为15.3 cm2/(V·s), 前者的开关比(107)也远胜后者(105). 由于短沟道效应、漏电流增大以及玻尔兹曼极限(亚阈值摆幅SS ≥ 60 mV/dec)等因素, MOS(metal-oxide-semiconductor)场效应晶体管的尺寸减小是有限度的. 中科院北京纳米能源与系统研究所王中林课题组[73]通过将堆叠铁电薄膜P(VDF-TrFE)和HfO2薄膜作为顶栅材料, 构建的MoS2负电容场效应晶体管(negative-capacitance field-effect transistor, NC-FET)打破了“玻尔兹曼极限”, 在沟道长度小于100 nm的情况下, 把MoS2 NC-FET的亚阈值摆幅SS降至42.5 mV/dec, 电导率低至45.5 μS/μm, 开关比为4 × 106 (图16(b)). 与传统MOSFET不同的是, 随着温度的下降, MoS2 NC-FET的开态电流呈非线性增加, SS非线性减小. 相较于MoS2, MoSe2的晶体缺陷更少, 激子结合能可调性更高, 光电响应度也更大. 2017年, 湘潭大学王旭东等[74]以铁电共聚物P(VDF-TrFE)为顶栅介质、MoSe2薄膜为沟道材料制备了不同厚度的FeFETs(图16(c)). 其中单层MoSe2 FeFET器件的性能最为优异, 擦写比超过105, 数据保存时间超过2000 s, 最大擦写次数超过104 (图16(d)). 随着MoSe2厚度的增加, 存储窗口逐渐缩小, 存储性能开始降低. 当MoSe2厚度增加到5 nm时, FeFET擦/写比率仍保持在103以上.
此外, 采用铁电材料作为光电晶体管的栅介质还可提高沟道材料的光敏感性. 2015年, 中科院上海技术物理研究所王建禄和胡伟达课题组[75]在覆有285 nm氧化层的重掺杂单晶Si基底上转移了n型少层MoS2, 以300 nm P(VDF-TrFE)铁电聚合物为顶栅介质构建了光电探测器(图17(a)). 当P(VDF-TrFE)的极化方向向上时, 热离子和隧穿电流较小, 光生电流占主导地位, 探测器的光响应度显著增强(图17(b)). 该探测器的探测率高达2.2 × 1012 Jones, 响应度为2570 A/W, 将MoS2光电晶体管的可探测光波长范围扩展至了可见光及红外波段(0.85—1.55 μm). 2016年, 南京大学张善涛课题组[76]构建了以SiO2/p++-Si为背栅、300 nm P(VDF-TrFE)为顶栅的In2Se3基光电FET结构. 由于SiO2与In2Se3界面处陷阱态和杂质的影响, 双栅驱动模式下的开关比和场效应迁移率均优于背栅驱动模式, 光响应度为25 A/W, 响应时间低至200 μs. 对P(VDF-TrFE)施加外加电场, 由剩余极化产生的内建电场可缩小In2Se3的带隙, 将In2Se3光电FET的可探测光波长范围扩大为可见光至1550 nm(图17(d)). 2017年, 中国国家纳米科学中心何军课题组[77]采用铁电材料P(VDF-TrFE)作为顶栅介质调控了以双极性MoTe2、WSe2为沟道材料的FET电输运性能. 当在P(VDF-TrFE)和TMDC薄膜之间插入HfO2薄膜时(图17(c)), MoTe2 FET及WSe2 FET可由双极性导电转变为p型导电, 这是因为HfO2薄膜中的空穴填补了界面陷阱态, 使MoTe2和WSe2中的自由空穴浓度分别增加了4.4和2.5倍, 得以参与导电过程, 从而提高了场效应迁移率. 其中MoTe2光电晶体管的响应度高达3521 A/W, 远高于其它二维材料光电晶体管.
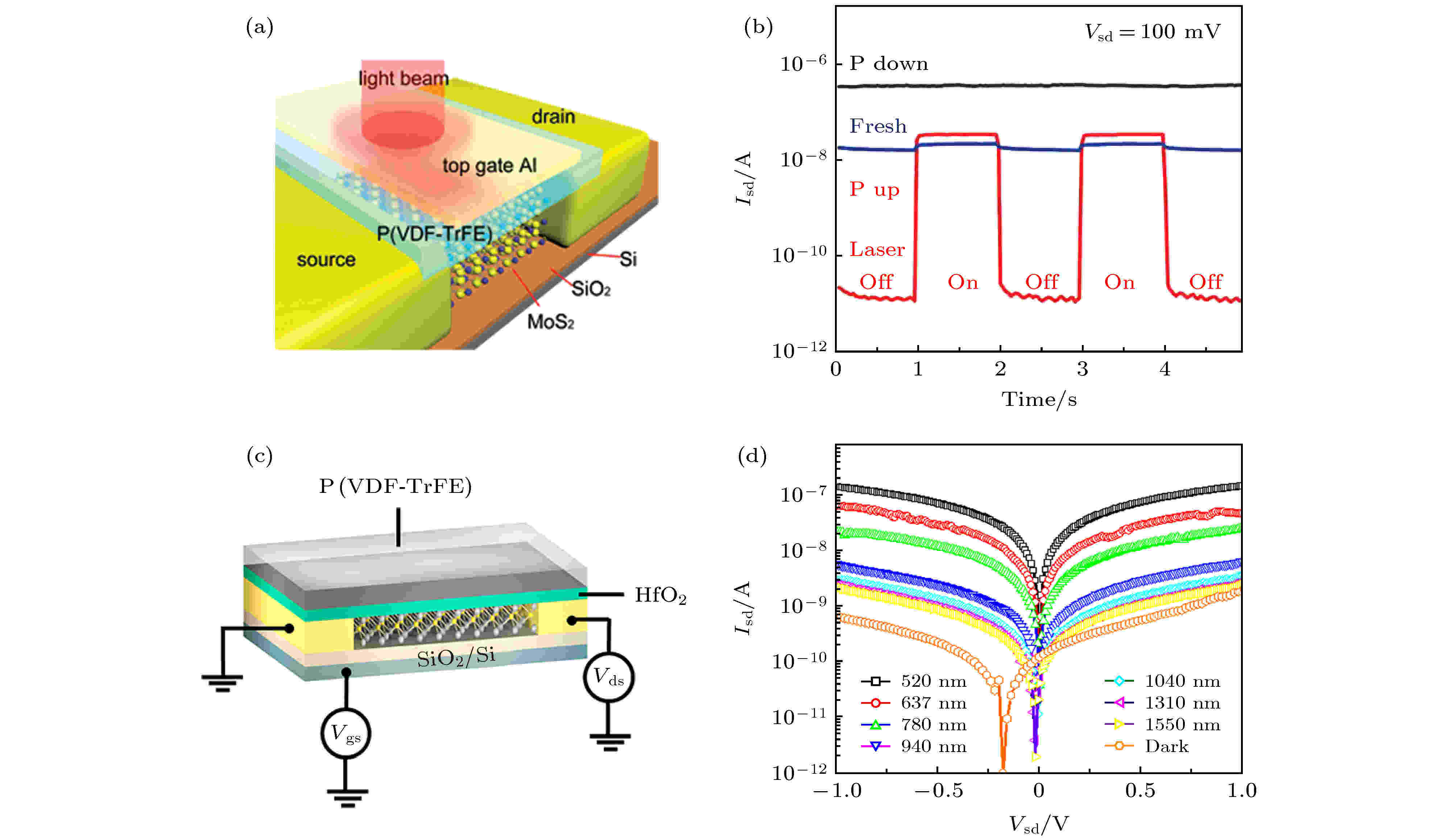 图 17 (a) P(VDF-TrFE)顶栅MoS2光电FET在光照下的3D模型图[75]; (b) P(VDF-TrFE)处于不同极化状态时, MoS2光电FET的光开关行为[75]; (c) 以P(VDF-TrFE)顶栅并中插HfO2薄膜的MoTe2光电FET示意图[77]; (d) 在黑暗及不同光照强度(520?1550 nm)下, In2Se3光电FET的伏安特性曲线[76]
图 17 (a) P(VDF-TrFE)顶栅MoS2光电FET在光照下的3D模型图[75]; (b) P(VDF-TrFE)处于不同极化状态时, MoS2光电FET的光开关行为[75]; (c) 以P(VDF-TrFE)顶栅并中插HfO2薄膜的MoTe2光电FET示意图[77]; (d) 在黑暗及不同光照强度(520?1550 nm)下, In2Se3光电FET的伏安特性曲线[76]Figure17. (a) 3D schematic diagram of the P(VDF-TrFE) top gated MoS2 phtodetector with light beam[75]; (b) photoswitching behavior of ferroelectric polarization gating triple-layer MoS2 photodetector at three states[75]; (c) the schematic diagram of back-gate MoTe2 FET in which HfO2 of 30 nm is deposited on MoTe2 before coating P(VDF-TrFE) polymer[77]; (d) drain-source characteristics of the In2Se3 phtodetector in the dark and under different illuminating light wavelength (520?1550 nm)[76].
2016年, 中国科学院上海技术物理研究所陈艳等[78]在覆有285 nm氧化层的重掺杂单晶Si基底上转移了n型少层MoS2, 以300 nm P(VDF-TrFE-CFE)铁电聚合物为顶栅介质构建了MoS2 FeFET. 由于高κ P(VDF-TrFE-CFE)顶栅层对界面处库仑杂质散射的屏蔽作用, 沟道的输运性能得到了提高, 开关电流比为3.27 × 106, 光响应度高于300 A/W, 但由于WSe2的费米能级位于带隙中央, 与金属电极间将存在较大接触电阻, 导致迁移率受到限制, 并且需要较大的工作电压才能实现较大的FET开关比. 随后, 浙江大学Yin等[79]通过在WSe2表面旋涂P(VDF-TrFE-CFE), 对WSe2薄膜进行p型掺杂, 成功调控了费米能级的位置. 选取6层WSe2作为沟道材料时, 以P(VDF-TrFE-CFE)为背栅驱动的WSe2 FET相较以SiO2为背栅驱动的WSe2 FET, 场效应空穴迁移率由27 cm2/(V·s)提升至170 cm2/(V·s). 在双栅驱动模式下, WSe2 FET可在低的工作电压下(± 10 V)达到很高的开关比(2 × 107), 低温时P(VDF-TrFE-CFE)发生的相转变将进一步使双层WSe2 FET场效应空穴迁移率提高至900 cm2/(V·s) (200 K).
3
3.2.4.其他TMDC/铁电异质结
除了上述介绍的铁电材料外, 其它的铁电材料诸如LiNbO3(LN)[80,81], PbTiO3(PTO)[82,83], BaTiO3 (BTO)[84,85], BiFeO3(BFO)[86,87], CuInP2S6[88], HfO2[89] 也被用作栅极材料来调控TMDC薄膜的性能. 利用LiNbO3的铁电转变温度大于1000 ℃的特点, 2015年, 美国加利福尼亚大学的Nguyen等[80]采用CVD法(650—700 ℃)在预先周期性极化的LiNbO3的衬底上生长了单层MoS2薄膜, 如图18(a)所示[80], 他们发现MoS2会优先生长在衬底极化方向向上的部分, 并且MoS2薄膜会保存界面处向上的铁电畴而轻微破坏向下的铁电畴. 通过对衬底施加极化电场, MoS2的载流子类型(n-p转变)和浓度均会发生变化. MoS2表现出的对铁电畴方向的择优生长的特性展示了通过衬底的极化图案控制MoS2生长的可能性, 而省去了后期平板刻蚀的麻烦. 2019年, 深圳大学的闻博等[81]进一步推进了他们的工作, 在预先六边形周期性极化的LiNbO3的衬底上分别生长了双层MoSe2和WSe2薄膜, 通过对衬底施加平面内周期电场, 在两个器件的薄膜内部均成功构建了p-n结. 因为MoSe2和WSe2薄膜原始分别为n-型和p-型导电, 相同铁电畴方向对二者的荧光发光产生相反的影响(图18(b)和图18(c)). 美国内布拉斯加大学Gruverman课题组[84,85]同样在MoS2/BaTiO3铁电隧道结(ferroelectric tunnel junctions, FTJ)中观察到覆盖着MoS2的BaTiO3薄膜极化翻转不对称的现象. 2017年, 他们在SrTiO3单晶衬底上依次生长了SrRuO3, BaTiO3, MoS2薄膜, 其中MoS2为顶电极和沟道材料[84]. BaTiO3铁电薄膜的极化翻转在MoS2表面引起电荷积聚与耗尽, 不仅使MoS2薄膜在金属型(n-型)和绝缘体型(p-型)之间来回切换, 而且可以调节MoS2/BaTiO3界面处的势垒, 界面处隧道电阻效应大大增强, 隧道结开关比为104, 是金属电极/BaTiO3 FTJ的50倍. 2018年, Gruverman课题组[85]发现紫外光照射MoS2薄膜可使原本极化方向向上的BaTiO3薄膜的极化方向向下翻转, 而对原本极化方向向下的BTO薄膜无影响, 认为光照引起了MoS2薄膜内部激子的产生, 使得正电荷在界面处累积, 诱导BTO极化方向从竖直向上转变为竖直向下(图18(d)—(f))[85]. 以上研究展示了TMDC薄膜的载流子浓度和铁电介质电偶极子之间的相互作用, 提供了多种调控TMDC材料电学性能的手段, 为TMDC/铁电复合结构在多功能器件中的应用奠定了基础. 图 18 (a) 单层薄膜在LiNbO3铁电畴上择优生长的光学照片和在单极化域上的双层[80]; (b) MoSe2和(c) WSe2的光致发光分布图[81]; (d) 在MoS2/BaTiO3/SrRuO3上的测试示意图[85]; (e?f) MoS2/BaTiO3/SrRuO3在紫外光照前后的PFM相图[85]
图 18 (a) 单层薄膜在LiNbO3铁电畴上择优生长的光学照片和在单极化域上的双层[80]; (b) MoSe2和(c) WSe2的光致发光分布图[81]; (d) 在MoS2/BaTiO3/SrRuO3上的测试示意图[85]; (e?f) MoS2/BaTiO3/SrRuO3在紫外光照前后的PFM相图[85]Figure18. (a) The optical micrograph shows preferential growth of single-layer MoS2 on LiNbO3 domains[80]; PL mapping of exfoliated monolayer (b) MoSe2 and (c) WSe2 on a single polarized domain. The gold dashed line indicates one single dipole[81]; (d) a sketch of the experiment geometry in MoS2/BaTiO3/SrRuO3 junctions[85]; (e)?(f) PFM phase images of MoS2/BaTiO3/SrRuO3 junctions acquired in the dark before and after UV illumination[85].
众所周知, 薄膜的功函数是决定器件能带排列和性能的重要因素. 2017年, 韩国梨花女子大学Jin等[82]构建了MoS2/PbTiO3/LaNiO3/SrTiO3, 发现通过PTO铁电薄膜的极化翻转可以改变MoS2的表面势, 进而改变MoS2的功函数, 并且在边缘和内部的MoS2薄膜的功函数随BTO极化翻转的变化趋势也不同. 2018年, 哈尔滨工业大学Li等[83]将石墨烯、MoS2分别与BiFeO3结合, 研究了铁电材料对2D/BFO FTJs性能的调控作用. 通过BFO的极化翻转或者改变薄膜的厚度, 可调控2D薄膜的功函数, 进而影响二维薄膜与铁电材料界面处的接触势垒和耗尽层宽度, 从而调控沟道材料的电阻. MoS2/BFO比石墨烯/BFO FTJ的开关比高, 大约为100. 韩国庆熙大学Shin等[87]用MoS2和BFO构建了非易失存储FET, 分别使用外延生长的(001)SrRuO3和Pt作为对照试验, 研究电极对FET性能的影响. 研究表明, 以SrRuO3为电极的MoS2 FET具有更高的剩余极化强度、更快的切换速度、更宽的存储窗口和更耐疲劳的优良特性. 通过改变器件形状、薄膜厚度或者电极材料, 可以调控2D/铁电器件的性能, 制备适应各种应用目的的TMDC/铁电复合材料.
此外, 美国普渡大学Si等[88]采用MoS2作为沟道材料, 二维铁电薄膜CuInP2S6作为顶栅介质, SiO2作为底栅介质, 构建了双栅FET结构. 通过扫描顶栅电压(VTG), 该器件的I-VTG曲线呈类电滞回线形状, 展示了该器件的非易失存储特性. 另外改变底栅电压可调控MoS2和CuInP2S6之间的电容匹配, 提高开关比. 随后, 他们以HfO2为栅介质, 构建了p型WSe2负电容场效应晶体管(NC-FET), 室温下亚阈值摆幅SS减小至14.4 mV/dec[89].
2
3.3.其它二维/铁电异质结
拓扑绝缘体(topological insulator, TI)是一种具有量子特性的物态, 从能带结构上看, 其体内具有带隙, 但表面或边界上存在可导电的无带隙表面态. 拓扑绝缘体中具有拓扑磁阻效应、量子(反常)霍尔效应、拓扑超导等一系列新型的物理现象, 近年来成为物理学前沿研究领域. 目前已有越来越多的拓扑绝缘体材料被研究者预测和证实, 如Bi2Se3, Bi2Te3, Sb2Te3, Bi2Te2Se等[90,91]. 为了获知拓扑绝缘体材料的量子输运性能, 研究者采用栅极调控手段对拓扑绝缘体薄膜进行电学性能的原位调控. 栅极调控使用的绝缘体主要有SiO2, Al2O3, HfO2, h-BN等, 但这些材料对性能的调控具有易失性, 并且可调控的面载流子浓度范围较小(约1012—1013 cm–2)[92]. 如果采用铁电材料替换传统的绝缘栅极材料, 则可实现对拓扑绝缘体性能的非易失、可逆调控. 中科院上海硅酸盐研究所郑仁奎课题组[92]在PMN-PT(111)铁电单晶衬底上生长了Cr掺杂Bi2Se3 (CBS)薄膜, 以PMN-PT(111)为栅极介质, 对CBS薄膜进行了性能调控研究. 如图19 (a)所示, 在外加电场的作用下, PMN-PT衬底由正极化(Pr+)变为负极化(Pr–), 异质结中的界面电荷效应诱导80 nm-CBS薄膜面载流子浓度n2D减少, 从而导致薄膜的电阻增大以及金属-半导体转变. 在更薄的3 nm的CBS薄膜中, 衬底极化态的转变可直接可逆调控薄膜载流子类型(n型或p型, 图19(b)), 电阻变化率为33%. 此外, PMN-PT的铁电极化翻转还可引起薄膜的费米能级、磁导、导电通道数、相位相干长度等物理性能的可逆变化. 2019年, 该课题组[93]在Bi2Se3/PMN-PT异质结中发现了类似的现象, 电阻变化率显著提高到110%. 以上结果均显示了铁电栅极对拓扑绝缘体薄膜巨大的调控作用, 且这种可逆、非易失的调控方式为研究拓扑绝缘体中与载流子浓度相关的物性提供了一种新途径.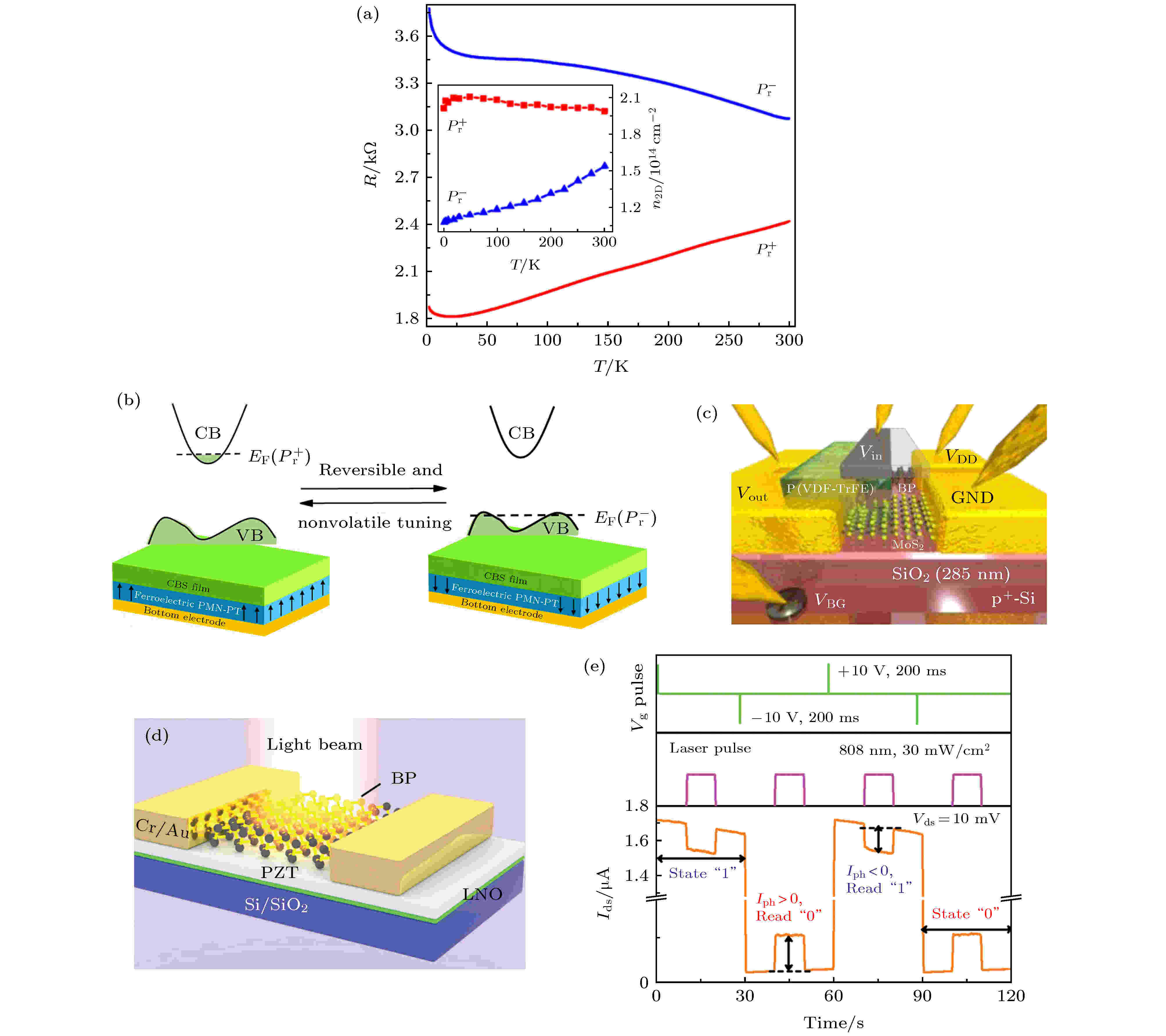 图 19 (a) PMN-PT衬底分别处于Pr+, Pr–态时, CBS薄膜的电阻R随温度T的变化曲线, 插图: CBS薄膜的载流子浓度随温度T的变化曲线[92]; (b) PMN-PT衬底极化翻转引起的CBS薄膜费米能级移动的示意图[92]; (c) P(VDF-TrFE)/BP/MoS2/SiO2/Si结构FeFET示意图[94]; (d) 在BP/PZT/LNO/SiO2/Si结构的FeFET中光电存储原理图[95]; (e) 在BP/PZT/LNO/SiO2/Si结构存储器中的“电写光读”动态循环曲线[95]
图 19 (a) PMN-PT衬底分别处于Pr+, Pr–态时, CBS薄膜的电阻R随温度T的变化曲线, 插图: CBS薄膜的载流子浓度随温度T的变化曲线[92]; (b) PMN-PT衬底极化翻转引起的CBS薄膜费米能级移动的示意图[92]; (c) P(VDF-TrFE)/BP/MoS2/SiO2/Si结构FeFET示意图[94]; (d) 在BP/PZT/LNO/SiO2/Si结构的FeFET中光电存储原理图[95]; (e) 在BP/PZT/LNO/SiO2/Si结构存储器中的“电写光读”动态循环曲线[95]Figure19. (a) The resistance R as a function of the temperature T for the CBS films at Pr+ state and Pr– state, respectively[92]; (b) schematic band diagrams of the Fermi level shift induced by polarization Switching[92]; (c) schematic of dual-gated P(VDF-TrFE)/BP/MoS2/SiO2/Si FeFET[94]; (d) schematic illustration of the photoelectric memory in FeFET with BP/PZT heterostructure fabricated on LNO/SiO2/Si substrate[95]; (e) dynamic cycles of the “electrical writing-optical reading” process of the BP/PZT/LNO/SiO2/Si memory[95]
除了TI薄膜, 黑磷因具有独特的各向异性(折叠蜂窝结构)[7]、高迁移率(~1000 cm2/(V·s))[96]和直接带隙(~0.3 eV)[7,97]等特性也引起了研究者的兴趣. 2015年, Im课题组[94]构建了P(VDF-TrFE)/BP/SiO2/Si异质结, 在此结构中铁电场效应起主要作用, 且作为沟道材料的BP的迁移率达到1159 cm2/(V·s), 源漏电流开关比达到103. 他们进一步在BP和SiO2间插入MoS2薄膜构造双门存储器件, 如图19(c)所示, 此器件的存储窗口为15 V, 且存储输出效率达到95%, 更有利于其在存储器中的应用. 2019年, 中科院苏州纳米所的张凯课题组[95]制备了BP/PZT/LaNiO3/Si/SiO2铁电场效应晶体管(图19(d)). 该器件展示了一种新型的“电写光读”工作模式, 并且具有低功耗(读取电压10 mV)、稳定性好(> 3.6×103 s)、抗疲劳性强(> 500次)等优点(图19(e)), 是基于二维材料的多功能器件研究的一项重要进展.
1) 优化材料制备工艺仍是研究的重点和基础. 虽然CVD, 氧化还原法等方法可以大面积合成二维材料, 但材料往往包含很多畴界和褶皱, 其质量和均匀性离微型器件的要求还有很大差距, 并且存在工艺成本高、重复性差、环境污染等问题. 其次, 制备二维/铁电结构的过程中往往涉及到二维材料的转移, 如何在转移过程中不破坏二维材料或者降低其性能需要进一步探索.
2) 二维/铁电异质结内部机理不明晰. 二维/铁电界面处存在多种影响因素(电荷、应变、界面分子、表面陷阱态等), 再加上材料本身性能的不稳定, 往往导致相互矛盾的实验结果, 因此建立清晰地物理模型和机制, 深入理解界面处各作用机制的影响, 不仅有助于精准地优化材料制备参数, 而且可以实现定量控制材料性能的目的.
3) 原型器件的开发及关键技术指标的提高. 目前基于二维/铁电异质结的器件性能还不能全面超越传统的硅基器件, 虽然二维/铁电复合材料表现出高开关比、高迁移率、非易失性等优点, 但其电流密度、接触电阻等还存在一定差距, 且大部分器件的重复性和稳定性有待提高. 此外, 新型二维/铁电异质结构器件有待发现和探索, 如WSe2, PdSe2, Ag2Se, 磷烯等二维材料与铁电材料的复合结构以及多层二维/铁电复合结构等. 最后, 如何结合电场、光照、温度等多种手段实现对二维/铁电异质结构器件的性能调控是多功能器件研究的重要发展方向.
