全文HTML
--> --> -->七彩LED光功率效率(简称光效)发展很不平衡, 其中在人眼对光最敏感的绿黄光区域的光效长期远低于蓝/紫光和红光, 这一现象被称为“绿/黄鸿沟”, 致使高效白光LED照明不得不通过蓝光激发荧光粉来实现. 这种“电-光-光”转换技术方案是目前LED照明的主流技术, 为节能减排发挥了重要作用. 但荧光粉在光光转换过程中存在热损耗大、光响应很慢、光品质与流明效率难以兼顾, 在一定程度上制约了LED向高质量照明和高速可见光通信等方向的快速发展. 红光LED的发明人Holonyak教授曾在2012年指出: “LED仍处于婴儿期, 因为没有人能把黄光做好…”.
关于黄光LED的研究, 最早可追溯到1965年, 美国贝尔实验室的Thomas和Hopfield [1]首次在掺氮的磷化镓中观察到黄光光致发光; 1971年, 美国孟山都公司的Craford使用气相外延(VPE)技术, 在GaAs衬底上制备了首只掺氮的磷砷化镓PN结黄光LED器件, 波长为570 nm, 20 A/cm2电流密度下光效为0.01%左右[2]; 1990年, 美国HP公司使用MOCVD技术, 在GaAs衬底上生长了铝镓铟磷双异质结黄光LED, 波长为574 nm, 30 A/cm2电流密度下光效达到0.5%[3]; 1994年, HP公司将AlGaInP黄光LED外延材料从吸光的GaAs衬底上转移到透光性较好的GaP基板上, 波长为571 nm, 44 A/cm2电流密度下光效提升到1.3% [4,5]; 2008年, 诺奖得主Nakamura所在的UCSB研究组, 使用MOCVD技术在半极性GaN衬底上生长了InGaN单阱黄光LED, 波长为562 nm, 7 A/cm2电流密度下外量子效率达到13.4%[6], 但电压较高, 光效仅为5.5%; 2013年, 日本东芝公司使用MOCVD技术, 在蓝宝石衬底上生长了InGaN黄光LED, 波长为559 nm, 9.5 A/cm2电流密度下外量子效率达到18.7%[7], 同样因电压过高, 光效仅为9.6%.
无论是AlGaInP还是InGaN材料体系, 在黄光波段的表现长期差强人意. 对于AlGaInP材料, 在红光波段光效很高, 但随着波长变短到黄光波段(570 nm附近), 其能带会由直接带隙转变为间接带隙[8], 导致光效急剧下降, 这属于物理瓶颈, 难以克服. 而对于直接带隙InGaN材料体系, 最大的问题在于难以生长高质量的InGaN量子阱材料, 属于技术瓶颈, 可望通过材料结构、生长方法、工艺技术和设备设计等方面的创新获得突破. 图1给出了黄光LED光效过去53年的发展进程, 其中最新进展是本文作者使用自制的MOCVD设备, 在硅衬底上生长InGaN基LED所取得的突破, 从而结束了长期缺乏高光效黄光LED的局面.
 图 1 黄光LED光效发展历程
图 1 黄光LED光效发展历程Figure1. The efficiency development progress of yellow LEDs
2
2.1.黄光LED材料结构
图2(a)为本团队设计的GaN/Si基LED材料结构示意图, 衬底是网格化图形Si(111), 厚度1 mm. 为了防止Si, Ga互溶, 首先在Si衬底上生长一层100 nm厚的AlN缓冲层; 然后利用GaN与AlN之间的晶格失配在AlN上生长三维岛状GaN, 再改变生长条件形成GaN侧向外延将岛合并成平面, 降低外延层位错密度.随后生长较低位错密度的n-GaN主层, 起载流子输运和扩展作用.为了降低InGaN黄光量子阱所受压应力和提高阱材料质量, 在n-GaN与有源层量子阱之间生长了三段In组分逐步提升的5 nm-InxGa1-xN/2 nm-GaN超晶格结构作为应力准备层; 接着生长了8个周期的2.5 nm-In0.3Ga0.7N/13.5 nm-GaN多量子阱. 在应力准备层与多量子阱层中, 沿着位错线会生成六角锥状的空洞, 即V坑. 多量子阱之后生长10 nm-Al0.2Ga0.8N作为电子阻挡层(EBL), 以及50 nm高掺p-GaN作为空穴注入层,然后将V坑合并填平, 再生长180 nm低掺p-GaN层作为空穴扩展输运层, 最后生长20 nm高掺的p-GaN层用于制作欧姆接触. 其MOCVD在线生长曲线见图2(b), 相关外延层的厚度、组分与掺杂见二次离子质谱(secondary ion mass spectroscopy, SIMS)曲线(图7).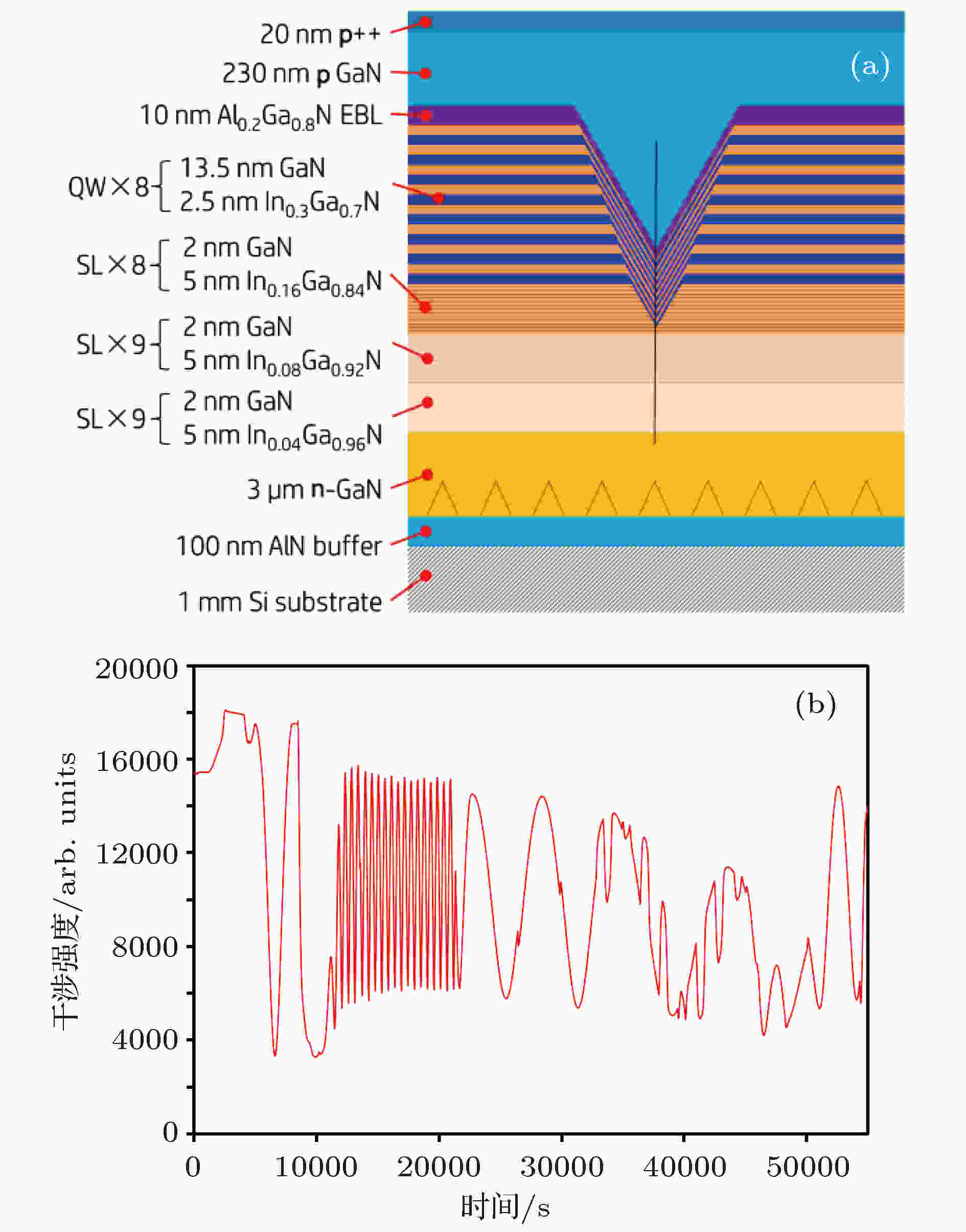 图 2 GaN/Si基黄光LED (a)外延材料结构示意图; (b)外延生长在线干涉曲线
图 2 GaN/Si基黄光LED (a)外延材料结构示意图; (b)外延生长在线干涉曲线Figure2. (a) Schematic structure and (b) in-situ interference curve of GaN based yellow LED on Si substrate
2
2.2.GaN/Si基材料一种选区生长方法
硅衬底GaN(GaN/Si)基LED材料及器件研发工作已历时46年. 1973年IBM申请了第一份GaN/Si发明专利[10], 之后众****一直在探索器件级材料的生长技术[11-18]. 但由于GaN/Si存在巨大的热膨胀系数失配(46%)和晶格常数失配(17%), 导致GaN/Si膜材料产生无规则裂纹和过高的位错密度, 无法用来制造实用化器件. 本团队提出并实现了GaN/Si材料的一种选区生长方法[19], 把硅衬底分成尺寸与芯片相同的一个个独立单元, 化整为零, 消除了GaN/Si材料整片应力集中效应, 使芯片工作区无裂纹, 如图3所示, 即在衬底上人为制造有规则的裂纹(即网格, 凸或凹)以替代不规则的裂纹, 解决了因材料龟裂而无法制造芯片问题, 获得了器件级GaN/Si材料, 其X射线衍射(XRD)半高宽(002)343弧秒和(102)520弧秒的结果[20], 被评价为当时最好结果[21]. 在此基础上, 2004年研制成功达到实用化水平的GaN/Si基蓝光LED[20]. 本方法在解决了外延膜龟裂的前提下, 不需要Al组分渐变、多层AlGaN应力调节层, 有利于提高量子阱波长均匀性; 同时, 保持了外延膜受张应力, 提高了量子阱材料的生长温度[22], 是生长高质量高铟组分黄光有源层的有效途径.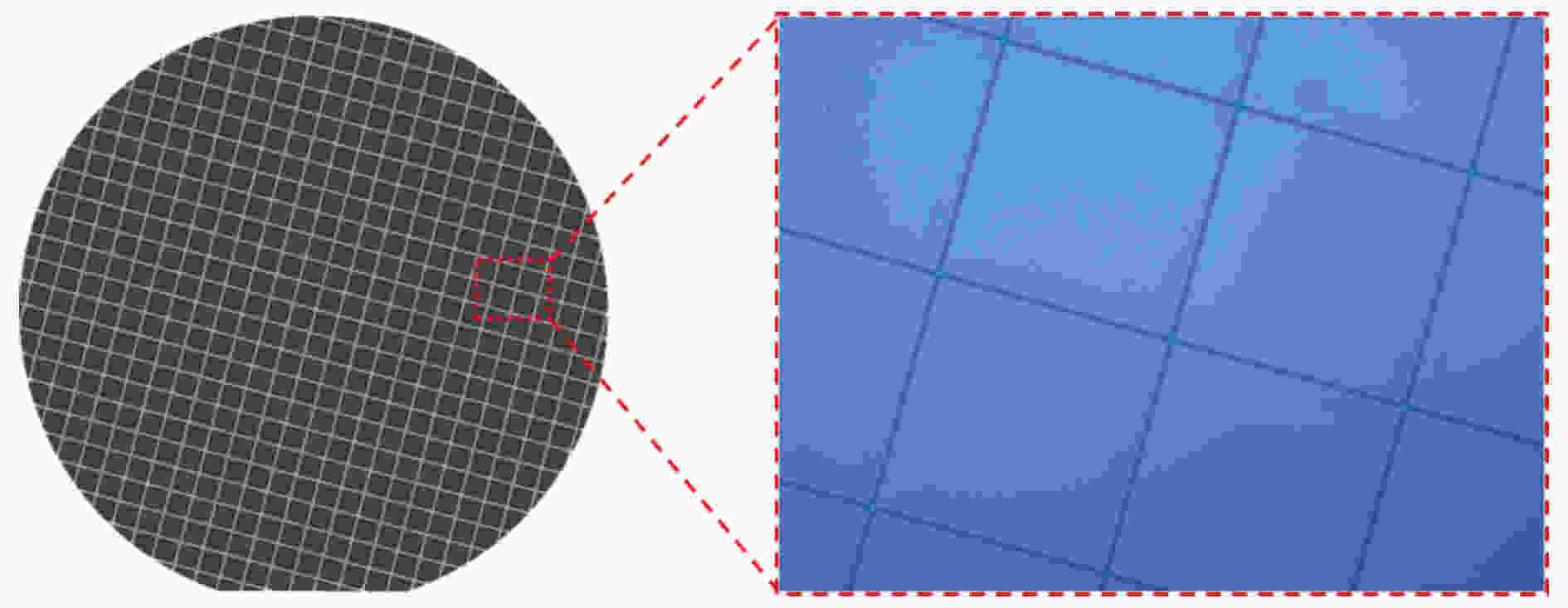 图 3 GaN/Si基LED外延材料网格化选区生长方法示意图
图 3 GaN/Si基LED外延材料网格化选区生长方法示意图Figure3. Schematic of grid patterned Si substrate with GaN film grown on it
2
2.3.综合过渡层
过高的位错密度是GaN/Si技术面临的另一大挑战. 为了调控薄膜材料中的应力和减少位错密度, 本团队发展了综合过渡层结构及其生长技术[23]. 首先在Si衬底上生长高温AlN缓冲层, 再在其上利用GaN与AlN晶格失配产生的压应力形成三维模式生长岛状GaN, 然后利用无掩膜在线侧向外延将GaN岛合并, 降低位错密度, 最后生长n-GaN主层. 综合过渡层结构使GaN/Si材料质量提升到新高度[24], 其XRD(002)和(102)半高宽分别减小到325和342弧秒, 位错密度降低至5 × 108/cm2.2
2.4.铟组分渐变超晶格应力准备层
In组分为30%的In0.3Ga0.7N黄光量子阱晶格常数约为0.3292 nm, 而n型GaN的晶格常数为0.3189 nm, 两者失配度达3.2%. 如果在n型GaN之上直接生长In0.3Ga0.7N, 黄光量子阱受到巨大的压应力, 会带来多方面负面影响: 首先, 压应力不利于量子阱中In的并入; 其次, 晶格常数变化过大会导致量子阱中直接产生新的位错; 第三, 过大压应力会导致InGaN相分离[22], 如图4(a)所示, 没有应力准备层、直接在GaN上生长InGaN黄光量子阱, 荧光显微镜下观测到大量暗区, 表明该量子阱材料相分离非常严重; 此外, 过大的压电场对提升器件光效不利. 基于上述因素, 本团队在黄光多量子阱与n型GaN之间, 设计了In组分适中的InGaN/GaN超晶格应力准备层, 将晶格从较小的GaN过渡到较大的高In组分黄光量子阱, 以缓解量子阱受到的压应力. 实验观测到, 使用32个周期的5 nm-In0.1Ga0.9N/2 nm-GaN超晶格作为黄光LED的应力准备层, 既能提高应力弛豫效果, 还能保持较高的材料质量, 如图4(b)所示, 插入应力准备层的黄光量子阱均匀性明显改善, 荧光显微形貌中暗区基本消失, 但仍可观察到黄、绿光两种相.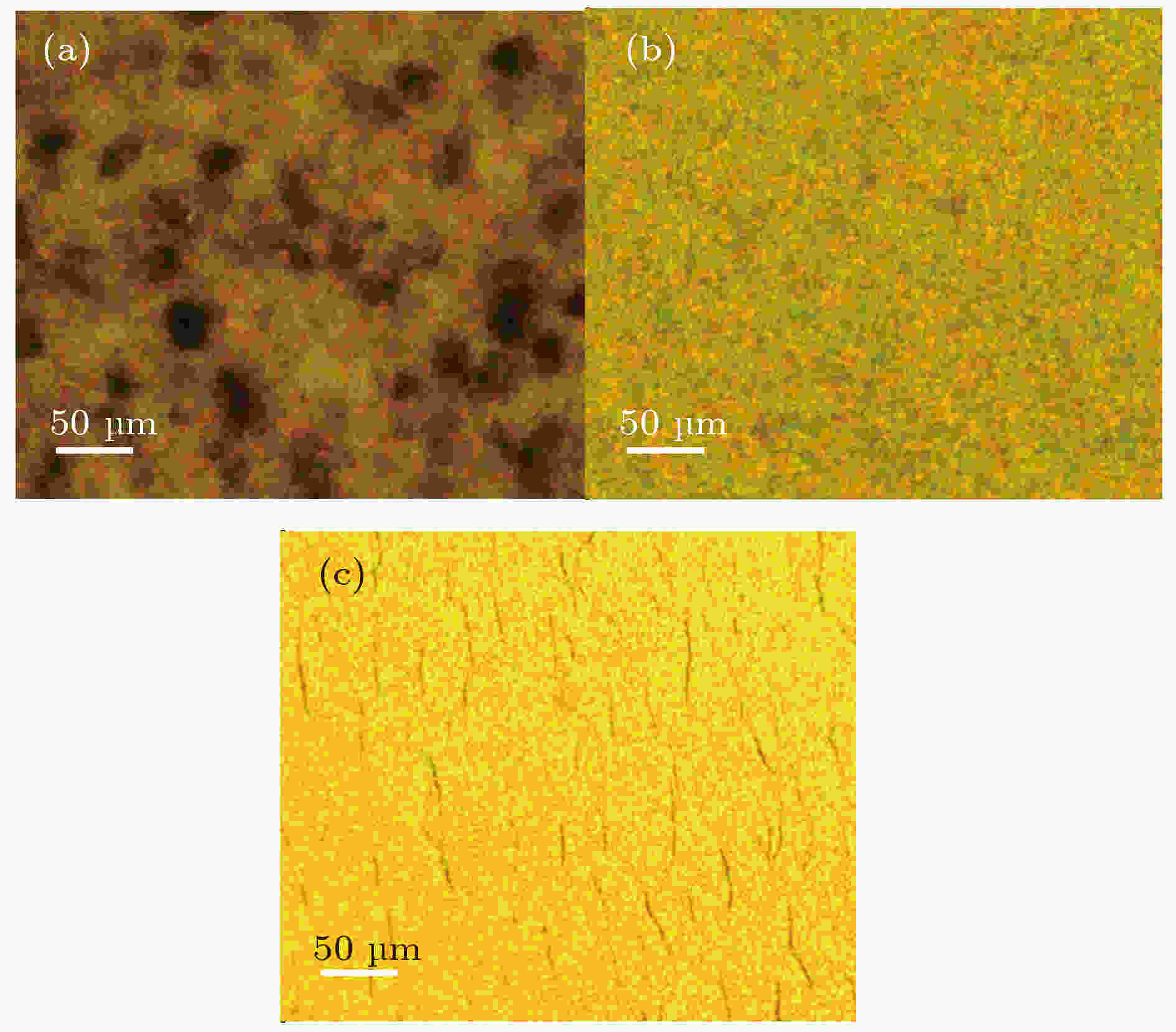 图 4 不同准备层的黄光LED量子阱荧光显微镜形貌 (a)无准备层; (b)单一In组分超晶格准备层; (c)三段In组分逐步提升的超晶格准备层
图 4 不同准备层的黄光LED量子阱荧光显微镜形貌 (a)无准备层; (b)单一In组分超晶格准备层; (c)三段In组分逐步提升的超晶格准备层Figure4. Fluorescent luminescence (FL) spectrometry of yellow LED quantum well: (a) Without prestrained layer; (b) with fixed indium content prestrained SLS layers; (c) with three steps of increased indium content prestrained SLS layers
为了进一步释放量子阱所受压应力、改善材料质量, 本文设计了三段渐变式准备层, 将原来单一组分的In0.1Ga0.9N/GaN超晶格准备层, 在保持总厚度不变的情况下, 变为组分逐步提升的三段In0.04Ga0.96N/GaN, In0.08Ga0.92N/GaN, In0.16Ga0.84N/ GaN超晶格准备层. 如图4(c)所示, 采用渐变式超晶格准备层结构的黄光量子阱, 荧光显微形貌中暗区消失, 仅观察到单一黄光相, 从而有效解决了InGaN黄光量子阱相分离问题.
2
2.5.V形三维PN结
第二代半导体磷化物与砷化物发光材料对晶体质量要求非常高, 否则器件光效低; 而第三代半导体氮化物在位错密度高达1 × 109/cm2时, 蓝光LED的光效仍能超过60%, 其中的机理一直未有定论, 直到V坑的概念被提出[25]. V坑是GaN外延材料中沿着位错线形成的一种六棱锥状体缺陷, 因其截面形状像“V”字而得名, 也被称作V型缺陷或V-pits. 图5(a)为本文黄光LED量子阱中的V坑截面透射电镜 (TEM)图. 传统器件物理认为, 位错对器件性能是负面的; 在GaN基LED的发展初期, V坑也是被敬而远之; 但是随着认识的深入, 发现V坑侧壁量子阱较平台量子阱厚度薄、In组分低, V坑量子阱禁带宽度大于平台量子阱, 即载流子在位错附近的势垒较高, 从而有效屏蔽位错[26], 使得氮化物在高位错密度下仍能保持较高的光效.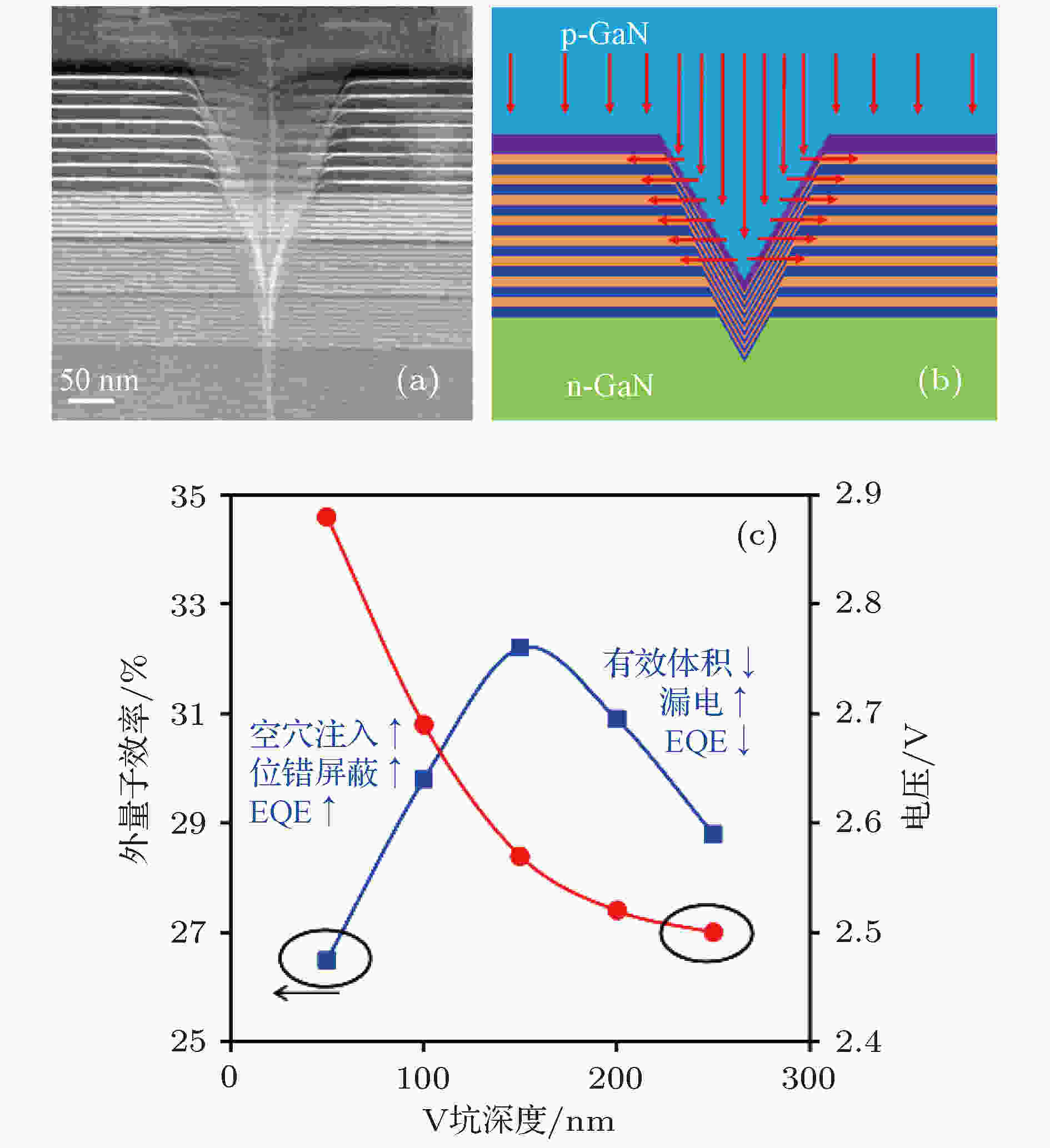 图 5 (a)含有V坑的黄光LED多量子阱结构透射电镜图; (b) V坑增强空穴注入示意图; (c)室温20 A/cm2下黄光LED外量子效率以及电压随V坑深度变化曲线
图 5 (a)含有V坑的黄光LED多量子阱结构透射电镜图; (b) V坑增强空穴注入示意图; (c)室温20 A/cm2下黄光LED外量子效率以及电压随V坑深度变化曲线Figure5. (a) TEM image of yellow MQWs structure with V-pits; (b) schematic of hole injection enhancement by V-pits; (c) dependence of external quantum efficiency and voltage on V-pits size of yellow LED with 20 A/cm2 at room temperature
本团队观察到含有V型坑的LED结构在低温下V型坑侧壁量子阱的电致发光现象, 表明存在载流子从V坑侧壁注入[27]; 通过数值计算发现[28—30], 空穴注入到平台量子阱时, 从V型坑侧壁方向的势垒小于从垂直样品表面方向, 即空穴优先从V型坑侧壁注入到平台量子阱, 也就是说, V型三维PN结增强了空穴注入效果[31], 如图5(b)所示. 从图5(a)样品的TEM谱可知, 多量子阱之后的电子阻挡层P-AlGaN, 其厚度在平台有10 nm、在V型坑侧壁不到2 nm, 这种差异进一步增强空穴优先从V型坑侧壁注入到平台量子阱.
本文实验研究了V坑尺寸对黄光LED性能的影响, 如图5(c)所示, 随着V坑尺寸的加大, 外量子效率先增大后减小, 其光效最佳处对应的V坑深度约为150 nm(样品位错密度为5 × 108/cm2). 具有增强空穴注入功能的V型坑的尺寸和平台发光量子阱有效体积成反比, V坑尺寸越大、平台量子阱区域有效发光体积越小, 反之亦然. 因此, V坑尺寸有一最佳值. 工作电压随着V型坑深度的加大而一直下降, 源自V型坑对空穴注入的增强.
2
2.6.黄光LED专用材料生长设备
1976年, Dupuis开创性地引入MOCVD技术生长高质量半导体薄膜材料和器件. 此后, MOCVD方法很快成为研究和生产半导体薄膜材料及光电子器件非常有效的技术手段. 生长高质量InGaN黄光材料是一项富有挑战性课题. 蓝光、绿光和黄光的InGaN量子阱中铟组分分别约为15%, 25%和30%, 波长越长发光阱所受到的压应力越大, 越容易引起相分离, 电子空穴分离也越严重, 对载流子复合发光越不利. 目前国内外市场上其他单位的MOCVD设备能有效生长蓝绿光InGaN材料, 但生长高质量高铟组分InGaN黄光材料未见取得重要突破.2015年, 作者使用在2004年为生长氧化锌自行发明的气体输运同轴套管结构喷头专利[32], 如图6所示, 研制成功高铟组分InGaN黄光专用MOCVD设备(研究型和生产型两种). 本设备设计MO源从内径很小的同轴套管内管输运, 大幅提高了MO源的流速, 显著减少了记忆效应, 获得了陡峭的高铟组分量子阱界面, 并提升了黄光量子阱铟镓氮材料生长温度. 图7为基于本设备生长的GaN/Si基黄光LED材料SIMS结果, 清晰地表明了各层界面陡峭. 本设备已在企业成功应用于批量生产高光效黄光LED外延材料.
 图 6 发明的专用MOCVD设备反应管气体输运结构-同轴套管喷头示意图
图 6 发明的专用MOCVD设备反应管气体输运结构-同轴套管喷头示意图Figure6. The showerhead structure of self-designed MOCVD for yellow LED
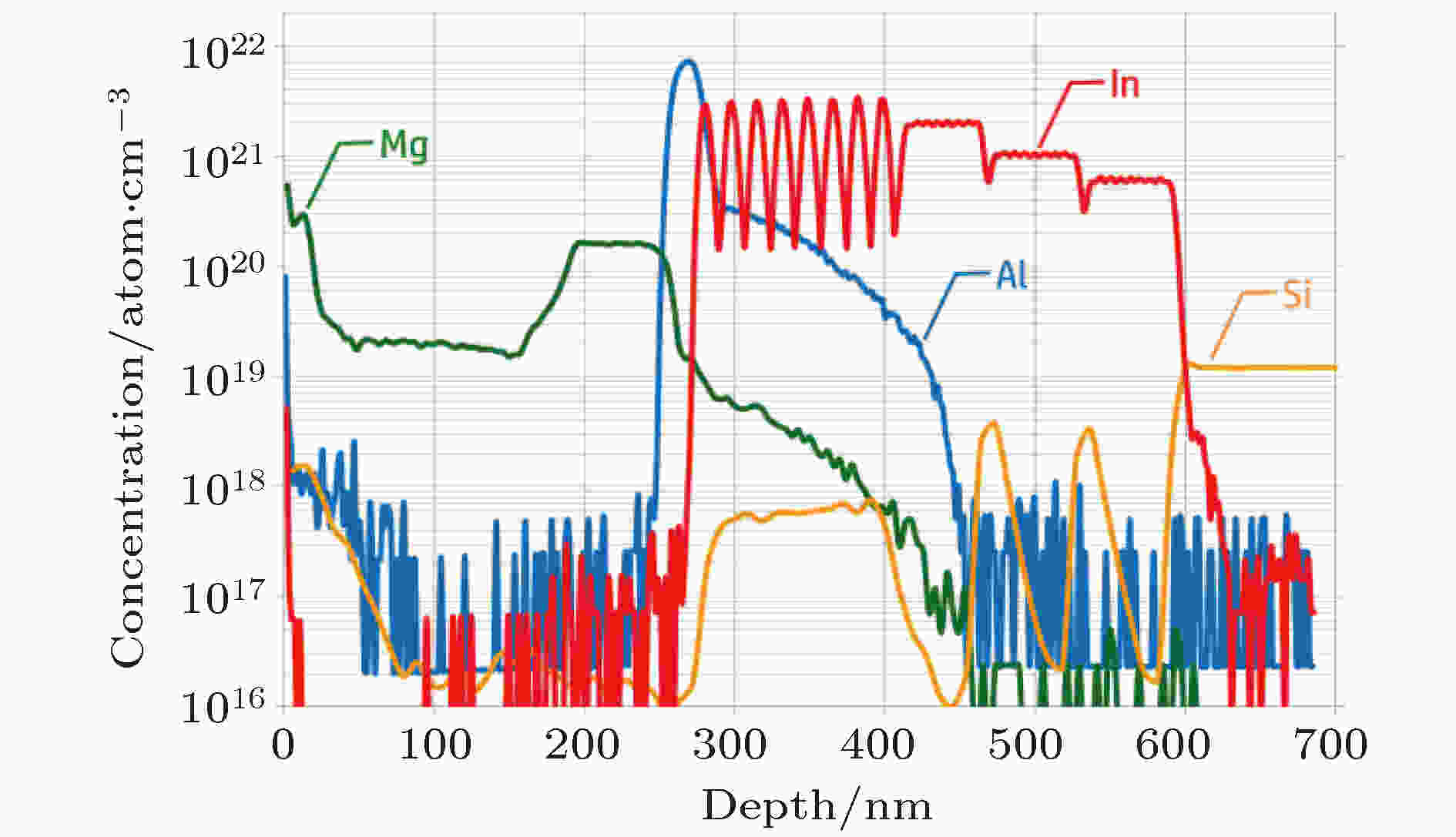 图 7 自制MOCVD设备生长的黄光LED材料的SIMS曲线
图 7 自制MOCVD设备生长的黄光LED材料的SIMS曲线Figure7. SIMS profile of yellow LED structure grown by self-designed MOCVD
2
2.7.黄光LED芯片结构
GaN/Si基黄光LED芯片结构如图8所示. 硅对可见光吸收强, 外延材料必须从原有硅衬底上剥离并转移到新的高反射基板上, 才能获得高出光效率, 该过程也称薄膜转移. 在薄膜转移发光芯片制造过程中, 本团队发明和发展了互补电极、高反射低电阻p电极、表面粗化, 双面钝化等芯片结构和工艺技术, 获得了高取光效率、良好的电流扩展和导热能力、高可靠性的垂直结构LED芯片[33,34].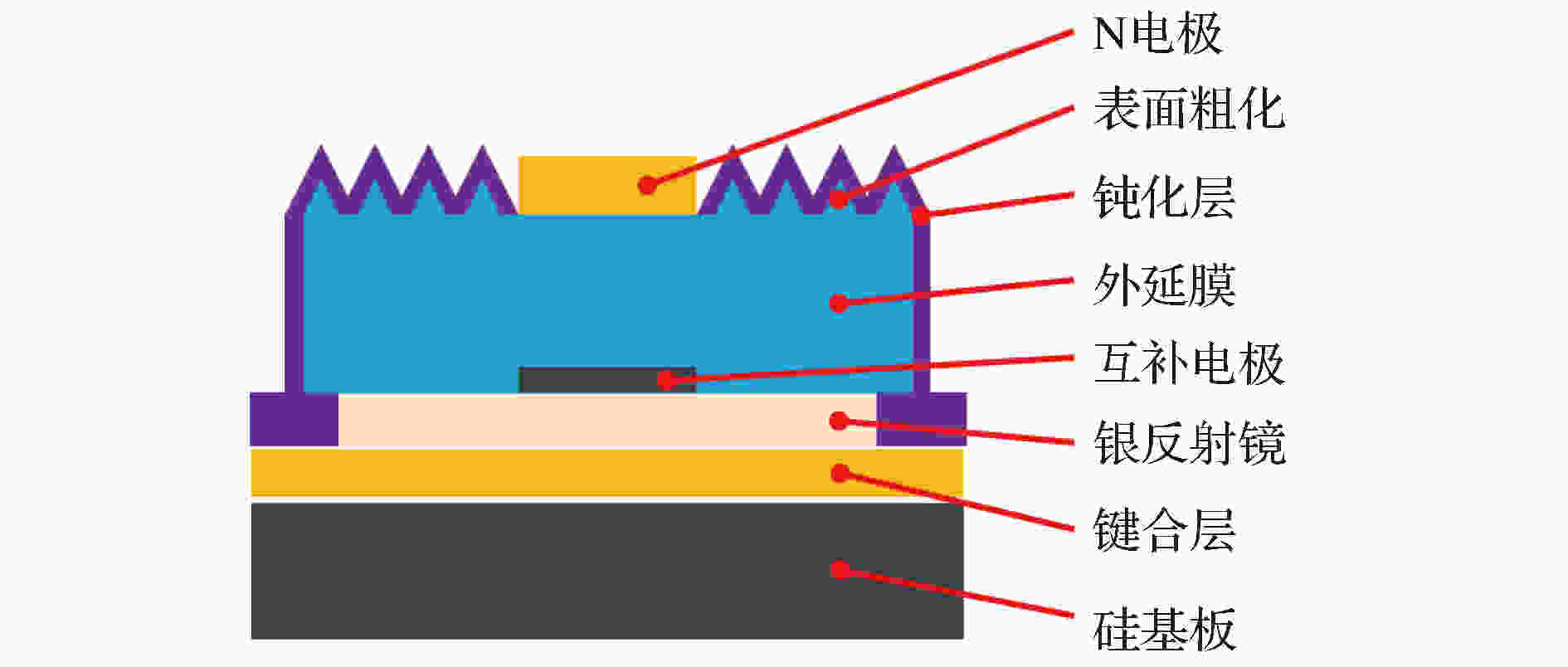 图 8 黄光LED芯片结构示意图
图 8 黄光LED芯片结构示意图Figure8. Schematic chip structure of the yellow LED
2
2.8.黄光LED器件结果
表1是研制的黄光LED器件在570 nm附近三组不同波长的光电性能结果, 电源为Keithley Instruments 2635A, 光谱仪为Instrument Systems CAS140CT, 测量方式为稳态电流.| 样品 | 电流密度/A·cm–2 | 电流/mA | 电压/V | 主波长/nm | 半宽/nm | 光功率/mW | 外量子效率/% | 光功率效率/% | 流明效率/lm·W–1 |
| A | 1 | 10 | 2.10 | 571 | 36.2 | 10.1 | 46.3 | 47.9 | 283 |
| 20 | 200 | 2.43 | 560 | 36.8 | 143.3 | 32.3 | 29.5 | 182 | |
| B | 1 | 10 | 2.09 | 577 | 37.8 | 8.9 | 41.6 | 42.8 | 248 |
| 20 | 200 | 2.41 | 565 | 38.6 | 128.7 | 29.4 | 26.7 | 164 | |
| C | 1 | 10 | 2.08 | 582 | 39.9 | 8.1 | 37.8 | 38.8 | 200 |
| 20 | 200 | 2.40 | 570 | 40.3 | 113.3 | 26.0 | 23.6 | 139 |
表1黄光LED器件(芯片1 mm2)室温稳流状态电致发光结果
Table1.Electroluminescence results of yellow LEDs (size 1 mm2) at room temperature and continues wave mode
20 A/cm2电流密度下, 波长560, 565, 570 nm的黄光LED光效分别为29.5%, 26.7%, 23.6%, 较之前国外文献报道的最好水平9.5 A/cm2下559 nm光效9.6%有了大幅提升, 对应的流明效率分别为182, 164, 139 lm/W, 达到照明实用水平. 低电流密度下(1 A/cm2), 波长571, 577, 582 nm的黄光LED光效分别高达47.9%, 42.8%, 38.8%, 对应的流明效率分别为283, 248, 200 lm/W, 为今后研制黄光波段micro-LED打下了重要技术基础. 图9(a)给出了样品B在不同电流密度下室温电致发光光谱, 其波长和半宽度随电流发生改变; 样品B在–5 V偏压下, 反向漏电流为1 nA.
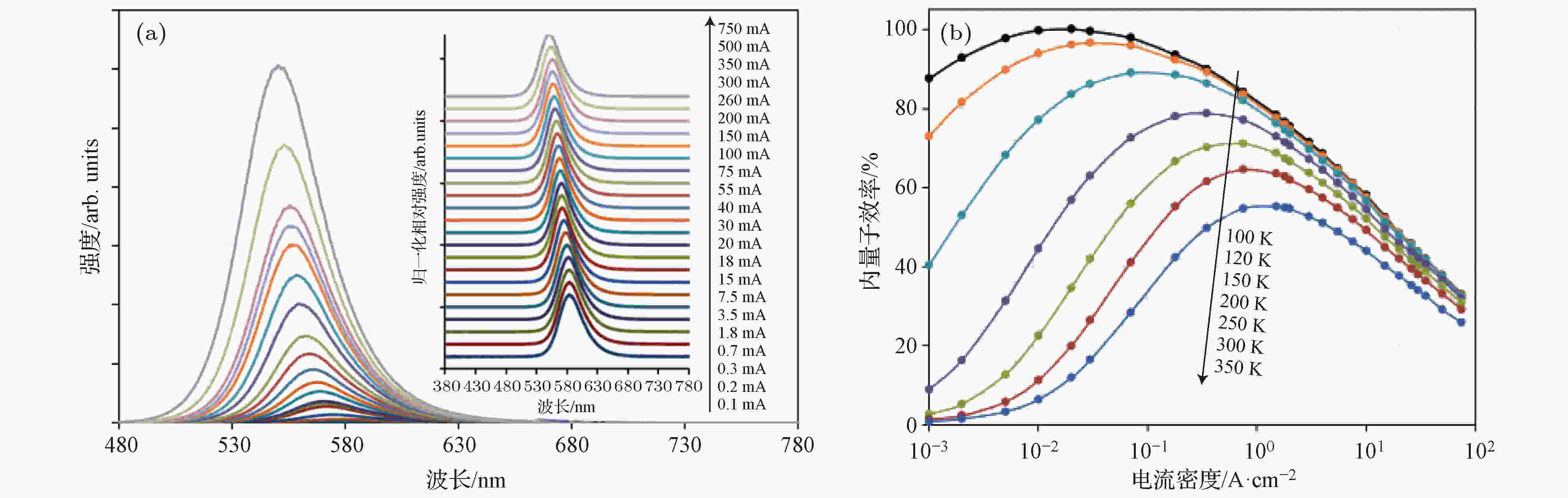 图 9 黄光LED样品B (a)室温不同电流下发光光谱; (b)变温变电流内量子效率曲线
图 9 黄光LED样品B (a)室温不同电流下发光光谱; (b)变温变电流内量子效率曲线Figure9. Electroluminescence of 565 nm yellow LED: (a) The room temperature emission spectrum at different current; (b) the internal quantum efficiency at various temperature and current density
样品B在不同温度、不同电流密度下的内量子效率, 如图9(b)所示, 其中采用了蓝光LED器件内量子效率测试常用的假设, 即低温100 K小电流密度下LED的峰值效率为100%. 在相同温度下, 内量子效率均随着电流密度的增大先升后降, 这与经典的LED内量子效率模型吻合. 内量子效率随着温度升高整体下降, 可归结于缺陷随着温度升高被逐渐激活. 室温300 K时, 样品B的内量子效率峰值为64.6%, 说明其量子阱质量较高; 20 A/cm2电流密度下, 内量子效率下降至42.1%. 相对蓝光、绿光LED而言, 黄光LED光效随电流密度droop更为严重, 20 A/cm2电流密度下IQE仅为其峰值的65%, 而蓝光、绿光LED对应的比值约为90%,80%. 黄光LED效率droop更严重主要归结于高In组分带来更强的压电场. 根据样品B在20 A/cm2电流密度下, 光功率效率26.7%、外量子效率29.4%和内量子效率42.1%, 获得了比较合理的芯片取光效率(70%), 表明上述内量子效率测试采用的假设相对有效.
2
2.9.高光效黄光LED的应用
近几年来, LED照明光健康问题被提上了议事日程, 其中蓝光危害问题在全球范围内引起了广泛关注. 高光效黄光LED的出现, 为实现无蓝光或少蓝光的LED照明提供了技术支撑, 给LED照明带来了新活力.基于本团队研发的高光效硅衬底蓝光(455 nm)、青光(490 nm)、绿光(530 nm)、黄光(570 nm)LED、和反极性红光(629 nm)LED, 我们研制出五基色白光LED, 实现了少蓝光、高显指(97.5, R9 = 96.24)、低色温(2941 K)、较高流明效率(121.3 lm/W)、无荧光粉、纯LED照明, 达到了实用水平, 图10(a)为其光谱图. 同时, 本团队利用高光效黄光LED与红光LED配色, 研制了超低色温(1761 K)、无蓝光成分的金黄光LED光源, 其光效达141.9 lm/W, 光谱如图10(b)所示; 开发了金黄光LED室内氛围台灯和室外路灯并获得应用, 如图11所示.
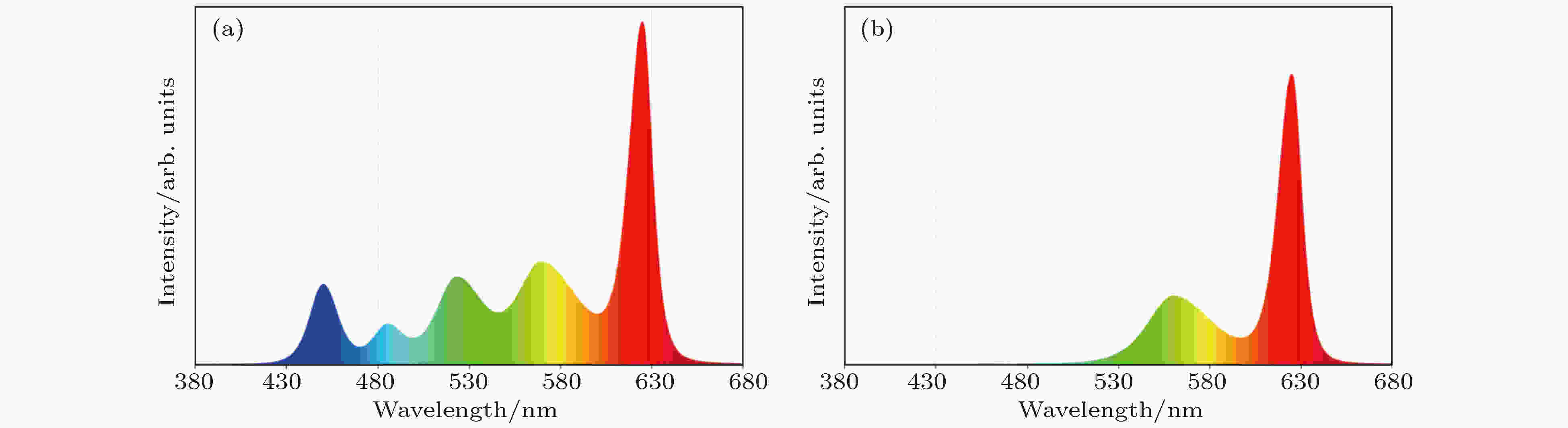 图 10 无荧光粉LED照明光源电致发光光谱图 (a)蓝、青、绿、黄、红五基色白光LED; (b)黄、红光组成的金黄光LED
图 10 无荧光粉LED照明光源电致发光光谱图 (a)蓝、青、绿、黄、红五基色白光LED; (b)黄、红光组成的金黄光LEDFigure10. EL spectra of phosphor free LEDs: (a) Color mixing white LED with blue, cyan, green, yellow and red LEDs; (b) golden light LEDs with yellow and red LEDs
 图 11 金黄光LED照明应用 (a)户外路灯(南昌市艾溪湖公园); (b)室内氛围台灯
图 11 金黄光LED照明应用 (a)户外路灯(南昌市艾溪湖公园); (b)室内氛围台灯Figure11. Applications of golden light LEDs as (a) Outdoor street lights and (b) indoor atmosphere lamps
经光生物医学研究观测[35], 金黄光LED室内照明, 未见抑制褪黑素分泌现象, 还有降低干眼症和红眼症的发生概率、加快受损皮肤愈合、促进毛发再生等功效. 金黄光LED室外路灯, 兼有传统高压钠灯色温低、穿透能力强和荧光型LED路灯光效高、寿命长的优点.
