 , 马文超1,2, 邱迎昕1,2
, 马文超1,2, 邱迎昕1,2 1. 中国石油化工股份有限公司 北京化工研究院燕山分院, 北京 102500;
2. 橡塑新型材料合成国家工程研究中心, 北京 102500
2019-10-25 收稿, 2019-12-09 录用
基金项目: 中石化总部项目(G3365-2019-Z1912)资助
*通讯作者: 魏孜博
摘要: 本文综述了用于193 nm深紫外光刻胶的主体成膜树脂的种类及常用合成单体的研究进展,包括聚(甲基)丙烯酸酯体系、环烯烃-马来酸酐共聚物(COMA)体系、乙烯醚-马来酸酐共聚物(VEMA)体系、降冰片烯加成聚合物体系、环化聚合物体系、有机-无机杂化树脂体系以及光致产酸剂(PAG)接枝聚合物主链型等,并分析了目前关于曝光、分辨率和抗蚀刻性能方面存在的问题及未来的发展方向。
关键词: 光刻胶成膜树脂曝光分辨率抗蚀刻性能
Development of Matrix Resins for 193 nm Deep UV Photoresist
WEI Zibo1,2
 , MA Wenchao1,2, QIU Yingxin1,2
, MA Wenchao1,2, QIU Yingxin1,2 1. Yanshan Branch, Sinopec BRICI, Beijing 102500, P. R. China;
2. Rubber and Plastic Synthesis National Engineering Research Center, Beijing 102500, P. R. China
Abstract: The research progress of the main matrix resins and common synthetic monomers for 193 nm deep UV photoresist was reviewed. The film-forming resin includes poly(methyl)acrylate, cycloolefin-maleic anhydride (COMA), ethylene ether-maleic anhydride (VEMA), norborneene addendum polymer, cyclized polymer, organic-inorganic hybrid resin, and PAG graft on polymer backbone. The existing problems about exposure, resolution and etch resistance and the future development direction were also discussed.
Key words: photoresistmatrix resinexposureresolutionetch resistance
光刻胶是在微电子制造业中实现精细线路和图形加工的核心材料。光刻技术利用光刻胶在辐射前后溶解度的差异转移图案,不同光刻胶与曝光光源的组合会得到不同精细度的线路图形。光刻胶伴随着微电子技术的发展而不断更新换代。根据摩尔定律[1],集成电路的集成度每18个月翻一倍。这使得集成电路的加工线宽不断缩小,对光刻胶分辨率的要求不断增高。根据Relay公式[2],光刻胶的分辨率与曝光波长成反比,所以降低曝光波长成为提高分辨率的主要途径。因此,随着集成电路的发展,光刻工艺经历了从g线(436 nm)到i线(365 nm),进一步到深紫外的氟化氪(KrF)(248 nm)、氟化氩(ArF)(193 nm)的发展历程[3-5]。
1 193 nm光刻胶成膜树脂以KrF为激光源的248 nm光刻工艺加工精度已达到0.15 μm,对于小于0.15 μm的精细加工则需要波长更小的ArF光源进行光刻。由于聚对羟基苯乙烯体系含有苯环,在193 nm曝光光源下具有较高的吸收性而无法使用[6],因此要寻找在193 nm波长条件下更透明的材料。因为分辨率越高,对膜的极限厚度要求越薄,因此要求193 nm光刻胶比248 nm光刻胶具有更好的抗蚀性[7]。聚(甲基)丙烯酸酯在193 nm高度透明因而成为首选材料,但由于其线型结构、抗干法腐蚀性差,无法实用化。后来人们发现含有多脂环的聚合物可以像芳香族聚合物一样耐等离子蚀刻[3]。之后,带有酸敏脂环侧链基团的聚(甲基)丙烯酸酯成了193 nm光刻胶的设计基础[6]。
目前,已经开发的193 nm光刻胶成膜树脂主要包括:聚(甲基)丙烯酸甲酯体系;环烯烃-马来酸酐共聚物(COMA)体系;乙烯醚-马来酸酐共聚物体系;降冰片烯加成聚合物体系;环化聚合物体系;有机-无机杂化树脂类等。
1.1 聚(甲基)丙烯酸酯体系聚(甲基)丙烯酸酯在193 nm处具有良好的光学透明性,最早成为193 nm光刻胶。1997年,首款聚(甲基)丙烯酸酯光刻胶由IBM/MIT林肯实验室开发出来,分辨率达到0.22 μm[8]。紧接着,日本的半导体公司Toshiba、Fujitsu、NEC等都推出了这类胶[9]。但是此类树脂由于具有线型结构以及较高的氧含量,因而抗蚀刻性能较差[10]。研究表明,树脂中有效碳含量增加有助于改善材料的抗蚀刻性能[11],后来有研究者在其侧链上引入了脂环类碳氢化合物,常见结构如图 1所示[12]。如:四环十二碳烯由于具有较高的含碳量,因此抗蚀刻性比较好,经过改性之后用于193 nm光刻胶可以得到0.11 μm的分辨率图形[13], 其结构如图 2所示。此外,国内昆山西迪公司合成了含倍半萜的成膜树脂并应用于193 nm光刻胶[14]。尽管树脂改性之后提高了抗蚀刻性能,但是由于在侧链上引入了很高比例的脂环,导致聚合物的疏水性太大,导致与基片的粘附性差;另一缺点是蚀刻后图形表面粗糙度大。
图 1
 | 图 1 应用于193 nm光刻胶成膜树脂的典型(甲基)丙烯酸类树脂结构[12] |
图 2
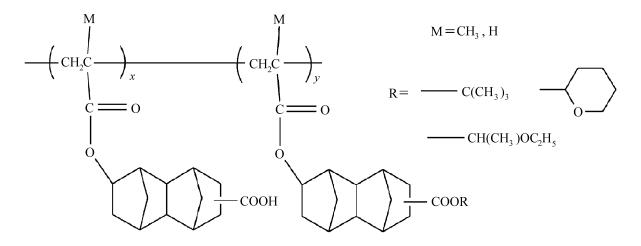 | 图 2 四环十二烯碳基聚(甲基)丙烯酸酯共聚物结构示意图[13] |
传统的化学增幅型光刻胶是由产酸剂和树脂按照一定比例进行复配,容易导致小分子产酸剂与树脂不相溶,产生相分离,后烘过程中产酸剂产生的H+向未曝光区域发生迁移,宏观上造成光刻胶分辨率下降[15, 16]。近年来发展的PAG接枝聚合物是解决这一问题的一种办法。顾名思义,就是把产酸剂引入可自由基聚合的双键,与其它功能性的单体进行共聚,从而将产酸剂接枝到聚合物主链上。这种方法可以有效减轻相分离,防止产酸剂产生的H+向未曝光区域扩散,提高了光刻胶的感光率和分辨度[17]。
1.2 环烯烃-马来酸酐共聚物(COMA)体系环烯烃-马来酸酐共聚物可用自由基聚合得到,工艺简单,是有望替代聚(甲基)丙烯酸酯体系的一类化合物,由贝尔实验室(Alcatel-Lucent Bell Labs)研发[9],典型结构如图 3所示。这类化合物在聚合物主链上引入脂环,可大幅提高抗蚀性。同时,这类聚合物与工业使用的标准0.26 mol/L四甲基氢氧化铵(TMAH)也相匹配。
图 3
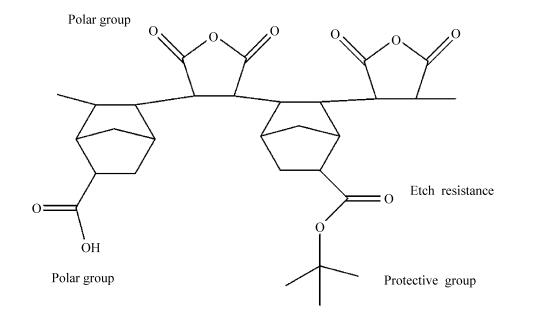 | 图 3 环烯烃-马来酸酐交替共聚物体系 |
另外,这类聚合物还可以与丙烯酸酯类单体共聚,形成多种杂化体系,可以灵活调节Tg和其它性能。但是这个体系也存在两大缺点:一是酸酐结构容易水解,对贮存条件要求较高;二是透明度不太理想。
1.3 乙烯醚-马来酸酐共聚物(VEMA)体系VEMA体系是由Samsung公司在2001年报道的,通过自由基聚合而制得[18](图 4)。与COMA的硬骨架不同,VEMA骨架柔软,增大了材料的透明度和与硅片的粘附性。由于其化学成像和抗蚀刻功能均由丙烯酸酯部分承担,为了提高其抗蚀性,后引入环形乙烯醚[18],分辨率达0.12 μm。2006年,国内苏州瑞红将此体系与其它单体共聚,用于193 nm光刻胶成膜树脂,取得了较好的效果[19]。
图 4
 | 图 4 VEMA结构示意图 |
1.4 降冰片烯加成聚合物体系由于降冰片烯具有优异的透光性能,逐步应用于193 nm光刻胶领域。降冰片烯可以单聚,也可以与其它含有双键的单体(如马来酸酐)共聚。Texas大学的研究者开发了主链为纯脂环的降冰片烯衍生物[9]。此体系中各个单体活性比较接近,聚合物各部分的组成可以通过调节单体投料比来设定。这种体系的好处就是光刻胶的性质(如显影性、粘附性、溶解反差等)都可以通过选择不同的降冰片烯单体进行控制。常用的单体如图 5所示[20]。
图 5
 | 图 5 常用的用于制备193 nm光刻胶的单体 |
降冰片烯类衍生物主要可以发生三类聚合反应[21](图 6):(1)金属催化阳离子加成聚合;(2)开环异位聚合;(3)自由基聚合。图 7所示聚合物保留主链脂环结构,必须进行阳离子聚合,存在金属杂质去除问题,工艺较为复杂。
图 6
 | 图 6 降冰片烯衍生物聚合反应路线[21] |
图 7
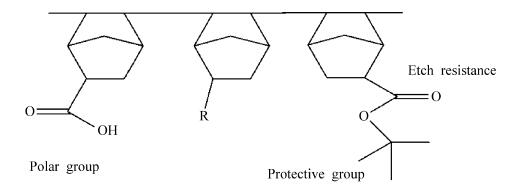 | 图 7 降冰片烯加成聚合物体系 |
1.5 环化聚合物体系环化聚合物体系是由双烯单体通过自由基聚合而制备,具有较高的透明性(图 8)。但是体系缺少极性基团,从而使得其粘附性较差,需要对侧链进行改性[22]。此类聚合物目前报道较少。
图 8
 | 图 8 环化聚合物体系 |
1.6 有机-无机杂化树脂体系具有高折射率的树脂能够提高曝光宽容度,同时若将水等高折射率流体替代空气作为透镜元件与光刻胶之间的介质,可以增大曝光机镜头的数值孔径(NA)和焦深比[23, 24]。因此,提高193 nm光刻胶的分辨率需要共同提高光刻胶和介质的折射率。在提高介质折射率方面,有研究者开发了浸没式光刻技术。纯水具有高折射率、高透明性、环保和低成本的特点,是首选的浸没介质,也是第一代浸没流体,NA达到1.35;第二代浸没流体包括水溶性有机分子、无机盐和酸、重金属盐、表面活性剂的水溶液,NA达到了1.55;硼酸盐、有机硅烷等无机纳米粒子与烷烃化合物的复合流体作为第三代高折射率浸没流体,NA达到了1.8以上[25]。目前受制于成本和工艺限制,193 nm浸没式光刻使用的介质主要是纯水。对于光刻胶本身,在聚合物主链中引入杂原子可以提高树脂的极性和折射率,目前最常用的是引入磺酸、硫醚、砜、二硫酯或者三硫酯等含S原子的基团[26, 27]。现已开发的含S原子的193 nm光刻胶树脂如图 9所示。
图 9
 | 图 9 常见含有硫原子193 nm光刻胶成膜树脂结构 |
此外,在树脂中引入F原子可以使树脂在193 nm处的吸收发生蓝移,从而提高树脂的透明性。在聚合物中引入Si原子不仅能够提高折射率还能够提高抗蚀刻性能[26],有报道将硅烷偶联剂引入聚合物体系,用于193 nm光刻胶[28]。详见图 10。
图 10
 | 图 10 含有F原子和Si原子的树脂结构 |
2 结论与展望目前国内对193 nm光刻胶的研究取得了一些进展,但距离实现产业化还有较长的路要走。193 nm光刻胶已经列入《中国制造2025》重点领域技术路线图中,这对于促进光刻胶的国产化、提升我国集成电路产业的自主配套能力具有重要意义。加快开发适合的体系和成熟的合成技术路线,改进纯化技术和检测技术,提升产品质量控制,突破国外专利和技术封锁,都是未来需要努力的方向。
参考文献
| [1] | Reichmanis A, Thompson L F. Polymer materials for microlithography[J]. Annual Review of Materials Research, 1987, 17(1): 235-271. DOI:10.1146/annurev.ms.17.080187.001315 |
| [2] | Okoroanyanwu U, Byers J, Shimokawa T, et al. Alicyclic polymers for 193 nm resist applications:lithographic evaluation[J]. Chemistry of Materials, 1998, 10(11): 3319-3327. DOI:10.1021/cm9705045 |
| [3] | Ito H. Chemically amplified resists:past, present, and future[J]. Procedings of SPIE, 1999, 3678: 2-12. DOI:10.1117/12.350143 |
| [4] | Sahoo P B, Vyas R, Wadhwa M, et al. Progress in deep-UV photoresists[J]. Bulletin of Materials Science, 2002, 25(6): 553-556. DOI:10.1007/BF02710549 |
| [5] | 郑金红, 黄志齐, 侯洪森. 248 nm深紫外光刻胶[J]. 影像科学与光化学, 2003, 21(5): 346-356. Zheng J H, Huang Z Q, Hou H S. Evolution and progress of deep UV 248 nm photoresists[J]. Imaging Science and Photochemistry, 2003, 21(5): 346-356. DOI:10.3969/j.issn.1674-0475.2003.05.005 |
| [6] | 郑金红, 黄志齐, 文武. ULSI用193 nm光刻胶的研究进展[J]. 精细化工, 2005, 22(5): 348-353. Zheng J H, Huang Z Q, Wen W. Progress of 193 nm photoresist for ULSI supporting materials[J]. Fine Chemicals, 2005, 22(5): 348-353. DOI:10.3321/j.issn:1003-5214.2005.05.010 |
| [7] | Kajita T, Nishimura Y, Yamamoto M, et al. 193 nm single layer resist materials:total consideration on design, physical properties, and lithographic performances on all major alicyclic platform chemistries[J]. Proceedings of SPIE-The International Society for Optical Engineering, 2001, 4345: 712-724. |
| [8] | Allen R D, Wallraff G M, Hofer D C, et al. Photoresists for 193-nm lithography[J]. IBM Journal of Research & Development, 1997, 41(41): 95-104. |
| [9] | Allen R. Progress in 193 nm photoresists for sub-0.20μm devices, 193 nm photoresists may prove to be the best solution[J]. Semiconductor International, 1997, 20(10): 70-81. |
| [10] | Reichmanis E, Omkaram N, Frank M H. Organic materials challenges for 193 nm imaging[J]. Accounts of Chemical Research, 1999, 32(8): 659-667. DOI:10.1021/ar970150n |
| [11] | Ohnishi Y, Itoh M, Mizuno K, et al. Postirradiation polymerization of e-beam negative resists:theoretical analysis and method of inhibition[J]. Journal of Vacuum Science & Technology, 1981, 19(4): 1141-1144. |
| [12] | Ito H. Chemical amplification resists for microlithography[J]. Advances in Polymer Science, 2005, 37-245. |
| [13] | Hasegawa E, Maeda K, Iwasa S. Molecular design and development of photoresists for ArF excimer laser lithography[J]. Polymers for Advanced Technologies, 2015, 11(8-12): 560-569. |
| [14] | 冉瑞成, 沈吉, 孙友松, 等.含倍半萜的成膜树脂及其正性干法曝光193 nm光刻胶[P].中国专利, CN104448114A. 2015-3-25. Ran R C, Shen J, Sun Y S, et al. Sesquiterpene containing film forming resin and its positive dry exposure to 193 nm photoresist[P]. Chinese Patent, CN104448114A. 2015-3-25. |
| [15] | Wang M, Tang M, Her T H, et al. Synthesis, characterization and lithography performance of novel anionic photoacid generator (PAG) bound polymers[J]. Journal of Photopolymer Science and Technology, 2007, 20(6): 793-797. DOI:10.2494/photopolymer.20.793 |
| [16] | Yamamoto H, Kozawa T, Tagawa S. Dissolution kinetics in polymer-bound and polymer-blended photo-acid generators[J]. Journal of Photopolymer Science and Technology, 2012, 25(5): 693-698. DOI:10.2494/photopolymer.25.693 |
| [17] | Jarnagin N D, Wang M, Rabinobich M, et al. PAG incorporated polymeric resists for sub-100 nm patterning at 193 nm exposure[J]. Journal of Photopolymer Science and Techno-logy, 2006, 19(6): 719-725. DOI:10.2494/photopolymer.19.719 |
| [18] | Kim H W, Jung D W, Lee S, et al. Design and performance of new photoresist materials for ArF lithography[J]. Journal of Applied Polymer Science, 2004, 92(1): 165-170. DOI:10.1002/app.13701 |
| [19] | 常磊. 193 nm远紫外光刻胶及其制备方法[P].中国专利, CN1869814A. 2006-11-29. Chang L. 193nm far-ultraviolet photoetching rubber and its preparation method[P]. Chinese Patent, CN1869814A. 2006-11-29. |
| [20] | Ito H. Dissolution behavior of chemically amplified resist polymers for 248-, 193-, and 157-nm lithography[J]. IBM Journal of Research and Development, 2001, 45(5): 683-695. DOI:10.1147/rd.455.0683 |
| [21] | Okoroanyanwu U, Shimokawa T, Byers J D, et al. Pd(Ⅱ)-catalyzed addition polymerization and ring opening metathesis polymerization of alicyclic monomers:routes to new matrix resins for 193 nm photolithography[J]. Journal of Molecular Catalysis A:Chemical, 1998, 133(1): 93-114. |
| [22] | Okoroanyanwu U, Shimokawa T, Byers J D, et al. New single-layer positive photoresists for 193-nm photolithography[J]. Proceedings of SPIE-The International Society for Optical Engineering, 1997, 3049: 92-103. |
| [23] | Whittaker A K, Blakey I, Liu H, et al. High-RI resist polymers for 193 nm immersion lithography[J]. Proceedings of SPIE-The International Society for Optical Engineering, 2005, 5753: 827-835. |
| [24] | 魏玮, 刘敬成, 李虎, 等. 微电子光致抗蚀剂的发展及应用[J]. 化学进展, 2014, 26(11): 1867-1888. Wei W, Liu J C, Li H, et al. Development and application of mircroelectronic photoresist[J]. Progress in Chemistry, 2014, 26(11): 1867-1888. |
| [25] | Sanders D P. Advances in patterning materials for 193 nm immersion lithography[J]. Chemical Reviews, 2010, 110(1): 321-360. DOI:10.1021/cr900244n |
| [26] | Zimmerman P A, Byers J, Piscani E, et al. Development of an operational high refractive index resist for 193nm immersion lithography[J]. Proceedings of the SPIE-Advanced Lithography, 2008, 6923(6): 1-10. |
| [27] | Wang Q, Yan C, You F, et al. A new type of sulfonium salt copolymers generating polymeric photoacid:Preparation, properties and application[J]. Reactive and Functional Polymers, 2018, 130: 118-125. DOI:10.1016/j.reactfunctpolym.2018.06.004 |
| [28] | 冉瑞城, 沈吉, 庄学军.含硅193 nm负性光刻胶及其成膜树脂[P].中国专利, CN1834785A. 2006-9-20. Ran R C, Shen J, Zhuang X J. Deep UV positive photoresist containing nano silicon and its film forming resin[P]. Chinese Patent, CN1834785A. 2006-9-20. |
