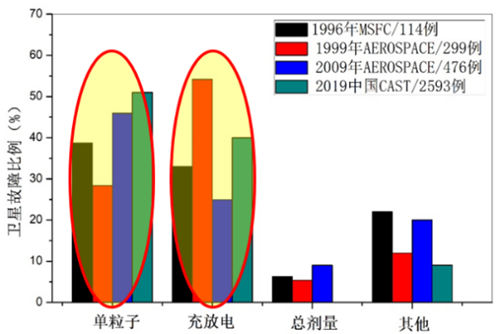
图1. 空间环境通过不同方式诱发在轨卫星故障的比例
空间中心复杂航天系统电子信息技术院重点实验室陈睿副研究员、韩建伟研究员团队以典型星用SRAM存储电路和运放线性电路为例,首次研究揭示了单粒子和充放电两种空间辐射效应导致星用电路“软错误”的特征规律、敏感区域以及损伤机制的关联性与区别,为全面厘清二者诱发星用电子器件错误和设备故障的异同规律及机理、建立全面评估风险、正确防护设计和准确诊断在轨故障的技术方法提供重要参考和理论支持。

图2. SEE与SESD作用SRAM电路(上)和运放电路(下)的原理过程
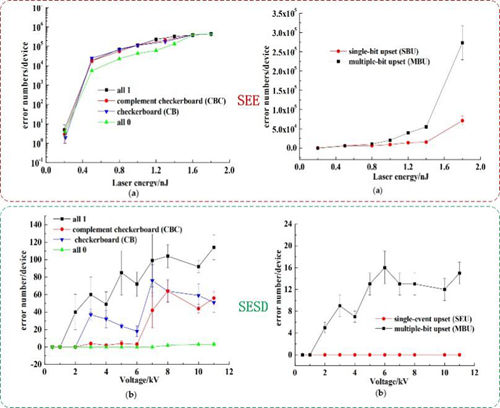
图3. SEE(上)和SESD(下)作用致SRAM错误数与错误类型
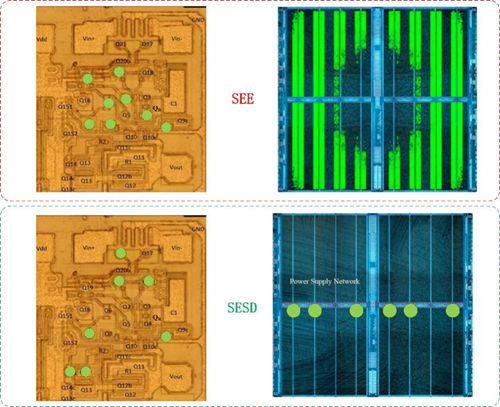
图4.SRAM(左)和运放(右)的辐射薄弱区域: SEE敏感区域(上)和SESD敏感区域(下)
该研究得到国家自然科学基金青年基金、面上项目以及中科院复杂航天系统电子信息技术重点实验室基金的资助。相关成果发表于空间抗辐照领域国际顶级刊物IEEE Transactions on Device and Materials Reliability[1]和Electronics[2]上。
[1] Chen R, Chen L , Han J W , et al. Comparative Study on the Transients Induced by Single Event Effect and Space Electrostatic Discharge[J]. IEEE Transactions on Device and Materials Reliability, 2019, PP (99):1-1.
[2] Chen R, Chen L, Han J W, et al. Comparative Study on the "Soft Errors" Induced by Single-Event Effect and Space Electrostatic Discharge [J]. Electronics, 2021, 10(7):802.
论文链接:
[1] https://ieeexplore.ieee.org/document/8889730
[2] https://www.mdpi.com/2079-9292/10/7/802/htm
(供稿:系统室)
