近期,中国科学院金属研究所沈阳材料科学国家研究中心研究人员与国内多家单位合作,发现了二维极限下层状半导体材料碲化镓(GaTe)面内电导率的巨各向异性,并实现了在门电压调控下电学各向异性几个数量级的变化,最后进行了相关原型器件的演示。该项研究工作于5月24日在Nature Communications杂志在线发表(DOI: 10.1038/s41467-019-10256-3)。
研究团队采用惰性气氛下原子层厚度的垂直组装技术,将厚度范围在4.8-20nm的少数层GaTe封装于两层氮化硼(h-BN)之中。通过微纳米加工手段制备得到场效应器件,并进行系统的电学测量。实验结果表明,室温下空穴掺杂的少数层GaTe电导率呈现出随方向变化的椭圆振荡行为,也即存在与已报道的SnSe、GeP等体系相似的电导率各向异性(比值在10以内)。研究人员通过门电压调控,将GaTe的费米面从空穴掺杂调节至价带边时,x方向电导率得到极大抑制,上述电导率各向异性的比值能够从10倍飙升至5000倍(图1),远超目前报道的具有面内电学各向异性的其他体系。
研究团队对该体系做了系统的第一性原理计算和量子输运特性模拟,计算和模拟结果与实验结果定性吻合。计算结果表明,该体系中低对称性的晶体结构导致了两能带色散的各向异性:在接近价带顶处,随方向变化的载流子其有效质量最大值和最小值之间存在一个数量级的差异(最大有效质量约1.55m0,最小有效质量约0.18m0)。同时,电声耦合形变势在晶格方向上也存在和有效质量一致的明显差异。这种载流子有效质量和电声耦合形变势的差异性正是GaTe巨各向异性电导率的原因。量子输运模拟结果表明,在特定方向上,载流子透射率展现出非同寻常的门电压调控敏感性,电导率各向异性比值随门电压变化产生数量级的巨大变化,呈现出与实验一致的调控趋势。
基于上述发现,研究团队在该体系中引入了石墨浮栅,构建了全范德华组装的各向异性GaTe浮栅存储纳米器件,并演示了该器件中优异的存储器性能(图2)。通过一次门电压擦写,在该浮栅操控的原型存储器件中可同时实现x和y方向(两者方向垂直)两组信息存储(图3)。
二维极限GaTe纳米电子器件展示出了门电压可调的、面内巨各向异性电阻效应(Giant Anisotropic Resistance),为实现新型各向异性逻辑运算及存储单元提供了可能。
该工作由金属所韩拯研究员、杨腾副研究员、张志东研究员设计,在山西大学秦成兵副教授、张靖教授,北京大学陈剑豪教授、叶堉教授,以及国防科技大学朱梦剑副教授等合作下完成。金属所博士生王汉文、陈茂林、王雅宁,与国防科技大学朱梦剑副教授为本文共同第一作者。韩拯研究员、杨腾副研究员、陈剑豪教授、秦成兵副教授为共同通讯作者。该工作得到了青年****、国家自然科学基金委、沈阳材料科学国家研究中心、科技部重点研发计划纳米科技专项等支持。
全文链接:https://www.nature.com/articles/s41467-019-10256-3

图1 少数层GaTe范德华异质结器件中随门电压可调的面内电学各向异性
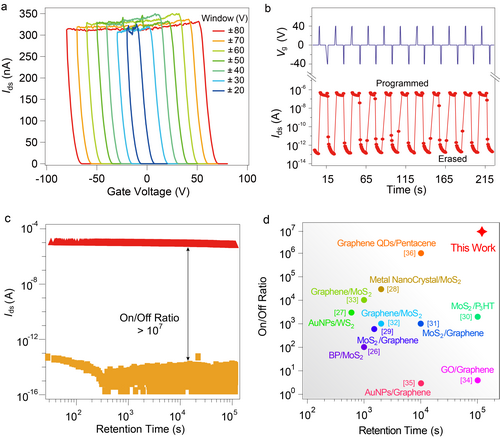
图2 堆叠范德华结构(h-BN/Graphene/h-BN/GaTe/h-BN)浮栅存储器的性能展示
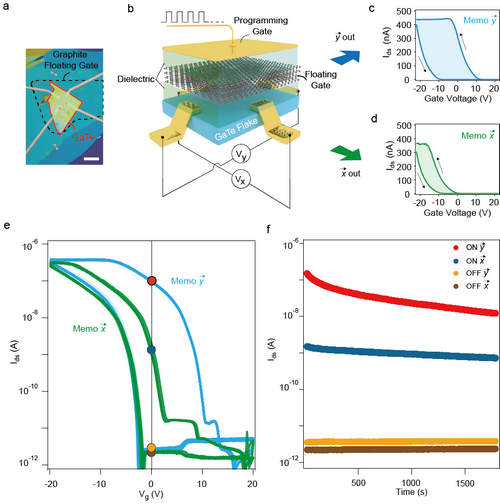
图3 少数层GaTe各向异性浮栅存储器件的操控演示:通过一次门电压擦写,实现了x和y方向(两者垂直)两组信息存储
