对于新型存储器RRAM,初始电形成过程会增加电路设计复杂度,带来可靠性问题,一直是工业界和科研界研究的热点。刘明院士团队在RRAM方向的研究具有丰富的经验,针对28纳米的1Mb RRAM测试芯片(IEDM 2017 2.4.1),提出了高温forming的编程方法,可以将平均forming电压从2.5V以上降为1.7V。由于高温forming过程中细丝内残留的氧离子大幅减少,编程之后由于氧离子和氧空位复合造成的电阻弛豫效应得到消除,器件的保持特性得到了40以上的大幅提升。
 针对先进工艺节点的嵌入式存储器缺失问题,刘明院士团队与殷华湘研究员合作提出了基于HZO铁电FinFET的混合存储器件。该器件在电荷俘获模式下,表现出高耐久性(>1012),高操作速度(<20ns),良好的数据保持特性(104@85oC),与DRAM的性能相近,为在SOC芯片及CPU芯片中集成嵌入式DRAM提供了可能。当器件工作在电筹翻转模式下的时候,器件表现出非常好的数据保持特性(>10年)以及对读取信号串扰的免疫能力,使该器件同时具有优越的不挥发存储特性。
针对先进工艺节点的嵌入式存储器缺失问题,刘明院士团队与殷华湘研究员合作提出了基于HZO铁电FinFET的混合存储器件。该器件在电荷俘获模式下,表现出高耐久性(>1012),高操作速度(<20ns),良好的数据保持特性(104@85oC),与DRAM的性能相近,为在SOC芯片及CPU芯片中集成嵌入式DRAM提供了可能。当器件工作在电筹翻转模式下的时候,器件表现出非常好的数据保持特性(>10年)以及对读取信号串扰的免疫能力,使该器件同时具有优越的不挥发存储特性。基于上述成果的2篇研究论文入选2018国际电子器件大会。第一作者许晓欣博士、罗庆博士分别在大会上作了口头报告。两篇论文的通讯作者均为吕杭炳研究员和刘明院士。
IEEE国际电子器件大会始于1954年,现已成为全球报道半导体及电子领域最新的科技、研发设计、制造、物理学及建模技术的主要论坛,旨在为产学研界的研究****提供关于电子器件最新研究进展和研究成果的国际交流平台。
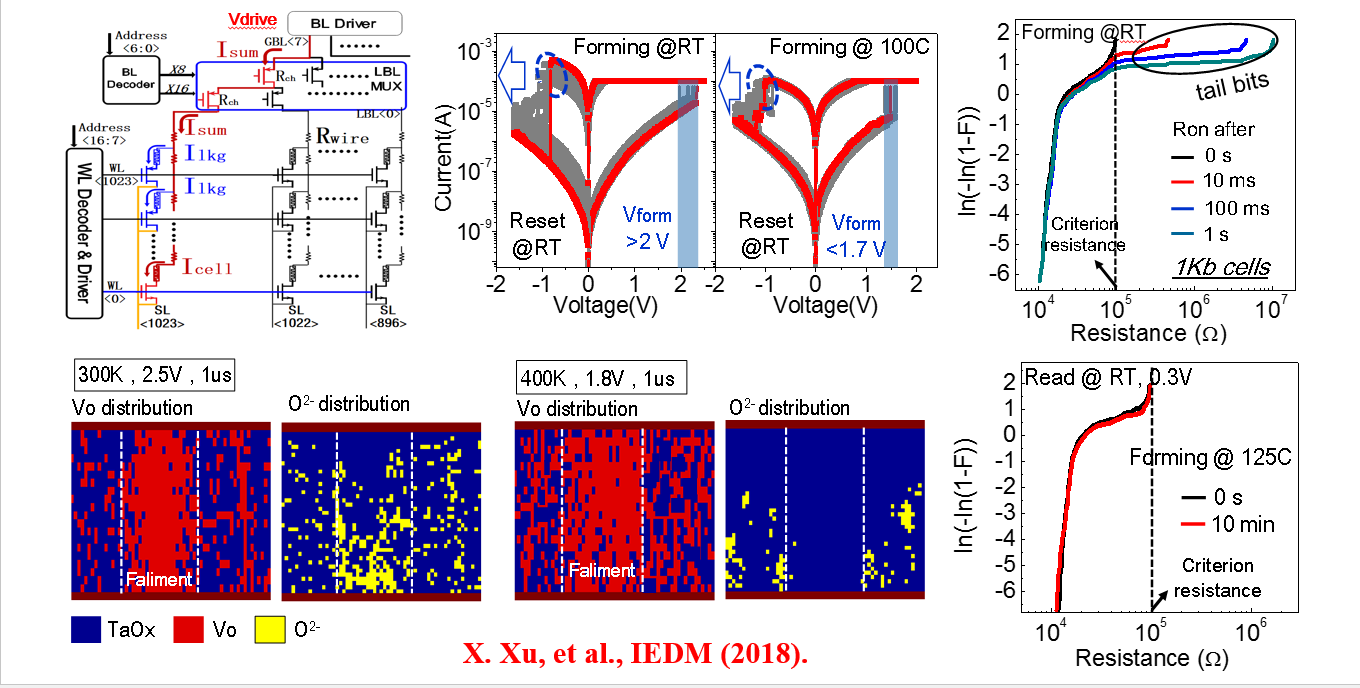
图1. 28纳米 RRAM测试芯片中采用高温forming的测试方法,将器件的forming电压降低至1.7V以下,显著提升了存储阵列的良率与可靠性
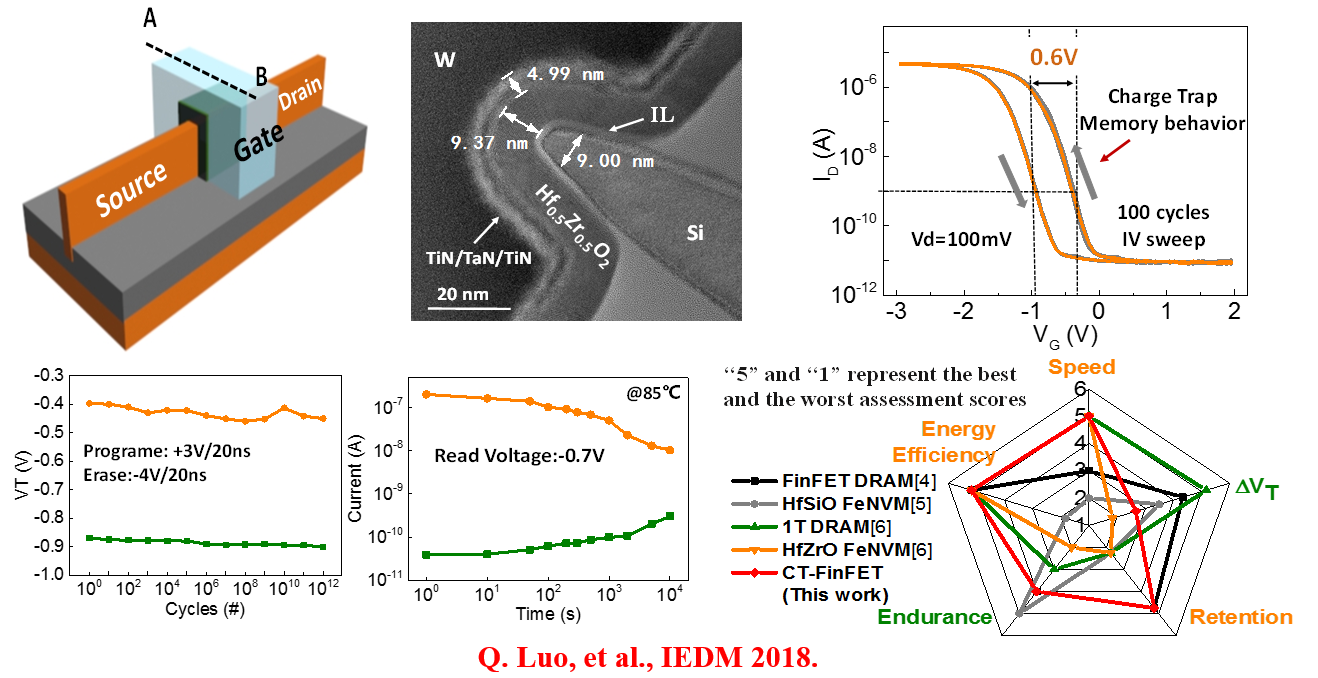
图2. 基于HfZrO2铁电材料的Finfet结构1T DRAM,实现了1012以上20ns量级的快速擦写,以及85度下104秒的长时间保持,为在CPU中嵌入百兆级别的大缓存提供了新途径
